一、什么是BGA封装?
BGA(Ball Grid Array,球栅阵列)封装,于1990年代初由美国Motorola与日本Citizen公司率先开创。它是一种高密度、多引脚的大规模集成电路封装技术,其核心结构是在封装基板背面,以矩阵形式排列的微小锡球作为与外部电路连接的媒介。

二、BGA封装的优势
相比传统的QFP(四边引脚扁平封装)等封装形式,BGA具有以下显著优势:
- 互连路径缩短:信号传输距离更短,有效提升电气性能。
- 空间利用率高:在同样面积下,BGA能容纳远超QFP的引脚数,极大节约基板空间。
- 成品率更高:BGA焊点间距较大(通常为1.27mm),对贴装精度要求相对宽松,且具有“自对位”特性。在回流焊过程中,表面张力能自动拉正偏移的芯片,焊点失效率较QFP降低两个数量级。
- 可靠性强:BGA引脚为球形,牢固且不易变形,共面性好,散热性能优良。
三、常见BGA类型
根据基板材料和封装结构的不同,BGA主要分为以下四种类型,它们在应用场景上各有侧重:
| 封装类型 | 基板/ 封装结构 | 引脚形式 | 特点 | 典型应用 |
|---|---|---|---|---|
| PBGA | BT 树脂基板 + 环氧塑封 | 焊球 | 成本低、与PCB 匹配好、工艺成熟 | 民用领域 |
| CBGA | 多层陶瓷基板+ 气密封装 | 焊球 | 高可靠、耐高温、气密性好 | 军用领域 |
| CCGA | 多层陶瓷基板+ 气密封装 | 金属柱 | CBGA 大尺寸升级版,抗热应力强 | 高功率大引脚可靠器件 |
| TBGA | 柔性载带+ 倒装芯片 | 焊球 | 热阻低、应力缓冲好、轻薄 | 民用通讯领域 |

PBGA剖面结构示意图
四、BGA质量控制
BGA封装的可靠性,核心在于焊点的牢固程度。在实际应用中,BGA器件需要承受温度变化、机械振动、冲击等多种应力,任何微小的焊接缺陷都可能导致“虚焊”、“冷焊”甚至焊点脱落,引发严重的功能失效。因此,在BGA的研发、生产及来料检验环节,推拉力测试成为不可或缺的可靠性验证手段。

推拉力测试在BGA上的主要应用:
1. 金球推拉力测试: 通过推拉力测试机,可以对金球进行推球和拉线测试,评估键合强度。这直接关系到芯片内部引线连接的可靠性,防止因键合不良导致的早期开路失效。
2. 焊球剪切力测试: 这是针对BGA锡球的关键测试。测试机的推刀会从侧面水平推动单个焊球,记录焊球从基板或PCB上被推离时的最大剪切力值。该测试能有效评估焊球的焊接强度、焊盘附着力以及焊料合金的脆性,是判定回流焊工艺质量的核心指标。
3. 芯片剪切力测试: 针对裸片(Die)或封装体,测试机可以进行芯片剪切测试,测量芯片与基板或基板与PCB之间的粘接力。这有助于验证底部填充胶(Underfill)的加固效果,确保器件在跌落或弯曲测试中不会发生界面分层。
以上就是科准测控小编分享的关于BGA封装技术及其可靠性测试的全部内容。如果您对BGA推拉力测试、焊球剪切力测试、金球推力测试等方面有需求,或者对推拉力测试机选型,安装,使用方面有疑问,欢迎关注我们并私信联系,专业工程师将为您提供一站式的测试解决方案与技术支持。
(注:本文部分基础原理引用自行业公开资料,图表示意请参考相关技术文献。实际测试方案建议结合具体工艺需求。)
审核编辑 黄宇
-
封装
+关注
关注
128文章
9317浏览量
149021 -
BGA
+关注
关注
5文章
586浏览量
51932
发布评论请先 登录
COB元器件推拉力测试怎么做?推拉力测试机选型指南+实测演示

基于推拉力测试机的PCBA电路板元器件焊点可靠性评估与失效机理探讨

推拉力测试机详解:硅基WLP封装焊球剪切与拉脱测试全流程
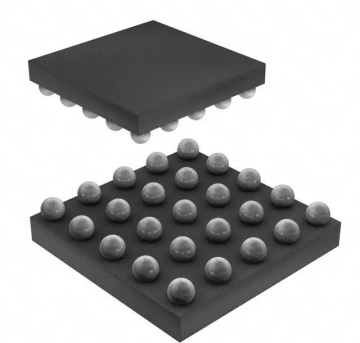
从失效分析到工艺优化:推拉力测试机在微电子封装中的应用

从检测到优化:推拉力测试仪在半导体封装中的全流程应用解析

提升功率半导体可靠性:推拉力测试机在封装工艺优化中的应用

实测案例:如何用推拉力测试机进行SMT元器件焊接强度测试?

ASTM F1269标准解读:推拉力测试机在BGA焊球可靠性测试中的应用




 一文掌握BGA封装技术:从基础到可靠性测试,推拉力测试机如何保障品质?
一文掌握BGA封装技术:从基础到可靠性测试,推拉力测试机如何保障品质?


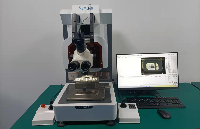





评论