武汉千亿芯片项目停摆,成立不到三年陷“烂尾”风险。据武汉东西湖区政府于 7 月 30 日发布的《上半年东西湖区投资建设领域经济运行分析》文件(现已删除)披露,投资千亿的武汉弘芯项目运行近三年后,因存在较大资金缺口,随时面临资金链断裂风险。弘芯半导体项目目前基本停滞,剩余 1123 亿元投资难以在今年申报。
目前,该报告文件已经在官网删除。
报告节选:
我区(武汉东湖区)投资领域面临的挑战比疫情期间小了很多,但随着疫情的全球爆发,在全球市场信心不足的大环境下,我区投资领域依然困难重重。
(一)项目投资主体资金不足。
1、武汉弘芯半导体制造项目为我区重大项目,目前,该项目一期主要生产厂房、研发大楼(总建筑面积 39 万 m2)均已封顶或完成。一期生产线 300 余台套设备均在有序订购,陆续进厂。国内唯一能生产 7 纳米芯片的核心设备 ASML 高端光刻机已入厂。但项目存在较大资金缺口,随时面临资金链断裂导致项目停滞的风险。二期用地一直未完成土地调规和出让。因项目缺少土地、环评等支撑资料,无法上报国家发改委窗口指导,导致国家半导体大基金、其他股权基金无法导入。
2、1-6 月,全区房地产企业本年实际到位资金 100.98 亿元,……
这是武汉官方首次提及弘芯面临的危机,但从 2019 年底因诉讼造成土地冻结之后,业内关于武汉弘芯难以为继的猜测早已此起彼伏。首先是去年接任武汉弘芯半导体 CEO 一职的前台积电共同 COO 蒋尚义,当时一度传出他有倦勤之意,可能退出该团队,那时外界分析武汉弘芯项目恐有变。
武汉弘芯半导体制造有限公司于 2017 年 11 月成立,总部位于中国武汉临空港经济技术开发区。公司总经理兼首席执行官蒋尚义系在台积电任职 10 多年并曾担任 CTO,也是创始人张忠谋最为重视的研发人物之一。
然而,弘芯仍然在“武汉市重大专案”中,被武汉市政府视为当地发展半导体产业的重大项目。
官网消息显示,公司汇聚了来自全球半导体晶圆研发与制造领域的专家团队,拥有丰富的 14 纳米及 7 纳米以下节点 FinFET 先进逻辑工艺与晶圆级先进封装技术经验。
武汉弘芯项目总投资额约 200 亿美元。主要投资项目为:
一、预计建成 14 纳米逻辑工艺生产线,总产能达每月 30,000 片;
二、预计建成 7 纳米以下逻辑工艺生产线,总产能达每月 30,000 片;
三、预计建成晶圆级先进封装生产线。
弘芯半导体制造产业园曾是 2018 年武汉单个最大投资项目。该半导体项目在武汉市 2020 年市级重大在建项目计划中位居第一,总投资额第一。
根据武汉市发改委发布的《武汉市 2020 年市级重大专案计划》,武汉弘芯半导体制造专案在先进制造专案中排名第一位。
虽然成立仅三年,武汉弘芯也是麻烦不断。由于项目一期工程总承包商拖欠分包商 4100 万工程款,2019 年 11 月,湖北省武汉市中级人民法院一纸民事裁定书,查封武汉弘芯半导体制造有限公司 300 多亩土地使用权,查封期限三年并立即执行。项目总规划用地面积 636 亩,此次被查封土地面积超过一半。
武汉弘芯一期项目的计划总投资额 520 亿元,为何会出现这种情况,对此官方声明回应称,公司按期足额支付总承包商火炬集团工程款,无拖期支付工程进度款行为。
光刻机入场就被拿去抵押贷款
2019 年 12 月,武汉弘芯高调举行的“ASML 光刻机入场仪式”掩盖了资金困境。这台 ASML 光刻机价值人民币 5.8 亿元,号称“国内唯一一台能生产 7 纳米芯片”的设备,但有业内人士表示这台型号 1980 的设备做不到 7 纳米。、
据报道,这台的光刻机刚刚入场就被用于抵押贷款。通过天眼查发现,今年 1 月 20 日(也就是在武汉封城之前),武汉弘芯就将这台 ASML 光刻机抵押给了武汉农村商业银行股份有限公司东西湖支行,贷款了 58180.86 万元。根据抵押资料显示,抵押的这台 ASML 光刻机型号为 TWINSCAN NXT:1980Di,状态为“全新尚未启用”,评估价值为 58180.86 万元。
除了这台光刻机,目前弘芯厂区的设备寥寥无几。
2020 年第一季到第二季之间,武汉弘芯是处于搬入机台设备的高峰期,已入厂的设备主要以光刻机为主,而其他的设备预计于 3 月后陆续到位,等到机台进场,会进行装机和验机程序,然后密集地展开研发。
然而,疫情打乱了原本计划和节奏,除了影响密集装机,目前已经招募员工距离目标数字也有较大距离。2020 年 6 月,有传闻称蒋尚义已“萌生退意”,原因是弘芯的投资与设备未能到位,导致运营困难。
官方新闻最后一次更新显示为 7 月 8 日。主题为疫情期间弘芯公司坚守岗位员工表彰大会隆重举行,董事长李雪艳、总经理兼首席执行官出席蒋尚义出席会议。
据了解,武汉弘芯原计划购置设备 3,560 台套,但根据东西湖区统计局的分析报告,2020 年开始的新冠肺炎疫情让武汉封城长达 76 天,导致后续设备无法顺利装机。再加上近期中美贸易战的持续升温,取得美国半导体设备难度增高,目前专案一期生产线仅有 300 多台套设备,处于在订购和进厂阶段。
武汉弘芯原本计划第一阶段建月产能达 3 万片的 14nm 逻辑 IC 生产线,第二阶段将建置月产能 3 万片的 7nm 生产线,第三阶段将建晶圆级先进封装及小芯片(chiplet)生产线,如今产线规模大幅度缩水。
即使只有少数设备进厂,武汉弘芯也未能付清尾款。据台媒报道,台湾厂商帆宣系统科技日前就因未收到尾款,而将卖给武汉弘芯的特种气体设备从厂区撤走。
员工被要求延迟入职
有自称弘芯员工的网友表示,工厂现有四、五百名员工,但因设备数量屈指可数,无法进行生产线实际操作,现在的日常工作“都是读 paper、写 PPT”,部分员工须进行“产线模拟”,由员工“饰演”机台。有报导指出,弘芯的 14nm、7nm 生产线都还遥不可及,但“产线模拟”员工组已开始强攻 3nm 了。
据悉公司还要求部分已经收到 offer 的员工延迟到岗报道。知乎上名为@inception 的作者表示,他本来 7 月份应该入职的,结果现在不断往后延迟入职,而且具体入职时间也不说,就叫等,头一次遇到这种情况。
在他的发言下有不少遇到相同情况的员工分享他们的遭遇。令人不解的是,延期入职说明公司暂时不需要这么多人,但是弘芯每天在前程无忧仍有 200 多个岗位在招聘。
还有网友表示去现场看过,工地根本没啥动静,基本只能用荒凉来形容了。
官方新闻最后一次更新显示为 7 月 8 日。主题为疫情期间弘芯公司坚守岗位员工表彰大会隆重举行,董事长李雪艳、总经理兼首席执行官出席蒋尚义出席会议。
对于陷入窘境的半导体项目,一些业内人士并不惊讶。当前多地一窝蜂地上马项目,一旦后续资金接续不上,最终的结局只能是关门。对于动辄上百亿的半导体项目投资,政府投资带动社会投资的模式也是知易行难。
责任编辑:pj
-
芯片
+关注
关注
463文章
54562浏览量
470357 -
半导体
+关注
关注
339文章
31398浏览量
267278 -
晶圆
+关注
关注
53文章
5472浏览量
132875
发布评论请先 登录
晶圆工艺制程清洗方法

武汉芯源小容量存储芯片EEPROM产品的特点
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
国内最大!长飞先进武汉基地投产,明治传感助力半导体智造升级
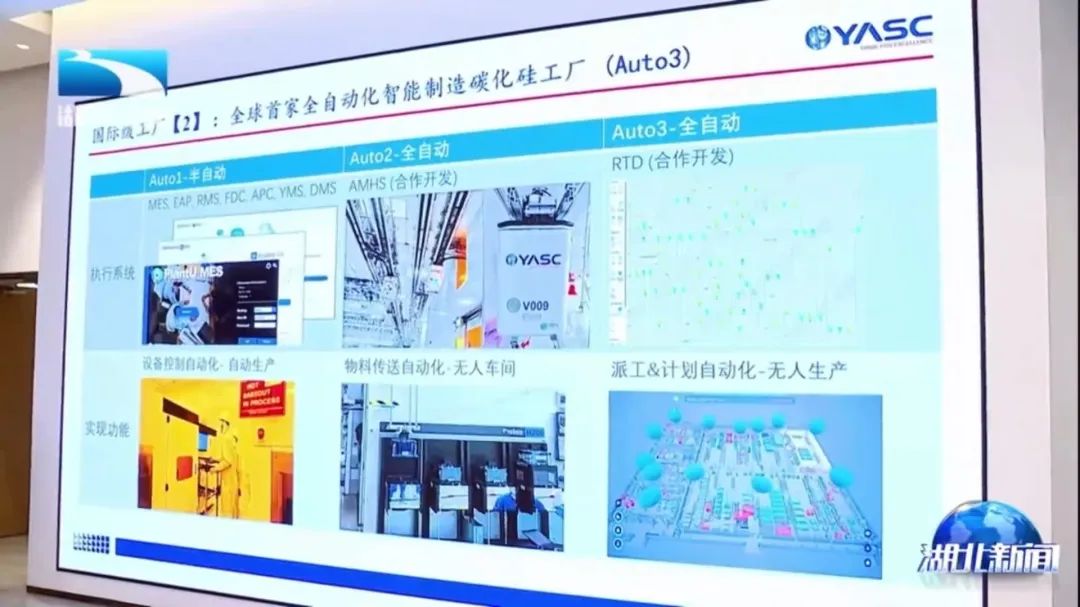
什么是晶圆级扇入封装技术




 武汉弘芯基于FinFET 先进逻辑工艺与晶圆级先进封装技术经验
武汉弘芯基于FinFET 先进逻辑工艺与晶圆级先进封装技术经验












评论