技术成为实现系统性能、带宽和功耗等方面指标提升的重要备选方案之一。对目前已有的晶圆级多层堆叠技术及其封装过程进行了详细介绍; 并对封装过程中的两项关键工艺,硅通孔工艺和晶圆键合与解键合工艺进行了分析
2022-09-13 11:13:05 6190
6190 介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP
2023-11-08 09:20:19 11649
11649 
晶圆承载系统是指针对晶圆背面减薄进行进一步加工的系统,该工艺一般在背面研磨前使用。晶圆承载系统工序涉及两个步骤:首先是载片键合,需将被用于硅通孔封装的晶圆贴附于载片上;其次是载片脱粘,即在如晶圆背面凸点制作等流程完工后,将载片分离。
2023-11-13 14:02:49 6498
6498 
技术的研究,由深圳市华芯邦科技有限公司(Hotchip)提出,可解决元器件散热、可靠性、成本、器件尺寸等问题,是替代传统封装技术解决方案之一。本文总结了HRP工艺的封装特点和优势,详细介绍其工艺实现路线,为传统封装技术替代提供解决方案。HRP晶圆级先进封装芯片
2023-11-30 09:23:24 3833
3833 
在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射(Sputtering)工艺
2024-01-24 09:39:09 3633
3633 
小弟想知道8寸晶圆盒的制造工艺和检验规范,还有不知道在大陆有谁在生产?
2010-08-04 14:02:12
经底部填充的CSP装配,其稳健的机械连接强度得到很大的提升。在二级装配中,由于底部填充,其抵御 由于扭转、振动和热疲劳应力的能力得以加强。但经过底部填充的CSP如何进行返修成了我们面临
2018-09-06 16:32:17
返修之后可以对重新装配的元件进行检查测试,检查测试的方法包括非破坏性的检查方法,如目视、光 学显微镜、电子扫描显微镜、超声波扫描显微镜、X-Ray和一些破坏性的检查测试,如切片和染色实验、老 化
2018-09-06 16:39:59
焊盘整理完成之后就可以重新贴装元件了。这时我们又面临了新的问题:如果选择锡膏装配的话,如何印刷锡膏呢?对于密间距的晶圆级CSP来说,这的确是一个难题。有采用小钢网,采用手工的方式来局部印刷锡膏
2018-09-06 16:32:16
晶圆级CSP的返修工艺包括哪几个步骤?晶圆级CSP对返修设备的要求是什么?
2021-04-25 08:33:16
晶圆级CSP的元件如何重新贴装?怎么进行底部填充?
2021-04-25 06:31:58
细间距的晶圆级CSP时,将其当做倒装晶片并采用助焊剂浸蘸的方法进行组装,以取代传统的焊膏印刷组装,如图2所示,首先将晶圆级CSP浸蘸在设定厚度的助焊剂薄膜中,然后贴装,再回流焊接,最后底部填充(如果有要求)。关于锡膏装配和助焊剂装配的优缺点。图1 工艺流程1——锡膏装配图2 工艺流程2——助焊剂装配
2018-09-06 16:24:04
; ·尺寸和位置精度受阻焊膜窗口的影响,不适合密间距元件的装配。 NSMD焊盘的尺寸和位置不受阻焊膜窗口的影响,在焊盘和阻焊膜之间有一定空隙,如图2和图3所示。对于 密间距晶圆级CSP,印刷电路板上的焊盘
2018-09-06 16:32:27
低,这样焊锡膏可以很容易地沉积。 对于0.5 mm和0.4 mm晶圆级CSP的装配,锡膏印刷面临挑战,选择合适的锡膏是关键之一。0.5 mmCSP的印 刷可以选用免洗型type3。0.4 mmCSP
2018-11-22 16:27:28
晶圆级CSP装配回流焊接工艺控制,看完你就懂了
2021-04-25 06:28:40
的是CSP装配的热循环可靠性,利用晶圆级CSP,采用不同的装配方式来比较其在热循环测试中的 可靠性。依据IPC-9701失效标准,热循环测试测试条件: ·0/100°C气——气热循环测试
2018-09-06 16:40:03
晶圆级CSP的装配对贴装压力控制、贴装精度及稳定性、照相机和影像处理技术、吸嘴的选择、助焊剂应 用单元和供料器,以及板支撑及定位系统的要求类似倒装晶片对设备的要求。WLCSP贴装工艺的控制可以参
2018-09-06 16:32:18
先进封装发展背景晶圆级三维封装技术发展
2020-12-28 07:15:50
晶圆级封装技术源自于倒装芯片。晶圆级封装的开发主要是由集成器件制造厂家(IBM)率先启动。1964年,美国IBM公司在其M360计算器中最先采用了FCOB焊料凸点倒装芯片器件。
2020-03-06 09:02:23
晶圆级封装类型及涉及的产品
2015-07-11 18:21:31
晶圆级芯片封装技术是对整片晶圆进行封装测试后再切割得到单个成品芯片的技术,封装后的芯片尺寸与裸片一致。
2019-09-18 09:02:14
` 晶圆级封装是一项公认成熟的工艺,元器件供应商正寻求在更多应用中使用WLP,而支持WLP的技术也正快速走向成熟。随着元件供应商正积极转向WLP应用,其使用范围也在不断扩大。 目前有5种成熟
2011-12-01 14:33:02
圆比人造钻石便宜多了,感觉还是很划算的。硅的纯化I——通过化学反应将冶金级硅提纯以生成三氯硅烷硅的纯化II——利用西门子方法,通过三氯硅烷和氢气反应来生产电子级硅 二、制造晶棒晶体硅经过高温成型,采用
2019-09-17 09:05:06
。包含所有常见术语,中英文对照,并辅以详细说明,可以帮助大家很好的掌握晶圆的操作。晶圆处理工程常用术语[hide][/hide]
2011-12-01 14:53:05
有人又将其称为圆片级-芯片尺寸封装(WLP-CSP),以晶圆圆片为加工对象,在晶圆上封装芯片。晶圆封装中最关键的工艺为晶圆键合,即是通过化学或物理的方法将两片晶圆结合在一起,以达到密封效果。如下
2021-02-23 16:35:18
多数返修工艺的开发都会考虑尽量减少对操作员的依赖以提高可靠性。但是对经过底部填充的CSP的移除 ,仅仅用真空吸嘴不能将元件移除。经过加热软化的底部填充材料对元件具有黏着力,此力远大于熔融的焊 料
2018-09-06 16:40:01
hi,all
硬件平台:6678,软件平台:CCS5.4
在CCS5中,怎么查看汇编指令的详细说明?
在CCS3.3中,可以通过help->
2018-06-21 13:41:41
到什么地方怎样找。比如我需要F28335的SCI的详细说明,我需要F28335的I2C的详细说明(具体到工作原理的细节,每一个寄存器每一个位的说明),不一定要中文的,英文的也可以,请问这样的文档我应该怎么找
2020-06-10 15:31:39
MCKIT - 需要单个分流方法的更详细说明/文档以上来自于谷歌翻译以下为原文 MCKIT - more detailed explanation / documentation for single shunt method required
2019-05-06 15:01:44
PoP 元件和焊接。OKI公司已开发出基于APR 5000返修工作站的PoP返修工艺,下面就返修工艺中各环节的控制进行介绍。 (1)PoP元件的移除 在移除元件之前首先要对PCBA进行加热,控制组
2018-09-06 16:32:13
SiC SBD 晶圆级测试 求助:需要测试的参数和测试方法谢谢
2020-08-24 13:03:34
制造工艺,稳定控制产品的各种参数,具有漏电电流小, 击穿电压稳定,良率高,钳位电压低,电容有低容,普容和高容;做回扫型ESD产品性能更优,CSP晶圆级封装可以提高产品性能。接下来我们来分享常规ESD
2020-07-30 14:40:36
50Mhz来驱动网口正常工作,也可以用MCO1。这里的详细倍频分频选择网口模块的配置再详细说明。不需要MCO输出频
2021-08-03 06:23:20
hex文件格式详细说明
2013-11-13 12:36:55
hex文件格式详细说明
2013-11-13 12:37:53
本帖最后由 eehome 于 2013-1-5 09:52 编辑
spi总线协议详细说明
2012-08-18 21:28:31
stc下载烧录详细说明
2014-01-05 16:28:30
,我们将采用穿硅通孔(TSV)用于晶圆级堆叠器件的互连。该技术基本工艺为高密度钨填充穿硅通孔,通孔尺寸从1μm到3μm。用金属有机化学汽相淀积(MOCVD)淀积一层TiN薄膜作为籽晶层,随后同样也采用
2011-12-02 11:55:33
`晶圆级封装(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有密闭空腔的保护
2011-12-01 13:58:36
的辅助。 测试是为了以下三个目标。第一,在晶圆送到封装工厂之前,鉴别出合格的芯片。第二,器件/电路的电性参数进行特性评估。工程师们需要监测参数的分布状态来保持工艺的质量水平。第三,芯片的合格品与不良品
2011-12-01 13:54:00
1、为什么晶圆要做成圆的?如果做成矩形,不是更加不易产生浪费原料?2、为什么晶圆要多出一道研磨的工艺?为什么不能直接做成需求的厚度?
2014-01-20 15:58:42
今日分享晶圆制造过程中的工艺及运用到的半导体设备。晶圆制造过程中有几大重要的步骤:氧化、沉积、光刻、刻蚀、离子注入/扩散等。这几个主要步骤都需要若干种半导体设备,满足不同的需要。设备中应用较为广泛
2018-10-15 15:11:22
程序里开启了WIFI的相关功能和配置,并没有对menuconfig进行相关设置是否会影响程序运行?还有,哪里可以找到menuconfig配置的详细说明?
2023-03-03 08:03:24
是什么推动着高精度模拟芯片设计?如何利用专用晶圆加工工艺实现高性能模拟IC?
2021-04-07 06:38:35
颗粒(如三星,现代,美光,力晶,尔必达等)有长期供货能力(这方面渠道的)请与我公司联系采购各类半导体报废晶圆片,IC晶圆、IC硅片、IC裸片、IC级单晶硅片、单晶硅IC小颗粒、IC级白/蓝膜片、芸膜片
2020-12-29 08:27:02
怎么选择晶圆级CSP装配工艺的锡膏?
2021-04-25 08:48:29
招聘6/8吋晶圆测试工艺工程师/主管1名工作地点:无锡工资:面议要求:1. 工艺工程师:晶圆测试经验3年以上,工艺主管:晶圆测试经验5年以上;2. 精通分立器件类产品晶圆测试,熟悉IC晶圆测试尤佳
2017-04-26 15:07:57
是否应该使用均方根(rms)功率单位来详细说明或描述与我的信号、系统或器件相关的交流功率?
2021-01-06 07:36:57
求3525电路详细说明,越详细越好,谢谢!
2012-04-18 08:21:14
;nbsp; 用激光对晶圆进行精密划片是晶圆-尤其是易碎的单晶半导体晶圆如硅晶圆刀片机械划片裂片的替代工艺。激光能对所有
2010-01-13 17:01:57
®工艺提供了一种经济高效的方式进行单个晶片堆叠,并能产出高良率以及稳固可靠的连接。在未来,我们期待Durendal®工艺能促进扇出型晶圆级封装在单个晶片堆叠中得到更广泛的应用。
2020-07-07 11:04:42
SRAM中晶圆级芯片级封装的需求
2020-12-31 07:50:40
摘要:本文详细讨论了Maxim的晶片级封装(WL-CSP),其中包括:晶圆架构、卷带包装、PCB布局、安装及回流焊等问题。本文还按照IPC和JEDEC标准提供了可靠性测试数据。 注
2009-04-21 11:30:27 9869
9869 
晶圆级CSP的返修工艺
经底部填充的CSP装配,其稳健的机械连接强度得到很大的提升。在二级装配中,由于底部填充,其抵御 由于
2009-11-20 15:42:17 682
682 晶圆级CSP的装配工艺流程
目前有两种典型的工艺流程,一种是考虑与其他元件的SMT配,首先是锡膏印刷,然后贴装CSP,回流焊接
2009-11-20 15:44:59 1607
1607 晶圆级封装产业(WLP),晶圆级封装产业(WLP)是什么意思
一、晶圆级封装(Wafer Level Packaging)简介 晶圆级封装(WLP,Wafer Level Package) 的一般定
2010-03-04 11:35:01 46790
46790 超级CSP——让倒装芯片获得最大可靠性一种晶圆片级封装
2017-09-14 11:31:37 22
22 晶圆制造总的工艺流程 芯片的制造过程可概分为晶圆处理工序(Wafer Fabrication)、晶圆针测工序(Wafer Probe)、构装工序(Packaging)、测试工序(Initial Test and Final Test)等几个步骤。
2018-04-16 11:27:00 15246
15246 由于晶圆级封装不需要中介层、填充物与导线架,并且省略黏晶、打线等制程,能够大幅减少材料以及人工成本;已经成为强调轻薄短小特性的可携式电子产品 IC 封装应用的之选。FuzionSC贴片机能应对这种先进工艺。
2018-05-11 16:52:52 53962
53962 
由于电子产品越来越细小,晶圆级CSP组装已经广泛地应用在不同产品了。
2018-10-30 09:51:06 47034
47034 本文档的主要内容详细介绍的是电气系统如何进行维修详细计划说明主要内容包括了:一、配电柜的维护保养二、变压器的维护保养三、发电机定期保养(每季度一次)四、电动机及起动控制柜、动力配电箱的维护保养五、母排的维护保养六、照明配电箱的维护保养七、每年的维护保养八、供配电设备维修保养规程
2018-12-10 08:00:00 22
22 本文档的主要内容详细介绍的是进行单片机串口通信的方式详细说明。
2019-08-01 17:35:00 1
1 本文档的主要内容详细介绍的是如何进行集成电路异或门电路的设计详细资料说明。
2019-05-07 16:12:20 24
24 本文档的主要内容详细介绍的生活如何进行色环电阻识别详细的方法说明资料免费下载。
2019-06-10 08:00:00 2
2 本文档的主要内容详细介绍的是如何进行PLC控制程序的设计详细资料PPT说明
2019-07-28 09:47:01 6871
6871 MUNICH - Karl Suss KG GmbH&公司今天宣布与硅谷的Image Technology公司合作,开发和标准化9英寸掩模,用于大批量晶圆凸点和晶圆级芯片级封装的生产。总体目标是降低晶圆级芯片级封装的掩模成本。
2019-08-13 10:48:59 3097
3097 本文档的主要内容详细介绍的是手机维修的基础知识详细说明包括了:一、发展历史,二 、手机的条码,三、手机的维修常用工具
2019-12-27 08:00:00 23
23 本文档的主要内容详细介绍的是硬盘芯片的维修教程详细说明包括了:第一章硬盘的物理结构和原理,第二章硬盘的基本参款,第三章硬盘道树结构简介,第四章硬盘的物理安装,第五章系统启动过程,第六章硬盘的品牌
2020-01-15 11:34:00 65
65 本文档的主要内容详细介绍的是常用电压放大级即前级放大胆管代换说明详细说明。
2020-03-16 08:00:00 19
19 本文档的主要内容详细介绍的是普中51单片机仿真器如何进行下载和操作教程详细说明。
2020-05-22 08:00:00 12
12 本文档的主要内容详细介绍的是BF3005CSP型VGA CMOS图像传感器的设计指南资料详细说明。
2020-06-02 08:00:00 15
15 AD six板的布局布线和生产工艺详细说明
2020-12-15 16:25:00 13
13 5GSA的异常事件如何进行优化详细说明
2020-12-11 00:48:00 15
15 晶圆切割(即划片)是芯片制造工艺流程中一道不可或缺的工序,在晶圆制造中属于后道工序。晶圆切割就是将做好芯片的整片晶圆按芯片大小分割成单一的芯片(晶粒)。最早的晶圆是用切片系统进行切割(划片)的,这种方法以往占据了世界芯片切割市场的较大份额,特别是在非集成电路晶圆切割领域
2020-12-24 12:38:37 20276
20276 在传统晶圆封装中,是将成品晶圆切割成单个芯片,然后再进行黏合封装。不同于传统封装工艺,晶圆级封装是在芯片还在晶圆上的时候就对芯片进行封装,保护层可以黏接在晶圆的顶部或底部,然后连接电路,再将晶圆切成单个芯片。
2022-04-06 15:24:19 12070
12070 晶圆级封装技术可定义为:直接在晶圆上进行大部分或全部的封装、测试程序,然后再进行安装焊球并切割,从而产出一颗颗的IC成品单元。
2022-07-10 11:23:51 2212
2212 当前红外热成像行业内非制冷红外探测器的封装工艺主要有金属封装、陶瓷封装、晶圆级封装三种形式。金属封装是业内最早的封装形式。金属封装非制冷红外探测器制作工艺上,首先对读出电路的晶圆片进行加工,在读
2022-10-13 17:53:27 4945
4945 
晶圆级封装是在整个晶圆(wafer)的级别上进行封装,而普通封装是在单个芯片级别上进行封装。晶圆级封装通常在晶圆制造完成后,将多个芯片同时封装在同一个晶圆上,形成多个封装单元。相比之下,普通封装将单个芯片分别封装在独立的封装器件上。
2023-08-30 16:44:57 5858
5858 对于0.5 mm和0.4 mm晶圆级CSP的装配,锡膏印刷面临挑战,选择合适的锡膏是关键之一。0.5 mmCSP的印 刷可以选用免洗型type3。0.4 mmCSP的印刷可以选用免洗型type3或type4,但type4有时可能会出现连锡现 象。
2023-09-27 14:58:28 915
915 NSMD焊盘的尺寸和位置不受阻焊膜窗口的影响,在焊盘和阻焊膜之间有一定空隙,如图2和图3所示。对于 密间距晶圆级CSP,印刷电路板上的焊盘一般都采用NSMD设计。
2023-09-27 15:02:03 1441
1441 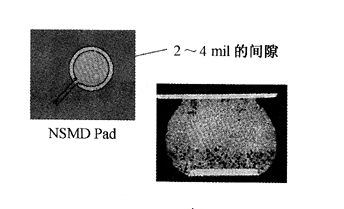
返修之后可以对重新装配的元件进行检查测试,检查测试的方法包括非破坏性的检查方法,如目视、光 学显微镜、电子扫描显微镜、超声波扫描显微镜、X-Ray和一些破坏性的检查测试,如切片和染色实验、老 化和热循环测试
2023-09-28 15:43:15 1080
1080 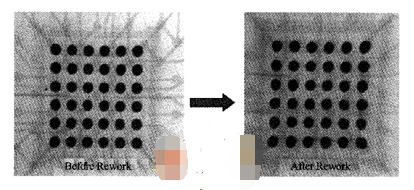
焊盘整理完成之后就可以重新贴装元件了。这时我们又面临了新的问题:如果选择锡膏装配的话,如何印刷锡膏呢?对于密间距的晶圆级CSP来说,这的确是一个难题。
2023-09-28 15:45:12 1277
1277 晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。
2023-10-18 09:31:05 4921
4921 
扇出型晶圆级封装技术的优势在于能够利用高密度布线制造工艺,形成功率损耗更低、功能性更强的芯片封装结构,让系统级封装(System in a Package, SiP)和3D芯片封装更愿意采用扇出型晶圆级封装工艺。
2023-10-25 15:16:14 2051
2051 
【科普】什么是晶圆级封装
2023-12-07 11:34:01 2771
2771 
随着半导体产业的飞速发展,晶圆键合设备及工艺在微电子制造领域扮演着越来越重要的角色。晶圆键合技术是一种将两个或多个晶圆通过特定的工艺方法紧密地结合在一起的技术,以实现更高性能、更小型化的电子元器件。本文将详细介绍晶圆键合设备的结构、工作原理以及晶圆键合工艺的流程、特点和应用。
2023-12-27 10:56:38 3180
3180 
共读好书 在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射
2024-03-05 08:42:13 3554
3554 
在本系列第七篇文章中,介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装
2024-08-21 15:10:38 4447
4447 
一、概述
晶圆背面涂敷工艺是在晶圆背面涂覆一层特定的材料,以满足封装过程中的各种需求。这种工艺不仅可以提高芯片的机械强度,还可以优化散热性能,确保芯片的稳定性和可靠性。
二、材料选择
晶圆背面涂敷
2024-12-19 09:54:10 620
620 
和低成本等优点,成为满足现代电子产品小型化、多功能化和高性能化需求的关键技术。本文将详细解析晶圆级封装的五项基本工艺,包括光刻(Photolithography)工
2025-01-07 11:21:59 3191
3191 
随着半导体技术的飞速发展,晶圆级封装(WLP)作为先进封装技术的重要组成部分,正逐渐成为集成电路封装的主流趋势。在晶圆级封装过程中,Bump工艺扮演着至关重要的角色。Bump,即凸块,是晶圆级封装中
2025-03-04 10:52:57 4980
4980 
晶圆清洗工艺是半导体制造中的关键步骤,用于去除晶圆表面的污染物(如颗粒、有机物、金属离子和氧化物),确保后续工艺(如光刻、沉积、刻蚀)的良率和器件性能。根据清洗介质、工艺原理和设备类型的不同,晶圆
2025-07-23 14:32:16 1369
1369 
 电子发烧友App
电子发烧友App

















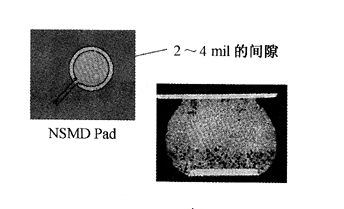
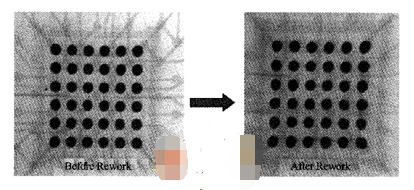













评论