MUNICH - Karl Suss KG GmbH&公司今天宣布与硅谷的Image Technology公司合作,开发和标准化9英寸掩模,用于大批量晶圆凸点和晶圆级芯片级封装的生产。总体目标是降低晶圆级芯片级封装的掩模成本。
“凭借当今的晶圆级CSP技术,先进封装行业正在迅速进入大批量生产200毫米晶圆,”迪特里希说。 Tönnies,慕尼黑Suss集团面罩对准器产品经理。 “两家公司之间的合作将进一步实现8英寸晶圆9英寸面罩全面曝光的标准化,并确保这些面罩可用于包装行业。”
根据合作协议,加利福尼亚州帕洛阿尔托的Karl Suss和Image Technology公司打算为9英寸光掩模定义质量标准,并对9英寸钠钙面膜进行大批量生产。在完成这项工作时,两家公司希望在不降低面罩性能的情况下找到降低成本的机会。
“先进的手持式射频设备的出现 - 通过无线接入互联网将宽带数据通信,电信和电力计算相结合 - 推动了对尖端封装技术的需求,”James A Quinn说道。 ,Palo Alto的Image Technology副总裁。 “我们公司在光掩模技术和光刻设备方面的综合经验将使我们能够为先进封装行业开发高性能但价格较低的解决方案,”他说。
用于晶圆凸点和晶圆级CSP生产,8英寸基板的全场曝光需要9×9英寸的掩模。两家公司表示,他们的联合开发工作旨在为关键尺寸(CD)均匀性和公差,层到层配准,数据放置精度,缺陷标准和材料平整度要求设定规格和定义参数。
-
CSP
+关注
关注
0文章
129浏览量
29606 -
PCB打样
+关注
关注
17文章
2982浏览量
23755 -
华强PCB
+关注
关注
8文章
1831浏览量
29401 -
华强pcb线路板打样
+关注
关注
5文章
14629浏览量
44788
发布评论请先 登录



 为晶圆级CSP生产设定掩模标准
为晶圆级CSP生产设定掩模标准

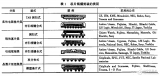



评论