常规IC封装需经过将晶圆与IC封装基板焊接,再将IC基板焊接至普通PCB的复杂过程。与之不同,WLP基于IC晶圆,借助PCB制造技术,在晶圆上构建类似IC封装基板的结构,塑封后可直接安装在普通PCB
2025-05-14 11:08:16 2423
2423 
晶棒需要经过一系列加工,才能形成符合半导体制造要求的硅衬底,即晶圆。加工的基本流程为:滚磨、切断、切片、硅片退火、倒角、研磨、抛光,以及清洗与包装等。
2025-08-12 10:43:43 4166
4166 
晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之IC产品。晶圆的原始材料是硅,而
2011-11-24 09:21:42 8021
8021 经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(Back Grinding)开始后端处理。背面研磨是将晶圆背面磨薄的工序,其目的不仅是为了减少晶圆厚度,还在于联结前端和后端工艺以解决前后两个工艺
2023-05-12 12:39:18 3435
3435 
经过前端工艺处理并通过晶圆测试的晶圆将从背面研磨(Back Grinding)开始后端处理。背面研磨是将晶圆背面磨薄的工序,其目的不仅是为了减少晶圆厚度,还在于联结前端和后端工艺以解决前后两个工艺
2023-05-22 12:44:23 2648
2648 
晶圆承载系统是指针对晶圆背面减薄进行进一步加工的系统,该工艺一般在背面研磨前使用。晶圆承载系统工序涉及两个步骤:首先是载片键合,需将被用于硅通孔封装的晶圆贴附于载片上;其次是载片脱粘,即在如晶圆背面凸点制作等流程完工后,将载片分离。
2023-11-13 14:02:49 6499
6499 
在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射(Sputtering)工艺
2024-01-24 09:39:09 3633
3633 
在半导体制造的复杂流程中,晶圆历经前道工序完成芯片制备后,划片工艺成为将芯片从晶圆上分离的关键环节,为后续封装奠定基础。由于不同厚度的晶圆具有各异的物理特性,因此需匹配不同的切割工艺,以确保切割效果与芯片质量。
2025-02-07 09:41:00 3050
3050 
晶圆制备是材料科学、热力学与精密控制的综合体现,每一环节均凝聚着工程技术的极致追求。而晶圆清洗本质是半导体工业与污染物持续博弈的缩影,每一次工艺革新都在突破物理极限。
2025-05-07 15:12:30 2193
2193 
本内容详解了晶圆制造工艺流程,包括表面清洗,初次氧化,热处理,光刻技术和离子刻蚀技术等
2011-11-24 09:32:10 7546
7546 小弟想知道8寸晶圆盒的制造工艺和检验规范,还有不知道在大陆有谁在生产?
2010-08-04 14:02:12
的印刷焊膏。 印刷焊膏的优点之一是设备投资少,这使很多晶圆凸起加工制造商都能进入该市场,为半导体厂商服务。随着WLP逐渐为商业市场所接受,全新晶圆凸起专业加工服务需求持续迅速增长。 实用工艺开发
2011-12-01 14:33:02
`晶圆制造总的工艺流程芯片的制造过程可概分为晶圆处理工序(Wafer Fabrication)、晶圆针测工序(Wafer Probe)、构装工序(Packaging)、测试工序(Initial
2011-12-01 15:43:10
+ 4HNO3 + 6 HF® 3H2SiF6 +4 NO + 8H2O 抛光:机械研磨、化学作用使表面平坦,移除晶圆表面的缺陷八、晶圆测试主要分三类:功能测试、性能测试、抗老化测试。具体有如:接触测试
2019-09-17 09:05:06
晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之IC产品。晶圆的原始材料是硅,而地壳表面有用之不竭的二氧化硅
2011-12-01 14:53:05
有人又将其称为圆片级-芯片尺寸封装(WLP-CSP),以晶圆圆片为加工对象,在晶圆上封装芯片。晶圆封装中最关键的工艺为晶圆键合,即是通过化学或物理的方法将两片晶圆结合在一起,以达到密封效果。如下
2021-02-23 16:35:18
晶圆级CSP的返修工艺包括哪几个步骤?晶圆级CSP对返修设备的要求是什么?
2021-04-25 08:33:16
晶圆级CSP装配回流焊接工艺控制,看完你就懂了
2021-04-25 06:28:40
晶圆级CSP的装配对贴装压力控制、贴装精度及稳定性、照相机和影像处理技术、吸嘴的选择、助焊剂应 用单元和供料器,以及板支撑及定位系统的要求类似倒装晶片对设备的要求。WLCSP贴装工艺的控制可以参
2018-09-06 16:32:18
,、WAFER承载料盒、晶圆提篮,芯片盒,晶圆包装盒,晶圆包装,晶圆切片,晶圆生产,晶圆制造,晶圆清洗,晶圆测试,晶圆切割,晶圆代工,晶圆销售,晶圆片测试,晶圆运输用包装盒,晶圆切割,防静电IC托盘(IC
2020-07-10 19:52:04
所有的电子元器件。 d辅助工具少测试周期长模拟IC设计者既需要全面的知识,也需要长时间经验的积累。模拟IC设计者需要熟悉IC和晶圆制造工艺与流程,需要熟悉大部分元器件的电特性和物理特性。通常很少
2016-12-26 15:06:14
Memory、PLL 锁相环电路、起振电路与温补电路。上面六幅图揭示了整个SITIME晶振生产工艺流程,SITIME MEMS 电子发烧友振采用上下两个晶圆叠加的方式,外部用 IC 通用的塑料做为封装。不仅大大减少的石英晶振的工序,而且更全面提升了产品性能。
2017-04-06 14:22:11
测量。
(2)系统覆盖衬底切磨抛,光刻/蚀刻后翘曲度检测,背面减薄厚度监测等关键工艺环节。
晶圆作为半导体工业的“地基”,其高纯度、单晶结构和大尺寸等特点,支撑了芯片的高性能与低成本制造。其战略价值不仅
2025-05-28 16:12:46
效应和功耗。因此,三维系统集成技术在性能、功能和形状因素等方面都具有较大的优势。用于三维集成的先进晶圆级技术晶圆级封装技术已在许多产品制造中得到广泛应用。目前正在开发晶圆级封装的不同工艺技术,以满足在提高性能
2011-12-02 11:55:33
产品重要性的同时,不约而同地表示要将精力集中在高性能模拟产品上。那么,在众说纷纭“高性能”的情况下,什么产品才是高性能模拟产品?面对集成度越来越高的半导体行业,高性能模拟产品是否生存不易?中国市场对高性能模拟产品的接受程度如何?
2019-06-20 06:22:00
纳米到底有多细微?什么晶圆?如何制造单晶的晶圆?
2021-06-08 07:06:42
` 晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之IC产品。晶圆的原始材料是硅,而地壳表面有用之不竭的二氧化硅
2011-12-01 11:40:04
的晶粒时,标有记号的不合格晶粒会被洮汰,不再进行下一个制程,以免徒增制造成本。在晶圆制造完成之后,晶圆测试是一步非常重要的测试。这步测试是晶圆生产过程的成绩单。在测试过程中,每一个芯片的电性能力和电路
2011-12-01 13:54:00
`晶圆级封装(WLP)就是在其上已经有某些电路微结构(好比古董)的晶片(好比座垫)与另一块经腐蚀带有空腔的晶片(好比玻璃罩)用化学键结合在一起。在这些电路微结构体的上面就形成了一个带有密闭空腔的保护
2011-12-01 13:58:36
本人做硅片,晶圆加工十三年,想做半导体行业的晶圆加工,不知道有没有合适的工作?
2018-04-03 16:09:21
1、为什么晶圆要做成圆的?如果做成矩形,不是更加不易产生浪费原料?2、为什么晶圆要多出一道研磨的工艺?为什么不能直接做成需求的厚度?
2014-01-20 15:58:42
翘曲度是实测平面在空间中的弯曲程度,以翘曲量来表示,比如绝对平面的翘曲度为0。计算翘曲平面在高度方向最远的两点距离为最大翘曲变形量。翘曲度计算公式:晶圆翘曲度影响着晶圆直接键合质量,翘曲度越小,表面
2022-11-18 17:45:23
的加工工艺流程,加工过程中需要运用刻蚀机在晶圆上把复杂的3D图形一层一层“堆叠”起来,实现单片机IC芯片的更小化。芯片,本质上是一片载有集成电路(IC:Integrated circuit)的半导体元件
2018-08-23 17:34:34
今日分享晶圆制造过程中的工艺及运用到的半导体设备。晶圆制造过程中有几大重要的步骤:氧化、沉积、光刻、刻蚀、离子注入/扩散等。这几个主要步骤都需要若干种半导体设备,满足不同的需要。设备中应用较为广泛
2018-10-15 15:11:22
目晶圆提高了设计效率,降低了开发成本,为设计人员提供了实践机会,并促进了集成电路设计成果转化,对IC设计人才的培训,及新产品的开发研制均有相当的促进作用。随着制造工艺水平的提高,在生产线上制造芯片
2011-12-01 14:01:36
是什么推动着高精度模拟芯片设计?如何利用专用晶圆加工工艺实现高性能模拟IC?
2021-04-07 06:38:35
在半导体晶圆的加工工艺中,对晶圆边缘磨削是非常重要的一环。晶锭材料被切割成晶圆后会形成锐利边缘,有棱角、毛刺、崩边,甚至有小的裂缝或其它缺陷,边缘的表面也比较粗糙。而晶圆的构成材料如Si、Ge
2019-09-17 16:41:44
怎么选择晶圆级CSP装配工艺的锡膏?
2021-04-25 08:48:29
招聘6/8吋晶圆测试工艺工程师/主管1名工作地点:无锡工资:面议要求:1. 工艺工程师:晶圆测试经验3年以上,工艺主管:晶圆测试经验5年以上;2. 精通分立器件类产品晶圆测试,熟悉IC晶圆测试尤佳
2017-04-26 15:07:57
时钟设备设计使用 I2C 可编程小数锁相环 (PLL),可满足高性能时序需求,这样可以产生零 PPM(百万分之一)合成误差的频率。高性能时钟 IC 具有多个时钟输出,用于驱动打印机、扫描仪和路由器等
2019-08-12 06:50:43
求晶圆划片或晶圆分捡装盒合作加工厂联系方式:QQ:2691003439
2019-03-13 22:23:17
激光用于晶圆划片的技术与工艺 激光加工为无接触加工,激光能量通过聚焦后获得高能量密度,直接将硅片
2010-01-13 17:01:57
`什么是硅晶圆呢,硅晶圆就是指硅半导体积体电路制作所用的硅晶片。晶圆是制造IC的基本原料。硅晶圆和晶圆有区别吗?其实二者是一个概念。集成电路(IC)是指在一半导体基板上,利用氧化、蚀刻、扩散等方法
2011-12-02 14:30:44
的两维直线电机工作台及直驱旋转平台,专用 CCD监视定位。采用红外激光作为光源切割硅晶圆,具有最佳的切割性价比,切割速度达到160mm/s,无机械应力作用,晶粒切割成品率高,切割后二极管芯片电学性能
2010-01-13 17:18:57
刻划LED刻划线条较传统的机械刻划窄得多,所以使得材料利用率显着提高,因此提高产出效率。另外激光加工是非接触式工艺,刻划带来晶圆微裂纹以及其他损伤更小,这就使得晶圆颗粒之间更紧密,产出效率高、产能高
2011-12-01 11:48:46
金属材料的工艺性能和切削加工性能的介绍:http://www.gooxian.com/ 1.金属材料的工艺性能 (1)铸造性能铸造性是指浇注铸件时,材料能充满比较复杂的铸型并获得优质铸件的能力
2017-08-25 09:36:21
` 集成电路按生产过程分类可归纳为前道测试和后到测试;集成电路测试技术员必须了解并熟悉测试对象—硅晶圆。测试技术员应该了解硅片的几何尺寸形状、加工工艺流程、主要质量指标和基本检测方法;集成电路晶圆测试基础教程ppt[hide][/hide]`
2011-12-02 10:20:54
什么是晶圆
晶圆是制造IC的基本原料
集成电路(IC)是指在一半导体基板上,利用氧化、蚀刻、扩散等方法,将众多电子电路组成
2009-06-30 10:19:34 9347
9347 Spartan EFEM系统可每小时加工450张晶圆
Crossing Automation公司 (www.crossinginc.com)宣布,已经提高公司的Spartan设备前端模块(EFEM)的性能,将其每小时的加工能力提高至450张晶
2010-03-31 09:50:52 1816
1816 什么是硅晶圆呢,硅晶圆就是指硅半导体积体电路制作所用的硅晶片。晶圆是制造IC的基本原料。
2011-08-07 16:29:09 11781
11781 2013年9月3日——领先的高性能模拟IC和传感器解决方案供应商奥地利微电子公司(SIX股票代码:AMS)今日宣布投资逾2,500万欧元在其位于奥地利格拉茨附近的晶圆制造工厂,用以建立3D IC专用的生产线。
2013-09-03 14:55:34 1433
1433 全球领先的高性能模拟IC和传感器供应商艾迈斯半导体(ams AG,SIX股票代码:AMS)晶圆代工事业部今日公布其快速、低成本的集成电路原型服务,该服务被称为多项目晶圆(MPW)或往复运行
2015-11-11 17:02:40 1178
1178 晶圆是微电子产业的行业术语之一。
2017-12-07 15:41:11 41078
41078 晶圆制造总的工艺流程 芯片的制造过程可概分为晶圆处理工序(Wafer Fabrication)、晶圆针测工序(Wafer Probe)、构装工序(Packaging)、测试工序(Initial Test and Final Test)等几个步骤。
2018-04-16 11:27:00 15246
15246 本文主要介绍了晶圆的结构,其次介绍了晶圆切割工艺,最后介绍了晶圆的制造过程。
2019-05-09 11:15:54 12823
12823 
IMT日前正式宣布:公司现已可提供8英寸(200mm)晶圆微电子机械系统(MEMS)工艺加工服务,同时公司还可以为MEMS行业发展提供空前丰富的其他资源组合。8英寸晶圆改变了MEMS器件制造的经济指标,每张晶圆可以产出大约为6英寸晶圆两倍数量的器件。
2019-06-13 14:32:53 3964
3964 晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能的集成电路产品。
2019-06-24 14:27:04 27809
27809 特种工艺技术包括高精度模拟CMOS、射频CMOS、嵌入式存储器CMOS、CIS、高压CMOS、 BiCMOS和BCDMOS。这些特种技术对晶圆代工厂的工艺参数有较为严格的容差限制,常用的DC-DC转换器、马达驱动器、电池充电器IC一般都使用8英寸晶圆生产。
2019-08-30 16:57:39 8128
8128 
晶圆的制造在半导体领域,科技含量相当的高,技术工艺要求非常高。而我们国半导体事业起步较晚,在晶圆的制造上还处于建设发展阶段。现在我国主要做的是晶圆的封测。我国的晶圆封测规模和市场都是全球首屈一指的,约占全球约1/4。
2019-08-12 14:13:00 48167
48167 根据台积电在第二十四届年度技术研讨会中的说明,SoIC是一种创新的多芯片堆叠技术,是一种晶圆对晶圆(Wafer-on-wafer)的键合(Bonding)技术,这是一种3D IC制程技术,可以让台积电具备直接为客户生产3D IC的能力。
2019-08-14 11:21:06 4993
4993 
随着模拟IC市场规模持续增长,模拟IC龙头厂商德州仪器(TI)已计划在美国德州Richardson地区投资32亿美元新建工厂,主要用于生产模拟IC的12英寸晶圆设施。
2019-11-28 15:05:36 1608
1608 晶圆切割(即划片)是芯片制造工艺流程中一道不可或缺的工序,在晶圆制造中属于后道工序。晶圆切割就是将做好芯片的整片晶圆按芯片大小分割成单一的芯片(晶粒)。最早的晶圆是用切片系统进行切割(划片)的,这种方法以往占据了世界芯片切割市场的较大份额,特别是在非集成电路晶圆切割领域
2020-12-24 12:38:37 20276
20276 晶圆在现实生活中具有重要应用,缺少晶圆,我们的手机、电脑等将无法制成。而且,高质量晶圆必将为我们制造的产品带来更高的性能。为增进大家对晶圆的了解,本文将对晶圆级CSP的返修工艺予以介绍。如果你对晶圆,抑或是晶圆相关内容具有兴趣,不妨继续往下阅读哦。
2021-02-11 17:38:00 2678
2678 晶圆是指制作硅半导体电路所用的硅晶片,其原始材料是硅。高纯度的多晶硅溶解后掺入硅晶体晶种,然后慢慢拉出,形成圆柱形的单晶硅。硅晶棒在经过研磨,抛光,切片后,形成硅晶圆片,也就是晶圆。晶圆的主要加工
2023-02-22 14:46:16 4
4 。 主要特点 化学品和晶圆消耗量低 占地面积小 3、层堆叠 4、通过优化的机器人和过程校准实现最佳性能 5、更高的安全标准 6、改进的最小晶圆接触 7、改进的化学控制稳定性 8、改进的排气压力控制稳定性 9、通过伺服电机改进杯层控制 10、易于维护 11、晶圆尺寸
2023-06-07 17:12:42 806
806 加工能力一定程度上决定了芯片封装的成品率与性能。IC晶圆,一般由硅(Si)构成,分为6英寸、8英寸、12英寸规格不等,晶片就是基于wafer制造而成。IC需要将Waf
2022-05-12 14:50:50 2311
2311 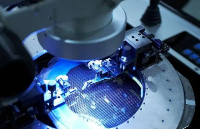
质变化。划片机制(TheDicingMechanism)硅晶圆划片工艺是“后端”封装制程工艺中的第一步。该工艺将晶圆分成独立带有电气性能的芯片,用于随后的芯片粘合(d
2021-11-25 17:29:51 3607
3607 
一、晶圆加工所有半导体工艺都始于一粒沙子!因为沙子所含的硅是生产晶圆所需要的原材料。晶圆是将硅(Si)或砷化镓(GaAs)制成的单晶柱体切割形成的圆薄片。要提取高纯度的硅材料需要用到硅砂,一种
2022-07-08 11:07:48 15325
15325 
晶圆经过前道工序后芯片制备完成,还需要经过切割使晶圆上的芯片分离下来,最后进行封装。不同厚度晶圆选择的晶圆切割工艺也不同:厚度100um以上的晶圆一般使用刀片切割;厚度不到100um的晶圆一般
2022-10-08 16:02:44 16401
16401 
晶圆切割是半导体制造中的关键环节之一。提升晶圆工艺制程需要综合考虑多个方面,包括切割效率、切割质量、设备性能等。针对这些问题,国产半导体划片机解决方案可以提供一些帮助。首先,在切割效率方面,国产
2023-06-05 15:30:44 20196
20196 
半导体制造设备厂商DISCO Corporation(总部:东京都大田区;总裁:Kazuma Sekiya)采用了KABRA(一种使用激光加工的晶锭切片方法),并开发了一种针对GaN(氮化镓)晶圆生产而优化的工艺。通过该工艺,可以同时提高GaN晶圆片产量,并缩短生产时间。
2023-08-25 09:43:52 1777
1777 
晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。
2023-10-18 09:31:05 4921
4921 
随着半导体产业的飞速发展,晶圆键合设备及工艺在微电子制造领域扮演着越来越重要的角色。晶圆键合技术是一种将两个或多个晶圆通过特定的工艺方法紧密地结合在一起的技术,以实现更高性能、更小型化的电子元器件。本文将详细介绍晶圆键合设备的结构、工作原理以及晶圆键合工艺的流程、特点和应用。
2023-12-27 10:56:38 3181
3181 
在本章当中,我们将为大家介绍硅片制造中使用的四种基本工艺,这四种基本工艺常用于在晶圆片表面上加工集成电路(IC)的电子元件。
2024-01-15 09:33:51 1925
1925 
的容量和功能。在过去的几十年中,基于薄晶圆 ( 通常厚度小于 100 μm) 的硅穿孔(Through-Silicon Via,TSV) 技术已经实现了 3D-IC 封装。但是由于薄晶圆的易碎性和易翘曲的倾向,在对器件晶圆进行背部加工过程中,需要利用胶粘剂将其固定在载体上,并使薄晶圆在背部
2024-03-29 08:37:59 2196
2196 FRAM SF25C20晶圆合封MCU,满足小尺寸和高性能需求
2024-04-22 09:49:21 1574
1574 
。而硅晶圆是传统的半导体材料,具有成熟的制造工艺和广泛的应用领域。 制造工艺: 碳化硅晶圆的制造工艺相对复杂,需要高温、高压和长时间的生长过程。而硅晶圆的制造工艺相对成熟,可以实现大规模生产。此外,碳化硅晶圆的生长速度
2024-08-08 10:13:17 4710
4710 在本系列第七篇文章中,介绍了晶圆级封装的基本流程。本篇文章将侧重介绍不同晶圆级封装方法所涉及的各项工艺。晶圆级封装可分为扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装
2024-08-21 15:10:38 4450
4450 
本文从硅片制备流程为切入点,以方便了解和选择合适的硅晶圆,硅晶圆的制备工艺流程比较复杂,加工工序多而长,所以必须严格控制每道工序的加工质量,才能获得满足工艺技术要求、质量合格的硅单晶片(晶圆),否则就会对器件的性能产生显著影响。
2024-10-21 15:22:27 1991
1991 在半导体行业,晶圆的制造、设计、加工、封装等近千道工艺环节中,温度始终贯穿其中。温度的精密监测对于确保晶圆的质量和最终产品的性能至关重要。微小的温度波动可能对电路的稳定性、可靠性以及功能性产生重大影响,因此,晶圆温度的精准测量已经成为关键的技术需求。
2024-12-04 15:57:08 1024
1024 
改善晶圆出刀TTV(Total Thickness Variation,总厚度变化量)异常的加工方法主要包括以下几种:
一、设备调整与优化
主轴与承片台角度调整
通过设备自动控制,进行工艺角度调整
2024-12-05 16:51:26 595
595 
一、概述
晶圆背面涂敷工艺是在晶圆背面涂覆一层特定的材料,以满足封装过程中的各种需求。这种工艺不仅可以提高芯片的机械强度,还可以优化散热性能,确保芯片的稳定性和可靠性。
二、材料选择
晶圆背面涂敷
2024-12-19 09:54:10 620
620 
指的是由于晶圆边缘的处理不同于中心区域,导致的电学和物理性能的差异。晶圆边缘由于距离加工工具较远或光刻曝光时的处理不均,可能会出现性能不稳定的情况。比如,金属层和通孔的连接可能不良,或者材料沉积不均,导致边缘区域的芯
2024-12-31 11:24:25 2163
2163 
8寸晶圆的清洗工艺是半导体制造过程中至关重要的环节,它直接关系到芯片的良率和性能。那么直接揭晓关于8寸晶圆的清洗工艺介绍吧! 颗粒去除清洗 目的与方法:此步骤旨在去除晶圆表面的微小颗粒物,这些颗粒
2025-01-07 16:12:00 813
813 实现芯片与外部电路电气连接的关键结构。本文将深入解析晶圆级封装Bump工艺的关键点,探讨其技术原理、工艺流程、关键参数以及面临的挑战和解决方案。
2025-03-04 10:52:57 4980
4980 
圆;TTV;磨片加工;研磨;抛光 一、引言 在半导体制造领域,晶圆的总厚度偏差(TTV)对芯片性能、良品率有着直接影响。高精度的 TTV 控制是实现高性能芯片制造的关键前提。随着半导体技术不断向更高精度发展,传统磨片加工方法在 TTV 控制上
2025-05-20 17:51:39 1029
1029 
一、引言
在半导体制造领域,晶圆总厚度变化(TTV)是衡量晶圆质量的关键指标之一,直接影响芯片制造的良品率与性能。传统切割工艺在加工过程中,易因单次切割深度过大引发应力集中、振动等问题,导致晶圆
2025-07-11 09:59:15 472
472 
一、引言
在半导体晶圆制造领域,晶圆总厚度变化(TTV)是衡量晶圆质量的关键指标,直接影响芯片制造的良品率与性能。浅切多道工艺通过分层切削降低单次切削力,有效改善晶圆切割质量,但该工艺过程中
2025-07-12 10:01:07 437
437 
晶圆清洗机中的晶圆夹持是确保晶圆在清洗过程中保持稳定、避免污染或损伤的关键环节。以下是晶圆夹持的设计原理、技术要点及实现方式: 1. 夹持方式分类 根据晶圆尺寸(如2英寸到12英寸)和工艺需求,夹持
2025-07-23 14:25:43 931
931 晶圆清洗工艺是半导体制造中的关键步骤,用于去除晶圆表面的污染物(如颗粒、有机物、金属离子和氧化物),确保后续工艺(如光刻、沉积、刻蚀)的良率和器件性能。根据清洗介质、工艺原理和设备类型的不同,晶圆
2025-07-23 14:32:16 1370
1370 
摘要:本文聚焦切割液多性能协同优化对晶圆 TTV 厚度均匀性的影响。深入剖析切割液冷却、润滑、排屑等性能影响晶圆 TTV 的内在机制,探索实现多性能协同优化的参数设计方法,为提升晶圆切割质量、保障
2025-07-24 10:23:09 500
500 
切割工艺参数以实现晶圆 TTV 均匀性有效控制,为晶圆切割工艺改进提供新的思路与方法。
一、引言
在半导体晶圆切割工艺中,晶圆 TTV 均匀性是影响芯片制造质量与良
2025-07-25 10:12:24 420
420 
退火工艺是晶圆制造中的关键步骤,通过控制加热和冷却过程,退火能够缓解应力、修复晶格缺陷、激活掺杂原子,并改善材料的电学和机械性质。这些改进对于确保晶圆在后续加工和最终应用中的性能和可靠性至关重要。退火工艺在晶圆制造过程中扮演着至关重要的角色。
2025-08-01 09:35:23 2030
2030 
在晶圆表面。这些残留的颗粒会影响后续的加工步骤。例如,在进行薄膜沉积时,残留颗粒可能会导致薄膜附着不良或产生缺陷,影响芯片的性能和可靠性。化学物质残留:去胶过程中
2025-12-16 11:22:10 111
111 

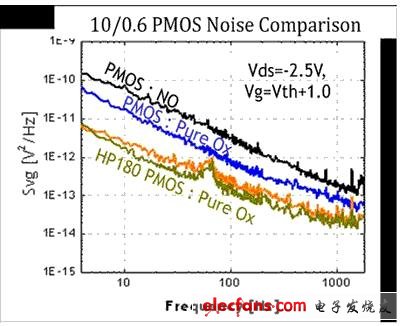
 电子发烧友App
电子发烧友App





















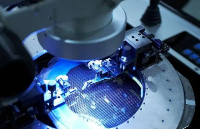






















评论