完善资料让更多小伙伴认识你,还能领取20积分哦,立即完善>
电子发烧友网技术文库为您提供最新技术文章,最实用的电子技术文章,是您了解电子技术动态的最佳平台。
回顾过去五六十年,先进逻辑芯片性能基本按照摩尔定律来提升。提升的主要动力来自三极管数量的增加来实现,而单个三极管性能的提高对维护摩尔定律只是起到辅佐的作用。随着SOC的尺寸逐步逼近光罩孔极限尺寸(858mm2)以及制程的缩小也变得非常艰难且性价比遇到挑战, 多芯片封装技术来到了舞台的中心成为进一步提...

系统级封装 (System in Package, SiP)是指将单个或多个芯片与各类元件通过系统设计及特定的封装工艺集成于单一封装体或模块,从而实现具完整功能的电路集成,如图 7-115 所示。与系统级芯片 (SoC)常用于集成数字及逻辑电路不同,系统级封装(SiP)更适用于无法(或非常困难)在单...
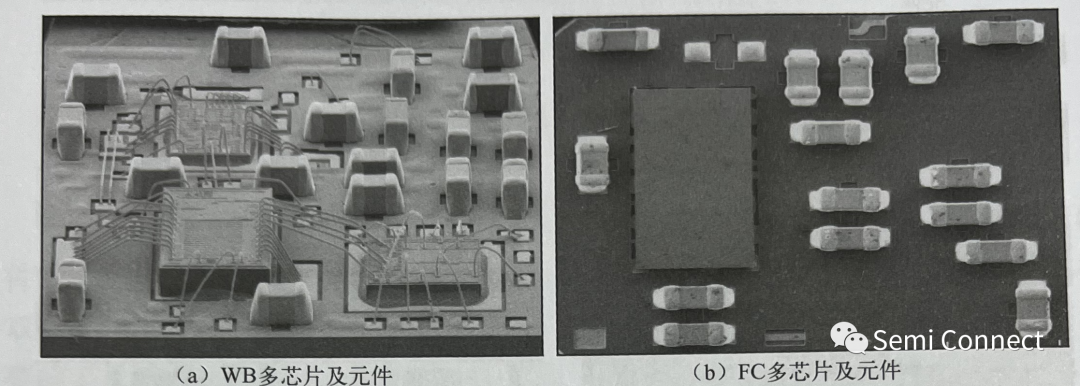
半导体技术按摩尔定理的发展,集成电路的密度将越来越高,且尺寸越来越小。所有芯片工作时都会发热,热量的累积必导致结点温度的升高,随着结点温度提高...

由于GRE报文为明文封装,在网络中传输容易被监听导致信息泄漏。基于此,本案例提供一种方案,使用NAT技术隐藏客户端源地址。...

板级埋人式封装是一种在基板制造工艺的基础上融合芯片封装工艺及 SMT工艺的集成封装技术,既可以是单芯片封装、多芯片封装,也可以是模组封装、堆叠封装。与传统封装中在基板表面贴装芯片或元件不同,板级埋人式封装直接将芯片或元件嵌人基板中间,因此它具有更短的互连路径、更小的体积、更优的电热性能及更高的集成度...
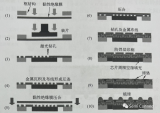
碳化硅衬底 产业链核心材料,制备难度大碳化硅衬底制备环节主要包括原料合成、碳化硅晶体生长、晶锭加工、晶棒切割、切割片研磨、研磨片抛光、抛光片清洗等环节。...


三维封装通过非 WB 互连技术实现芯片间的高密度封装,为微电子系统封装在三维空间开辟了一个新的发展方向,可以有效地满足高功能芯片超轻、超薄、高性能、低功耗及低成本的需求"。该技术主要应用在高速计算、网络和GPU 等系统芯片中。传统二维封装与三维封装对比示意图如图所示。...
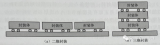
EUV光刻胶需要具有足够的耐刻蚀性,以便在后续的刻蚀过程中保护图案。为了提高耐刻蚀性,研究人员正在开发新型刻蚀抑制剂和交联剂,以增强光刻胶的结构稳定性。...
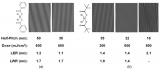
将半导体芯片压焊区与框架引脚之间用铝线连接起来的封装工艺技术!季丰电子所拥有的ASM绑定焊线机AB550为桌面式焊线机,其为全自动超声波焊线机,应用于细铝线的引线键合,主要应用于COB及PCB领域。...

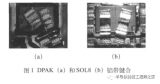
晶圆测试的方式主要是通过测试机和探针台的联动,在测试过程中,测试机台并不能直接对待测晶圆进行量测,而是透过探针卡(Probe Card)中的探针(Probe)与晶圆上的焊垫(Pad)或凸块(Bump)接触而构成电性接触。...
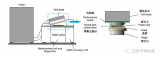
硅通孔(TSV) 是当前技术先进性最高的封装互连技术之一。基于 TSV 封装的核心工艺包括 TSV 制造、RDL/微凸点加工、衬底减薄、圆片键合与薄圆片拿持等。...

扇出型圆片级封装(FoWLP)是圆园片级封装中的一种。相对于传统封装圆片级封装具有不需要引线框、基板等介质的特点,因此可以实现更轻、薄短、小的封装。扇出型圆片级封装也可以支持多芯片、2.5D/3D 和系统级封装(SP)。扇出型圆片级封装可以彻底去除芯片和封装的连接环节(既不需要打线,也不需要凸块),...

先进逻辑芯片性能基本按照摩尔定律来提升。提升的主要动力来自三极管数量的增加来实现,而单个三极管性能的提高对维护摩尔定律只是起到辅佐的作用。...

对于BGA扇孔,同样过孔不宜打孔在焊盘上,推荐打孔在两个焊盘的中间位置。很多工程师为了出线方便,随意挪动BGA里面过孔的位置,甚至打在焊盘上面...
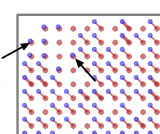
IC的发热量相当惊人,一般的CPU为2.3W,高速度、高功能的IC则可高达20.30W,藉由封装的热传设计,可将IC的发热排出,使IC在可工作温度下( 通常小于85C )正常运作c...

贴片化是从带独立散热片的插件封装走向更高功率散热的第一步。一般贴片封装的散热主要是靠芯片底部跟PCB(印刷电路板)之间的接触,利用PCB铜箔把芯片产生的热量传导出去。...
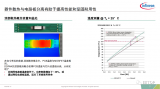
按照器件结构,分为二极管、功率晶体管、晶闸管等,其中功率晶体管分为双极性结型晶体管(BJT)、结型场效应晶体管(JFET)、金属氧化物场效应晶体管(MOSFET)和绝缘栅双极晶体管(IGBT)等。...
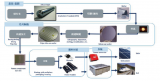
QFN封装(方形扁平无引脚封装),如图1所示,具有良好的电和热性能、体积小、重量轻、其应用正在快速增长,采用微型引线框架的QFN封装称为MLF封装(微引线框架)。...