管你买不买索尼,Xperia就在那里,不悲不喜……
今晚,知名爆料人Onleaks发布了Xperia 20的渲染图,看起来和当前在售的Xperia 10系列很是相似,延续了21:9纵横比的电影屏。
不过我们还是捕捉到了一些新变化,比如Xperia 20侧面的电源键和指纹键整合到了一起,而Xperia 10则是分离式。底部单扬声器,而非前作的双扬声器。
另外,据说Xperia 20的后壳不再是金属一体机身,可能升级为金属中框搭配玻璃,这取决与索尼的价格抉择。
细节方面,Xperia 20保留了3.5mm耳机孔,值得称赞。
基本配置方面,Xperia 20可能拥有6寸屏幕,三围157.8 x 68.9 x 8.14mm(含摄像头突出部分为9.84mm),骁龙600或700系芯片。
看起来,9月6日开幕的德国IFA是Xperia 20登场的好机会,也许,Xperia 2也会一道亮相。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
索尼
+关注
关注
18文章
3686浏览量
107570
发布评论请先 登录
相关推荐
热点推荐
高频超声键合技术:引线键合工艺优化与质量检测方法
一、 什么是 高频超声键合 ? 高频超声键合是指将超声频率提升至100kHz~250kHz范围内进行的引线键合工艺,相较于传统60kHz超声键合技术而言,该技术通过在更高频率下施加超声

半导体封装引线键合技术:超声键合步骤、优势与推拉力测试标准
就为您详细拆解超声键合步骤、优势,并明确推拉力测试标准,为行业从业者提供实操性参考,助力优化超声键合工艺、提升键合质量管控水平。 一、什么是超声键合? 在芯片内部,连接着

NTC热敏芯片键合工艺介绍
随着半导体技术的持续创新及进步,NTC热敏芯片键合工艺也不断发展。目前,芯片键合工艺为顺应行业发展需求,正逐步往高度集成、低功耗、高可靠的方向前进。为了让大家更充分地了解NTC芯片键合工艺,EXSENSE为大家介绍一些热敏芯片
半导体芯片键合技术概述
键合是芯片贴装后,将半导体芯片与其封装外壳、基板或中介层进行电气连接的工艺。它实现了芯片与外部世界之间的信号、电源和接地连接。键合是后端制造中最关键的步骤之一,因为互连质量直接影响器件的可靠性、性能和可扩展性。

电子元器件失效分析之金铝键合
电子元器件封装中的引线键合工艺,是实现芯片与外部世界连接的关键技术。其中,金铝键合因其应用广泛、工艺简单和成本低廉等优势,成为集成电路产品中常见的键合形式。金铝键合失效这种现象虽不为人

芯片键合工艺技术介绍
在半导体封装工艺中,芯片键合(Die Bonding)是指将晶圆芯片固定到封装基板上的关键步骤。键合工艺可分为传统方法和先进方法:传统方法包括芯片键合(Die Bonding)和引线键

IGBT 芯片平整度差,引发键合线与芯片连接部位应力集中,键合失效
一、引言 在 IGBT 模块的可靠性研究中,键合线失效是导致器件性能退化的重要因素。研究发现,芯片表面平整度与键合线连接可靠性存在紧密关联。当芯片表面平整度不佳时,键合线与芯片连接部位易出现应力集中

AD、Allegro、Pads的快捷键有什么不同
在高速迭代的电子设计领域,快捷键是工程师与EDA工具对话的核心语言,纵观EDA工具,AD的视觉化交互、Allegro的深度可编程性、Pads的无膜命令——三种理念催生了截然不同的操作逻辑,那么它们的快捷键操作是否会有些不同?

芯片制造中的键合技术详解
键合技术是通过温度、压力等外部条件调控材料表面分子间作用力或化学键,实现不同材料(如硅-硅、硅-玻璃)原子级结合的核心工艺,起源于MEMS领域并随SOI制造、三维集成需求发展,涵盖直接键合(如SiO

铝丝键合的具体步骤
铝丝键合常借助超声楔焊技术,通过超声能量实现铝丝与焊盘的直接键合。由于键合所用劈刀工具头为楔形,使得键合点两端同样呈楔形,因而该技术也被叫做楔形压焊。超声焊工艺较为复杂,
什么是引线键合?芯片引线键合保护胶用什么比较好?
引线键合的定义--什么是引线键合?引线键合(WireBonding)是微电子封装中的关键工艺,通过金属细丝(如金线、铝线或铜线)将芯片焊盘与外部基板、引线框架或其他芯片的焊区连接,实现电气互连。其

提高键合晶圆 TTV 质量的方法
关键词:键合晶圆;TTV 质量;晶圆预处理;键合工艺;检测机制 一、引言 在半导体制造领域,键合晶圆技术广泛应用于三维集成、传感器制造等领域。然而,键合过程中诸多因素会导致晶圆总厚度偏

电源键的一键多用:POWER_ON从开机到场景指挥官!
按键,即开关机键,在结构设计上可以实现 一键多用 ——既可以有效减少结构的按键设计,也可以使整机更加简洁。 本文以Air8000核心板为例,分享POWER_ON按键功能及其硬件设计、软件demo相关内容。 最新开发资料详见: www.air8000.cn 一、常用功能简介
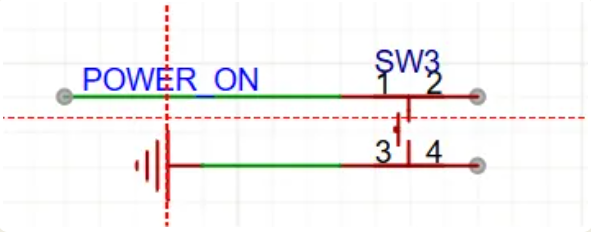



 Xperia20渲染图曝光 延续21:9纵横比的电影屏并将侧面电源键与指纹键整合
Xperia20渲染图曝光 延续21:9纵横比的电影屏并将侧面电源键与指纹键整合






评论