在近日举行的英特尔“架构日”活动中,英特尔不仅展示了基于10纳米的PC、数据中心和网络系统,支持人工智能和加密加速功能的下一代“Sunny Cove”架构,还推出了业界首创的3D逻辑芯片封装技术——Foveros。这一全新的3D封装技术首次引入了3D堆叠的优势,可实现在逻辑芯片上堆叠逻辑芯片。
以下两张图,是对这一突破性发明的详细介绍,第一张图展示了Foveros如何与英特尔?嵌入式多芯片互连桥接(EMIB)2D封装技术相结合,将不同类型的小芯片IP灵活组合在一起,第二张图则分别从俯视和侧视的角度透视了“Foveros” 3D封装技术。
据悉,英特尔预计将从2019年下半年开始推出一系列采用Foveros技术的产品。首款Foveros产品将整合高性能10nm计算堆叠“芯片组合”和低功耗22FFL基础晶片。它将在小巧的产品形态中实现世界一流的性能与功耗效率。
继2018年英特尔推出突破性的嵌入式多芯片互连桥接(EMIB)2D封装技术之后, Foveros将成为下一个技术飞跃。
-
芯片
+关注
关注
462文章
53573浏览量
459390 -
封装
+关注
关注
128文章
9149浏览量
147916 -
intel
+关注
关注
19文章
3506浏览量
190577
发布评论请先 登录
WLAN/WiMAX 时钟选型:TCXO/VCXO/OCXO 如何影响 EVM/CFO(含两张对比图)
Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障

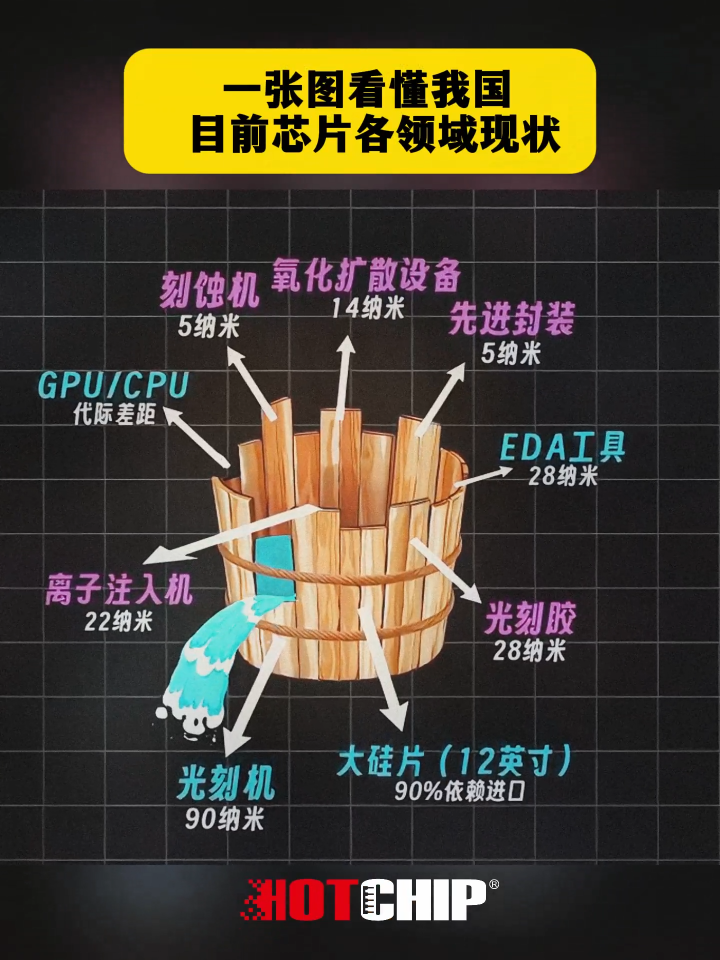
3D封装与系统级封装的背景体系解析介绍

使用MSVC编译器重新生成了DLP_SDK,执行Prepare DLP LightCrafter 4500时,生成的两张格雷码编码图片有问题,为什么?
芯片3D堆叠封装:开启高性能封装新时代!






 两张图看懂Intel3D逻辑芯片封装技术
两张图看懂Intel3D逻辑芯片封装技术


















评论