整合更多功能和提高性能是推动先进封装技术的驱动,如2.5D和3D封装。
2.5D/3D封装允许IC垂直集成。传统的flip-chip要求每个IC单独封装,并通过传统PCB技术与其他IC集成。
2.5D封装将die拉近,并通过硅中介连接。3D封装实际上采用2.5D封装,进一步垂直堆叠die,使die之间的连接更短。通过这种方式直接集成IC,IC间通信接口通常可以减少或完全消除。这既可以提高性能,又可以减轻重量和功耗。
这种封装的复杂性需要新颖的封装和测试技术。
了解2.5D封装与3D封装
随着半导体foundry开始达到工艺节点的潜在物理极限,芯片封装正在成为提高性能的一种方式。flip chip封装仍然是互连die最流行的方法,但硅中介的新进展使2.5D封装成为可能,进而又使3D封装成为可能。
什么是3D封装?
当然。3D封装涉及垂直堆叠多个半导体die(或chiplet),创建三维封装架构。这种方法使不同组件在单个封装中更紧密地集成。
同样值得注意的是,3D异构集成(3DHI)是3D封装的一个子类别。“异质”方面意味着这些die可能具有多种功能,并可能来自各种制造工艺或foundry。
2.5D和3D封装有什么不同?
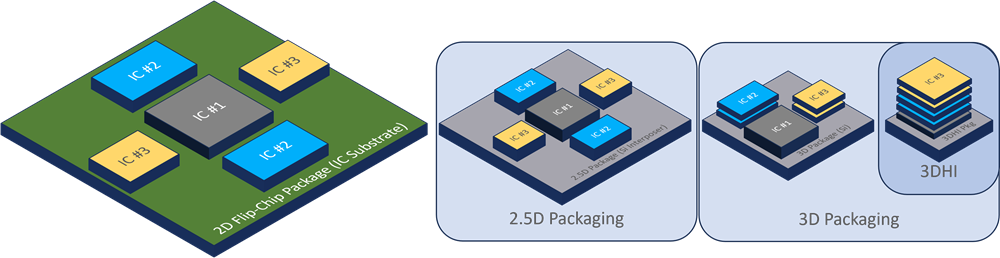
关键的区别在于die的垂直堆叠和粘接。传统的封装方法涉及将芯片并排放在平面上,限制了可以实现的集成量。在3D封装中,组件相互堆叠,减少了它们之间的距离,并提供了更高的集成密度。
2.5D和3D封装有什么好处?
3D封装方法有很多好处。
缩小尺寸:3D封装最明显的好处之一是其卓越的尺寸效率。通过将半导体组件垂直堆叠在单个封装中,它大大减少了封装的物理尺寸。这种尺寸的缩小在空间有限的应用中特别有价值,如移动设备、航空航天系统和可穿戴技术。随着电子设备尺寸的持续缩小,3D封装可以在不影响性能的情况下创建更小、更紧凑的产品。

减轻重量:3D封装有助于减轻电子系统的重量。通过垂直堆叠实现的紧凑和密集的集成设计导致设备的整体重量减轻。这在航空航天等行业至关重要,每一克都很重要。更轻的电子产品可以转化为更省油的飞机和扩展无人驾驶飞行器的任务能力。
能源效率:在能源效率方面,3D封装中组件的垂直堆叠通常会导致互连长度更短。减少数据传输距离可以降低信号损耗和功耗。
3D封装的这些优势在当今快节奏的技术环境中越来越有优势。随着电子设备变得更加便携、轻便和节能,3D封装成为这些进步的关键推动者。无论是在消费电子产品、航空航天还是医疗设备应用中,使电子产品更小、更轻、更节能的能力在未来都发挥着至关重要的作用。
-
3D
+关注
关注
9文章
2989浏览量
113779 -
封装
+关注
关注
128文章
9139浏览量
147862 -
2.5D
+关注
关注
0文章
13浏览量
13981
原文标题:什么是2.5D和3D封装技术
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
2.5D/3D芯片-封装-系统协同仿真技术研究
分享一下小芯片集成的2.5D/3D IC封装技术
3D封装结构与2.5D封装有何不同?3D IC封装主流产品介绍






 2.5D和3D封装技术介绍
2.5D和3D封装技术介绍

















评论