半导体硅片(Semiconductor Silicon Wafer)是半导体器件、芯片和集成电路(IC)的基础衬底材料,也被称为“芯片之母”。它是通过高纯度的多晶硅经过直拉法(CZ)或区熔法(FZ)制成单晶硅棒,再经切片、研磨、抛光等精密加工而成的圆形薄片。简单来说,它就是制造芯片的“原始土壤”。所有的晶体管、电阻、电容等元器件,以及它们之间的连线,都是构筑在这张薄薄的硅片表面上的。
核心特点与分类
1. 高纯度
对纯度要求极高,通常要达到99.9999999%(9N)甚至12N以上。杂质含量需控制在ppt(万亿分之一)级别, slightest的杂质都会影响芯片性能。
2. 尺寸规格
以直径衡量,常见尺寸有 8英寸(200mm)、12英寸(300mm),目前先进制程正向 18英寸(450mm) 发展。直径越大,能切割出的芯片越多,成本越低。
3. 导电类型
分为 P型(多为掺硼)和 N型(多为掺磷、砷),用于构建不同类型的半导体器件。
4. 主要分类- 硅基:最主流,占市场95%以上份额。
- 第三代半导体:以碳化硅(SiC)、氮化镓(GaN)为代表,以及你之前关注的蓝宝石等。它们在耐高温、高频、高功率场景(如新能源汽车、5G基站)中性能远超传统硅基。
主要应用
- 集成电路(IC):制造CPU、存储器(DRAM/NAND Flash)、逻辑芯片等。
- 功率器件:特别是SiC/GaN等第三代半导体材料,是新能源、电动汽车、快充领域的核心。
它是半导体产业链中最上游、最核心的环节,其技术壁垒和供应安全直接决定了下游芯片产业的发展。
半导体硅片蚀刻保护胶带是半导体湿法制程中的核心耗材,其性能直接决定晶圆蚀刻后的良率。它必须同时耐受严苛的化学腐蚀与高温环境,且确保剥离后不留任何痕迹。
核心技术特点
1. 极致耐化学腐蚀性
这是最关键的指标。胶带需直接接触 HF(氢氟酸)、TMAH、硫酸 等强腐蚀性蚀刻液或清洗液。- 要求:绝不允许液体通过胶带边缘渗透(侧蚀),也不能与化学品发生反应导致污染,需保护晶圆边缘和非蚀刻区域。
2. 高耐热稳定性
蚀刻制程通常伴随高温烘烤(如125℃–180℃)。- 要求:在高温下不能发生翘边、脱落或软化变形,否则会造成制程良率下降。
3. UV减粘与无残胶特性
针对薄晶圆(越来越薄的趋势),必须使用 UV减粘型 胶带。- 原理:曝光UV光后,胶带粘度瞬间降低,实现无残胶、低损伤剥离,防止胶带残留污染晶圆表面。
4. 超高洁净度与低污染
晶圆制程对杂质是零容忍的。- 要求:必须满足 ISO 1级/Class 1 洁净室标准。离子残留(如Na、K、Cl⁻)需低于ppm级别,且无颗粒掉落。
5. 优异的机械与电气性能- 抗静电:表面电阻需控制在较低水平(如<10⁶ Ω/sq),防止静电损伤精密电路。
- 高粘附与易撕:既要贴合紧密(防止渗液),又要剥离时不伤及晶圆表面(低雾度、低刀损)。
关键选型维度
- 蚀刻介质:首先确认是使用HF还是碱性溶液,决定胶带配方。
- 晶圆厚度:薄晶圆必须选UV减粘型,厚晶圆可选用热剥离或溶剂剥离型。
- 温度需求:根据后续烘烤温度选择合适的耐温等级(如150℃还是200℃+)。
半导体硅片蚀刻保护胶带虽看似小巧,实则是保障晶圆制程良率的关键耗材。其分类逻辑紧密围绕蚀刻工艺、晶圆材质和制程环境展开。
以下为您梳理的详细分类及对应核心要求:
一、 按剥离机制分类(核心分类)
这是选择胶带的第一维度,直接决定了晶圆剥离后的表面状态。
1. UV减粘型(Ultraviolet Removable)
适用场景:薄晶圆(<100μm)、先进封装、TSV(硅通孔)工艺、对残胶零容忍的场景。
- 核心原理:胶层在UV光照前粘度高(贴合密封),光照后化学结构改变,粘度急剧下降(易剥离)。
- 核心要求:- UV敏感度:需在特定波长(如365nm)下快速固化减粘,且光照均匀度要好。
- 低残胶:剥离后晶圆表面无残胶、无白雾,表面能(Surface Energy)需极低。
- 抗黄变:UV照射过程中不能发生黄变,以免污染晶圆或影响后续光学检测。
2. 热剥离型(Thermal Removable)
适用场景:厚晶圆加工、背磨、常规蚀刻。
- 核心原理:通过加热(通常超过100℃甚至200℃)降低胶带粘度,实现无损剥离。
- 核心要求:- 高温稳定性:在加热剥离前,必须能长期耐受蚀刻时的高温(如150℃-180℃),不翘边、不分解。
- 低温流变性:加热剥离时,胶层需软化流动,而非脆裂,避免损伤晶圆边缘。
3. 溶剂剥离型(Solvent Removable)
适用场景:特殊复杂结构、非UV/非热剥离的备选方案。
- 核心原理:利用特定有机溶剂渗透胶层与基材界面,实现剥离。
- 核心要求:- 化学相容性:必须能被指定溶剂(如NMP、乙醇等)有效溶解或渗透。
- 耐溶剂性:在蚀刻过程中不能溶解或溶胀。
二、 按耐化学属性分类
决定了胶带能否在恶劣的蚀刻液环境中“守住阵地”。
1. 耐强酸碱型(耐HF / 耐TMAH)
适用场景:硅片正面/背面湿法蚀刻、GaN/ SiC第三代半导体制程。
- 核心要求:- 防侧蚀:胶层与晶圆边缘结合紧密,防止强腐蚀性液体(如HF酸)侧向渗透,导致晶圆边缘腐蚀(Chipping/Erosion)。
- 不溶胀:在强酸/强碱溶液中保持形态稳定,不软化、不脱落。
2. 通用耐热型
适用场景:常规半导体加工、普通蚀刻。
- 核心要求:耐受120℃-150℃高温,粘性保持率高,不起泡。
三、 按基材材质分类
影响胶带的机械强度和物理支撑性。
1. PI(聚酰亚胺)基材
- 特点:耐高温性能极佳(可耐250℃+)、机械强度高、绝缘性好。
- 适用:高端制程、高温蚀刻工艺。
2. PET(聚酯)基材
- 特点:成本较低、柔韧性好、尺寸稳定性佳。
- 适用:中低端制程、对温度要求不极端的场景。
3. PO(烯烃)基材
- 特点:低雾度、低刀损、表面洁净度极高。
- 适用:先进封装、超薄晶圆加工。
以上部分资料转载AI网络平台,文章用于交流学习版权归原作者。如有侵权请告知立删。
-
半导体
+关注
关注
339文章
31197浏览量
266363 -
材料
+关注
关注
3文章
1583浏览量
28689 -
硅片
+关注
关注
13文章
417浏览量
35798
发布评论请先 登录
新型HERB技术如何重塑芯片蚀刻工艺

Neway微波国产化替代方案
半导体测试设备现状:国产IC测试仪能否替代进口?
硅片划片机破解硬脆材料崩边难题,助力半导体器件封装降本增效
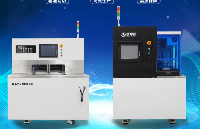
领跑国产替代的半导体测试公司:杭州加速科技的技术突破与产业赋能之路

Neway微波产品的国产化替代方案
数据驱动国产替代!智芯谷如何引爆半导体供应链新增长极?

国产替代新标杆!萨瑞微电子打造全产业链半导体平台

国产替代再传捷报!钜合新材SECrosslink H80E芯片烧结银膏获半导体头部企业认可!
芯导科技亮相2025半导体设备与核心部件及材料展
从光固化到半导体材料:久日新材的光刻胶国产替代之路
新材料与投资逻辑:任重道远、星辰大海、精耕细作

突破"卡脖子"困境:国产工业电源加速半导体设备国产替代潮




 半导体硅片蚀刻保护胶带 | 国产替代新材料
半导体硅片蚀刻保护胶带 | 国产替代新材料


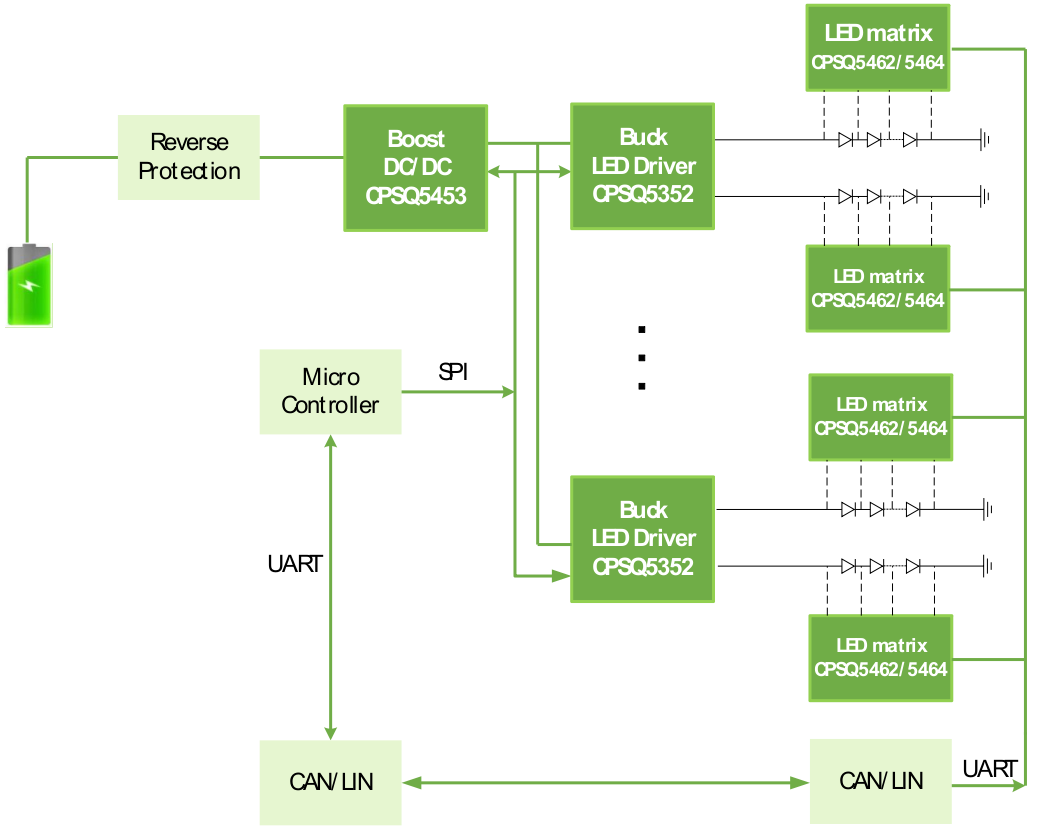



评论