图9-5展示了使用Kirchhof方法与严格的电磁场(EMF)仿真进行掩模建模所得结果之间的区别。Kirchhoff方法假设掩模无限薄,透过掩模的光直接从掩模版图中获得。掩模无吸收层区域的透射率为1.0,铬覆盖区域的透射率为0.0,透射光的相位在整个掩模上是恒定的。

严格的EMF仿真计算吸收层图形附近区域光的强度和相位。图9-5所示光强分布图的左上角和右上角的驻波图形是人射光和来自衬底/吸收层界面的反射光之间的干涉引起的。部分光通过吸收层中的蚀刻开口透射传播到投影物镜,透射光的相位类似于从蚀刻掩模开口处发射的圆柱波,图9-5所示透射近场的光强和相位为直接从吸收层下方获得的。与Kirchhoff方法的结果相反,透射光的强度和相位沿x轴呈现连续变化。
两种掩模建模方法获得的透射光之间的差异非常大。然而,并非该差异的所有细节对于在掩模远场处获得的图像都重要,例如,该差异的一个重要部分是倏逝波引起的,但它传播不到远场。此外,利用投影镜头的有限数值孔径充当带通滤波器,可进一步消除这种差异。接下来的两个小节将研究远场中的衍射光和使用光刻投影系统获得的图像。
9.2.1 掩模衍射分析
首先考虑平面波对掩模上周期性线空图形的衍射。掩模衍射分析研究单个衍射级的强度和相位值与偏振、周期和入射角的关系。此类分析的结果用于确定应用严格EMF建模所需要条件。此外,掩模衍射分析提供了对掩模形貌引起的成像伪影更深人的理解。掩模衍射分析除了用于系统性研究掩模材料和几何特性的影响,它还用于设计消除或利用掩模形貌效应的策略。
周期性掩模图形将入射光衍射成几个离散的衍射级,如图9-6所示。周期P和波长入的离散衍射级或衍射角的方向由光栅方程给出:

该值给出有多少非偏振人射光被衍射成m级的TE或TM偏振光。极化率fpol=1.0/-1.0描述了在第m个衍射级掩模实际充当了TE/TM的偏振器。fpol=0.0表示两种偏振具有相同的衍射效率。
图9-7为MoSi型AtPSM的掩模衍射分析结果。结果展示了在垂直人射光条件下,线宽和掩模周期之间的占空比为1:2密集线的零级和一级衍射。请注意,周期值是以掩模上的尺寸定义的,4倍缩放系统的晶圆级周期(和尺寸)值必须除以4。Kirchhof方法预测的零阶衍射效率为恒定值,其值对应于掩模的平均透射率。第一级衍射仅在周期大于193nm波长处传播。除了这个截止之外,第一衍射级具有恒定值。

相比之下,严格的EMF仿真预测了与偏振和周期相关的衍射效率。对于较大的周期,严格仿真计算的衍射效率接近Kirchhoff模型预测的值。换言之,Kirchhoff方法为大于800 nm的掩模尺寸周期提供了合理的精度,这分别对应于晶圆尺寸上200 nm和100 nm的周期和线宽。Kirchhof方法无法准确描述较小图形的衍射性能。
严格的EMF仿真表明,TM偏振光的衍射效率高于TE偏振光的衍射效率,这也可以在图9-7右下方的极化率图中看到,具有较小图形的MoSi掩模充当TM偏振器。这与偏向TE偏振光的高NA系统的成像要求相冲突(参见8.3.2节),这种MoSi型掩模光衍射的不利特性有时被称为"MoSi危机"。铬和其他掩模吸收材料可以提供更有利的偏振特性[25,26]。
掩模上尺寸较小图形的衍射的另一个重要特征,如图9-7左下图所示。特别是在600nm以下的周期范围内,掩模形貌引人了与周期相关的相位效应,这些都是在衍射光的远场中观察到的。它们对成像性能的影响类似于投影镜头的波像差[27]。下一节将讨论几种掩模引起的像差效应及其对光刻成像的影响。
类似的掩模衍射分析也可以用于其他掩模类型和材料[28]。该分析表明,具有波长数量级及更小的特征尺寸的掩模充当了散射体,会对衍射光的振幅和相位产生与偏振态相关的影响。
9.2.2 斜入射效应
光刻掩模上光的衍射不仅取决于掩模的形貌和材料特性,而且还取决于入射光的方向。光在掩模吸收层图形上的典型入射角范围由下式给出:

式中,0m.为光源的最大张角,NA为投影物镜在晶圆方的数值孔径,M为光刻机的缩放倍率,n。为掩模衬底的折射率。DUV光刻机照明的人射角范围相对于6=0的光轴对称。EUV光刻机的相关人射角范围取决于图形方向。对于垂直图形,它也相对于0=0对称;对于水平图形,它围绕物面主光线角度(CRAO)变化。
图9-8为不同数值孔径的DUV和EUV光刻的密集线空图形的仿真衍射效率的典型值。特征尺寸被缩放以提供可比较的工艺因子k1。为了进行更好地比较,将EUV吸收层置于真空中(无多层膜)。同时考虑到光两次通过具有多层膜的实际吸收层的传播(即多层膜反射之前和之后的厚度),EUV掩模吸收层厚度采用了2倍的因子。
接下来,先讨论DUV的仿真结果。对于小于5的人射角0ms,来自光学掩模的光衍射几乎与掩模上人射光方向的变化保持不变。在这个人射光的方向范围内,非垂直人射的衍射光谱可以通过垂直人射光的衍射光谱的简单移动来获得,只需要一个严格的EMF仿真来计算部分相干照明的图像。利用掩模衍射的这种位移不变性进行图像计算通常被称为霍普金斯(Hopkins)方法。方程(9-15)表明Hopkins近似可以应用于数值孔径低于0.8的系统和具有较小部分相干因子()的更高数值孔径的系统。
Hopkins方法对于具有明显离轴照明的高数值孔径浸没式DUV中较大范围的人射角是无效的,在人射角的相应范围内,其第0级和第1级衍射都表现出衍射效率的显著变化。较厚的吸收层(与波长相比)和斜人射,使得NA=0.33的EUV系统的水平图形对人射光方向的变化非常敏感。高数值孔径EUV光刻机(参见6.7.2节)对人射光方向变化更加敏感。该系统中这种对人射角的高敏感度表现在垂直图形和水平图形,尽管它们晶圆上相同尺寸相同,但掩模上垂直图形(4x)比水平图形(8x)的尺寸小一半[29]。

大多数先进高数值孔径DUV系统采用激进的离轴照明或o值大于0.5,掩模的光衍射与Hopkins假设的位移不变衍射效率存在显著偏差。在典型的EUy系统中,来自掩模的光衍射并不是位移不变的,因此,所有EUV系统和高数值孔径DUV系统都需要没有Hopkins假设的严格EMF建模。必须针对几个有代表性的人射角进行掩模衍射计算,最终图像是通过那些部分的光源对应的图像进行不相干叠加获得的,可以称为"局部"Hopkins方法[30)来计算。尽管针对多个人射角的EMF建模增加了掩模和图像建模的数值计算量,但它对于EUV成像的精确建模和高NA状态下的DUV成像是必不可少的[31]。
9.2.3掩模引起的成像效应
第一个证明严格掩模建模重要性的例子涉及交替型相移掩模(AlIPSM)的强度不平衡[32],吸收层中蚀刻开口的较大深度使得AlIuPSM对掩模形貌效应非常敏感。AluPSM的近场仿真如图9-2所示,这里采用波导法结合矢量成像来研究AltPSM65nm密集线空图形的成像性能。在这个和下面的成像示例中,掩模图形的横向尺寸以晶圆尺寸为准。与通过未蚀刻空间的光相比,产生180的相移所选取的蚀刻开口(移位器)的深度为

图9-9左图为仿真的空间向横截面。实线为相同宽度的蚀刻和未蚀刻空的图像横截面。与(左图)未蚀刻开口的图像强度相比,来自(右图)蚀刻开口/移位器边缘的光散射降低了图像强度。未蚀刻掩模开口处的较大的光强,导致了由两个光强峰值决定的线向右移动了将近12nm。
补偿AlrPSM的强度不平衡和由此产生的偏置误差的一种策略是增加右侧蚀刻开口的宽度。图9-9(左)横截面图中的虚线显示了较大移位器宽度wshite的横截面。移位器宽度为85 nm时两个强度最大值的高度几乎相同。图9-9右图显示了中心线相对于移位器宽度的仿真位置,82.5nm的移位器宽度将偏置误差降至零。
上述仿真仅研究了在单个焦点位置时掩模形貌引起的图像不平衡,更全面的仿真和实验研究表明,与简单地偏置刻蚀开口相比,浅刻蚀或预刻蚀等不平衡补偿策略可以提供更好的离焦性能[33]。

观察到较小图形的衍射效应也会对衰减型和二元掩模的设计产生影响。图9-10中显示了MoSi型AtPSM上50 nm线空图形的光学邻近效应曲线。本示例中未应用任何辅助图形,将阈值模型应用到光刻胶折射率与衬底匹配的光刻胶内部的图像,可以仿真晶圆CD;掩模线宽和晶圆CD都是以晶圆尺寸为准。图9-10左图显示了在没有OPC的情况下,给定的掩模线宽(LW)和仿真的晶圆CD与图形周期的关系。Kirohhor方法和严格掩模模型得到的结果相差270高达5nm。图9-10右图也可以看到类似的差异,该图显示了在所有周期下,为获得50nm恒定目标晶圆CD而计算得到的掩模线宽。这一结果和许多其他仿真结果证明,OPC模型中必须考虑掩模形貌效应以进行掩模图形设计。

图9-10的OPC仿真是在没有辅助图形的情况下完成的,辅助图形比掩模上的主要图形还要小。9.2.1节1.0中对掩模形貌效应的特征尺0.8寸依赖性的观察表明,辅助0.6图形的成像性能对掩模形貌0.4效应更加敏感。图9-11中的仿真结果证实了这一点,02该图显示了MoSi型衰减0.0LPSM上孤立线的仿真结果横截面。为了比较不同代光刻技术的结果,孤立线使用根据第一个阿贝-瑞利方程缩放的数值孔径成像:NA=0.3A/LW,其中LW表示晶圆特征尺寸或线宽。

与Kirchhoff仿真的预测相比,较小的暗辅助图形的严格电磁场仿真得到的光散射表明辅助图形附近的强度最小值更小。定义OPC适当的辅助图形宽度时,必须考虑这种影响,这里所观察到的影响取决于所用光的偏振特性和掩模的色调。一般而言,Kirchhoff方法低估了TE偏振照明成形暗辅助图形的风险,高估了成形亮辅助图形的风险;TM偏振照明则表现出相反的趋势。
如9.2.1节所述,掩模形貌效应不仅影响衍射光的振幅,还会影响衍射光的相位。这些相位效应会产生类似像差的成像现象,例如不对称工艺窗口、与图形周期和方向相关的最佳焦点位置偏移等[27,34,35]。图9-12展示了其中一些影响,该图显示了不同掩模材料的工艺窗口和不同图形周期的最佳焦点偏移的分析。玻璃衬底上不透明MoSi(OMOG)掩模[36]和传统MoSi掩模的工艺窗口,在最佳焦面相对于标称图像平面不对称。对最佳焦点位置的分析表明,最佳焦点随着图形周期而变化,类似的成像现象已经在有球面像差的投影镜头中被观察到;可参见8.1.6节。

此例以及其他更多例子都表明,光学光刻所用的高级掩模的形貌会产生相位效应,对成像性能产生类似于像差的影响。这存在将掩模引起的像差现象归因于投影镜头波像差的风险。特定的像差测量技术的应用必须考虑这些影响,像差测量技术可以从特别设计的掩模图像的离焦分析中检测波像差[37-39]。
投影物镜的波前控制和新型掩模吸收材料的使用可以补偿掩模引起的像差效应[40-42]。投影光刻机和掩模引起的像差之间关系的详细讨论可以在本章后的参考文献[35]中找到,其中介绍了严格仿真的衍射光谱的Zerike分析,可以作为量化掩模效应的有效方法。
图9-13展示了使用Kirchof法和掩模缺陷成形的严格电磁场仿真结果之间的差异。两条45 nm宽的线条之间的中心处有一个边长为20nm的方形暗缺陷,此缺陷可能是掩模制作缺陷,也可能是在掩模使用过程中沉积的颗粒。该图显示了掩模版图上层几个略有不同强度阈值的图像轮廓。Kirchhoff方法低估了缺陷的影响,尽管它预测到线条之间的空隙变窄。相比之下,严格的掩模建模预测到线条之间空隙区域发生桥连,特别是对于略低于阈值的强度值。
缺陷成形的预测对不同掩模模型的这种高敏感性并不出人意料。缺陷是光刻掩模上最小的图形,因此,它们对掩模形貌效应非常敏感。一般而言,Kirchhoff方法低估了暗色缺陷的成形性能,而高估了亮缺陷的成形性能。交替型PSM上的相位缺陷可以会聚或发散来自缺陷附近的光,因而它们被成形的风险相对于离焦位置会呈现出不对称的变化[43]。

9.2.4EUV光刻中的掩模形貌效应及缓解策略
上一节中的示例已经证明了严格掩模建模对DUV光刻的重要性。通常,所描述的掩模形貌效应的幅度随着(掩模尺度)横向特征尺寸与所用波长之间的比率减小而增加。EUV光波长的显著减少增加了掩模图形横向特征尺寸与波长之间的比率,这是否意味着EUV光刻对掩模形貌效应不太敏感?
然而,事实并非如此。掩模形貌效应重要性的第二个指标是掩模图形的厚度或高度。EUV掩模吸收层的物理厚度与DUV光刻掩模吸收层的厚度相似,EUV光刻掩模的典型吸收层厚度约为4~5个波长。吸收层厚度和波长之间的这种大比例关系使得EUV光刻对掩模形貌效应非常敏感。EUV掩模的特定几何形状及其在成像装置中的集成引入了EUV光刻中掩模形貌效应的几个特点。
图9-14 比较了EUV光刻的反射掩模与DUV光刻的透射掩模。在EUV光刻波长下,光学材料特性(折射率n和消光系数k)与DUV光刻的相应数据相比,表现出的变化要小得多。为了获得所需的强度和相位调制,EUV掩模需要更厚的吸收层。
EUV光刻吸收层特征的相对厚度(由波长归一化)远大于DUV 光刻的相应值。EUV掩模吸收层厚度的重要性因光要通过吸收层两次而被强化:第一次是来自照明系统的光照射掩模;第二次是来自多层膜的背反射光再次照射吸收层时。

EUV掩模的多层膜引入了额外的特定掩模效应。光不在多层膜的顶部反射,而是从多层膜内部的几个界面反射,这增加了掩模的有效厚度。斜照明、多层膜反射率的角度依赖性以及(厚)吸收层对光的双重衍射增强了斜入射效应对EUV光刻的重要性(参见9.2.2节)。
光衍射与掩模上人射光方向的显著相关性对成像性能具有重要影响。图9-15显示了二极照明下,NA=0.33的EUV成像系统对16 mm密集线的离焦图像,该图显示了单极和完整二极照明的图像。
由于照射方向不同,因此两个单独极子相对于不同离焦的图像差异很大。它们不仅表现出相反的远心行为(图形位置随离焦的变化),而且也具有不同的对比度和平均光强,这些差异归因于衍射效率随照明方向的不同变化。在其他周期和成像条件下,也可以观察到类似的现象[29,45]。通常,来自EUV照明光瞳的几个部分的(不同)图像的叠加会导致图像对比度降低或对比度衰减[46,47]0EUV光刻中掩模形貌效应与照明几何形状的强烈相互作用增加了EUV光源掩模协同优化(SMO)的重要性。例如,在本章后的参考文献[48,49]中描述了最重要的挑战和可能的解决方案。
另一种掩模形貌效应如图9-16所示,左图展示了EUV吸收层引起的波前形变,对应的反射近场的相位形变已经在图6-9中进行了介绍和讨论;图9-16右图显示(归一化)对比度值相对于仿真空间像的离焦位置曲线,这些数据表明不同周期引起的最佳焦点位置(具有最高对比度)偏移约为20nm,DUV光刻中也观察到类似的效应[50]。由于焦深预算(范围)的减少,因此这类效应在EUV光刻比 DUV光刻更为显著。

为了进一步减小EUV光刻中所能实现的特征尺寸和工艺因子,EUV光刻中需要缓解这些掩模形貌效应的影响,为此有几种方法已经被开发。下面给出三个例子:前两种方法采用对光源形状和/或掩模设计图的不对称修改,来提高目前使用的EUV掩模吸收层的成像性能,这两种方法的实现相对简单,但严重依赖于掩模设计;第三个例子是利用新型吸收层材料,这会对掩模基础结构造成重大影响。然而,这些新型吸收层从根本上解决了掩模形貌效应,并提供了更通用的解决方案。
图9-17展示了优化用户定义照明形状的方法,可用于减少两个相邻空隙线图形离焦成像的不对称性[51]。该图左列部分显示了对称二极照明的仿真图像和CD值与离焦位置的显著不对称性。通过图9-17右列中优化用户定义非对称照明,这些全焦距范围的不对称性可以得到完全补偿。在光源优化的过程中还必须特别注意,要在保持高对比度的同时避免引人异常的像差灵敏度。

另一种减少EUV成像对比度衰减的方法是应用非对称辅助图形,图9-18276展示了Stephen Hsu和Jinging Liu对变形高NA EUV成像系统的仿真结果[52]。

需要特别注意的是:非对称辅助图形的应用有助于改善不同照明方向衍射级的平衡。因为其可以保证辅助图形良好的离焦性能,并避免在相关离焦点位置范围内辅助图形的成形。关于EUV光刻的非对称辅助图形及其对工艺性能的影响的进一步详细信息,请参阅本章后的参考文献[52]。
解决掩模形貌效应的最通用方法是使用优化的掩模材料。高k:吸收层材料的应用能够减少吸收层厚度。折射率接近1的吸收材料引起的光波前变形和相位变化较小,图9-19的近场图证明了这一点。
然而,具有较低消光系数和折射率介于0.88~0.95的吸收材料可用作EUV光刻的衰减型相移掩模[54]。具有小折射率的吸收材料也有利于引导光进入掩模的无吸收层区域,并减少不同照明方向之间的图像偏移[45]。
优化掩模吸收材料和掩模结构的研究仍在进行中[55-57]。确定最佳选择需要考虑不同的成像指标(NILS、尺寸阈值、非远心度等),更重要的是,这些材料对掩模结构的适用性(图案化、寿命、检查、修复等)。EUV光刻机中,高k:吸收层材料成像性能的首次实验研究显示出套刻性能的改善[58]。最后,还必须考虑多层膜的特性[59]。

9.2.5各种三维掩模模型
将严格的掩模建模应用于较大的掩模设计图形区域需要大量的计算资源,这可以通过算法[60,61]和专用硬件[62,63]的并行化来部分解决。然而,用于光刻成像计算的掩模衍射建模是一项特殊的任务,它允许一些方法具有合理的精度损失。例如,掩模衍射光谱的高空间频率对使用具有有限数值孔径的投影系统获得的远场图像没有贡献,因而针对这些高空间频率出现的数值误差是可以忽略的。此外,光刻掩模上的掩模图形大多是层次分明的,并具有优先图形设计方向。上述这些结果可用于建立更有效的模型来捕捉掩模形貌效应。
掩模分解技术用于将大面积、全3D问题拆分为更简单的小面积或2D/1D问题。Kostas Adam和Andrew Neureuther提出了一种结合 FDTDo4]的域分解技术(DDT)。DDT使用FDTD计算来自掩模孤立边缘光的衍射。此后,特征衍射图案被应用于掩模设计图形中的所有边缘。如果设计图形离掩模的边缘不是太近,这种方法可以提供非常好的精度。该模型还可以扩展到描述角效应或不同入射角的光[31]。类似的分解技术也被用于波导法[65],这种方法将完全3D问题(例如来自接触孔阵列或更复杂布局的光衍射)分解为几个2D问题,类似来自线空图形的光衍射。
其他更近似的模型试图在不求解麦克斯韦方程组的情况下捕捉掩模形貌
效应,这些紧凑模型通过修改Kirchof掩模模型或成像系统来模拟掩模形貌效应。边界层模型是在Kirchoff型掩模设计图形中采用薄的半透明层包围图形边缘(m0)。该半透明层的宽度、透射率和相位是由完全严格的掩模模型校准确定的。边缘脉冲模型采用了类似的方法,将具有特定高度和相位的脉冲添加到Kirchoff型掩模的所有边缘。边缘脉冲模型已被用于光学[34]和EUy掩模[67,68]
由掩模形貌引起的偏振幅度和相位效应也可以通过修改投影物镜的光瞳函数来近似,将复杂的光瞳滤波器引人到投影物镜的琼斯光瞳中(60)。光瞳滤波器的形状是由Zemike或Tschebyscheff多项式来描述的,并且多项式系数由完全严格的掩模和成像仿真来进行校准。或者,这些多项式可以直接应用于掩模的衍射光谱.701。另一种更灵活的方法是应用神经网络来仿真掩模形貌引起的衍射光谱修改(71。神经网络针对特定的测试图形进行训练,能够高精度地再现许多掩模形貌效果。
所有描述的紧凑型掩模模型都必须通过完全严格的EMF仿真进行校准,这些模型的精度、性能、灵活性和可扩展性取决于所考虑的掩模类型、成像条件和特定的应用场景。
图9-20给出了不同版本掩模模型的分类。它们的范围从薄掩模或Kirchhof模型到没有Hopkins假设的完全严格的模型。与Kirchhoff模型相比,紧凑模型提高了仿真精度,但需要使用完全严格的模型进行校准。域分解技术能够将严格的仿真技术应用于更大的掩模区域。图9-20中,这些模型的精度和计算工作量从左到右增加,选择最合适的模型取决于具体的应用。不同的模型相组合有助于在光学邻近效应校正和光源掩模协同优化中有效地包含掩模形貌效应。

-
仿真
+关注
关注
55文章
4532浏览量
138647 -
掩模
+关注
关注
0文章
15浏览量
7755 -
电磁场
+关注
关注
0文章
806浏览量
49499
原文标题:掩模形貌效应-------光学光刻和极紫外光刻 安迪•爱德曼 著
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
VirtualLab Fusion应用:泰伯效应
光刻技术原理及应用
助力高级光刻技术:存储和运输EUV掩模面临的挑战
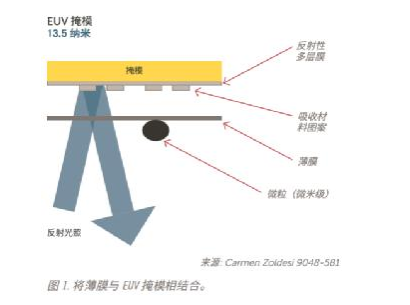
用于后端光刻的新型无掩模技术分析
计算光刻技术的发展
浅谈EUV光刻中的光刻胶和掩模等材料挑战
考虑光刻中厚掩模效应的边界层模型
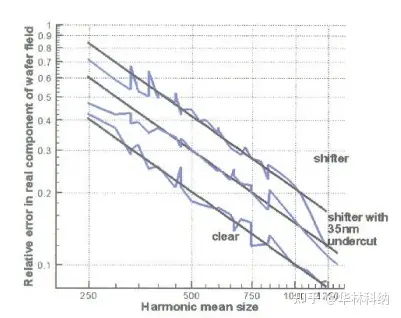
解析光刻芯片掩模的核心作用与设计

高数值孔径投影光刻中的偏振效应




 光刻技术中的掩模形貌效应详解
光刻技术中的掩模形貌效应详解

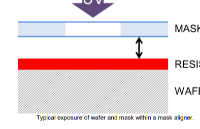

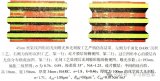




评论