短波长透明光学元件的缺乏限制了深紫外光刻中的可用波长,而晶片上所需的最小特征继续向更深的亚波长尺度收缩。这对用入射场代替掩模开口上的场的基尔霍夫边界条件造成了严重的限制,因为这种近似无法考虑光刻图像计算中日益重要的地形效应(厚掩模效应)。在本文中,我们华林科纳提出了一种复杂的基尔霍夫近似,它能够模拟严格的近场效应,同时保持标量模型的简单性。我们华林科纳的模型是基于对晶片上的厚掩模和理想薄掩模产生的场的比较。偏振和边缘衍射效应以及相位和透射误差都包含在我们的模型中。
在过去的几年里,光刻工艺首次进入亚波长操作模式。这意味着晶片上印刷电路的最小特征小于光源的波长,由于深紫外光刻(DUVL)中缺乏折射透镜,因此限制为157nm。在过去的十年里,二进制掩模的一些复杂扩展被逐渐添加,例如相移掩模(PSM),以提高分辨率,同时减少可打印的临界尺寸(CD)。然而,航空图像形成的模拟完全依赖于基尔霍夫边界条件,以使用等效标量二进制模型(薄掩模近似)来近似图案化掩模正后方的fifield。Kirchhoff模型的优势简单性允许对远大于源波长的特征尺寸进行快速但合理准确的计算,但在亚波长维度上却非常不准确,因为在亚波长尺度上,由光的矢量性质引起的地形效应变得明显。
其中一些厚掩模效应:由于电场和磁场的不同边界条件引起的偏振依赖性、小开口中的传输误差、衍射边缘效应或电磁耦合,对于交替相移掩模(Alte.PSM)来说变得特别关键,因为它们基于通过它们传播的em场的振幅和相位的调制。因此,在Alt-PSM掩模的航空图像形成中,消耗资源的严格3D电磁场模拟变得必要,这提高了对精确但仍然简单的物理模型的需求。
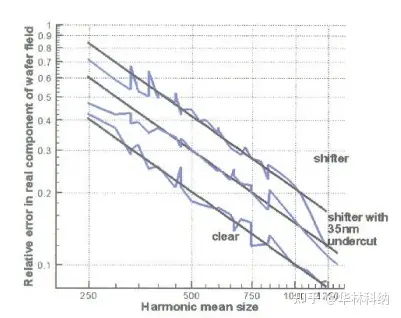
最后,模型的实部和虚部的叠加给出了最终的边界层,如图5(c)所示,宽度和透射系数参数如表1所示。对于每个蚀刻轮廓,在最小二乘意义上从最佳拟合直线到数据点的斜率获得边界层参数。
由于光刻行业使用具有与照明波长相当的特征的光掩模图案设计,为了突破光学分辨率的极限,有必要对掩模地形效应进行严格的模拟。然而,在实践中,即使在相对较小的掩模区域上评估麦克斯韦方程所需的数值努力也太高,并且这些厚掩模效应的可靠建模已被证明是具有挑战性的。
为更好的服务客户,华林科纳特别成立了监理团队,团队成员拥有多年半导体行业项目实施、监督、控制、检查经验,可对项目建设全过程或分阶段进行专业化管理与服务,实现高质量监理,降本增效。利用仿真技术可对未来可能发生的情况进行系统的、科学的、合理的推算,有效避免造成人力、物力的浪费,助科研人员和技术工作者做出正确的决策,助力工程师应对物理机械设计和耐受性制造中遇到的难题。
审核编辑 黄宇
-
光刻
+关注
关注
8文章
368浏览量
31426 -
掩模
+关注
关注
0文章
15浏览量
7757
发布评论请先 登录
VirtualLab Fusion应用:泰伯效应
VirtualLab Fusion应用:锥形相位掩模的Talbot图像
光刻技术原理及应用
考虑从众效应的谣言传播模型
回顾半导体技术趋势及其对光刻的影响分析与应用
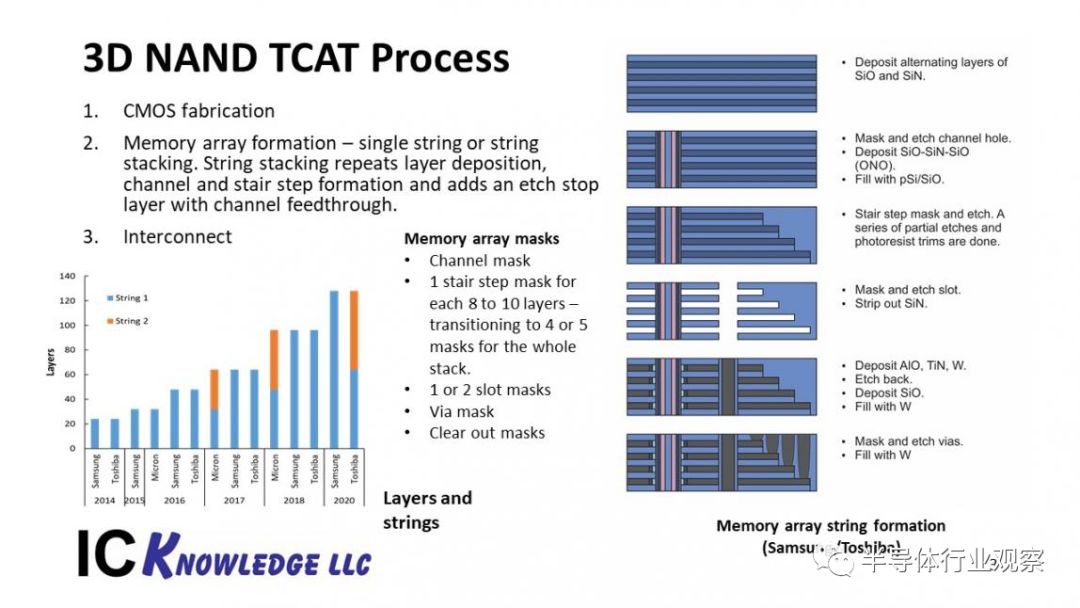
基于传感器测量节点和数据采集器实现海气边界层监测系统的设计
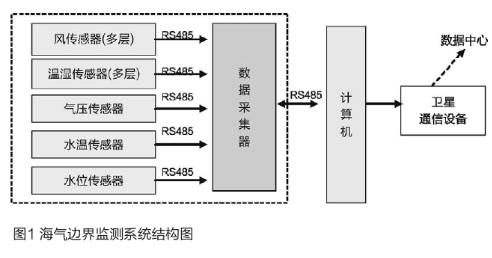
边界层的理论及其特点
浅谈EUV光刻中的光刻胶和掩模等材料挑战
光刻各环节对应的不同模型种类

解析光刻芯片掩模的核心作用与设计

光刻技术中的掩模形貌效应详解




 考虑光刻中厚掩模效应的边界层模型
考虑光刻中厚掩模效应的边界层模型








评论