第一次对非平面衬底上的光刻曝光的详细研究出现在20世纪80年代后期,Matsuzawa等人72]采用有限元方法来描述硅衬底上高台阶的光散射,他们证明了散射光会导致局部曝光剂量和由此产生的光刻胶轮廓的变化。这种反射凹口也通过其他方法进行了研究!".73。尽管很早就开始研究晶圆形貌对光刻工艺的影响,但将严格的电磁场建模应用到晶圆散射效应建模的研究并不成熟。
通常,化学机械抛光(CMP)和底部抗反射涂层(BARC)用于调整晶圆的平面度,抑制晶圆图案的反射,并改善离焦和工艺的控制。正如3.2.2节所述,此类BARC改善了所获光刻胶轮廓的形状,并降低了所得特征尺寸(CD)对光刻胶厚度变化的敏感性。此外,BARC的应用减少了进入晶圆不均匀区域的光,使得光从晶圆不均匀区域到非预期方向的衍射可以忽略。类似的论点被用来证明描述光刻胶内部强度分布的解析薄膜转移矩阵的应用。然而,FinFET等新器件架构和包括双重成形技术在内的新工艺技术,增加了晶圆形貌效应的重要性。
晶圆散射效应的严格电磁场建模比掩模形貌效应的严格建模更具挑战性。典型光刻机是4x缩放,因此与掩模上的特征尺寸相比,晶圆上仿真对象的尺寸更小。然而,光在晶圆上更大的入射角范围和部分相干效应增加了晶圆形貌效应建模的数值计算工作量。对于许多单独点光源,必须计算、存储和叠加其散射场。此外,晶圆散射效应的严格建模对电磁场的高空间频率分量的数值误差更为敏感。投影物镜的有限孔径和相应的带通滤波效果减少了此类误差对掩模形貌仿真的影响。对于晶圆形貌仿真,情况并非如此,电场中的所有傅里叶分量都对光刻胶内部的强度分布有着影响。
本节重点介绍几种情况,其中晶圆散射现象会引入薄膜转移矩阵无法描述的重要光刻效应,这包括比较不同的BARC沉积策略,靠近栅极的光刻胶底部残余效应,以及由于晶圆形貌导致的双重成形技术的线宽变化。
9.3.1 底部抗反射涂层的沉积策略
第一个晶圆形貌效应的示例展示了45mm宽密集线的光刻曝光和工艺,这些线穿过晶圆上10nm高和150nm宽的硅台阶,相关的曝光和光刻胶膜层参数如图9-21所示。该图的顶行显示了两种不同的晶圆几何形状,分别是通过底部抗反射涂层(BARC)的平面化(左)沉积和保形(右)沉积获得的。图9-21的中行显示了沿空中心的光刻胶膜层内部产生的强度分布。图中的虚线表示BARC的上表面,计算得到的光刻胶轮廓在图9-21的底行中给出。
平面化沉积在BARC和光刻胶之间产生一个平坦的界面。BARC厚度仅在硅台阶的顶部达到其最佳值。在x=0处,硅台阶中心上方的光刻胶相应区域中没有驻波。硅台阶左右两侧的光刻胶区域中,BARC太厚,由此产生的反射光在光刻胶的左右区域会产生明显的驻波图样。BARC在硅台阶外部区域的性能不佳也可以在光刻胶的剖面中观察到,它们分别在硅台阶的左右两侧表现出明显231的驻波和光刻胶底部残留效应。
BARC的保形沉积在晶圆上产生均匀的BARC厚度,相应的光强分布中几乎看不到驻波。然而,来自硅/BARC中的较小台阶的光散射会导致在硅台阶左右两侧的光刻胶/BARC界面附近的光强略有降低。这带来相应区域光刻胶线宽的些许变化和光刻胶的底部残留。

9.3.2 靠近栅极的光刻胶底部残余
在某些情况下,化学机械抛光(CMP)和BARC不能被用于降低晶圆形貌的影响。例如,BARC材料有时与特定工艺步骤中采用的技术不兼容。此外,BARC和CMP会增加额外的工艺时间和成本。图9-22为一个典型情况,为了简化对相关效应的讨论,所示仿真中假设衬底具有与光刻胶相同的折射率;70nm宽和175 nm高的多晶硅线嵌入在500mm厚的光刻胶中。该多晶硅线是在前一个光刻和刻蚀步骤中生成的,被用作后续离子注入步骤的掩模。本示例无法使用BARC,因为它可能会影响注人特性。图9-22所示晶圆用250 mm线宽、周期为1000 nm的图形曝光,这些线垂直于多晶硅线条。

图9-22中图显示了光刻胶内部沿掩模图形空的中心计算所得光强分布,多晶硅线对光不透明,并将其散射到光刻胶的其他部分。来自多晶硅线顶部的光散射会在光刻胶的相应区域产生明显的驻波。多晶硅线的垂直边缘将光散射到其左右两边,导致光刻胶中相应区域的局部曝光剂量显著降低。多晶硅线左右两侧区域中较小的曝光剂量,会在靠近多晶硅线底部附近产生光刻胶残留(参见图9-22右图),来自多晶硅线顶部的散射光则会导致额外的线宽变化。本章后的参考文献[74,75]中发表了针对各种曝光场景中的光刻胶底部残留效应的综合仿真研究,包括与实验数据的比较。结果表明,光刻胶底部残留的多少取决于掩模的照射方向,更激进的离轴照明有助于减少光刻胶底部残留效应。
9.3.3 双重成形技术中的线宽变化
本节的最后一个示例展示了晶圆形貌效应对双重成形技术中某些场景的重要性。图9-23显示了在光刻-固化-光刻-刻蚀(LFLE)工艺(参见5.3.2节)中第一次曝光和光刻胶工艺步骤之后的晶圆几何形状。此过程的目标是使用正交线空图形的后续曝光和工艺来生成(拉长的)接触孔阵列。固化步骤可以改变第一个光刻步骤中图案化光刻胶的折射率,这里假设固化使图9-23左图光刻胶中心部分折射率增加了0.03。

增加的折射率会吸引光并在光刻胶底部生成一个较强的光强分布,如图9-23中图所示。固化光刻胶附近这一较高的局部曝光剂量导致第二个光刻步骤中的线宽变化(图9-23右图)。本章后的参考文献[76]中发表了针对不同周期图形,第二次光刻步骤中观察到的线宽变化与固化引发的光刻胶光学特性改变,以及二者之间相关性的综合定量研究。其展示了如何通过严格的晶圆形貌仿真来识别适当的材料性能和固化过程中可容忍的折射率变化,并优化双重成形技术应用的设计拆分方法。其他研究者也应用了类似的建模技术来研究旋涂第二层光刻胶和由此产生的晶圆形貌对双重成形工艺中第二次光刻步骤的影响[77]。
-
晶圆
+关注
关注
53文章
5445浏览量
132713 -
光刻
+关注
关注
8文章
367浏览量
31393 -
散射
+关注
关注
0文章
19浏览量
7834
原文标题:晶圆形貌效应-------光学光刻和极紫外光刻 安迪•爱德曼 著
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
晶圆表面形貌及台阶高度测量方法

一文读懂半导体晶圆形貌厚度测量的意义与挑战

解析LED晶圆激光刻划技术
光刻技术原理及应用
光刻及资料分享—Optical Lithography
光刻胶在集成电路制造中的应用
单片机晶圆制造工艺及设备详解
光刻机工艺的原理及设备
晶圆表面形貌及台阶高度测量方法
半导体晶圆形貌厚度测量设备
光刻技术中的掩模形貌效应详解




 光刻技术中的晶圆形貌效应详解
光刻技术中的晶圆形貌效应详解

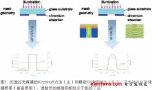
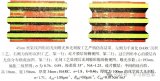



评论