随着半导体制程向先进节点演进,3D 晶体管架构与多层互连堆叠技术的规模化应用,使得器件缺陷的隐蔽性与检测难度显著提升。传统光学检测技术已难以满足电学相关缺陷的识别需求,而电子束检测的效率瓶颈又制约了量产应用。DirectScan 检测通过核心技术创新破解了这一行业痛点,为下一代半导体制造提供了高效、精准的检测解决方案。
本文将从技术原理、核心优势、应用场景及落地实践等方面,对该技术进行系统性解析。
一、先进工艺节点的检测挑战与技术缺口
当前半导体制造技术正经历关键变革:鳍式场效应晶体管逐步被全环绕栅极(GAA)纳米带晶体管替代,中段制程(MOL)因多重图形化技术的应用,堆叠复杂度持续增加。这一变革导致致命缺陷多隐匿于 3D 结构内部,传统光学检测手段难以有效识别。
同时,先进工艺节点的缺陷呈现显著的产品特异性,集中分布于特定工艺 - 版图组合的 “热点区域”,此类缺陷由芯片设计固有的版图特征引发,成为影响良率的核心因素。
行业面临的核心矛盾在于:电子束电压衬度检测是识别电学缺陷的关键技术,但传统电子束检测采用光栅扫描模式,效率远低于光学检测,无法匹配大批量生产的需求。DirectScan 技术的出现,为破解这一矛盾提供了可行路径。

二、DirectScan 核心技术架构:PointScan 的创新逻辑
DirectScan 检测方案由eProbe 电子束检测工具、FIRE GDS 版图分析平台及Exensio 大数据智能分析平台三大核心组件构成,其技术突破的核心在于PointScan 扫描技术对传统电子束检测逻辑的重构,主要体现在以下三方面:
1
设计感知驱动的靶向检测
传统电子束检测采用无差别光栅扫描,需覆盖包括介质区域在内的全部区域,且无法识别被测目标的图形特征;PointScan 技术具备非接触式电学测试特性,可精准跳转至目标器件的关键位置(如焊盘、接触点),仅对有效检测区域实施电压衬度检测,完全规避介质区域的无效扫描,实现 “按需检测”。

2
检测效率的量级提升
通过 FIRE 平台的精细化版图分析,可精准筛选出需检测的 “关键区域”,大幅缩减检测范围:
后段制程金属 3 层通孔检测:仅需扫描总可检测面积的 2.5%
中段制程栅极 - 漏极短路检测:仅需扫描总接触点的 1%
栅极残筋检测:可规避 50%-75% 的介质区域,检测面积缩减至传统方案的 10% 以下
基于上述优化,PointScan 技术的检测吞吐量可达传统单束电子束检测设备的 20-100 倍,每小时可完成数十亿个被测器件的扫描。
3
设计感知学习与属性分析能力
DirectScan 与 FIRE 平台的深度整合,可实现跨多层版图的属性提取,包括触点类型(漏极 / 栅极)、晶体管阈值电压、极性、与扩散区隔离槽的距离等关键参数。
eProbe 输出的 KLARF 格式数据含专属属性识别码,可与版图特征精准匹配,工程师可直接计算特定属性或属性组合对应的缺陷率,快速定位高风险晶体管类型与版图设计方案,为工艺优化提供数据支撑。
三、高难度场景的应用突破
PointScan 技术的低电荷沉积特性,使其在传统电子束检测难以覆盖的场景中实现突破:
背侧供电网络(BSPDN)晶圆检测
键合晶圆形成的绝缘层会阻碍电荷传导,导致传统电子束检测出现电荷累积、电子束偏折与失焦问题;PointScan 技术大幅降低单位面积电荷沉积量,有效缓解上述问题,已完成实际应用验证。
3D DRAM 检测
3D DRAM 的结构特性同样易引发电荷累积,此前检测难度较高,DirectScan 技术的应用使该类器件的精准检测成为可能。
DRAM 阵列短路检测
独有的可控 “充电 - 检测” 功能,可在指定位置施加电荷后跳转至目标区域采集电压衬度信号,使特定岛状节点呈现高亮状态,清晰识别与浮空相邻触点的短路问题,该功能为传统光栅扫描技术所不具备。
四、行业落地实践与全流程应用
自 2022 年初起,eProbe 检测系统已在多家先进逻辑芯片制造工厂落地,目前两套设备投入大批量生产,第三套设备处于产能爬坡阶段,应用场景覆盖半导体制造全流程:
先进逻辑芯片制造
中段制程:GAA 栅极 - 漏极短路、栅极接触孔开路、栅极外延层 / 硅化物层开路检测
后段制程:M0 层、1X 层、2X 层系统性接触孔开路与金属布线短路检测
背侧供电网络:电源通孔、源极 / 漏极通孔接触孔开路与短路检测
随机逻辑电路漏电情况评估
先进 DRAM 制造(2024-2025 年)
外围电路:栅极 - 栅极残筋短路、栅极 - 漏极短路、字线 - 字线短路与开路检测及缺陷定位
存储阵列:基于可控 “充电 - 检测” 技术的存储节点短路检测
技术总结
在半导体制程向更精密 3D 架构演进的背景下,检测技术的创新成为保障良率的关键。DirectScan 方案通过 PointScan 靶向扫描技术、设计感知分析能力与产品特异性缺陷学习功能的融合,在保留电子束检测高灵敏度的基础上,实现了检测吞吐量的量级提升,同时破解了高难度场景的检测难题。
该技术不仅解决了先进工艺节点下缺陷“难识别、难检测” 的问题,更推动半导体检测从 “缺陷识别” 向 “工艺优化赋能” 升级,为下一代半导体制造提供了核心技术支撑和全新路径。
-
半导体
+关注
关注
339文章
31192浏览量
266321 -
检测
+关注
关注
5文章
4918浏览量
94283 -
电子束
+关注
关注
2文章
135浏览量
14074
发布评论请先 登录
SiC碳化硅功率电子在下一代太空光伏基础设施中的战略集成

功率放大器在电子束金属3D打印中的应用

构建下一代电力架构:倾佳电子面向AI服务器的全数字双输入碳化硅电源深度解析

意法半导体推进下一代芯片制造技术 在法国图尔工厂新建一条PLP封装试点生产线
适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM skyworksinc

从电路板到创新领袖:电子技术人才的进阶之路
国产首台28 纳米关键尺寸电子束量测量产设备出机

意法半导体携手Flex推动下一代移动出行发展
下一代高速芯片晶体管解制造问题解决了!
NVIDIA 采用纳微半导体开发新一代数据中心电源架构 800V HVDC 方案,赋能下一代AI兆瓦级算力需求
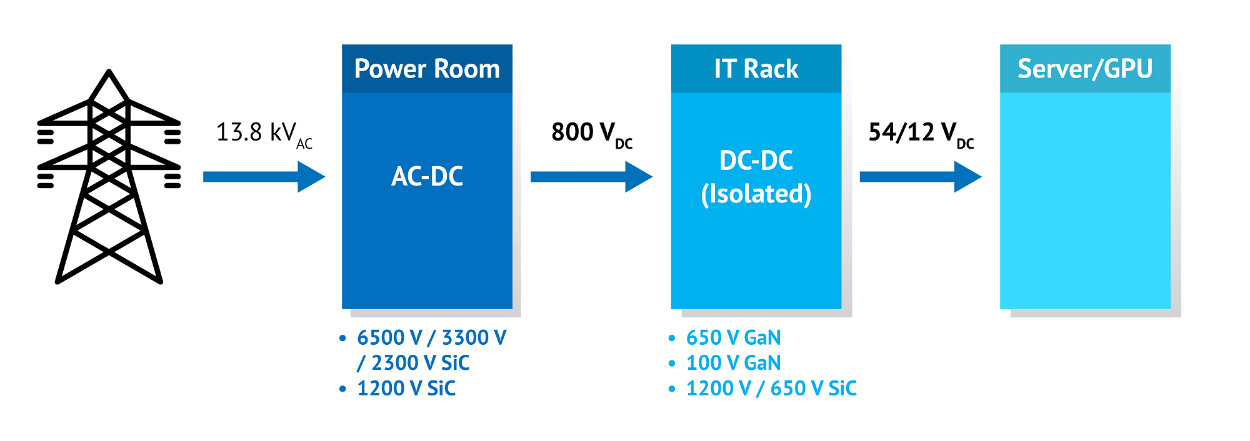



 DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用
DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用




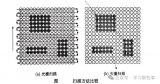



评论