半导体器件是经过以下步骤制造出来的
一、从ingot(硅锭)到制造出晶圆的过程
二、前道制程:在晶圆上形成半导体芯片的过程:
三,后道制程:将半导体芯片封装为 IC的过程。
在每一步骤,Nanoscope Systems都可以为三维形貌检测技术提供快速精确可靠的测试方案。
一、【Si晶圆的制造工程】 :从圆柱形的硅锭切出圆盘状的晶圆,并将其表面抛光,如同镜面一样。
第一步、从硅单结晶晶柱切出品圆状的品圆(切成薄片:Slicing)
将圆柱状的 Si单结晶晶柱贴在支撑台上,再使带有钻石粒的内圆周刀刃旋转,就可切出圆盘状的晶圆。
第二步、Si晶圆的表面抛光(研磨-精磨:Polishing)
如果想制造缺陷少的器件,需要将 Si晶圆表面用机械或化学方法加以抛光成镜面,
以去除表面的缺陷层。在此可使用NS3500对 wafer表面上三维均实现高精度(亚纳米)粗糙度测量,用于评定抛光效果;同时对整个 wafer的TTV/Bow/Warp,Flatness进行测量


二、【前道制程】:反复进行黄光微影、蚀刻及杂质扩散的工程,以制造半导体芯片。
第一步、气相成长
在完成镜面研磨的晶圆表面(单结晶硅基板)形成气相沉积层。

第二步、选择性的掺杂扩散
运用类似照相技术的微影方法,可选择性地扩散掺杂物而在部分区域制造想要地极性与杂质浓度。通过重复这个过程可制造所需求地半导体器件。
第三步、蒸镀电极金属
将铝、铜等蒸镀在晶圆表面形成电极及配线

NS3500 可以对3D形貌、高度、角度等进行测量。

三、【后道制程】:从晶圆切割芯片,再用导线与引线连接,然后用塑膜树脂包装IC芯片,并进行测试以去除不良品
第一步、切片(dicing)
将制造在晶圆上的半导体器件,用钻石刀将晶圆切割成各个芯片。

第二步、Wire Bonding引线键合
用细金属线,利用热、压力使金属引线与基板焊盘紧密焊合,实现芯片与基板间的电气互联和芯片间的信息互通。

第三步、封装
为了增加机械强度,将芯片上的接点用导线连接刀封装外壳的引脚上,将芯片封装起来。

第四步、测试筛检
最后用测试表测定并判断其电气特性,并除去不良品。
专业术语
前道Front End:
后道Back End:
晶圆 Wafer:
晶粒 Die:
晶片、芯片Chip:
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54441浏览量
469421
发布评论请先 登录

【封装技术】几种常用硅光芯片光纤耦合方案
12寸晶圆的制造工艺是什么
芯片制造过程中的布线技术

芯片引脚成型与整形:电子制造中不可或缺的两种精密工艺
晶圆和芯片哪个更难制造一些
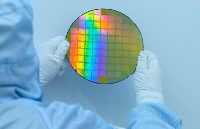

从芯片到主板,科技创新实现高质量发展
硅肖特基二极管芯片 skyworksinc

多晶硅在芯片制造中的作用
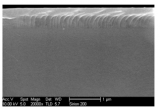



 芯片的制造过程---从硅锭到芯片
芯片的制造过程---从硅锭到芯片








评论