倾佳电子基于碳化硅MOSFET技术的固态开关解决光储直流侧安全的痛点:深度技术研究报告
倾佳电子(Changer Tech)是一家专注于功率半导体和新能源汽车连接器的分销商。主要服务于中国工业电源、电力电子设备和新能源汽车产业链。倾佳电子聚焦于新能源、交通电动化和数字化转型三大方向,分销代理BASiC基本半导体SiC碳化硅MOSFET单管,SiC碳化硅MOSFET功率模块,SiC模块驱动板等功率半导体器件以及新能源汽车连接器。
倾佳电子杨茜致力于推动国产SiC碳化硅模块在电力电子应用中全面取代进口IGBT模块,助力电力电子行业自主可控和产业升级!
倾佳电子杨茜咬住SiC碳化硅MOSFET功率器件三个必然,勇立功率半导体器件变革潮头:
倾佳电子杨茜咬住SiC碳化硅MOSFET模块全面取代IGBT模块和IPM模块的必然趋势!
倾佳电子杨茜咬住SiC碳化硅MOSFET单管全面取代IGBT单管和大于650V的高压硅MOSFET的必然趋势!
1. 绪论:高压直流时代的能源安全挑战
1.1 全球能源架构的直流化转型

在当今全球能源转型的宏大叙事中,电力系统的底层架构正经历着一场静悄悄却极具颠覆性的“直流化”革命。随着“碳中和”目标在各国政策层面的确立,以光伏(Photovoltaic, PV)发电和电化学储能(Energy Storage System, ESS)为代表的新能源装机容量呈指数级增长。这一趋势不仅仅是能源来源的更替,更是电网物理形态的重塑。
传统电力系统基于交流(AC)架构,源于旋转电机(发电机)的物理特性。然而,现代能源体系的核心组件——光伏组件输出的是直流电,锂离子电池存储和释放的也是直流电。为了追求更高的能效,减少DC/AC和AC/DC的多级转换损耗,并降低线缆成本,光储系统内部的直流母线电压等级不断攀升。从早期的600V系统,演进到1000V,目前1500V已成为地面电站和大型储能系统的主流标准,甚至更高电压等级(如2000V+)的研发也已提上日程。
然而,这种电压等级的提升,叠加储能电池极高的能量密度,给直流侧的电气安全带来了前所未有的挑战。直流电缺乏自然过零点(Zero Crossing Point),导致故障电流切断极其困难;电池极低的内阻特性使得短路电流上升率(di/dt)极高。传统的机械式保护设备在面对这些新特性时,逐渐显露出其物理极限。基于第三代半导体材料——碳化硅(Silicon Carbide, SiC)的固态断路器(Solid State Circuit Breaker, SSCB),正是在这一背景下应运而生,成为解决光储直流侧安全痛点的关键技术路径。

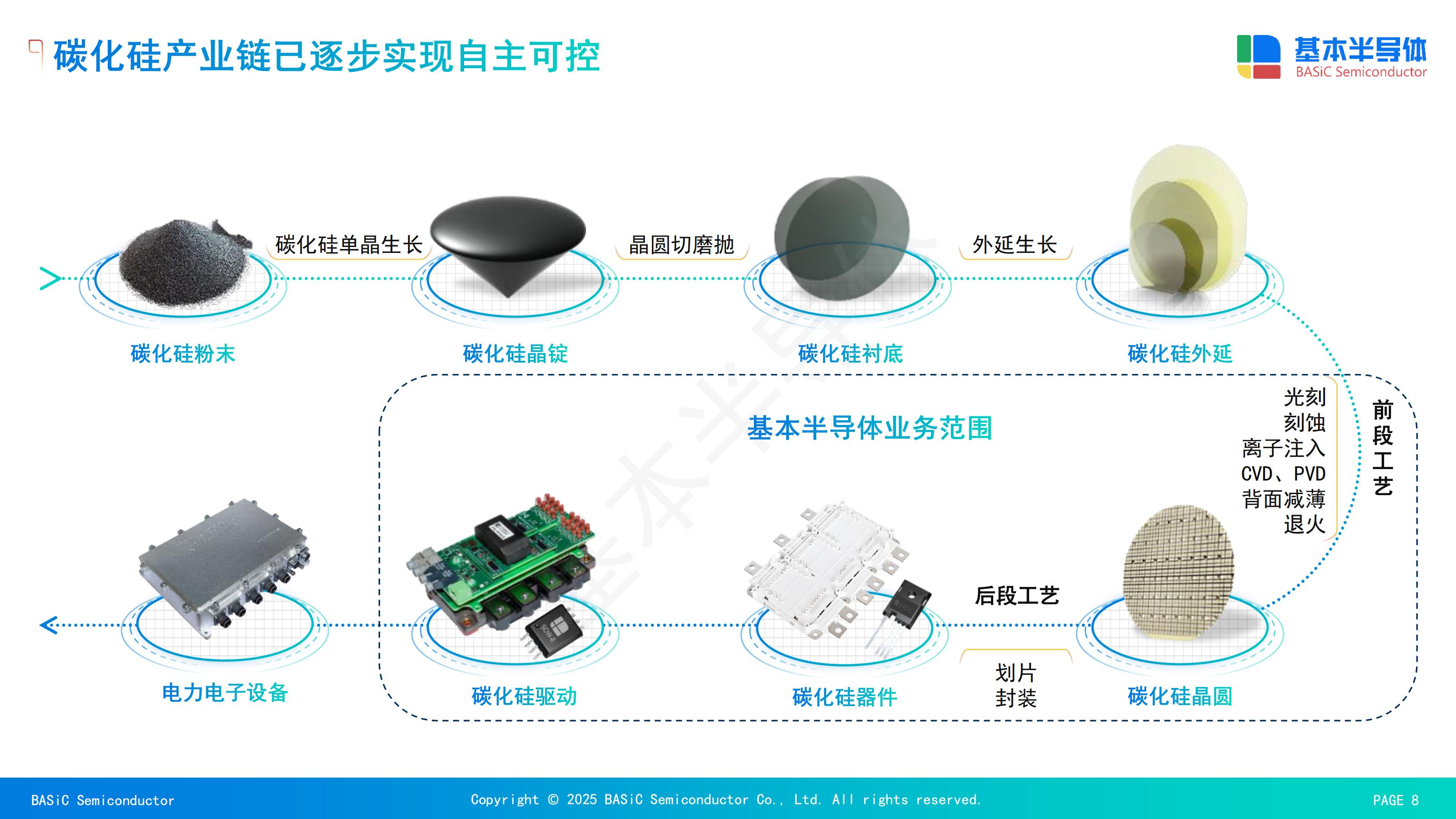

1.2 光储直流侧的三大核心痛点
1.2.1 极高短路电流上升率与机械开关的响应迟滞
在吉瓦时(GWh)级别的储能电站中,电池集装箱内部并联了成百上千个电芯。锂离子电池具有极低的内阻,这在正常运行时是优势,能提供高效率;但在外部短路故障时,这成为了巨大的安全隐患。一旦发生短路,电流不再像交流系统那样受限于线路阻抗呈正弦波变化,而是呈现出近乎垂直的指数级上升。
根据工程经验,储能系统的短路电流上升率(di/dt)可轻松超过10kA/ms。对于传统的空气断路器(ACB)或塑壳断路器(MCCB),其动作依赖于物理脱扣机构和弹簧储能释放,加上灭弧室的去游离过程,全分断时间(Total Clearing Time)通常在10ms至30ms之间。在面对高di/dt故障时,这意味着在断路器触头刚刚开始分离的瞬间,短路电流可能已经攀升至数万安培,甚至超过了设备的极限分断能力(Icu)。巨大的电动力足以使母排变形、绝缘支柱断裂,而长时间的故障电流持续注入,极易导致电池单体突破热失控临界点,引发连锁燃烧或爆炸。
1.2.2 直流电弧的持续性与火灾风险

交流电每秒钟有100次(50Hz)或120次(60Hz)经过零点,此时电流瞬时值为零,电弧容易熄灭。只要触头间隙的介质恢复强度大于恢复电压,电弧就不会重燃。然而,直流电没有过零点。在1500V高压下,即便触头拉开数厘米,空气被电离后形成的等离子体通道仍能维持导电,产生数千度的高温电弧。
传统的机械直流断路器依赖复杂的磁吹灭弧系统,利用磁场力将电弧拉长并引入灭弧栅片进行冷却和切割。这不仅增加了设备的体积和成本,而且在高海拔、低气压等恶劣环境下,灭弧能力会显著下降。更严重的是,随着触头的磨损,灭弧性能会随动作次数增加而衰减,存在保护失效的风险。在电池预制舱这种相对封闭且充满易燃电解液气体的环境中,任何持续的电弧都可能成为引爆点。
1.2.3 双向功率流控制的复杂性
与光伏单向发电不同,储能系统是典型的双向功率流应用。在充电模式下,电流从母线流向电池;在放电模式下,电流从电池流向母线。许多传统的直流断路器设计具有极性限制,即只能在一个电流方向上有效灭弧(利用特定方向的磁吹力)。如果反向故障电流流过,磁吹力可能将电弧吹向灭弧室的死角,导致无法熄弧甚至烧毁断路器。虽然无极性直流断路器已经问世,但往往伴随着体积庞大、结构复杂和成本高昂的问题。
1.3 固态开关技术的演进与SiC的崛起
固态断路器(SSCB)利用功率半导体器件代替机械触头,通过控制门极信号实现电路的通断。其理论优势在于微秒级的动作速度和无弧分断特性。然而,早期的SSCB主要基于硅基IGBT(绝缘栅双极型晶体管)。IGBT虽然耐压高,但由于是双极型器件,导通时存在固有的集电极-发射极饱和压降(VCE(sat)),通常在1.5V-2.0V以上。在数百安培的电流下,这会产生巨大的导通损耗,需要庞大的液冷散热系统,严重降低了系统效率。
碳化硅(SiC)MOSFET的成熟,彻底改变了这一局面。作为宽禁带半导体,SiC具有硅无法比拟的物理特性:
高临界击穿场强(约硅的10倍):允许漂移区做得更薄、掺杂浓度更高,从而在相同耐压下大幅降低比导通电阻。
高热导率(约硅的3倍):提升了器件的散热能力和功率密度。
单极性导通:MOSFET呈电阻特性(RDS(on)),在部分负载下压降极低,且无拖尾电流,开关速度更快。
倾佳电子将基于BASIC Semiconductor(基本半导体)提供的最新技术资料,包括750V/1200V分立器件及1200V专用SSCB模块,深入剖析SiC MOSFET技术如何从器件物理、封装工艺到系统应用层面,全面解决光储直流侧的安全痛点。
2. 碳化硅MOSFET器件物理与关键参数深度解析
为了理解SiC SSCB的性能边界,必须首先深入到器件层面的物理特性。我们选取了三款代表性产品进行分析:750V分立器件B3M010C075Z 、1200V分立器件B3M013C120Z 以及1200V专用模块BMCS002MR12L3CG5 。
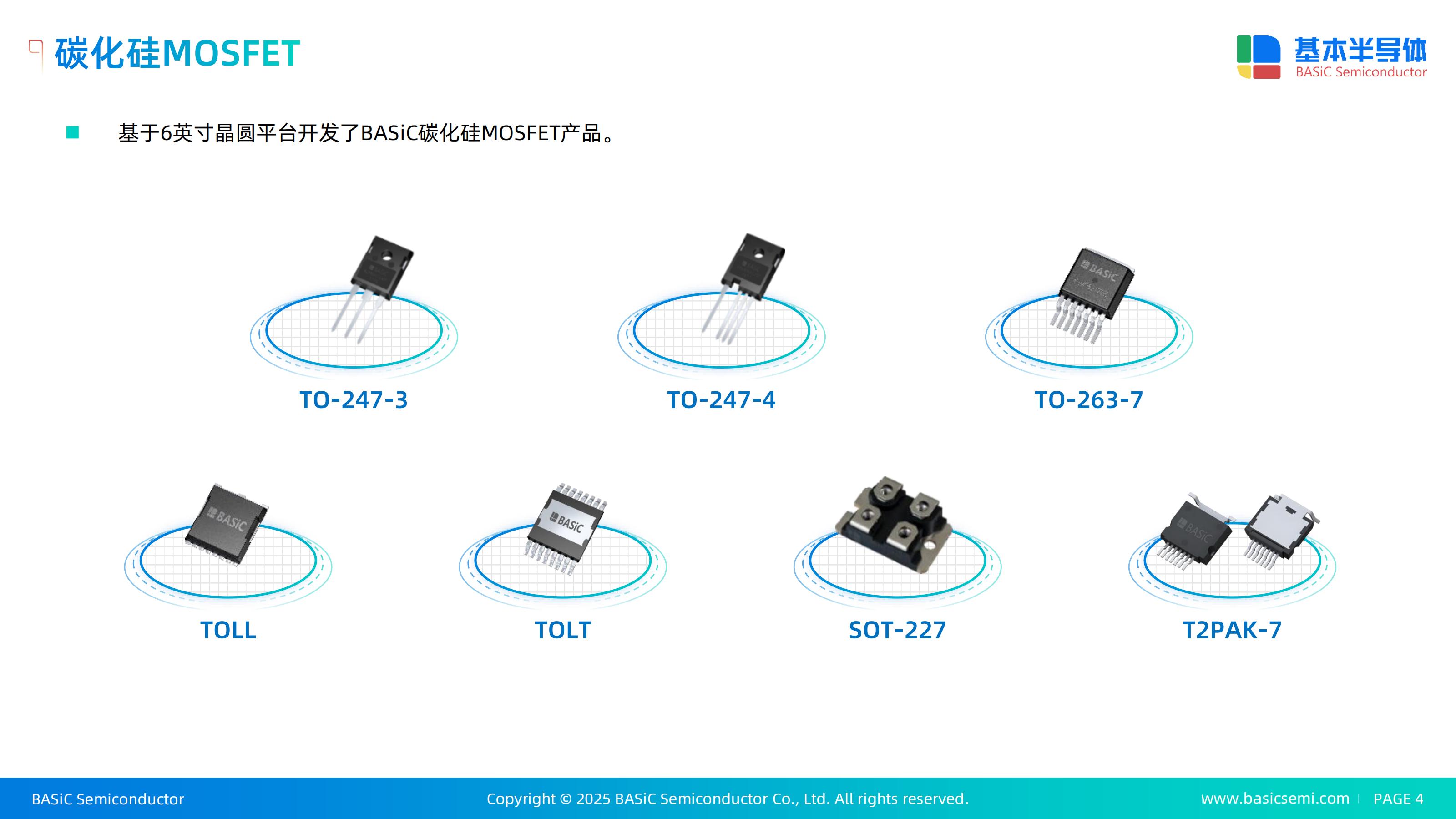

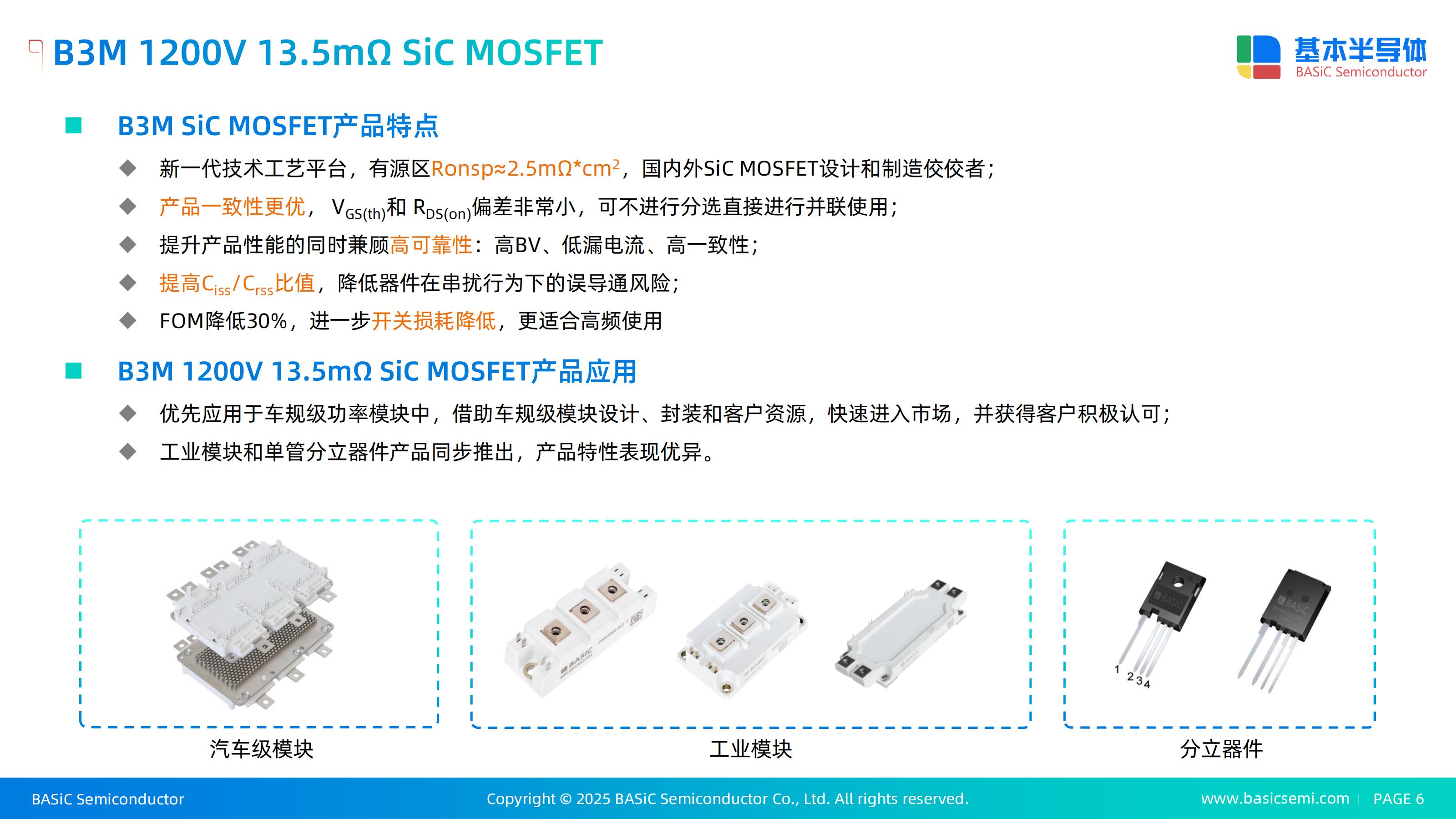
2.1 静态特性:导通电阻与耐压的平衡
2.1.1 极低的导通电阻(RDS(on))
SSCB作为一种常通部件,其稳态导通损耗是系统设计者最关心的指标之一。
B3M010C075Z (750V):资料1显示,在VGS=18V,ID=80A,TJ=25∘C条件下,其典型导通电阻低至10mΩ。即便在175∘C的高温下,电阻也仅上升至12.5mΩ(注:此处需结合1 Electrical Characteristics表仔细核对,表中显示175∘C时典型值为12.5mΩ可能是指归一化系数下的值或特定测试条件,通常SiC MOSFET的温度系数为正,高温下电阻会增加。查阅1 Table中RDS(on)项,175∘C时的Max值未直接给出具体数字,但给出了175∘C的测试条件。参考Figure 5 "Normalized On-Resistance vs. Temperature",在175∘C时,归一化因子约为1.6倍。因此,实际高温电阻约为16mΩ左右)。
B3M013C120Z (1200V):资料1显示,其典型电阻为13.5mΩ(VGS=18V)。在175∘C时,典型值上升至23mΩ。这意味着在1200V的高压耐受能力下,SiC依然保持了极低的通道阻抗。
BMCS002MR12L3CG5 (模块):作为大功率SSCB的核心,该模块内部并联了多颗芯片。资料1显示,其单开关(Per Switch)的RDS(on)在25∘C时典型值仅为2.6mΩ,在175∘C时为5.0mΩ。双向导通时(两个开关串联),总阻抗为5.0mΩ(25∘C)。这对于承载760A的额定电流至关重要。
深度洞察:与Si IGBT相比,SiC MOSFET的纯电阻特性在部分负载(Light Load)下优势巨大。例如在200A工况下,模块产生的压降仅为200A×0.005Ω=1V,显著低于IGBT的VCE(sat)。
2.1.2 漏电流与绝缘性能
作为断路器,关断状态下的漏电流决定了系统的安全隔离能力。
单管器件在额定电压下的零栅压漏电流(IDSS)非常小,典型值仅为1μA(750V器件)和5μA(1200V器件)。
然而,值得注意的是,随着温度升高,漏电流会显著增加。在175∘C时,B3M010C075Z的漏电流最大值可达12μA ,B3M013C120Z可达50μA 。
对于模块BMCS002MR12L3CG5,由于芯片并联数量多,其IDSS最大值达到了240μA 。虽然对于功率回路这微不足道,但在设计绝缘监测(IMD)系统时必须予以考虑,以免误报绝缘故障。
2.2 动态特性:电容、电荷与开关速度
SiC MOSFET的极快开关速度是实现微秒级保护的基础,但也对驱动设计提出了挑战。
2.2.1 极小的寄生电容
输入电容 (Ciss):B3M010C075Z为5500pF ,B3M013C120Z为5200pF 。
反向传输电容 (Crss, Miller Capacitance):这是决定开关过程电压变化率(dv/dt)的关键参数。B3M010C075Z的Crss仅为19pF ,B3M013C120Z仅为14pF 。
洞察:极小的Crss允许器件以极高的dv/dt(可达50−100V/ns)切换。这对于SSCB快速切断故障电流非常有利,但也意味着在关断大电流时,极小的栅极电流就能维持米勒平台的电压,容易受到干扰。
2.2.2 栅极电荷 (Qg) 与驱动功率
总栅极电荷 (Qg):750V器件为220nC ,1200V器件为225nC 。
模块级挑战:BMCS002MR12L3CG5模块的总栅极电荷高达1880nC 。
系统影响:为了在几百纳秒内完成关断,驱动器必须提供巨大的瞬时电流。根据公式 I=Q/t,若要求在200ns内释放1880nC电荷,驱动器需提供平均9.4A的灌电流(Sink Current)。考虑到峰值效应,驱动芯片的峰值电流能力至少应在15A-20A以上。这直接影响了驱动电路的成本和选型。
2.2.3 关断延迟时间 (td(off))
这是SSCB最核心的性能指标。
分立器件的td(off)非常短,约为80ns左右 。
模块BMCS002MR12L3CG5在175∘C、760A大电流下的关断延迟时间为359ns 。
数据解读:这359ns包含了驱动信号变化到漏源电压开始上升的时间。加上下降时间(Fall Time, tf)约280ns ,整个物理关断过程不到1μs。相比于机械开关的毫秒级动作,SiC SSCB在时间尺度上实现了三个数量级的跨越。
2.3 鲁棒性:雪崩耐量与体二极管性能
2.3.1 雪崩耐受性 (Avalanche Ruggedness)
在SSCB切断感性负载或长电缆时,杂散电感中存储的能量(1/2Li2)会产生电压尖峰。如果电压超过器件击穿电压,器件将进入雪崩模式。
资料1和1在"Features"中均明确标注了"Avalanche Ruggedness"。这意味着器件设计上具备吸收一定雪崩能量的能力,而不会立即损坏。这为SSCB的吸收电路(Snubber)设计提供了安全裕度,允许在压敏电阻(MOV)动作延迟的微小间隙内,由SiC器件自身承担部分过压能量。
3. 封装技术的革新:银烧结与低感设计
优异的芯片物理特性必须配合先进的封装技术才能发挥作用。资料1揭示了BASIC Semiconductor在封装层面的多项关键创新。


3.1 银烧结技术(Silver Sintering):热管理的革命
在所有三份资料的"Features"列表中,"Silver Sintering applied, Rth(j−c) improved"均被置于显著位置。
3.1.1 工艺机理
传统的功率器件封装使用锡铅或锡银铜焊料将芯片焊接在DBC(Direct Bonded Copper)基板上。焊料的热导率通常在30-60 W/(m·K)之间,且熔点较低(约220°C)。
银烧结技术利用纳米银膏在高温高压下烧结成多孔银层。银的热导率高达429 W/(m·K),烧结层的热导率通常能达到200 W/(m·K)以上,是传统焊料的3-5倍。更重要的是,烧结银的熔点高达960°C。
3.1.2 对SSCB的意义
降低热阻:资料1显示,BMCS002MR12L3CG5模块的结壳热阻Rth(j−c)低至0.0670K/W。这是一个极低的数值,意味着每产生100W的热损耗,结温仅比壳温高6.7°C。这极大地提升了器件在额定电流下的散热效率。
提升短路耐受力:在短路发生的微秒级时间内,热量来不及传导到散热器,主要依靠芯片自身的热容和芯片到DBC的热传导。银烧结层提供了极佳的热通路,延缓了结温上升到破坏点(通常是铝层熔化或闩锁效应)的时间。
功率循环寿命:光储系统通常设计寿命为20-25年。银烧结层克服了焊料层在反复热胀冷缩中容易产生疲劳裂纹、导致空洞扩大的缺陷,显著提升了器件的长期可靠性。
3.2 开尔文源极(Kelvin Source):解耦驱动回路
资料1和1中的TO-247-4封装,以及资料1中的模块原理图,都采用了开尔文连接设计。
3.2.1 问题的根源:源极电感
在传统3引脚封装中,源极引线既是主功率回路的一部分,也是栅极驱动回路的公共端。当SSCB切断巨大的短路电流时,电流变化率di/dt可达3000−5000A/μs。根据楞次定律,源极寄生电感Ls上会感应出电压 VLs=Ls×di/dt。这个电压方向会抵消栅极驱动电压,导致实际施加在芯片栅源极(VGS)上的电压降低,减缓关断速度,甚至造成关断振荡。
3.2.2 解决方案
开尔文源极(Pin 3 in TO-247-4, S1/S2 in Module)专门用于连接驱动器的参考地,不流过主功率电流。
效果:主回路的di/dt不会在驱动回路中引入感应电压。
数据验证:这直接使得器件能够实现资料中提到的极短开关时间(如tr=37ns ),并保证了在故障工况下关断的确定性和稳定性。
3.3 专用L3模块封装设计
资料1展示的L3封装(尺寸约63mm x 115mm,依据图纸比例估算,具体见Package Dimensions)是专为大功率应用设计的。
低电感端子布局:D1P/D2P和D1T/D2T的主端子设计采用了尽量短且宽的铜排,以降低模块内部电感(虽然具体数值TBD,但设计意图明显)。
集成温度传感器(PTC):模块内部集成了两路PT1000温度传感器(PTC1/PTC2)。
参数:0∘C时阻值为1000Ω,温度系数3850ppm/K 1。
应用:这允许控制系统实时监测SiC芯片的温度。对于SSCB,这不仅用于过热保护,还可以通过温度推算实时的导通电阻(利用RDS(on)的正温度系数),进而实现更精准的电流估算或老化监测。
4. 专用SSCB模块BMCS002MR12L3CG5的系统级性能分析
本章将重点分析资料1中的这款核心产品,它代表了当前SiC SSCB技术的最高集成度。
4.1 拓扑结构:共源极双向开关(Common-Source Bidirectional Switch)
该模块内部集成了两个背靠背串联的SiC MOSFET(S1/D1 和 S2/D2),并采用了共源极连接方式 。
4.1.1 极性与双向阻断
这种结构天然具备双向阻断能力。
原理:无论电流方向如何,总有一个MOSFET的体二极管处于反偏状态,配合另一个关断的MOSFET,可以阻断双向的高电压。资料明确指出VDSS=1200V(For both Direction)。
对比:相比于使用两个分立器件搭建,模块化设计减少了外部母排连接,降低了接触电阻和寄生电感。
4.1.2 驱动电路的简化
共源极设计的最大优势在于驱动。
单电源驱动:由于两个MOSFET的源极电位相同(S1和S2短接),它们可以共用同一个驱动器的参考地。这意味着只需要一路隔离驱动电源和驱动信号,就可以同时控制两个开关管的通断。
成本与可靠性:相比于共漏极(Common-Drain)接法需要两路独立的隔离驱动,这种设计减少了元器件数量,提高了系统的平均无故障时间(MTBF)。
4.2 电流能力与安全工作区(SOA)
4.2.1 额定电流与降额
标称能力:TC=100∘C时,连续漏极电流ID=760A 。
散热限制:资料中的Figure 15 "Continuous Drain Current Derating vs. Case Temperature" 显示,电流能力随壳温线性下降。在25∘C时,理论电流能力甚至超过1000A(受限于封装端子)。这表明760A是一个考虑了实际散热瓶颈的保守额定值,为过载运行留有余地。
4.2.2 瞬态热阻抗与短路耐受
瞬态热阻 (Zth(j−c)):资料1 Figure 14展示了瞬态热阻抗曲线。在10ms(典型短路保护时间窗口的上限)时,瞬态热阻远低于稳态值0.067K/W。
意义:这意味着在短时间的故障冲击下,模块可以承受远超额定功率的热耗散。这对于SSCB在检测到短路但尚未完全切断的数微秒内的热生存能力至关重要。
4.3 开关能量与频率
尽管SSCB不进行高频开关,但其开关损耗数据反映了其动态性能。
开通损耗 (Eon):175∘C下为156mJ 。
关断损耗 (Eoff):175∘C下为119mJ 。
数据对比:相比于同电压电流等级的IGBT模块(通常Eon+Eoff在500mJ-1000mJ级别),SiC模块的损耗极低。虽然SSCB动作频率低,但这极低的损耗意味着更小的热冲击,允许在保护动作后更快地恢复导通状态(Reclosing),提高了电网的可用性。
5. 解决光储直流侧安全痛点的具体技术路径
基于上述器件和模块的特性分析,我们可以构建具体的解决方案来应对第一章提出的三大痛点。
5.1 应对高di/dt短路:微秒级“限流式”分断
策略:利用SiC SSCB极快的响应速度,在短路电流上升到破坏性峰值之前将其切断。
时间预算分析:
电流检测:采用高带宽霍尔传感器或分流器,响应时间 <2μs。
驱动延迟:SiC MOSFET关断延迟 td(off)≈359ns 1。
电流下降时间:tf≈280ns 1。
总切断时间:<4μs。
效果:假设短路电流上升率为10kA/ms。在4μs时刻,电流仅上升了40A(叠加在负载电流上)。这意味着SSCB实际上是在电流远未达到短路峰值(如50kA)时就切断了电路。这不仅保护了电池,也大幅降低了对SSCB自身分断能力(Icu)的要求,实现了“四两拨千斤”的效果。
5.2 应对直流电弧:全固态无触头灭弧
策略:利用半导体物理关断特性消除电弧产生的条件。
机理:SiC MOSFET的关断是沟道电阻从毫欧级突变到兆欧级的过程。在这个过程中,电子流被夹断,路径中没有任何物理气隙被拉开,因此不存在气体电离和等离子体形成的物理基础。
优势:
本质安全:消除了电弧引燃风险,特别适用于防爆区。
无飞弧距离:机械断路器分断时会有电弧喷出,需要预留飞弧距离(Clearance)。SSCB没有飞弧,可以紧凑安装,大幅提升储能集装箱的功率密度。
5.3 应对双向保护:对称的背靠背拓扑


策略:利用BMCS002MR12L3CG5的共源极结构实现无死角的双向保护。
场景1:PCS侧短路(放电过流)
控制器关断S1和S2。此时,虽然电池侧电压高,但S1(或S2)的体二极管反偏,阻断电流。
场景2:电池侧内部短路(充电反灌)
控制器同样关断S1和S2。电流方向反转,另一个MOSFET承担阻断任务。
场景3:死区控制与模式切换
在储能系统从充电转为放电的瞬间,传统机械开关需要毫秒级的动作时间。SiC SSCB可以在微秒级内完成切换,极大地提高了电网一次调频(Primary Frequency Regulation)的响应速度,增强了电网稳定性。
6. 系统级设计考量与挑战
虽然SiC SSCB优势明显,但在实际工程应用中仍面临诸多挑战。
6.1 关断过电压与吸收电路设计
挑战:极快的关断速度(高di/dt)和线路杂散电感(Lσ)会产生巨大的电压尖峰 Vpeak=Vbus+Lσ×di/dt。
数据支撑:BMCS002MR12L3CG5的VDSS=1200V。在1000V直流系统中,仅留有200V的过压裕度。如果Lσ=20μH(典型长电缆),关断1000A电流,若di/dt过大,电压尖峰将轻易击穿器件。
解决方案:
混合式Snubber:并联RC吸收电路抑制高频振荡,同时并联大容量MOV(金属氧化物压敏电阻)钳位电压。
软关断(Soft Turn-off):在检测到短路时,驱动器不立即硬关断,而是通过增加栅极电阻RG(off)或分级关断,主动降低关断di/dt,以时间换取电压安全裕度。资料[1]中RG(ext)对开关时间的影响(Figure 13)证明了调节栅极电阻控制速度的可行性。
6.2 栅极驱动的抗干扰设计
挑战:SiC MOSFET的高dv/dt会通过Crss产生米勒电流,可能导致误导通(Crosstalk)。
数据支撑:资料1的推荐工作条件中,关断栅压VGS(off)均为−5V。
设计建议:必须采用负压关断(-3V至-5V)来提供足够的噪声容限。此外,推荐使用带有“有源米勒钳位”(Active Miller Clamp)功能的驱动芯片,在关断期间提供低阻抗通路,将栅极电压牢牢钳制在负电位。
6.3 散热设计
尽管效率高,但在760A下,模块损耗依然可观(约3000W @ 175∘C)。
设计建议:利用模块的低热阻特性(0.067K/W),必须配合高性能的液冷散热板(Cold Plate)。Si3N4陶瓷基板的优异机械性能允许模块以更大的压力安装在散热器上,进一步降低接触热阻。
7. 经济性分析与未来展望



7.1 全生命周期成本(TCO)
虽然SiC SSCB的初期采购成本(CAPEX)高于机械断路器,但从TCO角度看极具竞争力:
免维护:机械断路器电气寿命仅数百次,需定期维护。SiC SSCB寿命理论无限,适合高频次操作。
空间节省:体积仅为同级机械开关的1/3,节省宝贵的集装箱空间。
事故止损:防止一次电池火灾事故节省的资金,远超设备本身的成本。
7.2 智能化趋势
基于SiC的SSCB不仅是开关,更是智能节点。通过集成电流检测和资料1中的PT1000温度传感器,SSCB可以实时上传健康状态,实现预测性维护,成为能源互联网中的智能感知执行单元。
7.3 结论
基于BASIC Semiconductor 750V/1200V SiC MOSFET分立器件及BMCS002MR12L3CG5专用模块的深入研究表明,SiC固态断路器技术在物理特性、封装工艺和系统性能上已具备解决光储直流侧安全痛点的全部条件。特别是银烧结技术带来的高可靠性、开尔文源极带来的高速驱动能力以及共源双向模块带来的拓扑优势,共同构建了下一代本质安全型直流能源系统的基石。随着成本的进一步优化,SiC SSCB必将成为高压光储系统的标准配置。
深圳市倾佳电子有限公司(简称“倾佳电子”)是聚焦新能源与电力电子变革的核心推动者:
倾佳电子成立于2018年,总部位于深圳福田区,定位于功率半导体与新能源汽车连接器的专业分销商,业务聚焦三大方向:
新能源:覆盖光伏、储能、充电基础设施;
交通电动化:服务新能源汽车三电系统(电控、电池、电机)及高压平台升级;
数字化转型:支持AI算力电源、数据中心等新型电力电子应用。
公司以“推动国产SiC替代进口、加速能源低碳转型”为使命,响应国家“双碳”政策(碳达峰、碳中和),致力于降低电力电子系统能耗。
需求SiC碳化硅MOSFET单管及功率模块,配套驱动板及驱动IC,请添加倾佳电子杨茜微芯(壹叁贰 陆陆陆陆 叁叁壹叁)
附录:关键技术参数对比表
下表总结了本报告涉及的三款核心器件的关键参数,供系统设计参考。
| 参数指标 | 750V 分立器件 | 1200V 分立器件 | 1200V SSCB专用模块 | 设计意义 |
|---|---|---|---|---|
| 型号 | B3M010C075Z | B3M013C120Z | BMCS002MR12L3CG5 | |
| 封装形式 | TO-247-4 | TO-247-4 | L3 Module | 决定功率密度与安装方式 |
| 额定电压 (VDS) | 750 V | 1200 V | 1200 V | 适配不同直流母线电压等级 |
| 额定电流 (ID) | 240 A (@25°C) | 180 A (@25°C) | 760 A (@100°C) | 决定单机容量 |
| 脉冲电流 (ID,pulse) | 480 A | 360 A | 1520 A | 决定短路耐受上限 |
| 导通电阻 (RDS(on),typ) | 10mΩ | 13.5mΩ | 2.6mΩ (单管) | 决定系统效率与散热需求 |
| 关断延迟 (td(off)) | 81 ns | 80 ns | 359 ns (@175°C) | 决定保护响应速度 |
| 总栅极电荷 (Qg) | 220 nC | 225 nC | 1880 nC | 决定驱动器功率选型 |
| 反向传输电容 (Crss) | 19 pF | 14 pF | 0.12 nF (120pF) | 决定抗干扰能力与dv/dt |
| 热阻 (Rth(j−c)) | 0.20 K/W | 0.20 K/W | 0.067 K/W | 决定散热设计难度 |
| 关键技术 | 银烧结,开尔文源 | 银烧结,开尔文源 | 共源双向,集成PTC,银烧结 | 提升可靠性与易用性 |
审核编辑 黄宇
-
MOSFET
+关注
关注
151文章
10833浏览量
235016 -
光伏
+关注
关注
56文章
4809浏览量
76315 -
固态开关
+关注
关注
0文章
8浏览量
7268
发布评论请先 登录
碳化硅 (SiC) MOSFET dv/dt 极限物理本质深度研究报告

碳化硅(SiC)功率模块替代IGBT模块的工程技术研究报告

MCS兆瓦级充电系统拓扑架构演进与SiC碳化硅模块升级替代IGBT模块技术研究报告




 倾佳电子基于碳化硅MOSFET技术的固态开关解决光储直流侧安全的痛点:深度技术研究报告
倾佳电子基于碳化硅MOSFET技术的固态开关解决光储直流侧安全的痛点:深度技术研究报告



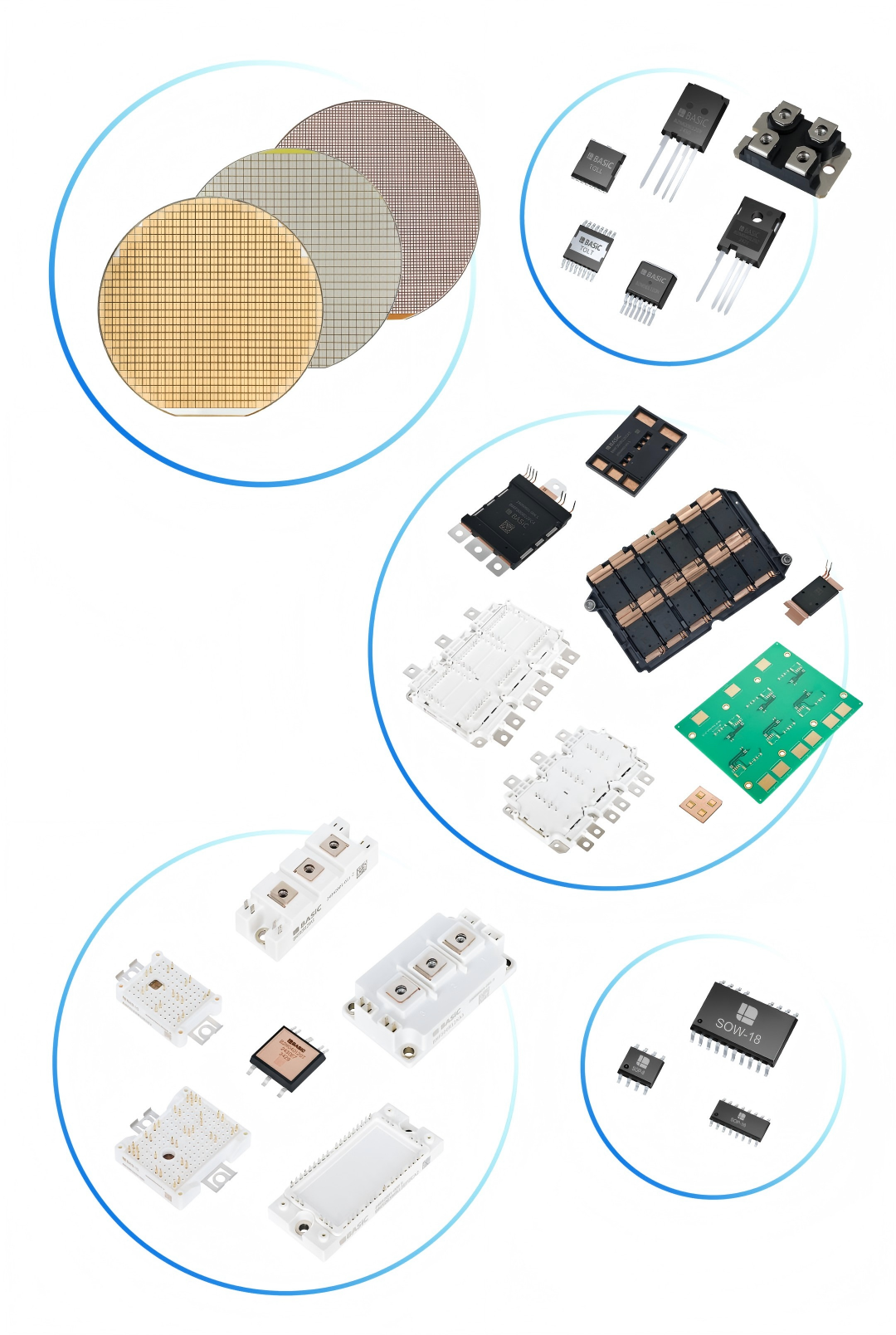
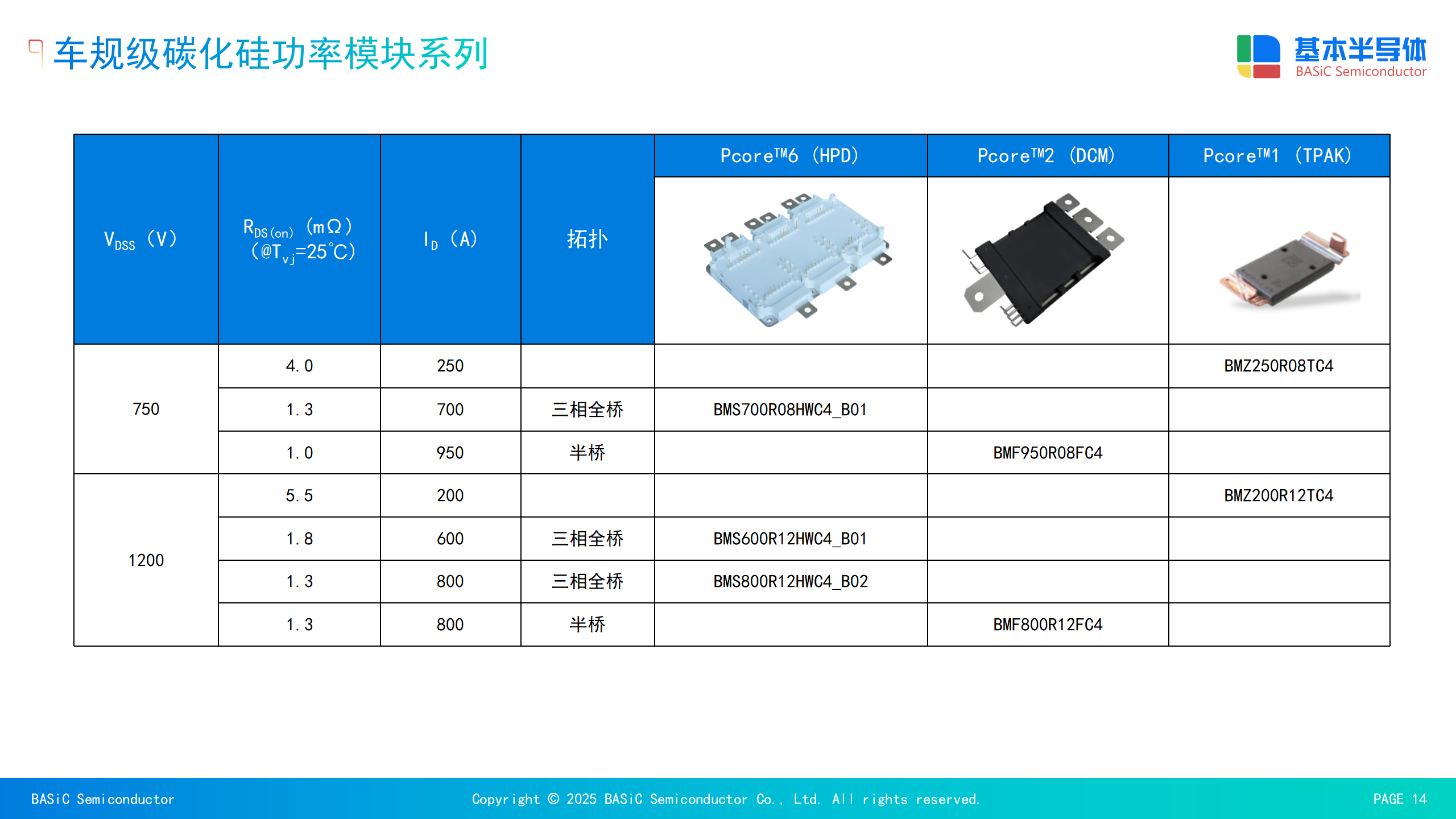




评论