电子发烧友网报道(文/莫婷婷)随着人工智能与可穿戴设备的深度融合,增强现实(AR)智能眼镜正逐步从概念走向大众市场。尽管当前AI眼镜在消费端热度较高,其中AR智能眼镜作为下一代人机交互的核心载体,其技术迭代与产业布局正迎来关键转折点。尤其在中国市场的推动下,AR眼镜已逐渐完善产业链生态,中国企业成为近眼显示技术发展的中流砥柱。
中国主导全球AR眼镜市场,Meta带动LCoS技术份额提升
TrendForce集邦咨询的数据显示,当前AR眼镜的开发和出货主力集中在中国市场,占据全球88%的份额。以影目、Xreal、Rokid等为代表的中国企业,凭借快速的产品迭代能力和成本控制优势,持续推出具备竞争力的AR产品。 
TrendForce集邦咨询资深研究副总经理邱宇彬指出,目前AR眼镜的产品发展路径愈发清晰,产品功能也开始明确、收敛。原先各家厂商入局的搭配OLEDoS显示技术的观影功能,也在逐步形成新的共识:资讯提示类为AR眼镜的最佳战场。因此,新一代AR眼镜的设计标准正在向重量低于60克、FOV控制在30°以内的方向演进。这一转变不仅降低了佩戴负担,对整个产品的设计、各组件的成本都有很大的助益。
在显示技术层面,2025年AR眼镜光引擎市场呈现“三足鼎立”态势:OLEDoS(Micro OLED)显示技术方案大约占据53%的市场份额,依然为市场主流;LCoS 在Meta产品的带动下来到7%,LEDoS(Micro LED)方案凭借室内提示与户外骑行等应用场景的崛起上升至37%。
集邦咨询认为,LEDos凭借其在亮度、对比度方面的先天优势,将在AR终端产品中占据一席之地。而LCoS则凭借成熟的供应链、技术工艺在成本性价比上表现更佳,且在较高APL下,相较于LEDoS具备一定的功耗优势,也因此受到Meta的青睐,其在9月发布的最新AR眼镜 Ray-Ban Display采用的就是“LCoS + 阵列光波导”方案。而Meta的选择也让业内开始重新评估LCoS在AR领域的潜力,预计其带动效应将在2026年推动LCoS市场份额提升至13%。同时邱宇彬也指出,LEDoS发展还很前期,在高APL下,EQE外部量子效率的提升将有非常显著的效果,这也对LEDoS的未来渗透率的提升至关重要。 
全彩化需求驱动Micro LED技术突破:垂直堆叠成关键方向
目前主流的全彩化方案分为两类:三色合光、单片全彩。三色合光技术通过红、绿、蓝三片独立LED面板进行光学合成。该方案成熟度较高,但存在结构复杂、组装精度要求高、成本难以压缩等问题。单片全彩技术将红、绿、蓝三种颜色集成在同一芯片上,避免多片拼接带来的对准误差。
目前,行业的终极目标还是希望可以做到单片全彩化。单片全彩又进一步分为单片全彩和垂直堆叠两个主流的技术路线。 垂直堆叠的核心原理是将红光置于最底层,蓝/绿光位于上方,利用不同波长穿透能力差异实现分层发光。在企业的技术进展方面,JBD、鸿石智能、诺视科技等企业均在此领域取得突破。
例如JBD 完成各阶段 R/G/B LED 晶圆片的电极线路后再透过晶圆片接合技术垂直堆叠而成电极线路皆制作在芯片内层。邱宇彬表示,垂直堆叠技术难度极高,而对位精准度(1um)会是最大的技术挑战。
鸿石智能在2025年发布混合堆叠结构技术,融合两次晶圆键合和一次亮度色转,实现蓝绿外延片的集成和红光的精准呈现,将光效提高60%以上,同时搭配光学微结构,可再提高出光效率20%。新市场开拓副总经理刘怿在演讲中指出,公司在今年上半年已经推出了0.12英寸的320×240分辨率单片全彩的产品。
但是Micro LED作为新技术,也面临多个技术问题亟须解决,邱宇彬指出在材料与晶圆尺寸两大方面存在的问题:
材料层面:传统LED采用蓝宝石衬底,而Micro LED需与硅背板键合。由于两者热膨胀系数差异,在250℃工艺温度下,有可能会产生0.1%的微米级分离,无法满足近眼显示的高精度要求。尺寸层面:主流LED晶圆为4寸为主,慢慢过渡到6寸;而硅基工艺普遍采用8/12寸晶圆,两者之间很难达到百分之百的利用键合率。
为解决传统LED外延片(蓝宝石衬底)与硅基背板之间的热膨胀系数不匹配问题,业界提出了多种键合方案:Die to Die(D2D):小面积键合,可有效缓解CTE失配,但生产效率低;Wafer to Wafer(W2W):整片晶圆键合,效率高,但面临尺寸不匹配挑战;Die to Wafer to Wafer(D2W2W):引入临时衬底,先将LED芯片排列至临时基板,再整体键合至硅基板,兼顾良率与效率,被认为是中长期最优解,但相对来讲,制程的复杂度也进一步提高。
在厂商方案的选择上也有所差异,例如英国Porotech公司投资开发8英寸硅基GaN平台,实现与8英寸CMOS的100%键合利用率;而国内的JBD则通过将12英寸晶圆切割为7块4英寸区域,实现约80%的利用率,具备一定的产业化可行性。目前无论从材料层面还是尺寸匹配度上都有相应的解决方案,只是行业内还未形成共识。 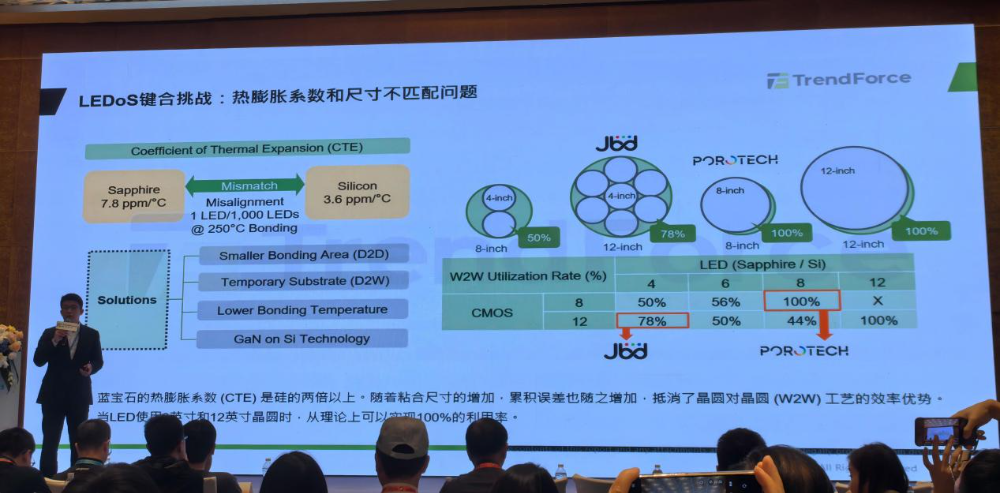
但依旧可以期待的是,随着硅基GaN向8英寸甚至12英寸演进,以及基于硅衬底Micro LED的各种全彩技术发展,Micro LED一定会迎来大规模的产业机遇。 在量产进程上,邱宇彬指出,AR应用作为科技行业产品,面临一个隐形的挑战:目前来说并未形成统一的规格共识,因此在发展过程中,目标持续滚动升级,这使得后进厂商在跟进时会有资源分配的抉择,也会影响第二、第三梯队实际规模化量产的时程,因而或延缓行业的发展节奏。
小结
尽管当前AR眼镜仍处于成长初期,但以中国为核心的产业链正在加速构建。从轻量化设计到全彩化突破,从LEDos的垂直堆叠到LCoS的微型化革新,再到光波导材料的升级换代,每一项技术进步都在为AR眼镜的普及铺平道路。正如邱宇彬所言:“AR眼镜正在从‘我全都要’走向‘精准服务’。”唯有聚焦核心需求,优化用户体验,才能真正实现“人手一副”的愿景。
-
Ar
+关注
关注
25文章
5292浏览量
176686 -
智能眼镜
+关注
关注
8文章
798浏览量
75257
发布评论请先 登录

北方华创发布12英寸芯片对晶圆混合键合设备Qomola HPD30

灵犀微光阵列光波导技术推动消费级AR眼镜普及

CPO量产再加速,高塔半导体推新型CPO代工平台
芯片制造中的键合技术详解




 国产霸屏88%出货!垂直堆叠+晶圆键合技术升级,AR眼镜加速跨越量产鸿沟
国产霸屏88%出货!垂直堆叠+晶圆键合技术升级,AR眼镜加速跨越量产鸿沟



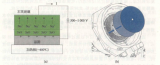






评论