超导薄膜的微观不均匀性(颗粒度)是影响其宏观性能的关键因素。在接近临界温度(T ᶜ)时,传统四探针法常观测到异常电阻峰,这一现象长期被误认为材料本征特性。然而,研究表明,此类异常可能源于超导参数的局部差异(如T ᶜ和ΔT ᶜ的非均匀分布)导致的电流重分布效应。本文通过构建非局域四探针模型,结合实验与磁场调控,系统解析了电阻峰的物理起源,揭示了超导颗粒度的动态响应机制。研究中采用Xfilm埃利四探针方阻仪对NbN薄膜进行全自动多点扫描,其高精度与快速材料表征能力为超导薄膜的精准分析提供了技术支撑。
四探针非局域测量模型
/Xfilm
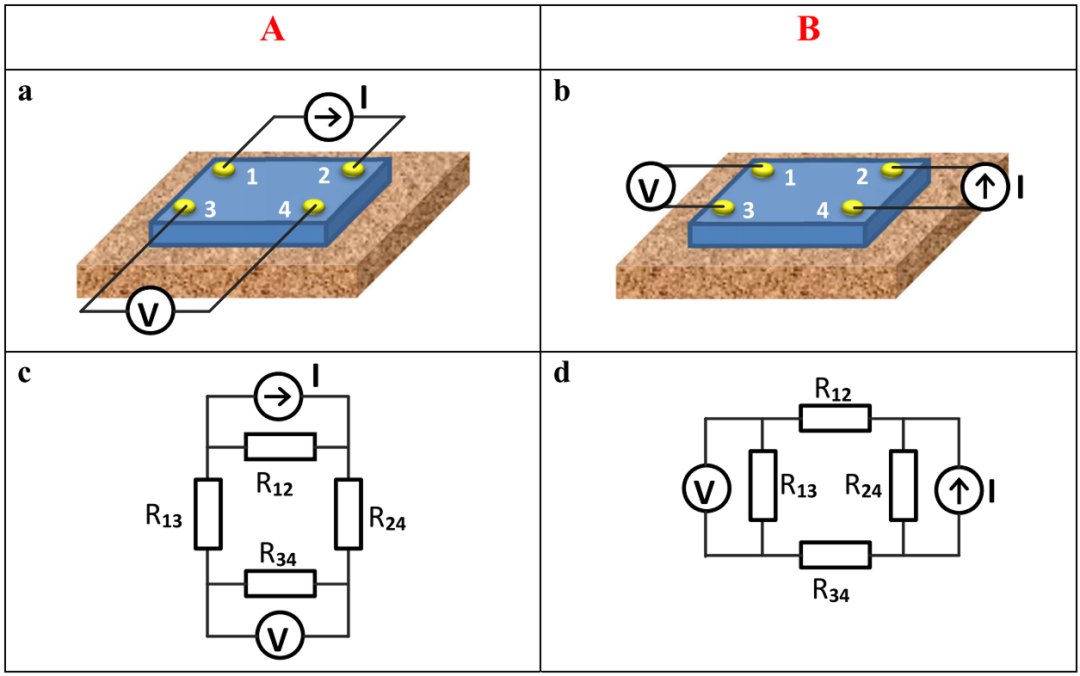
非局域四探针两种接触配置(A和B)及其等效电路
等效电路构建:
- 区域划分:将正方形超导薄膜划分为四个独立电阻区域(编号12、13、24、34),各区域电阻服从温度依赖关系R(T) = R⁺⋅ [1 + tanh((T − T ᶜ)/ΔT ᶜ)]。
- 非局域电阻计算:通过基尔霍夫定律推导配置A(R ᴬ(T))和B(R ᴮ(T))的电阻表达式,揭示电流路径对局部超导参数的敏感性。
模拟结果与机制分析:
- 单区域参数差异:
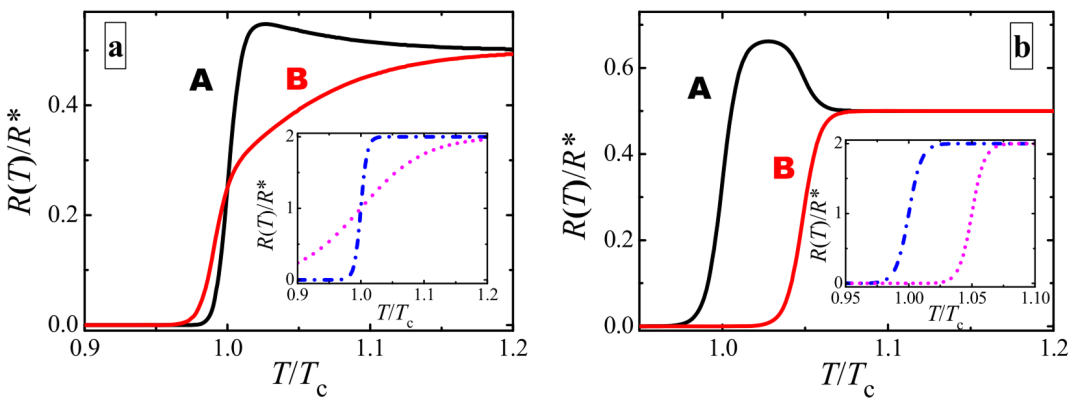 不同场景下计算的电阻-温度特性曲线(A和B配置)当区域24的转变宽度(ΔT ᶜ²⁴ = 0.1T ᶜ)显著大于其他区域时(ΔT ᶜ = 0.01T ᶜ),电流优先流经低阻路径,导致T ᶜ附近出现电阻峰; 若区域24的T ᶜ偏高(T ᶜ²⁴ = 1.05T ᶜ),其提前进入超导态迫使电流绕行,进一步放大电阻峰。
不同场景下计算的电阻-温度特性曲线(A和B配置)当区域24的转变宽度(ΔT ᶜ²⁴ = 0.1T ᶜ)显著大于其他区域时(ΔT ᶜ = 0.01T ᶜ),电流优先流经低阻路径,导致T ᶜ附近出现电阻峰; 若区域24的T ᶜ偏高(T ᶜ²⁴ = 1.05T ᶜ),其提前进入超导态迫使电流绕行,进一步放大电阻峰。
- 多区域协同效应:
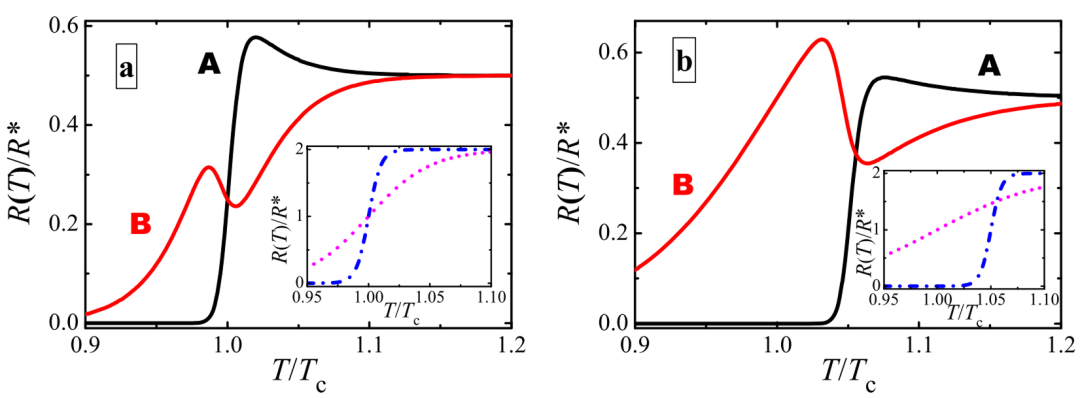 多区域参数差异对电阻-温度曲线的影响多个区域的T ᶜ或ΔT ᶜ差异可导致类“再入超导”行为,突显颗粒度对全局电阻的动态调控能力。
多区域参数差异对电阻-温度曲线的影响多个区域的T ᶜ或ΔT ᶜ差异可导致类“再入超导”行为,突显颗粒度对全局电阻的动态调控能力。 
NbN薄膜的制备与电阻行为验证
/Xfilm
- 样品制备与表征:
工艺细节:采用脉冲激光沉积(PLD)在Al₂O₃衬底上生长50 nm NbN薄膜,缓冲层为50 nm AlN; 测量系统:物理性质测量系统(PPMS)在1.9–300 K范围内获取电阻-温度曲线。
- 实验结果:
 50 nm厚NbN薄膜的实验数据与数值拟合(零磁场)
50 nm厚NbN薄膜的实验数据与数值拟合(零磁场)
- 零磁场下非局域测量:
配置A/B显示显著电阻峰(峰值较正常态高10–20%),而共线配置(电压探针位于电流路径内)无此现象; 参数拟合表明,局部T ᶜ差异(13.6–14.1 K)与ΔT ᶜ波动(0.25–0.35 K)是电阻峰的主因。 
磁场效应:颗粒度的抑制与调控
/Xfilm
- 垂直磁场(B ⊥ = 6 T)的作用:
 垂直磁场(B ⊥ = 6 T)下的实验数据与拟合现象:所有区域T ᶜ趋同(11.5 K),电阻峰消失,曲线趋于平滑; 机制:磁场诱导涡旋穿透,破坏大尺度超导畴,抑制颗粒度,实现全局均匀化。
垂直磁场(B ⊥ = 6 T)下的实验数据与拟合现象:所有区域T ᶜ趋同(11.5 K),电阻峰消失,曲线趋于平滑; 机制:磁场诱导涡旋穿透,破坏大尺度超导畴,抑制颗粒度,实现全局均匀化。
- 平行磁场(B ∥ = 6 T)的响应:
 平行磁场(B ∥ = 6 T)下的实验数据与拟合现象:局部T ᶜ差异保留(11.5–11.8 K),电阻峰重现; 机制:平行磁场主要影响自旋自由度(Zeeman效应),对轨道耦合作用微弱,颗粒度未被完全消除。 非局域四探针法通过电流路径敏感性,可高效探测超导薄膜的颗粒度,异常电阻峰本质为电流重分布的假象;垂直磁场通过涡旋穿透抑制颗粒度,平行磁场则保留局部不均匀性,二者共同揭示超导畴的动态竞争机制;
平行磁场(B ∥ = 6 T)下的实验数据与拟合现象:局部T ᶜ差异保留(11.5–11.8 K),电阻峰重现; 机制:平行磁场主要影响自旋自由度(Zeeman效应),对轨道耦合作用微弱,颗粒度未被完全消除。 非局域四探针法通过电流路径敏感性,可高效探测超导薄膜的颗粒度,异常电阻峰本质为电流重分布的假象;垂直磁场通过涡旋穿透抑制颗粒度,平行磁场则保留局部不均匀性,二者共同揭示超导畴的动态竞争机制; 
Xfilm埃利四探针方阻仪
/Xfilm

Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电阻率,可以对最大230mm 样品进行快速、自动的扫描, 获得样品不同位置的方阻/电阻率分布信息。
- 超高测量范围,测量1mΩ~100MΩ
- 高精密测量,动态重复性可达0.2%
- 全自动多点扫描,多种预设方案亦可自定义调节
- 快速材料表征,可自动执行校正因子计算
Xfilm埃利四探针方阻仪凭借其全自动扫描与高动态重复性,在超导薄膜的电阻分布表征中展现出显著优势。本研究通过非局域四探针法揭示了超导颗粒度对电阻峰的调控机制,并验证了磁场对超导畴结构的动态影响。
原文参考:《Probing superconducting granularity using nonlocal four-probe measurements》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
薄膜
+关注
关注
1文章
372浏览量
46258 -
测量
+关注
关注
10文章
5709浏览量
116962 -
电阻特性
+关注
关注
0文章
4浏览量
7445
发布评论请先 登录
吉时利四探针法测试系统实现材料电阻率的测量

高温电阻测试仪的四探针法中,探针的间距对测量结果是否有影响

四探针法丨导电薄膜薄层电阻的精确测量、性能验证与创新应用

四探针法 | 测量射频(RF)技术制备的SnO2:F薄膜的表面电阻

非接触式发射极片电阻测量:与四探针法的对比验证

四探针法校正因子的全面综述:基于实验与数值模拟的电阻率测量误差修正

四探针法测电阻的原理与常见问题解答

源表应用拓展:四探针法测电阻率




 非局域四探针法:超导薄膜颗粒度对电阻特性的影响机制解析
非局域四探针法:超导薄膜颗粒度对电阻特性的影响机制解析


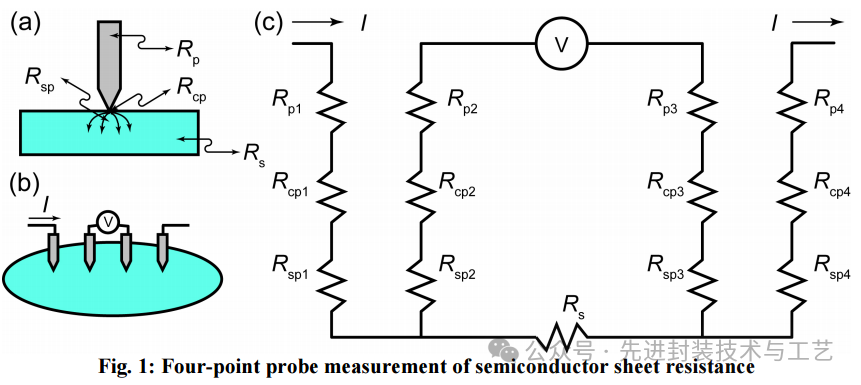



评论