以下完整内容发表在「SysPro电力电子技术」知识星球-《功率芯片嵌入式封装:从实验室到量产的全链路解析》三部曲- 文字原创,素材来源:TMC现场记录、西安交大、网络、半导体厂商
- 本篇为节选,完整内容会在知识星球发布,欢迎学习、交流
- 1400+最新全球汽车动力系统相关的报告与解析已上传知识星球
导语:在电动汽车与新能源技术迅猛发展的当下,芯片内嵌式PCB逆变器技术凭借其创新性与颠覆性,成为2025年汽车半导体领域的焦点。从Schweizer Electronic AG的p²Pack到保时捷&博世Dauerpower逆变器,从采埃孚的CIPB方案到麦格纳嵌入式功率模块,从舍弗勒的高压嵌入式功率模组到威睿新一代内埋式封装CEPU,一系列创新成果标志着车规级功率模块封装技术迈向新高度。作为电力电子系统的心脏,功率器件的性能直接决定了整个系统的能效与可靠性。传统封装方式在面对宽禁带半导体(如SiC、GaN)时,暴露出散热困难、寄生参数过大、集成度受限等瓶颈。芯片内嵌技术通过将功率芯片直接嵌入PCB基板内部,实现了电气连接、散热路径和机械结构的全面优化,为电动汽车、新能源、工业自动化等领域带来了显著的性能提升。
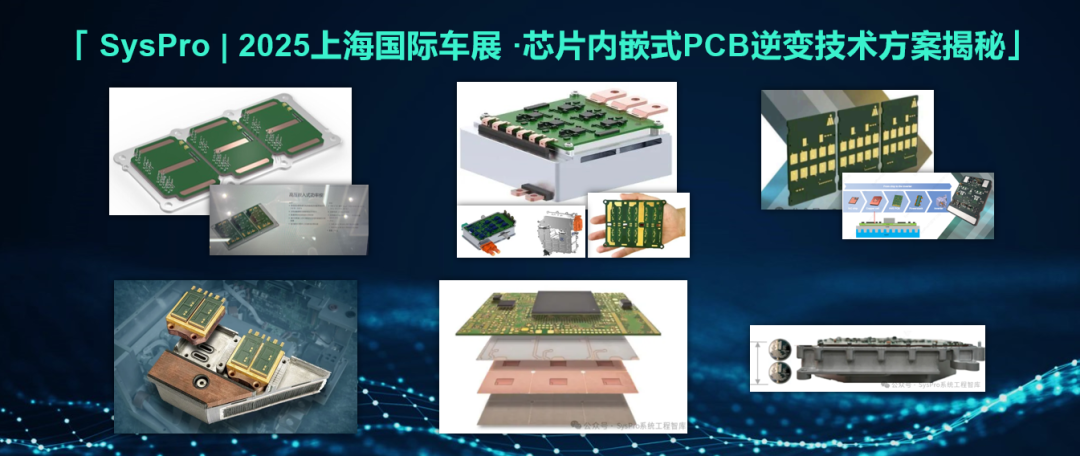
图片来源:上海车展,SysPro拍摄
关于这一技术路线,我们已做过系统性的解读:芯片内嵌式PCB封装技术全面解析的"七部曲"。今年6月初,有幸参加了TMC2025,并聆听了包括来自西安交通大学电气工程学院的杨旭教授等诸多行业专家、学者关于功率芯片嵌入式封装技术相关的主题报告,帮助我搞明白了这一技术方向的来龙去脉。本文,在基于前人研究的基础上,结合实践和市场上的产品技术方案,对芯片内嵌式PCB封装技术进行了系统性解析,构建《功率芯片PCB内埋式封装:从概念到量产的全链路解析》三部曲系列文章:
上篇,聚焦宽禁带器件发展与封装瓶颈,梳理电力电子器件发展脉络,揭示传统封装在电性能、散热与可靠性方面的挑战,并分析电-热-应力耦合问题,明确高性能封装需围绕电、热、力学三大核心问题展开。
中篇,深入探讨芯片内嵌PCB封装的多维度协同创新,从空间维度(结构设计优化)、材料维度(基材性能突破)及可靠性维度(长期稳定性评估)三个方向,提出结构创新、材料改进与可靠性评估等综合解决方案,攻克PCB封装散热差、热应力大、绝缘可靠性低等短板。
下篇,聚焦工艺实践,解析芯片内嵌PCB封装全流程,并深度解析镀铜芯片、Cell单元集成、PCB嵌入等关键工艺步骤,通过具体案例揭示理论方案如何转化为实际产品,并探讨其在电力电子系统中的创新应用与未来拓展方向。
本文旨在为工程实践与技术产品落地提供系统性指导,助力行业突破封装瓶颈,充分释放宽禁带器件潜力。
目录
上篇:宽禁带器件发展与封装瓶颈
1. 电力电子器件发展历程与封装重要性
1.1 电力电子器件发展脉络
1.2 封装对器件性能的关键影响
2. 传统封装与宽禁带器件封装的挑战
3. 封装问题的综合分析与解决方案(知识星球发布)
3.1 封装涉及的主要问题
3.2 实现高性能、高密度封装的解决思路
4. 现有器件封装的维度划分与分析(知识星球发布)
4.1 封装的三个维度划分
4.2 PCB封装概念的出现
5. PCB作为封装的优劣势分析(知识星球发布)
5.1 PCB封装的优势
5.2 PCB封装存在的"短板"
中篇:芯片内嵌PCB封装的多维度协同创新-互联、散热、基材、绝缘可靠性
6. PCB封装问题的综合解决思路与维度划分
6.1 综合解决思路
6.2 三个维度的解释
07 空间维度:结构创新与电路布局布线优化(知识星球发布)
7.1 结构创新
7.2 电路布局布线优化
8. 材料维度:PCB材料改进研究(知识星球发布)
8.1 材料改进的方向与目标
8.2 具体改进措施
8.3 性能优化验证结果:5大维度
9. 芯片内嵌PCB封装的绝缘问题解析(知识星球发布)
9.1 绝缘问题的分析方法和思路
9.2 绝缘失效背后的秘密:电树枝+铜须
9.3 电树枝生长的影响因素
9.4 直流电场下铜须生长的秘密
9.5 小结:芯片内嵌PCB封装绝缘失效的"因果链"
下篇:芯片内嵌 PCB 封装-主流工艺实践的深度解析
10 芯片内嵌PCB封装工艺方法指南
10.1 GaN期间的PCB内埋封装
10.2 芯片内嵌PCB封装工艺的全流程解析
10.3 Step2 - 镀铜芯片 · 工艺制程解析(知识星球发布)
10.4 Step3 - Cell 单元 · 工艺制程解析(知识星球发布)
10.5 Step4 - PCB 嵌入 · 工艺制程解析(知识星球发布)
10.6 小结
11 总结
|SysPro备注:本文为概述,更多记录与解读请在知识星球中查阅
上篇:宽禁带器件发展与封装瓶颈
01
电力电子器件发展历程与封装重要性
1.1 电力电子器件发展脉络
电力电子技术的发展史,本质上是器件技术的迭代史。1956年晶闸管的发明开启了电力电子时代,其后的功率MOSFET和IGBT进一步推动了技术进步。2010年后,氮化镓(GaN)和碳化硅(SiC)等宽禁带器件的实用化,标志着第三次技术革命的到来。
以晶闸管为例,从发明到应用于直流输电耗时16年;IGBT从发明到商业化应用用了15年。而SiC器件自2011年商业化以来,14年过去了,其推广速度仍未达预期,这其中封装技术是重要瓶颈。

图片来源:西安交大
1.2 封装对器件性能的关键影响
半导体器件的性能由芯片和封装共同决定。芯片决定电磁场、热场和载流子分布,而封装直接影响:
可用电流和功率容量:封装结构决定器件的电流承载能力
电压频率特性:寄生参数影响高频性能
开关损耗:封装电阻和电感导致额外能量损耗
传统半导体封装主要考虑成本、性能和功率密度三个方面。在大多数情况下,我们为了降低成本,封装设计以成本优化为主,只有少部分会进行性能优化和功率密度优化。然而,高性能封装往往需要付出更高的成本代价。这种传统的封装方式在面对宽禁带器件时,逐渐暴露出诸多问题。那么,究竟有哪些挑战呢?
02
宽禁带器件封装的挑战
宽禁带器件对封装的挑战主要在三方面:
电性能方面:宽禁带器件,如SiC器件和GaN器件,开关速度比常规硅器件快10倍以上。若沿用传统的硅器件TO塑封,不进行优化,杂散电感过大,会产生很高的电压尖峰和寄生振荡,导致器件击穿、误触发等问题,无法充分发挥宽禁带器件的优势导致器件无法发挥其优势,甚至可能因过电压而烧毁。以常见的硅器件 TO 塑封为例,其杂散电感在某些情况下甚至会使芯片的实际工作性能降低 30% - 40%。
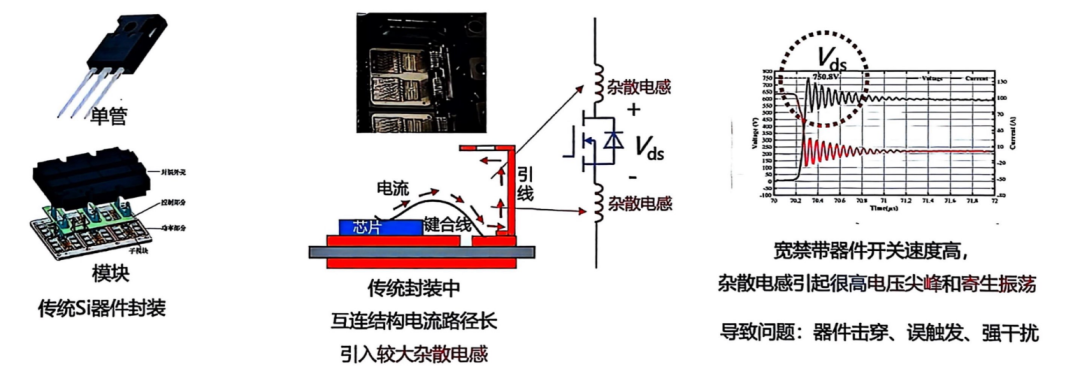
图片来源:西安交大
散热方面:宽禁带器件芯片面积比Si器件小很多,碳化硅器件芯片面积更是比硅器件小3 - 5倍以上。在发热相近的情况下,热流密度会提高5 - 10倍,导致结温显著升高。虽然SiC允许较高的结温,但封装材料的限制使得器件难以达到如此高的温度,传统散热方式无法有效控制结温。
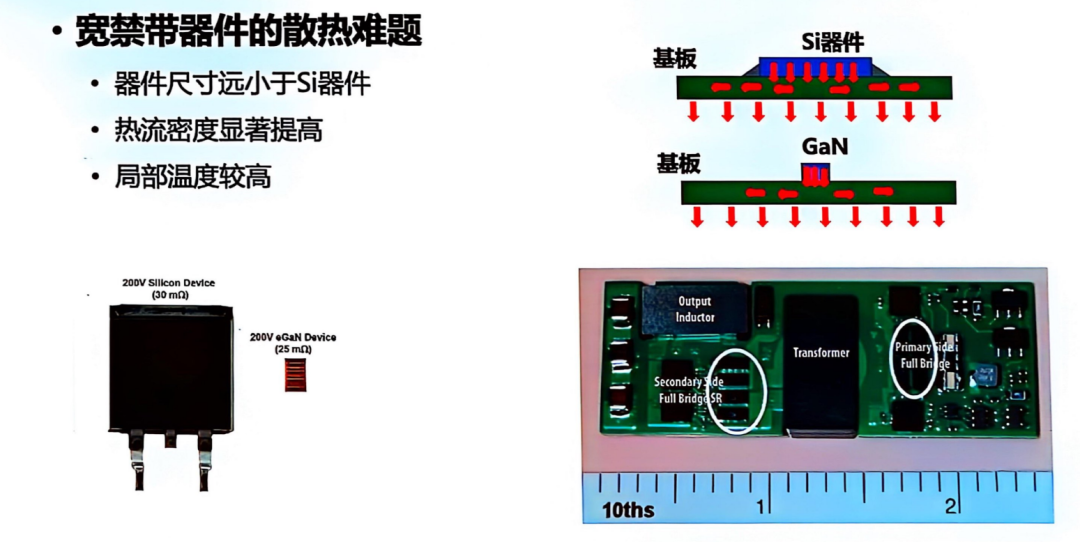
图片来源:西安交大
可靠性方面:芯片尺寸小、温度高会导致工作时的温循较高;同时,由于芯片与封装材料之间的热膨胀系数不匹配,在温度循环变化的过程中,会产生较大的热应力,从而导致焊点开裂、键合线脱落等问题。据统计,在功率设备的故障中,约有 30% - 40% 是由封装的可靠性问题引起的。

图片来源:西安交大
耦合问题:最关键的是,上面所述这三大问题不是孤立的,而是相互 “纠缠”:
热 - 电耦合:散热差→温度高→电性能(如电阻、载流子迁移率)变,电性能恶化又可能让损耗、发热更严重,恶性循环。
热 - 应力耦合:温度变化→热应力→封装结构变形、开裂,反过来影响散热、电连接,可靠性暴跌。
电场 - 绝缘耦合、电流 - 应力耦合:电场分布影响绝缘,电流产生的电磁力、焦耳热带来应力,和电性能、散热、可靠性问题交叉影响,复杂度直接拉满。

图片来源:西安交大
因此,封装成为制约宽禁带器件发展的重要瓶颈,好器件需要好封装来匹配。为了最大程度的发挥出宽禁带器件优势,我们需要搞明白电、热、可靠性层面的问题,以及它们的 “联动搞事” 背后逻辑。那么,针对上述的挑战,需要怎样的分析方法,又有哪些有效的解决方案呢?我们接着聊。
03
封装问题的综合分析与解决方案
3.1 封装涉及的主要问题
从上面解读可知:封装主要涉及电性能、散热和可靠性三个方面的问题:
电性能问题:要求器件工作可靠,减少杂散电感等参数对性能的影响
散热问题:需要有效将热量散出,控制结温
可靠性问题:则要减少应力,提高器件的使用寿命。
因此,先进封装技术,要仅仅围绕此三者开展。下面讲讲具体可以有哪些可选手段。
3.2 实现高性能、高密度封装的解决思路
搞清楚了问题来源,下面解决问题。
这背后的核心逻辑是:我们需要找到一种封装,攻克电、热、力学层面的挑战,充分发挥宽禁带器件优势。为了实现高性能、高密度的封装。
因此,我们需要分电性能、热性能、力学性能三条主线展开。
3.2.1 电性能维度(知识星球发布)...3.2.2 热性能维度(知识星球发布)...3.2.3 力学性能维度(知识星球发布)...
再升华一个层次,其实上述所有问题最终真正的落脚点无非三处:基板、互联、密封。具体怎么做呢?我们接着往下看。
04
现有器件封装的维度划分与分析
4.1 封装的三个维度解析(知识星球发布)...
4.2 芯片内嵌PCB封装的诞生(知识星球发布)...
05
PCB作为封装的优劣势分析
5.1 PCB封装的优势(知识星球发布)...
5.2 PCB封装存在的"三点短板"(知识星球发布)...
那么,针对上述PCB封装存在的先天问题,如何解决呢?我们在中篇继续展开。
中篇
芯片内嵌PCB封装的多维度协同创新:互联、散热、基材、绝缘可靠性
06
PCB封装问题的综合解决思路与维度划分
6.1综合解决思路
针对PCB作为封装存在的问题,需要从互连、散热、应力、绝缘等方面进行综合解决。进一步分析可归纳为物理空间设计、材料本质特性、长期可靠性三维度个方向。
6.2 三个维度的解释
1. 空间维度 → 聚焦 “结构设计”
针对的问题:互连、散热(前文中的 PCB 封装 “散热差”“热应力”,本质和空间结构设计有关)。
解决的思路:电热耦合空间结构优化
|SysPro解释:宽禁带器件工作时,电、热特性相互影响(电热耦合),需要通过空间结构设计(比如布线布局、散热通道、芯片与基板的堆叠方式),让电性能(低寄生、高传输)和热管理(高效散热)协同优化,解决 “想密集布线提升性能,但容易热量堆积” 的矛盾。
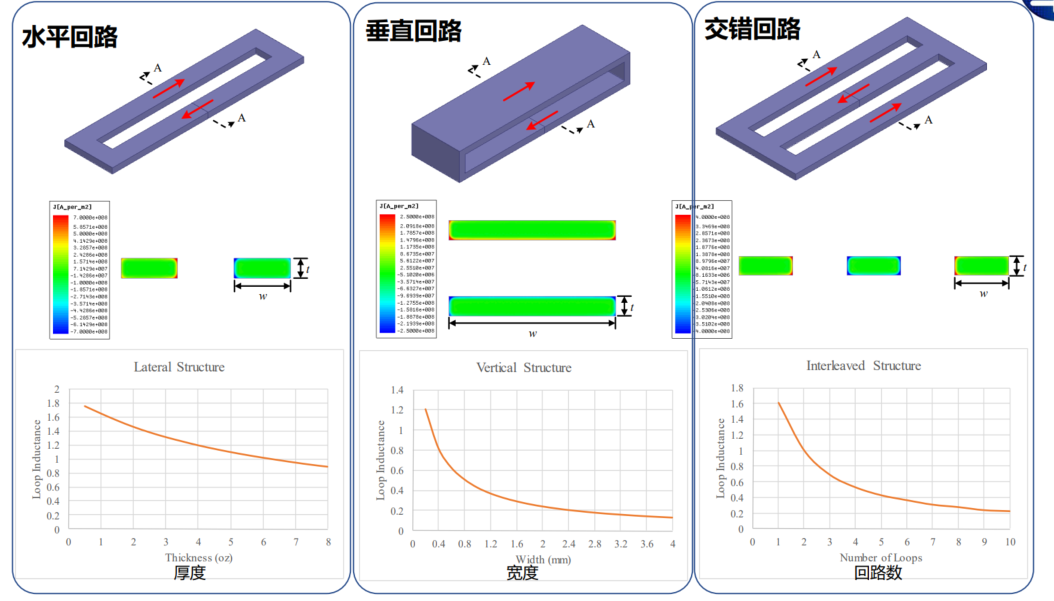
图片来源:西安交大
2. 材料维度 → 聚焦 “基材突破”
针对的问题:应力、绝缘(前文中的 “热应力大”“绝缘可靠性差”,和 FR-4 基材的性能缺陷直接相关)。
解决的思路:电热力高性能 PCB 材料制备
|SysPro解释:传统 FR-4 材料在 “电(绝缘、寄生参数)、热(导热、膨胀系数)、力(机械强度、应力匹配)” 方面无法满足宽禁带器件需求,必须开发高性能 PCB 材料—— 比如更高导热、低膨胀系数、高绝缘强度的基材,同时兼顾电、热、力性能,从 “材料根上” 解决问题。
图片来源:西安交大
3. 可靠性维度 → 聚焦 “长期稳定”
针对的问题:应力、绝缘(前文中的热应力导致开裂、绝缘老化失效,都是 “可靠性” 范畴)。
解决的思路:应力 - 绝缘可靠性评估
|SysPro解释:宽禁带器件工作时,应力(热应力、机械应力)和绝缘性能相互影响(比如应力集中会加速绝缘老化),需要建立可靠性评估体系—— 模拟实际工况(温度循环、电压冲击等),量化分析“应力如何影响绝缘寿命”,通过模拟电场施加,观察电损伤、电树枝生长、电迁移等现象,提前发现潜在失效风险,保障长期稳定运行。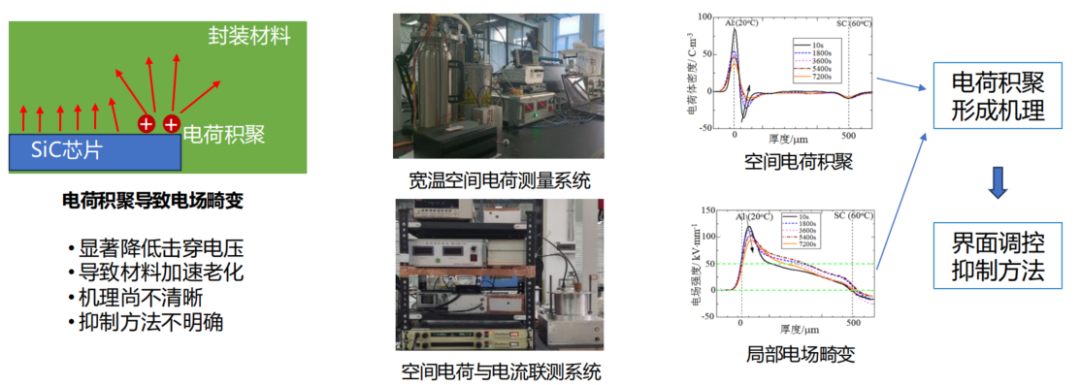
图片来源:西安交大
| SysPro备注:此处先做概述,在后续章节中会展开讲讲,说明背后的机理和解决方法。
07
空间维度:结构创新与电路布局布线优化
7.1 结构创新(知识星球发布)
针对宽禁带器件(如 SiC、GaN)对"低杂散电感、高性能散热"的需求,从互连设计、散热设计两方面,来看看如何通过结构创新解决问题?主要有两个方面。
7.1.1 低杂散电感、高密度互连的实现...
7.1.2 高性能散热的实现...
7.2 电路布局布线优化(知识星球发布)...
08
材料维度:PCB材料改进研究
8.1 材料改进的方向与目标(知识星球发布)...
8.2 具体改进手段(知识星球发布)...
那么,这一解决方案效果如何呢?我们从导热、膨胀、机械、介电、绝缘五大维度来看下测试结果。
8.3 性能优化验证结果:5大维度(知识星球发布)
8.3.1 导热性能...
8.3.2 膨胀系数...
8.2.3. 机械强度...
8.2.4 介电性能...
8.2.5 绝缘性能...
09
芯片内嵌PCB封装的绝缘问题解析
9.1 绝缘问题的分析方法和思路
在可靠性维度下,绝缘问题是重点关注的内容,下面我们聚焦 “PCB 封装的绝缘问题”,研究电热耦合场下PCB封装材料绝缘损伤失效机理和影响。
长期以来,人们普遍认为只有电压高时才会出现绝缘问题,但实际上,在PCB中,即使电压不是特别高,由于芯片表面边角等因素导致的电场集中,也会引发绝缘失效。特别是在电力电子应用环境下,高温、非正弦波、快速变化的方波等因素会对绝缘材料造成恶劣影响。
所以,想要完整还原 PCB 绝缘失效的 “因 - 果” 过程,采用以下逻辑开展这个工作:模拟真实放电试样 → 施加多场耦合应力 → 观测绝缘损伤(电树枝、放电数据)。下面我们具体来看看。

图片来源:西安交大
9.2 绝缘失效背后的秘密:电树枝+铜须(知识星球发布)...
9.3电树枝生长的影响因素(知识星球发布)...9.4 直流电场下铜须生长的秘密(知识星球发布)...9.5小结:芯片内嵌PCB封装绝缘失效的"因果链"(知识星球发布)...
下篇芯片内嵌 PCB 封装-主流工艺实践的深度解析
导语:在上篇中,我们了解了为什么封装是制约宽禁带器件发展的重要瓶颈?明确了好器件需要好封装来匹配。为了最大程度的发挥出宽禁带器件优势,我们需要搞明白电、热、可靠性层面的问题,以及它们的“联动搞事” 背后逻辑。
在中篇中,我们深入探讨了宽禁带器件封装所面临的电性能、散热及可靠性等多维度挑战,并从空间维度(结构设计优化)、材料维度(基材性能突破)及可靠性维度(长期稳定性评估)三个方向,系统阐述了PCB封装技术的创新路径与解决方案。
然而,技术突破不仅需理论支撑,更需实践验证。下篇,将聚焦芯片内嵌PCB封装的主流工艺实践,从内埋GaN器件的PCB封装结构解析,到全流程工艺制程的深度拆解,再到关键工艺步骤(如镀铜芯片、Cell单元集成、PCB嵌入等)的详细说明,我们将通过具体工艺案例,揭示如何将理论方案转化为实际产品,并探讨该技术在电力电子系统中的创新应用与未来拓展方向。
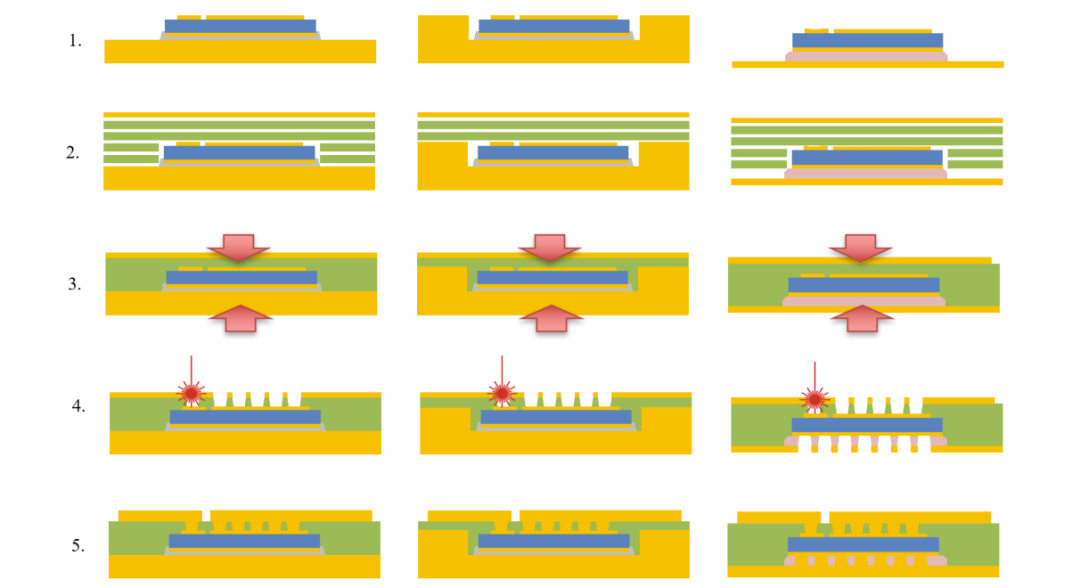
图片来源:ASK
10
芯片内嵌PCB封装工艺方法指南
10.1 内嵌GaN器件的PCB内埋式封装结构说明
最后,我们聊一聊这一技术方案的工艺制程。
芯片内嵌PCB封装的核心目标是通过将芯片(如SiC、GaN等功率半导体芯片)嵌入PCB内部,实现高集成度、高性能的封装解决方案。正如我们上面所述,整个制程包含互连设计、结构优化、层压工艺,只有掌握这些,才能为后续实践打下基础。
我们借助下图,一起先来看看PCB内埋式封装的基本结构。
下图所示为芯片内嵌式PCB技术的概念图 (Power Chip Embedding)。整体结构分为顶部连接(top connections)、隔离层(isolation)和底部连接(bottom connections),通过特殊的制程工艺,将功率芯片直接嵌入到PCB板间,实现器件与PCB的一体化。
简单些理解,就是将传统的三维结构功率半导体模块转化为平面化配置的形式,用镀铜连接(Plated Cu Connections)替代了传统的键合线工艺(Bonding Wires)。
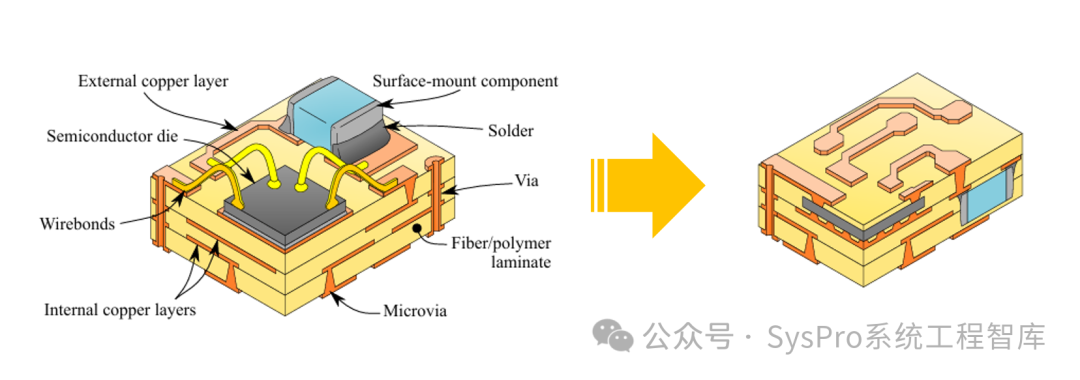
图片来源:HAL
了解了PCB内埋式封装的基本结构后,那么内埋PCB封装工艺的全流程是什么样子呢?我们接着往下看。
10.2 芯片内嵌PCB封装工艺的全流程解析
(知识星球发布)
下图芯片内嵌PCB封装工艺的全流程。概述下来一共6个关键环节:...
下面我们对其中的最为关键的几个环节进行展开,说明其中的细分工艺制程方法,关键!
10.3Step2 - 镀铜芯片 · 工艺制程解析
(知识星球发布)
镀铜芯片,指对晶圆进行镀铜处理,目的是优化芯片的电气连接和散热性能。这一步至关重要,它直接关系到芯片与PCB之间互连的可靠性和性能。特别是在功率半导体应用中,高质量的镀层能够满足高频、高功率的需求。整个工艺流程包含十个关键环节,每一步都紧密相连,共同构建起高质量的铜电镀层...
10.4Step3 -Cell 单元· 工艺制程解析
(知识星球发布)
下面我们接着看看另一个关键工艺:PCB封装Cell单元的工艺,这一步用于将芯片与DTS层集成,形成可用于PCB封装的功能单元。整个过程包含6个关键步骤...
10.5Step4 - 芯片PCB嵌入· 工艺制程解析
(知识星球发布)
下面我们聊聊整个工艺制程中最为重要的一部:芯片的PCB嵌入...
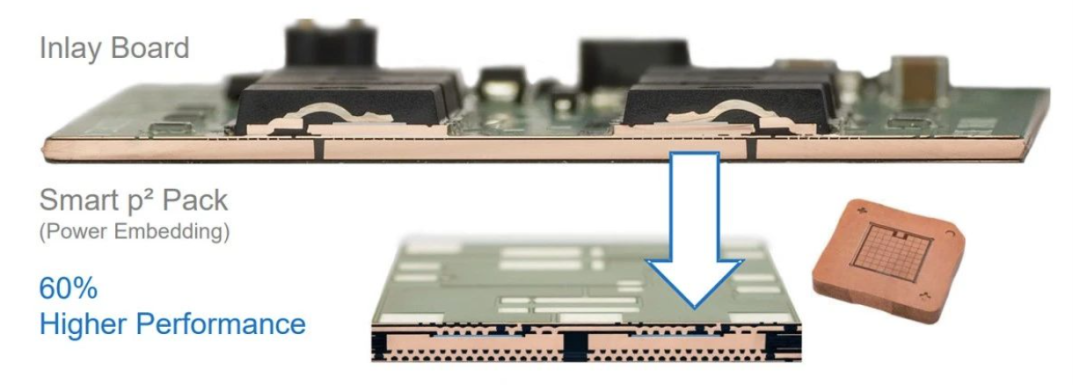
图片来源:Schweizer
11
内埋式PCB封装工艺的拓展和创新应用
(知识星球发布)
...
12 总结
到此,关于功率芯片PCB内埋式封装 · 从概念到量产的全链路解析就基本结束了,内容比较多,我们再将上、中、下三篇串起来,进行总结。
在上篇中,我们了解了电力电子器件的发展历程中,封装技术的重要性日益凸显。宽禁带器件的开关速度快、功率密度高,对封装技术提出了更高要求,尤其在电性能、散热和可靠性方面。
传统封装技术在面对宽禁带器件时暴露出诸多问题,如杂散电感过大、散热困难、热应力导致的可靠性下降等。这些问题相互耦合,形成复杂的技术挑战。因此,先进封装技术需围绕电性能、散热和可靠性三个核心问题展开。
【上篇 · 链接】功率芯片PCB内埋式封装:从概念到量产的全链路解析

图片来源:西安交大
在中篇中,针对这些挑战,提出了多种解决方案。
在电性能方面,通过高密度多层布线和低寄生电感设计来提升性能;在散热方面,选用高热导率基板和优化散热结构来强化热管理;在可靠性方面,通过减小热应力、优化材料匹配来提高器件寿命。

图片来源:西安交大
PCB封装作为一种有潜力的解决方案,通过高密度互连、集成化设计和成熟工艺,实现了低成本、高性能的封装目标。然而,PCB封装也面临散热差、热应力大和绝缘可靠性等问题。针对这些问题,我们从空间维度、材料维度和可靠性维度出发,探讨了了结构创新、材料改进和可靠性评估等综合解决方案。
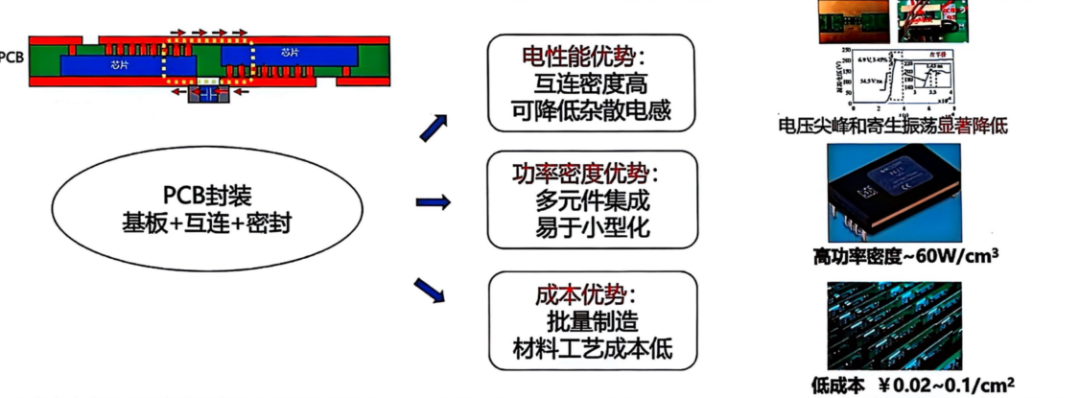
图片来源:西安交大
从电、热、力学维度出发,通过高密度布线降电感、高热导基板强化散热、匹配热膨胀系数减应力;还创新 PCB 封装,利用其高密度互连、集成化优势适配宽禁带特性,同时攻克其散热、应力、绝缘短板。
【中篇 · 链接】功率芯片PCB内埋式封装:从概念到量产的全链路解析(中篇)
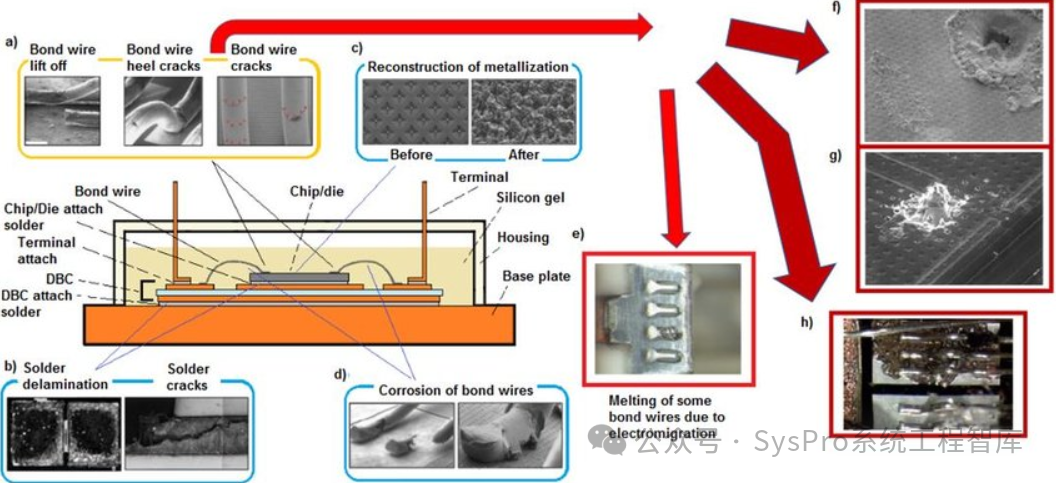
图片来源:网络
最后,在下篇中,我们学习、深度解读芯片内嵌PCB封装工艺的全流程,一共6大关键环节。我们了解了其核心是通过镀铜芯片、Cell单元集成、PCB嵌入等关键工艺步骤,实现了功率半导体芯片与PCB的高质量集成,在此基础上对上述三大工艺制程的细分步骤进行了详细说明。
以上功率芯片PCB内埋式封装从概念到量产的全链路解析。感谢你的阅读,希望有所帮助!
以上《功率芯片PCB内埋式封装:从概念到量产的全链路解析》的全集汇总(节选),完整内容、相关产品技术方案资料、深度解读、视频解析已在在知识星球「SysPro电力电子技术EE」中发布,全文18500字+,欢迎进一步查阅、学习,希望有所帮助!
-
pcb
+关注
关注
4425文章
24037浏览量
427476 -
功率芯片
+关注
关注
0文章
122浏览量
16087
发布评论请先 登录
Type-C浪潮席卷小家电:SINK芯片如何成为快充高压的"心脏"

AR-1106 技术深探:打破声源定位 &quot;不可能三角&quot; 的工程化创新 摘要
从&amp;quot;端子排丛林&amp;quot;到&amp;quot;总线拓扑&amp;quot;:海纳A8/H8互联式温控器的嵌入式系统剖析
从&amp;quot;替代人力&amp;quot;到&amp;quot;智能协同&amp;quot;:履带式巡检机器人的产业跃迁
选EtherCAT模块,别只看价格,先看&amp;quot;体检报告&amp;quot;

机械臂越复杂越&amp;quot;卡顿&amp;quot;?别让控制器拖了后腿

L3试点落地,和芯星通如何成为车企突围的&amp;quot;隐形守护者&amp;quot;?

地热发电环网柜局放监测设备:清洁能源电网的&amp;quot;安全卫士&amp;quot;

为什么GNSS/INS组合被誉为导航界的&amp;quot;黄金搭档&amp;quot;?

芯片内嵌式PCB封装技术方案解析&amp;quot;七部曲&amp;quot; | 第二曲:市场主流玩家与技术方案解读




 功率芯片PCB内埋式封装技术 · 从概念到量产的全链路解析"三部曲"(汇总篇)
功率芯片PCB内埋式封装技术 · 从概念到量产的全链路解析"三部曲"(汇总篇)





评论