作为焊料厂家,我们常说“封装技术的升级,本质是凸点的升级”。从早期的插装芯片到如今的3D堆叠,凸点制作始终是连接芯片与外部世界的核心环节。今天就从焊料厂家工程师的视角,简单回顾封装的发展,聊聊凸点制作的“进化史”,以及作为焊料的锡膏如何一路适配这些变化。
一、凸点制作在封装流程中的“定位”:始终是“互连桥梁”
无论哪种封装形式,凸点制作都处于芯片与基板/载板互连的前端环节,相当于给芯片“装插头”。
具体来说:在晶圆级封装中,它是切割前的最后一步——在晶圆上做好凸点,再切割成单颗芯片。在传统封装中,凸点紧随芯片切割之后,是芯片贴装到基板前的关键工序。简单说,没有凸点,芯片就是“孤岛”,无法与外界传输信号。
二、封装形式升级倒逼凸点“迭代”:从“粗放”到“精密”
1. 插装时代(DIP/SOP):凸点只是“配角”
封装特点:芯片通过长引脚插入 PCB 孔中,引脚间距≥2.54mm,对互连精度要求低
凸点角色:此时还没有“独立凸点” 概念,仅在引线键合处形成微小焊点,相当于“临时固定点”。
材料应用:以锡铅合金为主(熔点 183℃),成本低、润湿性好。
工艺:手工蘸取焊锡膏点涂,再经简易加热固化,焊点直径≥500μm,几乎无精度要求。
锡膏状态:颗粒度 T3 级(25-45μm),助焊剂含量高,能容忍焊盘氧化。
2. 面阵封装时代(BGA/CSP):凸点成为“主角”
封装特点:I/O 引脚从边缘扩展到整个芯片表面,间距缩小至0.8-1.2mm,需要密集的 “点接触”。
凸点角色:替代长引脚成为主要互连结构,直接决定封装尺寸和信号传输效率。
材料变化:无铅化推动锡基焊料主流化,SAC305成为首选,熔点217℃,满足RoHS要求;部分高端场景开始试用铜柱凸点(导电性提升5倍)。
工艺升级:电镀工艺普及,能做出高度一致的凸点(偏差≤5μm);印刷——回流工艺也开始应用,通过钢网将锡膏印在焊盘上,回流后形成凸点。
锡膏进化:颗粒度提升至T5级(15-25μm),触变性优化,能在0.8mm间距下避免桥连。
3. 晶圆级封装(WLP):凸点进入“微米级战场”
封装特点:封装尺寸接近芯片尺寸,I/O间距缩小至0.3-0.5mm,要求凸点“微型化 + 高密度”。
凸点角色:不仅是互连点,还要承担信号重分布功能(配合RDL)。
材料突破:铜柱 + 锡帽结构成为主流 —— 铜柱提供机械支撑,锡帽负责焊接,兼顾导电性与可靠性;低温锡膏(Sn58Bi,138℃熔点)开始用于多层堆叠,避免高温损伤下层芯片。
工艺革新:电镀精度提升至±2μm,能做出直径20-50μm的凸点;印刷——回流工艺改用电铸钢网,锡膏脱模更彻底。
锡膏适配:颗粒度达T8/T9级(2-5μm),满足0.3mm以下间距印刷,助焊剂改为低挥发配方,减少回流气泡。
4. Chiplet 与 3D IC 时代:凸点进入 “纳米级对决”
封装特点:多芯片堆叠,垂直互连间距≤50μm,需要 “超小 + 超可靠” 的凸点。
凸点角色:是芯片间直接通信的 “高速通道”,延迟要求≤10ps。
材料革命:金属间化合物(如 Cu₃Sn、Ag₃Sn)崛起,通过固态焊接形成,熔点>600℃,抗疲劳性是锡基的3倍;铜柱直径缩小至10-30μm,表面镀镍金防氧化。
工艺极限:电镀铜柱垂直度偏差<1°,固态焊接压力控制精度±1MPa;印刷——回流工艺面临极限,逐渐被电镀替代。
锡膏定位:退为“辅助角色”,仅在顶层芯片与基板互连时使用,要求超低空洞率(<1%)和超细印刷(点径<50μm)。
三、锡膏的“生存智慧”:跟着封装需求“变”
从T3到T9级颗粒,从高助焊剂到低挥发配方,锡膏的进化始终围绕两个核心:
适配更小间距:早期BGA用T5级锡膏就能满足0.8mm间距,而现在3D IC的凸点印刷需要 T8 级,粉末粒径小到能穿过头发丝粗细的钢网孔(20μm)。
平衡可靠性与工艺性:在高温封装中,锡膏添加银、铜元素提升耐热性;在低温堆叠中,改用 SnBi 合金降低熔点;为减少空洞,助焊剂中加入活性更强的有机酸,同时控制挥发速度。
傲牛科技为某Chiplet客户定制的锡膏,通过调整触变指数(从3.0到4.5),解决了 0.2mm间距印刷时的“塌边”问题,良率从78%提升至95%,助焊剂中加入了与日本材料公司共同开发的空洞抑制剂,将空洞率降低至3%。
四、未来趋势:凸点还能 “小” 到什么程度?
行业预测,到2030年,Micro LED 的凸点直径将缩小至5μm,这对锡膏提出了新挑战:粉末粒径可能需要达到亚微米级(<1μm),印刷精度要控制在±1μm以内,这对于焊料厂家的研发和生产能力提出了新的要求,行业的变化和需求也在鞭策我们在不断进步和提升。
-
DIP封装
+关注
关注
1文章
42浏览量
14015 -
锡膏
+关注
关注
1文章
983浏览量
18071 -
3D封装
+关注
关注
9文章
147浏览量
28205 -
chiplet
+关注
关注
6文章
485浏览量
13520 -
先进封装
+关注
关注
2文章
521浏览量
981
发布评论请先 登录





 从DIP到Chiplet,聊聊凸点制作和锡膏适配的进化史
从DIP到Chiplet,聊聊凸点制作和锡膏适配的进化史






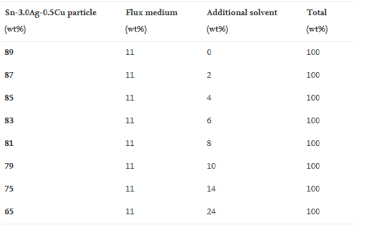














评论