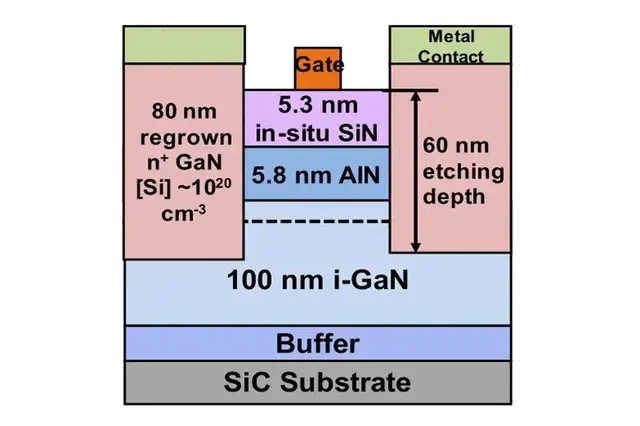
一种用于重掺杂n型接触的选择性刻蚀工艺实现了AlN/GaN HEMT的缩小
上图:原位SiN/AlN/GaN HEMT外延堆叠示意图
俄亥俄州立大学的工程师们宣称,他们已经打开了一扇大门,有望制备出尺寸小得多、工作频率高得多的AlN/GaN HEMT。
该团队的突破涉及原位钝化和使用选择性刻蚀工艺添加再生长重掺杂n型接触。
AlN/GaN HEMT是一类极具前景的晶体管,可用于射频和功率器件。与更传统的AlGaN/GaN形式的III-N HEMT相比,AlN/GaN HEMT不存在合金散射,且具备高得多的二维电子气密度和电子迁移率,分别高达4 x 1013 cm-2,以及介于1000 cm2 V-1 s-1和1800 cm2 V-1 s-1之间。
早在2010年,HRL Laboratories的Keisuke Shinohara及其同事就报道了AlN/GaN HEMT的截止频率值和最大振荡频率值,分别为220 GHz和400 GHz。俄亥俄州立大学的工程师们表示,通过缩小源极-漏极间距,可以获得更好的性能。然而,这在传统工艺中并不容易实现,需要使用SiO2进行再生长和剥离步骤。
据称,俄亥俄州立大学的方法提供了一种替代方案,有助于制备具有极低接触电阻的高度微缩化HEMT。
为了证明其新工艺的潜力,俄亥俄州立大学的工程师们用外延片制备了AlN/GaN HEMT,该外延片包含AlN成核层、1.5 mm厚的半绝缘缓冲层、100 nm厚的无意掺杂GaN沟道、5.8 nm厚的势垒和4.3 nm厚的原位SiN层。根据霍尔效应测量结果,该外延结构中二维电子气的载流子密度为2.2 x 1013 cm-2,电子迁移率为1060 cm2 V-1 s-1。
制备器件的第一步是进行选择性刻蚀,以暴露二维电子气的侧壁,使源极-漏极间距达到3 mm。通过镓抛光从二维电子气的表面和侧壁吸附低价氧化物后,研究团队将处理过的外延片装入MBE室,并沉积了一层重掺杂n型GaN,其生长高度高出SiN表面20 nm。这种方法旨在确保侧壁与二维电子气接触。化学刻蚀可选择性去除未刻蚀原位SiN层上形成的多晶GaN,从而暴露出栅极的有源区。
研究团队通过各种形式的电子显微镜分析了加工晶圆的质量,发现刻蚀边缘及再生长界面处没有明显的位错或边界,显示出高质量的晶格匹配n型GaN再生长。
为完成AlN/GaN HEMT的制备,研究团队使用等离子体刻蚀形成了一个台面,利用电子束蒸发在再生长GaN区域上添加了非合金金属堆叠,并通过光刻和电子束蒸发形成了0.7 mm的Ni/Au栅极。
通过聚焦离子束扫描隧道电子显微镜仔细观察这些晶体管,发现钛和SiN之间的界面平直清晰。这表明加工过程未对SiN薄层造成任何破坏或损伤,因此SiN薄层可以起到防止AlN表面暴露在外的作用。
扫描电子显微镜图像显示,再生长n型GaN的边缘平直清晰,锐度极高。与此相反,采用传统剥离工艺制备的对照器件的图像显示出不规则的粗糙边缘,这一缺点制约了器件的大幅缩小。
HEMT的霍尔效应测量值与外延片的霍尔效应测量值相似,表明加工过程没有造成表面损伤。
工程师们测得的界面电阻为0.058 Ω mm,接近理论值。基于这一发现,研究团队认为,他们的刻蚀工艺不会使再生长n型GaN与经过刻蚀的二维电子气侧壁之间的界面发生退化。
对栅极长度为0.7 µm的HEMT进行电学测量,测得的最大跨导为0.25 S mm-1,线性拟合和外推法表明其阈值电压为-4.9 V。最大漏极电流为1.57 mA mm-1,栅极电压为1 V时的导通电阻为1.85 Ω mm。击穿电压为23.3 V,与采用传统工艺制备的对照器件相近,表明俄亥俄州立大学工程师的选择性刻蚀工艺不会降低击穿性能。
参考文献
C. Cao et al. Appl. Phys. Express 18 036501 (2025)
来源:半导体芯科技
【线上会议】
6月24日14:00,聚焦半导体量测智能化升级的线上研讨会重磅开启!后摩尔时代,半导体检测技术如何突破?AI+多维协同是关键!直击AI+AOI/3D检测/HBM/先进封装等技术痛点,立即扫码报名,锁定席位:https://w.lwc.cn/s/Y7RnQ3
【2025全年计划】
隶属于ACT雅时国际商讯旗下的两本优秀杂志:《化合物半导体》&《半导体芯科技》2025年研讨会全年计划已出。
线上线下,共谋行业发展、产业进步!商机合作一览无余,欢迎您点击获取!
https://www.compoundsemiconductorchina.net/seminar/
审核编辑 黄宇
-
GaN
+关注
关注
21文章
2385浏览量
84472 -
HEMT
+关注
关注
2文章
80浏览量
14538 -
AlN
+关注
关注
0文章
5浏览量
9717
发布评论请先 登录
氮化镓GaN FET/GaN HEMT 功率驱动电路选型表
PI 1250V/1700V GaN HEMT助力英伟达800VDC架构

PC5200 700V_10A GaN HEMT驱动器数据手册
CHA6154-99F三级单片氮化镓(GaN)中功率放大器
快充国产替代新突破!争妍微650V GaN HEMT赋能300W USB-C PD,替代英诺赛科INN650D02

CHA8107-QCB两级氮化镓(GaN)高功率放大器
“芯”品发布 | 高可靠GaN专用驱动器,便捷GaN电源设计

STDRIVEG60015演示板技术解析:650V E模式GaN半桥驱动设计指南

GaN HEMT器件的结构和工作模式

GaN HEMT开关过程中振荡机制与驱动设计考量

垂直GaN迎来新突破!
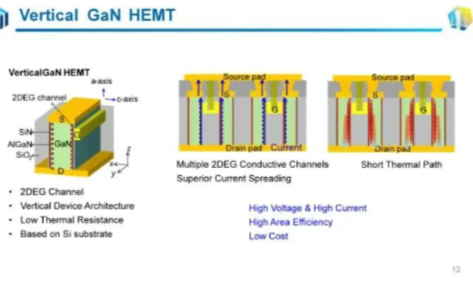
GAN功率器件在机器人上的应用实践
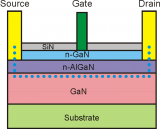
MPS新品 MPG44100 集成GaN FET的高效率、增强型 PFC 稳压器,具有峰值功率总线升压功能




 增强AlN/GaN HEMT
增强AlN/GaN HEMT




评论