
芯东西12月16日报道,在IEDM 2024(2024年IEEE国际电子器件会议)上,英特尔代工展示了包括先进封装、晶体管微缩、互连缩放等在内的多项技术突破,以助力推动半导体行业在下一个十年及更长远的发展。
英特尔通过改进封装技术将芯片封装中的吞吐量提升高达100倍,探索解决采用铜材料的晶体管在开发未来制程节点时可预见的互连微缩限制,并继续为先进的全环绕栅极(GAA)晶体管及其它相关技术定义和规划晶体管路线图。

这些技术进展来自负责研发突破性制程和封装技术的英特尔代工技术研究团队。在IEDM 2024上发表的部分论文由英特尔代工与其他团队共同完成。
随着行业朝着到2030年在单个芯片上实现一万亿个晶体管的目标前进,先进封装、晶体管微缩、互连微缩等技术突破对于未来满足更高性能、更高能效、更高成本效益的计算应用需求至关重要。
一、先进封装:异构集成新方案,将吞吐量提升多达100倍
英特尔代工汇报了一种用于先进封装的异构集成解决方案——选择性层转移(Selective Layer Transfer, SLT),可以在芯片封装中将吞吐量提升高达100倍,实现超快速的芯片间封装(chip-to-chip assembly)。
与传统的芯片到晶圆键合(chip-to-wafer bonding)技术相比,选择性层转移能够让芯片的尺寸变得更小,纵横比变得更高。
该解决方案的基本思路是以晶圆到晶圆连接的吞吐量,实现芯片到晶圆连接的灵活性和能力,能够以更高的灵活性集成超薄芯粒,还带来了更高的功能密度,并可以结合混合键合(hybrid bonding)或融合键合(fusion bonding)工艺,提供更灵活且成本效益更高的解决方案,封装来自不同晶圆的芯粒。
这为AI应用提供了一种更高效、更灵活的架构。

相应的技术论文名为《选择性层转移:业界领先的异构集成技术》,作者包括Adel Elsherbini、Tushar Talukdar、Thomas Sounart等人。
二、晶体管微缩:持续缩短栅极长度,探索用新材料替代硅
晶体管技术进步一直是英特尔的主业之一。
在最先进的全环绕栅极(GAA)晶体管方面,英特尔代工展示了硅基RibbionFET CMOS (互补金属氧化物半导体)技术,以及用于微缩的2D场效应晶体管(2D FETs)的栅氧化层(gate oxide)模块,以提高设备性能。
为了将RibbonFET GAA晶体管的微缩推向更高水平,英特尔代工展示了栅极长度为6nm、硅层厚度仅为1.7nm的硅基RibbonFET CMOS晶体管,在大幅缩短栅极长度和减少沟道厚度的同时,在对短沟道效应的抑制和性能上达到了业界领先水平。

英特尔代工正在研究一个渐进式的发展步骤,将沟道材料由传统材料替换为其它材料,比如2D材料。他们判断一旦将基于硅的沟道性能推至极限,采用2D材料的GAA晶体管很有可能会成为下一步发展的合理方向。
为了在CFET(互补场效应晶体管)之外进一步加速GAA技术创新,英特尔代工展示了其在2D GAA NMOS(N型金属氧化物半导体)和PMOS(P型金属氧化物半导体)晶体管制造方面的研究,侧重于栅氧化层模块的研发,将晶体管的栅极长度微缩到了30nm。该研究还报告了行业在2D TMD(过渡金属二硫化物)半导体领域的研究进展,此类材料未来有望在先进晶体管工艺中成为硅的替代品。
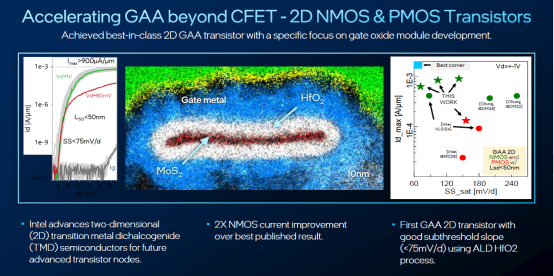
GaN是一种新兴的用于功率器件和射频(RF)器件的材料,相较于硅,它的性能更强,也能承受更高的电压和温度。英特尔代工团队发现在数据中心领域,硅材料在电力传输方面快达到极限,而以300毫米GaN(氮化镓)为代表的其他材料体系是颇具吸引力的替代选择。
在300毫米GaN-on-TRSOI(富陷阱绝缘体上硅)衬底(substrate)上,英特尔代工制造了业界领先的高性能微缩增强型GaN MOSHEMT(金属氧化物半导体高电子迁移率晶体管)。GaN-on-TRSOI等工艺上较为先进的衬底,可以通过减少信号损失,提高信号线性度和基于衬底背部处理的先进集成方案,为功率器件和射频器件等应用带来更强的性能。
三、互连缩放:改善芯片内互连,最高将线间电容降低25%
铜互连的时代即将走向尾声。随着线宽不断缩小,铜线的电阻率呈指数级上升,以至到难以接受的程度。当晶体管尺寸不断缩小,使其越来越密集、功能越来越强大时,却没有能将所有这些晶体管连接在一起所需的布线。
取得突破的一个方法是减成法钌互连技术(subtractive Ruthenium)。
在间距小于或等于25nm时,采用减成法钌互连技术实现的空气间隙最高可将线间电容降低25%,有助于改善芯片内互连,提升芯片性能。
具体而言,减成法钌互连技术通过采用钌这一新型、关键、替代性的金属化材料,利用薄膜电阻率(thin film resistivity)和空气间隙(airgap),实现了在互连微缩方面的重大进步。
英特尔代工率先在研发测试设备上展示了一种可行、可量产、具有成本效益的减成法钌互连技术,该工艺引入空气间隙,无需通孔周围昂贵的光刻空气间隙区域(lithographic airgap exclusion zone),也不需要使用选择性蚀刻的自对准通孔(self-aligned via)。这表明该技术作为一种金属化方案,在紧密间距层中替代铜镶嵌工艺的优势。
这一解决方案有望在英特尔代工的未来制程节点中得以应用,或能探索出合理的下一代互连技术,使其与下一代晶体管及下一代封装技术相适配。
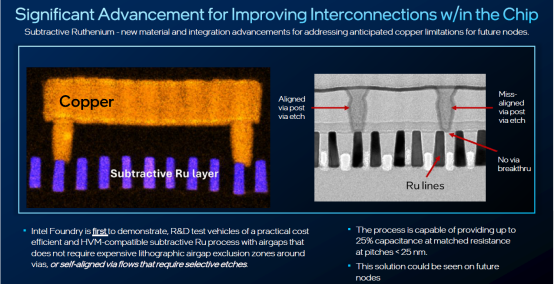
相应技术论文名为《利用空气间隙的减成法钌互连技术》,作者是Ananya Dutta、Askhit Peer、Christopher Jezewski。
结语:三大创新着力点,推动AI向能效更高发展
在IEDM 2024上,英特尔代工还分享了对先进封装和晶体管微缩技术未来发展的愿景,以下三个关键的创新着力点将有助于AI在未来十年朝着能效更高的方向发展:
1、先进内存集成(memory integration),以消除容量、带宽和延迟的瓶颈;2、用于优化互连带宽的混合键合;3、模块化系统(modular system)及相应的连接解决方案。

新型材料还有待进一步探索,来增强英特尔代工的PowerVia背面供电技术在缓解互连瓶颈、实现晶体管的进一步微缩中的作用。这对于持续推进摩尔定律、推动面向AI时代的半导体创新至关重要。
同时,英特尔代工发出行动号召,开发关键性和突破性的创新,持续推进晶体管微缩,推动实现“万亿晶体管时代”。
英特尔代工概述了对能够在超低电压(低于300毫伏)下运行的晶体管的研发,将如何有助于解决日益严重的热瓶颈,并大幅改善功耗和散热。
其团队认为,应对能源挑战的途径之一,是采用极低供电电压的高品质晶体管,不是仅在研究环境中制造出一个这样的晶体管,而是要制造出数以万亿计的此类晶体管,使其具备足够高的性能、稳定性、可重复性及可靠性,这样才能用它们来制造产品。
审核编辑 黄宇
-
英特尔
+关注
关注
61文章
10326浏览量
181116 -
晶体管
+关注
关注
78文章
10443浏览量
148684 -
IEDM
+关注
关注
0文章
5浏览量
11543
发布评论请先 登录
晶体管达林顿光耦:核心特性驱动的技术优势与应用价值
不同于HBM垂直堆叠,英特尔新型内存ZAM技术采用交错互连拓扑结构

突破供电瓶颈,英特尔代工实现功率传输的跨代际飞跃
英特尔半导体制造技术突破:2D 材料晶体管、新型电容器、12吋硅基氮化镓
五家大厂盯上,英特尔EMIB成了?
吉方工控荣膺英特尔中国2025市场突破奖
吉方工控亮相2025英特尔技术创新与产业生态大会
英特尔举办行业解决方案大会,共同打造机器人“芯”动脉

18A工艺大单!英特尔将代工微软AI芯片Maia 2
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
下一代高速芯片晶体管解制造问题解决了!
分析师:英特尔转型之路,机遇与挑战并存




 英特尔IEDM 2024大晒封装、晶体管、互连等领域技术突破
英特尔IEDM 2024大晒封装、晶体管、互连等领域技术突破





评论