随着集成电路技术的飞速发展,芯片封装技术也在不断进步,以适应日益增长的微型化、多功能化和高集成化的需求。其中,球栅阵列封装(BGA)作为一种先进的封装技术,凭借其硅片利用率高、互连路径短、信号传输延时短以及寄生参数小等优点,迅速成为当今中高端芯片封装领域的主流。在BGA芯片封装中,凸点制作工艺是至关重要的一环,它不仅关系到封装的可靠性和性能,还直接影响到封装的生产效率和成本。本文将详细介绍BGA芯片封装上的凸点制作工艺,包括其特点、常见方法、工艺流程以及发展趋势。
一、凸点制作工艺的特点
凸点制作工艺在BGA芯片封装中起着电互连、热传递和机械支撑等重要作用。凸点通常位于芯片的有源电极上,与封装基板上的电极直接连接,形成最短的电路路径,从而减小电阻、电感,提高信号传输速度和质量。此外,凸点还可以作为散热通道,将芯片产生的热量传递到封装基板或其他组件上,提高芯片的散热性能。
在BGA芯片封装中,凸点制作工艺具有以下特点:
高精度:凸点的尺寸和位置精度对封装的可靠性至关重要。因此,凸点制作工艺需要具备高精度的设备和技术,以确保凸点的尺寸和位置符合设计要求。
高可靠性:凸点作为电互连和机械支撑的关键部分,其可靠性直接影响到封装的整体性能。凸点制作工艺需要确保凸点与芯片电极、封装基板电极之间的连接牢固可靠,能够承受封装和使用过程中的各种应力和环境变化。
高效率:随着电子产品市场的快速发展,对封装生产效率的要求也越来越高。凸点制作工艺需要具备高效、自动化程度高的特点,以提高封装生产线的产能和降低生产成本。
二、常见的凸点制作方法
在BGA芯片封装中,凸点制作方法多种多样,主要包括电镀、印刷、植球、激光重熔等。下面将详细介绍这些常见的凸点制作方法。
电镀法
电镀法是一种通过电化学沉积在芯片电极上形成凸点的方法。其工艺流程通常包括以下几个步骤:
UBM制备:在芯片电极上沉积一层凸点下金属化层(UBM),以提高凸点与芯片电极之间的黏附性和防止金属间化合物的生成。
光刻胶涂覆与曝光:在UBM上涂覆一层光刻胶,并通过曝光和显影形成凸点的图形。
电镀:将芯片放入电镀槽中,通过控制电镀电流和时间,在光刻胶开窗图形的底部开始生长并得到一定厚度的金属层作为凸点。
光刻胶去除与回流:去除多余的光刻胶,并通过回流工艺使凸点形成球状。
电镀法具有成本效益好、良率高、速度快且凸点密度高的优点,特别适用于极细节距凸点的制作。然而,电镀法也存在设备投入大、成本高以及工艺复杂等缺点。
印刷法
印刷法是一种通过涂刷器和网板将锡膏涂刷在芯片电极上形成凸点的方法。其工艺流程通常包括以下几个步骤:
UBM制备:在芯片电极上沉积一层UBM。
锡膏丝网印刷:通过涂刷器和网板将锡膏涂刷在芯片电极上形成凸点图形。
锡膏回流:对芯片进行加热回流,使锡膏熔化形成凸点。
焊盘清洗:清洗焊盘上的残留物。
印刷法具有成本低、效率高的优点,特别适用于间距为200~400μm的焊盘。然而,在节距小于150μm的高密度互连中,印刷法面临较大的挑战,如助焊剂容易桥接、回流后焊料容易桥接等问题。
植球法
植球法是一种通过专用设备将预成型精密焊球放置在芯片电极上形成凸点的方法。其工艺流程通常包括以下几个步骤:
UBM制备:在芯片电极上沉积一层UBM。
助焊剂涂覆:在芯片电极上涂刷黏性助焊剂。
焊球放置:通过专用设备将预成型精密焊球放置在芯片电极上。
加热回流:对芯片进行加热回流,使焊球熔化形成凸点。
植球法具有简单快捷、生产效率高的优点,可灵活应用于不同尺寸和材料的焊球。然而,植球法对焊球的一致性要求较高,且对助焊剂和回流温度设定的依赖度较高。
激光重熔法
激光重熔法是一种通过激光束将预置在芯片电极上的钎料合金熔化形成凸点的方法。其工艺流程通常包括以下几个步骤:
钎料预置:在芯片电极上预置钎料合金。
激光重熔:通过激光束将钎料合金熔化形成凸点。
回流与冷却:对芯片进行加热回流和冷却处理,使凸点形成稳定的球状。
激光重熔法具有局部加热、热影响区小、凸点一致性好等优点,特别适用于BGA封装钎料凸点的补修和精确控制。然而,激光重熔法也存在设备成本高、工艺复杂等缺点。
三、凸点制作的工艺流程
凸点制作的工艺流程因方法而异,但总体上可以归纳为以下几个步骤:
芯片准备:对芯片进行清洗、烘干等预处理工作,确保芯片表面干净无杂质。
UBM制备:在芯片电极上沉积一层UBM,以提高凸点与芯片电极之间的黏附性和防止金属间化合物的生成。UBM的制备方法主要有溅射、蒸镀、电镀等。
凸点形成:根据所选的凸点制作方法,在芯片电极上形成凸点。这一步是凸点制作工艺的核心部分,需要精确控制凸点的尺寸、位置和形状。
回流与冷却:对芯片进行加热回流和冷却处理,使凸点形成稳定的球状。回流温度和时间需要根据所选的钎料合金和芯片材料进行调整。
检查与测试:对形成的凸点进行检查和测试,确保其尺寸、位置和形状符合设计要求。同时还需要对凸点的可靠性进行测试,以确保封装的整体性能。
四、凸点制作工艺的发展趋势
随着电子信息技术的飞速发展,芯片封装技术也在不断进步。凸点制作工艺作为芯片封装中的关键环节,其发展趋势主要体现在以下几个方面:
高精度与高密度:随着芯片引脚数的增加和封装尺寸的减小,对凸点制作工艺的精度和密度要求也越来越高。未来凸点制作工艺将更加注重高精度和高密度的实现。
绿色制造:随着环保意识的增强和法规政策的推动,绿色制造已成为芯片封装技术的重要发展方向。凸点制作工艺需要采用环保材料、减少化学污染和废弃物产生等措施,以实现绿色制造的目标。
自动化与智能化:为了提高生产效率和降低成本,凸点制作工艺将更加注重自动化和智能化的实现。通过引入先进的自动化设备和智能控制系统,可以实现凸点制作过程的自动化控制和智能监控。
新材料与新工艺:随着新材料和新工艺的不断涌现,凸点制作工艺也将不断创新和发展。例如,采用新型钎料合金、开发新型UBM材料、引入先进的激光重熔技术等,都可以提高凸点制作的质量和效率。
五、结论
凸点制作工艺在BGA芯片封装中起着至关重要的作用。通过选择合适的凸点制作方法和工艺流程,可以确保凸点的尺寸、位置和形状符合设计要求,从而提高封装的可靠性和性能。未来,随着电子信息技术的不断发展和市场需求的变化,凸点制作工艺将更加注重高精度、高密度、绿色制造、自动化与智能化以及新材料与新工艺的应用和创新发展。
-
集成电路
+关注
关注
5446文章
12467浏览量
372687 -
BGA
+关注
关注
5文章
581浏览量
50959 -
芯片封装
+关注
关注
13文章
604浏览量
32082
发布评论请先 登录
晶圆级封装(WLP)中Bump凸点工艺:4大实现方式的技术细节与场景适配






 BGA芯片封装凸点工艺:技术详解与未来趋势
BGA芯片封装凸点工艺:技术详解与未来趋势







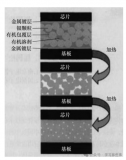




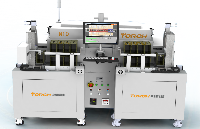










评论