塑料封装尽管在散热性、耐热性和密封性方面稍逊于陶瓷封装和金属封装,但其凭借低成本、薄型化、工艺简便及高度自动化生产的优势,已成为微电子工业中使用最广泛的封装方法。本文聚焦于塑料封装这一广泛应用的封装形式,聊一聊它的技术特点、发展历程、工艺挑战以及未来趋势。
一、塑料封装的广泛应用与技术演进
塑料封装的应用范围极为广泛,从日常生活中的消费性电子产品,到精密的超高速计算机,几乎无处不在。这一技术的普及,得益于其成本效益和灵活性,使得电子产品能够迅速普及并满足多样化的市场需求。尽管早期塑料封装的成品可靠度与陶瓷封装相比存在差距,但随着材料科学与工艺技术的不断进步,这一差距已显著缩小。现代塑料封装技术不仅提高了耐热性和密封性,还通过创新设计满足了高性能、高可靠性的要求,使其在电子封装技术中的地位日益重要。
塑料封装的历史可以追溯到DIP(Dual In-line Package,双列直插式封装)的发明。随后,塑料双列式封装(PDIP)凭借其低成本和易于自动化的优势,迅速成为IC封装的主流方法。随着IC技术的快速发展,对封装的多脚化、薄型化需求日益迫切,塑料封装技术也迎来了新一轮的创新。SOP(Small Outline Package,小外形封装)、SOJ(Small Outline J-leaded Package,J形引脚小外形封装)、SIP/ZIP(Single In-line Package/Zigzag In-line Package,单列直插/锯齿形引脚封装)、POFP(Plastic Open Grid Flat Package,塑料开栅式扁平封装)、PBGA(Plastic Ball Grid Array,塑料球栅阵列)以及FCBGA(Flip Chip Ball Grid Array,倒装焊球栅阵列)等一系列新型塑料封装形式应运而生,满足了不同应用场景下的需求。
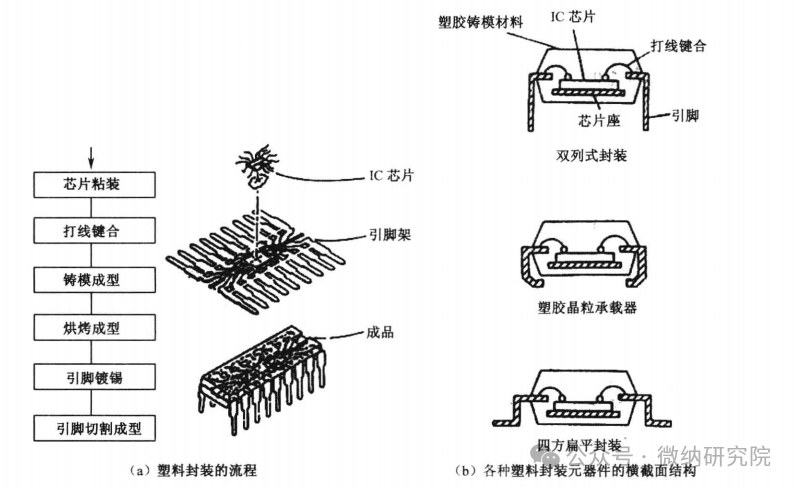
二、塑料封装的工艺挑战与整体设计考量
尽管塑料封装相较于陶瓷封装在工艺上更为简单,但其封装的成功实现却受到众多工艺和材料因素的深刻影响。这些因素包括但不限于:
封装配置与IC芯片尺寸
合理的封装配置能够最大化利用空间,同时确保良好的散热和机械强度。IC芯片尺寸的变化要求封装设计进行相应调整,以保持最佳的封装效率和性能。
导体与钝化保护层材料的选择
导体材料的选择需考虑导电性、耐腐蚀性和成本等因素;钝化保护层则用于保护芯片免受环境侵害,其材料的选择需兼顾透气性、耐热性和化学稳定性。
芯片黏结方法
芯片与封装基板的黏结是封装过程中的关键步骤,直接影响封装的可靠性和稳定性。常用的黏结方法包括环氧树脂黏结、银浆黏结和玻璃化黏结等,每种方法都有其独特的优势和适用场景。
铸膜树脂材料
铸膜树脂是塑料封装中的主要材料,其性能直接影响封装的耐热性、密封性和机械强度。随着材料科学的进步,新型铸膜树脂不断涌现,如环氧树脂、聚酰亚胺等,为塑料封装提供了更多选择。
引脚架的设计
引脚架作为封装与外部电路的连接桥梁,其设计需考虑引脚数量、排列方式、引脚间距以及引脚的材料和形状等因素,以确保良好的电气连接和机械支撑。
铸膜成型工艺条件
温度、压力、时间和烘烤硬化条件是铸膜成型过程中的关键参数,它们共同决定了封装的质量和性能。精确控制这些参数对于实现高质量封装至关重要。
塑料封装的设计必须综合考虑上述因素之间的相互影响,以实现整体性能的最优化。塑料封装的流程涵盖了从芯片准备、黏结、引线键合、铸膜成型到后处理等多个环节,每个环节都需严格控制以确保最终产品的质量和可靠性。同时,不同塑料封装元器件的横截面结构也展示了其多样化的设计特点,如PDIP的引脚排列、SOP的紧凑外形、PBGA的球栅阵列等,这些设计都是为了满足特定应用场景下的需求。
三、塑料封装技术的持续创新
随着5G、物联网、人工智能等技术的快速发展,对封装技术的要求将更加严格,如更高的数据传输速率、更低的功耗和更好的散热性能等。新材料、新工艺的不断涌现也为塑料封装技术的创新提供了可能。例如,采用高性能聚合物材料、纳米复合材料以及先进的成型技术,可以进一步提升塑料封装的耐热性、密封性和机械强度;而3D封装、系统级封装等新型封装技术的引入,则有望解决传统封装在引脚数量、集成度和互连密度等方面的限制。
塑料封装作为微电子工业中使用最广泛的封装方法,其重要性不言而喻。未来,塑料封装技术必定将不断创新与发展,为电子产品的小型化、高性能化和智能化提供坚实的支撑。
-
封装
+关注
关注
128文章
9386浏览量
149220 -
塑料封装
+关注
关注
0文章
16浏览量
7396
原文标题:【芯片封装】使用最广泛的封装方法——塑料封装
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 塑料封装技术特点、发展历程、工艺挑战以及未来趋势
塑料封装技术特点、发展历程、工艺挑战以及未来趋势








评论