玻璃基板在异质集成技术中被广泛应用。它与有机基板、硅以及其他陶瓷材料相似,能在2.5D和3D封装中充当转接层或中间层,并且在3D封装技术中,玻璃基板扮演着基础材料的角色,为产品创新提供了新的可能性。
玻璃基板:
材料与工艺的变革
玻璃基板主要用于替代传统的硅/有机基板和中介层,其应用范围覆盖了面板、IC等泛半导体领域。玻璃材质因其成本低、电学性能优越以及低翘曲率等优势,能够有效克服有机物和硅材质的缺陷,实现更稳定、更高效的连接,并降低生产成本。

国际大厂对玻璃基板的布局动态
尽管英特尔已投入超过十年的研发,并计划在下一代产品中使用玻璃基板,但在中国大陆,玻璃基板仍被视为一项新兴技术。这项技术可能面临的主要问题之一是成本问题。
目前,玻璃基板技术可能首先在高性能计算领域得到应用,因为这一领域的客户更愿意投资新技术以获得更高的性能。因此,玻璃基板技术的发展可能会更多地围绕AI芯片进行突破。
除了高性能GPU和AI产品外,玻璃基板技术本身并不新颖,因为它已在其他产品中得到成熟应用,比如早期的光通信、传感器、射频产品,尤其是显示用LED产品等。但对于先进封装技术而言,玻璃基板仍是一个相对较新的领域,还需要经历一个较长的发展过程。
目前,国内从事先进封装的玻璃基板工厂大多还未进入量产阶段,多数仍处于研发阶段。他们正在解决玻璃与金属层的结合力问题、填孔问题,以及未来更高层数的可靠性问题。预计到2025年底或2026年,这些工厂才能达到量产水平。在此之前,大部分工作仍将集中在研发上。
四大关键技术挑战
玻璃基板技术虽然具有巨大的潜力和优势,但要实现其在先进封装领域的广泛应用,仍需克服众多技术挑战。
高精度通孔
玻璃通孔成孔技术是制约TGV发展的主要困难之一。
制备要求:
高速、侧壁光滑、高精度
垂直度好、窄节距、低成本
目前,TGV的制作工艺包括但不限于喷砂法、聚焦放电法、等离子刻蚀法等。从玻璃基板制造工艺及行业应用来看,激光诱导刻蚀法是目前最主流的TGV制作工艺之一。其主要方法相对简单,即通过激光对玻璃进行改性处理,然后在青木酸中利用不同的时间控制来制作不同孔径的孔。

然而,尽管单个或少量孔的制作可能较为简单,但当数量增加到数十万个时,难度会以几何级数增长。这也是许多TGV未能达到预期效果的原因之一。此外,如何测试每个通孔的良率或尺寸精度,也是我们需要考虑的问题。目前来看,除了玻璃基板的先进板厂在研发之外,进程比较快的是那些原本从事光电或玻璃相关工艺的工厂。
高质量金属填充
目前,金属填孔TGV主要有两种工艺:一是铜浆塞孔工艺,二是电镀工艺。这两种工艺在应用场景、材料成本和性能上存在差异。选择何种工艺取决于孔径、深宽比以及对电阻率和电导率的要求。值得一提的是,铜浆塞孔技术相较于电镀工艺具有独特优势,但可能在电导率方面存在较大劣势。
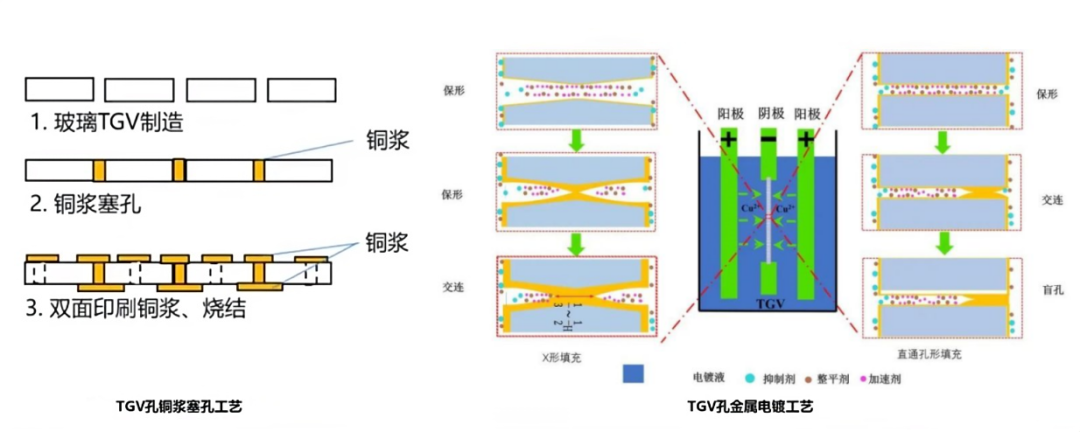
高密度布线
另一个制约玻璃基板技术应用的关键因素是高密度布线。尽管有不少公司能够较好地完成玻璃基板的填孔或TGV工艺,但真正挑战在于完成玻璃通孔的制备后,如何通过布线来实现电气连接,将其制成一个完整的玻璃基板或玻璃基interposer,并且在有实际应用场景时实现高密度布线。
传统的工艺方法可能包括半加成法,以及将现有的有机基板电路制作模式应用到玻璃基板上,即将有机的BT层转化为玻璃级别的层以提供支撑。其他部分则采用完整的有机基板电镀层制作方法,最后通过进一步的压合或其他工艺进行整合,这可能是板厂常用的一些手段。
但由于半加成工艺法在线宽小于5μm的时候会面临许多挑战,如在窄间距内刻蚀种子层容易对铜走线造成损伤且窄间距里的种子层残留易造成漏电。针对表面高密度布线也有不同工艺路线的探索。
至于先前提到的专注于玻璃机的LED场景的公司,它们可能会在玻璃机的TGV和填孔工序完成后,应用晶圆中道工艺,包括RDL工艺和CTT工艺来进行制作。海外还有一种新的技术,即多层RDL直接栅板转移技术。尽管这一技术目前尚未得到广泛应用,但也是未来的一个技术方向之一。
此外纳米压印,尤其是在晶圆制造方面,佳能已取得了一定的应用成果。未来,业界期望能够在玻璃基板电路的制作上找到更多应用场景。
键合技术
玻璃基板关键技术之四为键合技术,目前Chiplet的D2W及Flip Chip键合工艺主要分为三大类。
Reflow回流焊键合工艺:
回流焊炉可以批量焊接产品,并且随着技术水平的提升,bump pitch>80μm已不再是难题。但是缺点也很明显,热应力导致的翘曲极大,回流焊过程中高温和低温的波动可能会导致产品发生较大变形。尤其是当芯片面积接近基本面积时,整个焊盘也会变得极大。这也是为什么在做更大密度的先进封装芯片集成时,必须使用更大尺寸的封装,因为有机基板的翘曲极限无法满足PCB板的间隔要求。因此需要用玻璃基板来代替有机基板。
TCB热压焊键合工艺:
以100°C/s的升温速率和-50℃℃/s的降温速率对焊点进行快速焊接,bump pitch>10μm。
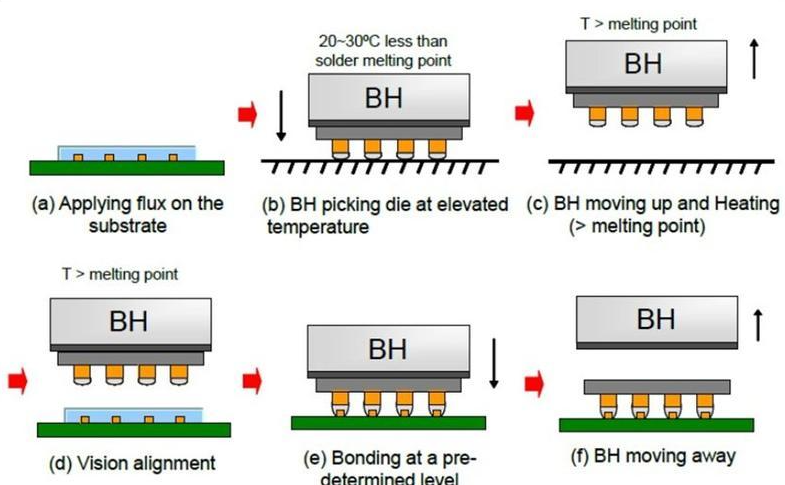
LAB激光辅助键合工艺:
产生尖锐且均匀的激光束,能够以极高的升温速度选择性地加热目标区域,通常焊接时间在1s内。bump pitch>40μm。
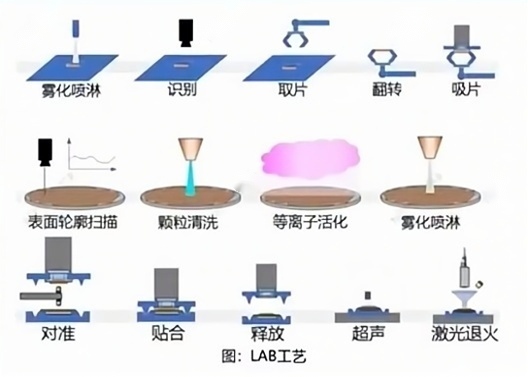
-
玻璃基板
+关注
关注
1文章
110浏览量
11119 -
3D封装
+关注
关注
9文章
151浏览量
28416
原文标题:玻璃基板的四大关键技术挑战
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
微电网保护的关键技术在工业园区应用场景中有哪些挑战

华为发布智能体通信网络的三大关键技术能力
动力电池组生产四大关键工艺,如何决定新能源汽车性能?
从FPGA应用前景视角解读Gartner 2026十大关键技术趋势(下)

解码LCD液晶屏的关键技术指标

玻璃基板技术的现状和优势

TGV技术:推动半导体封装创新的关键技术

Micro LED制造工艺中四大关键技术难点

DBA基板:开启高压大功率应用新时代的关键技术




 玻璃基板的四大关键技术挑战
玻璃基板的四大关键技术挑战










评论