共读好书
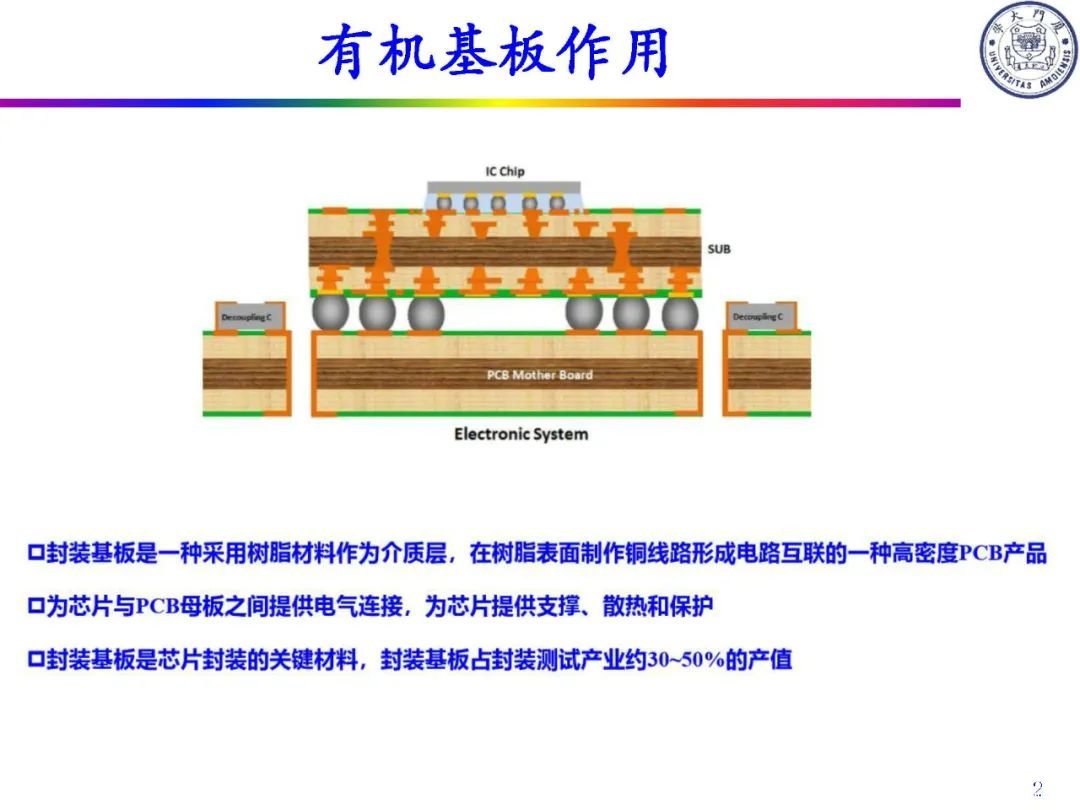



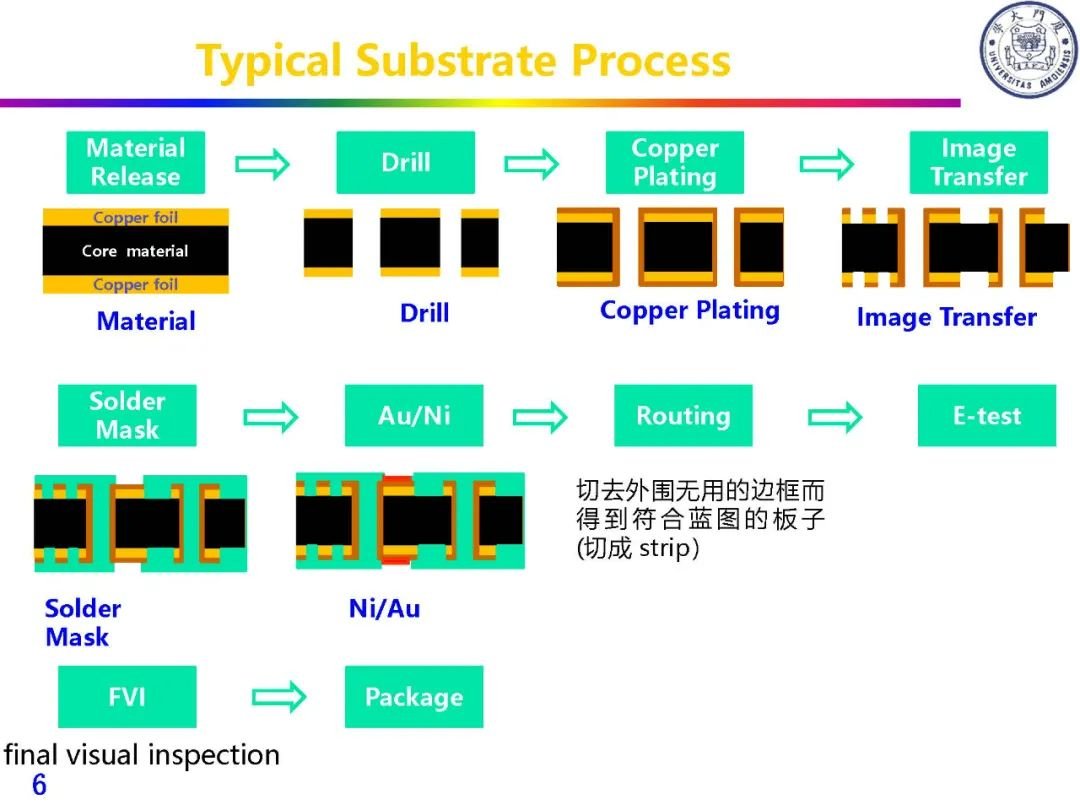
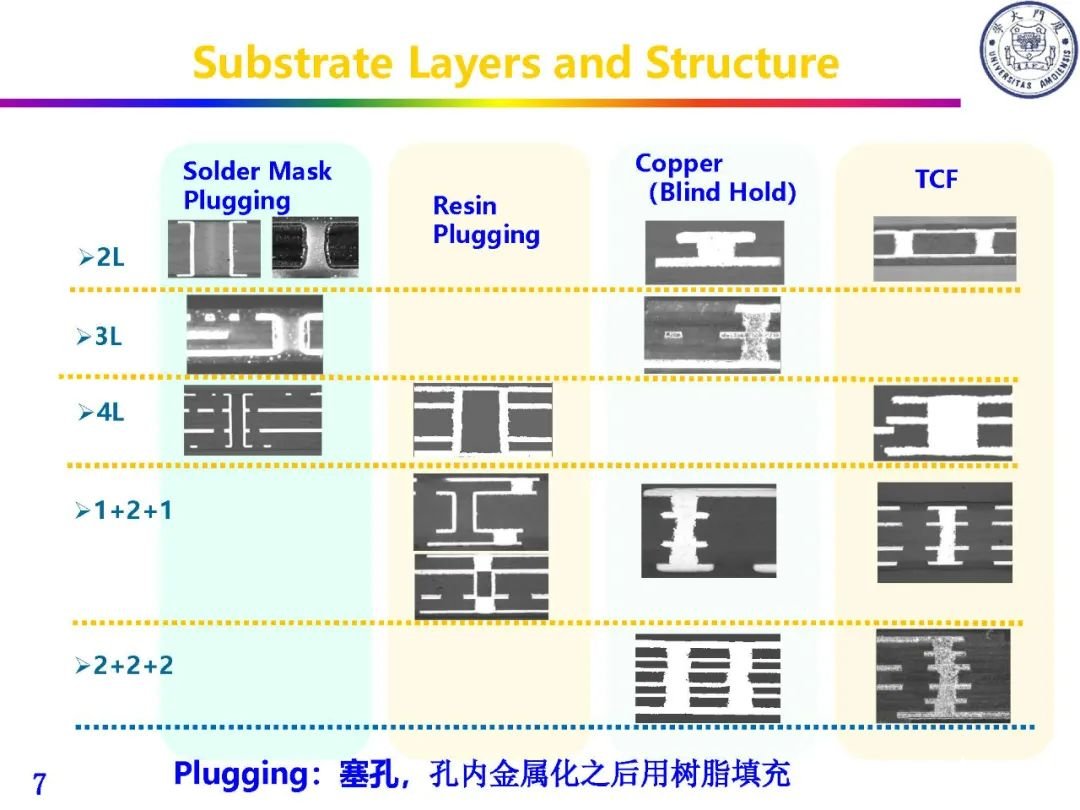
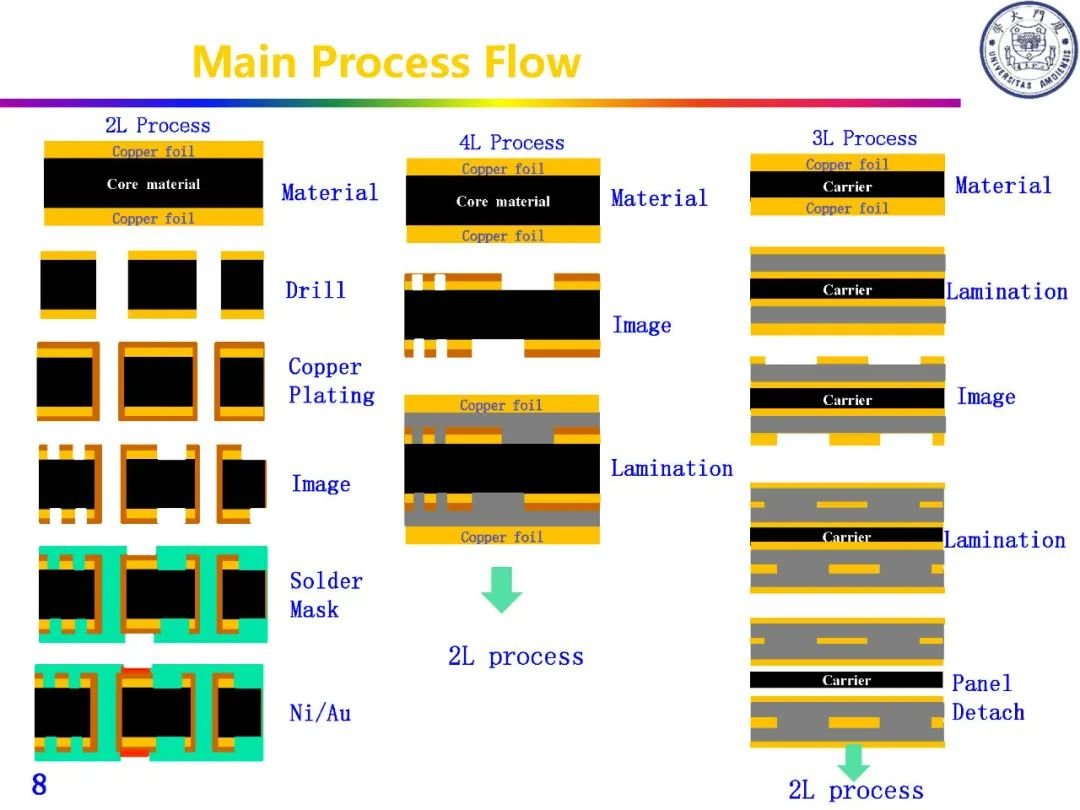
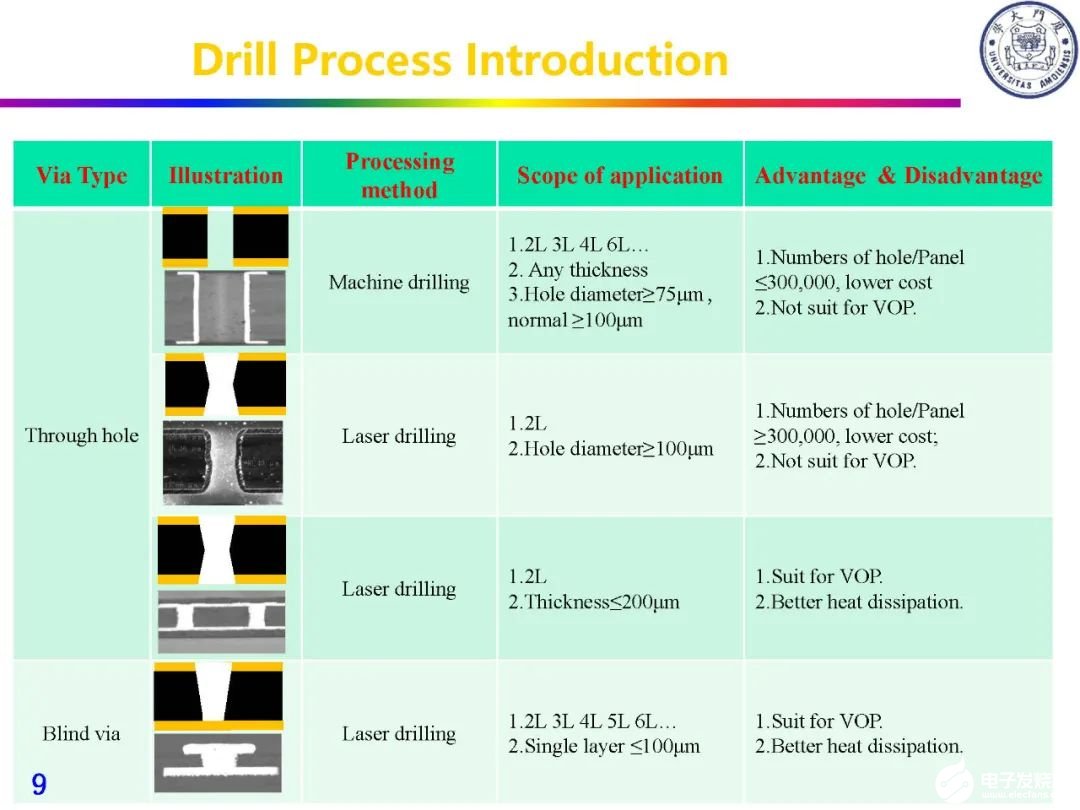
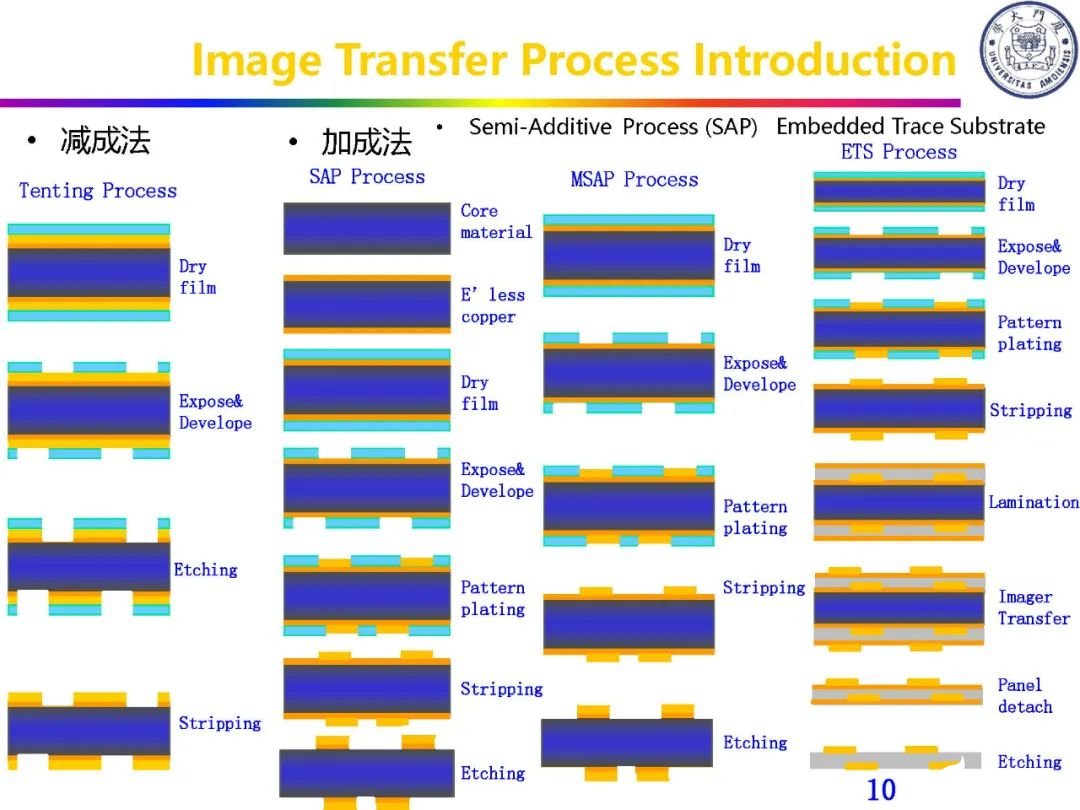
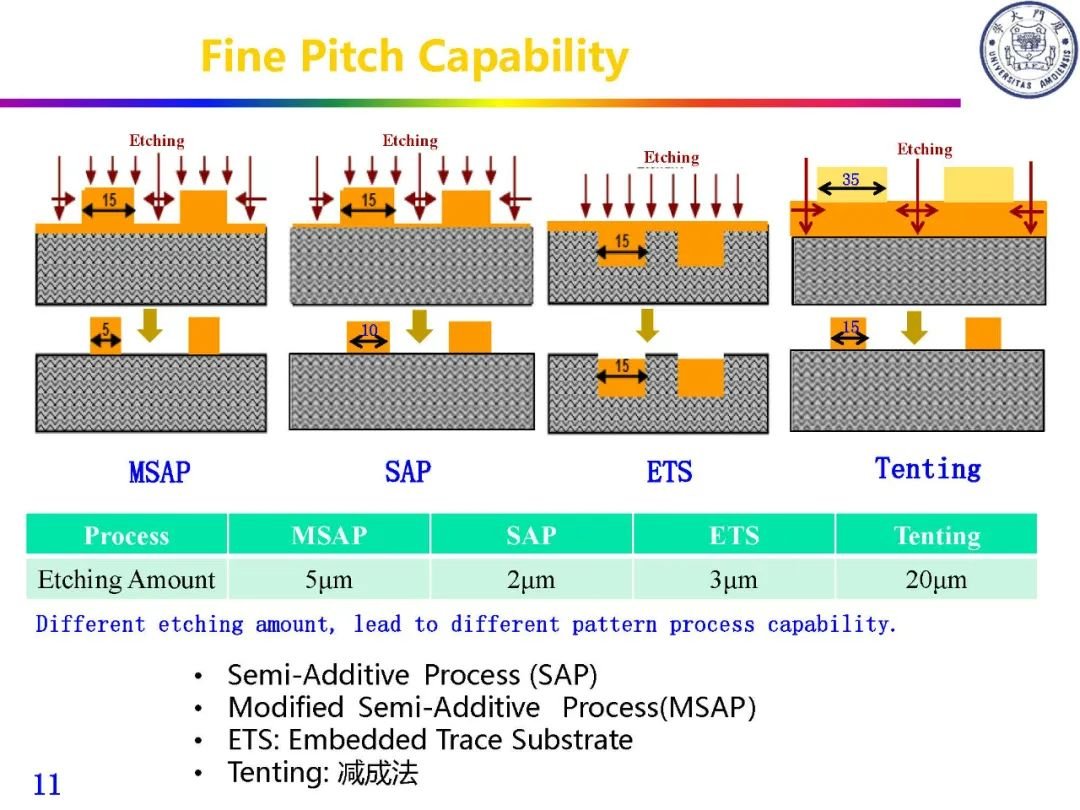
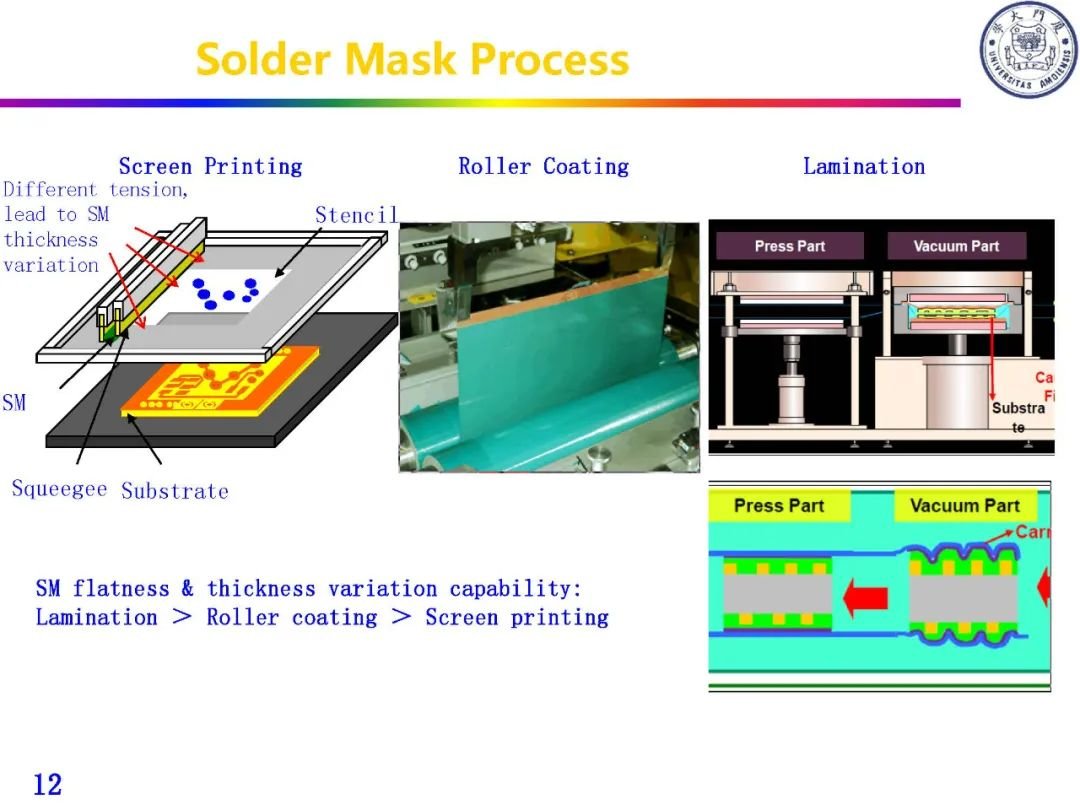
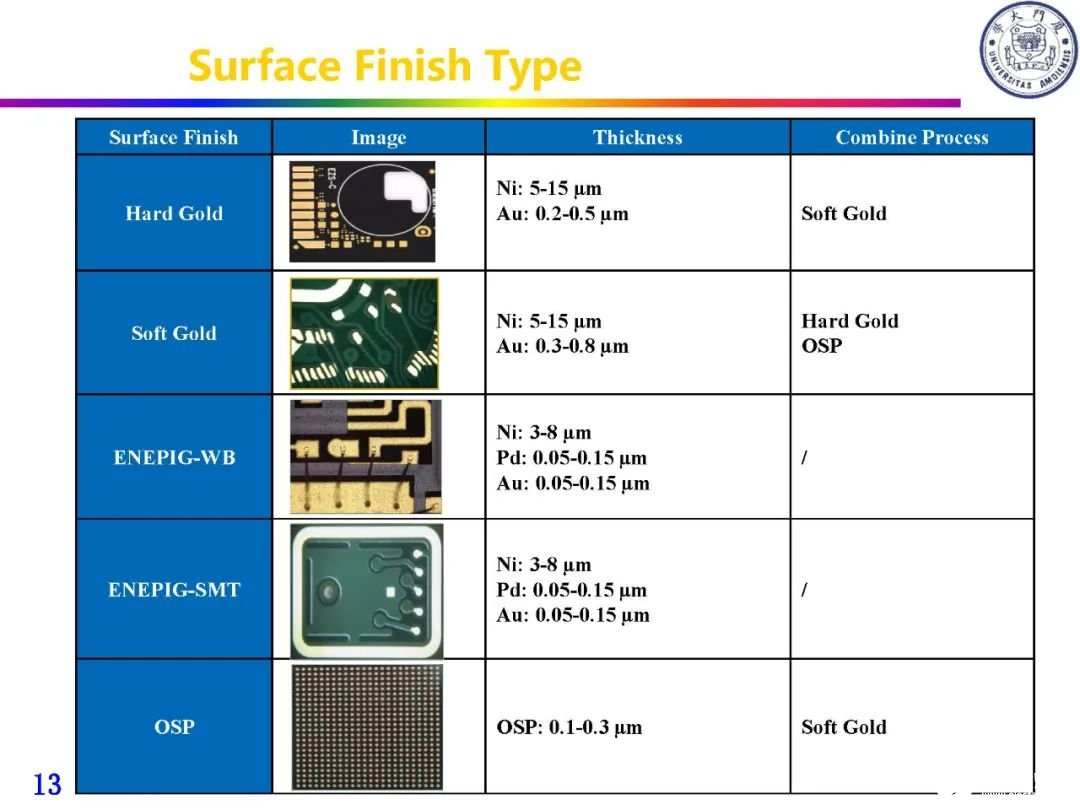
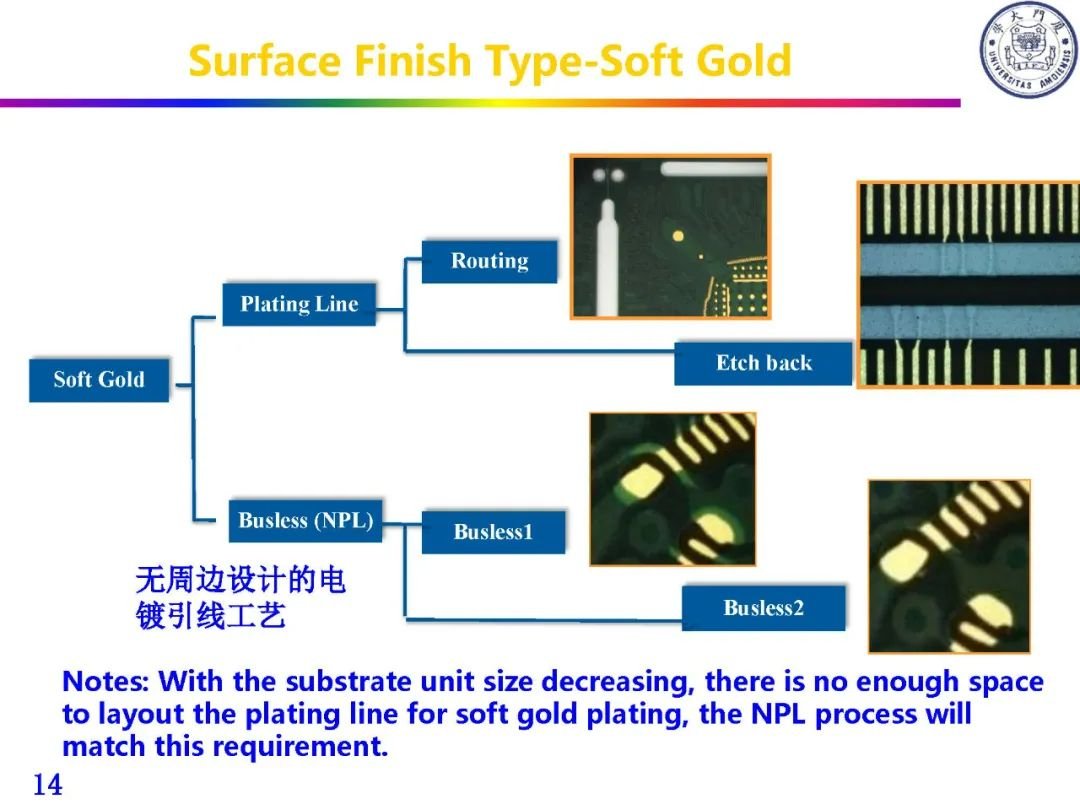
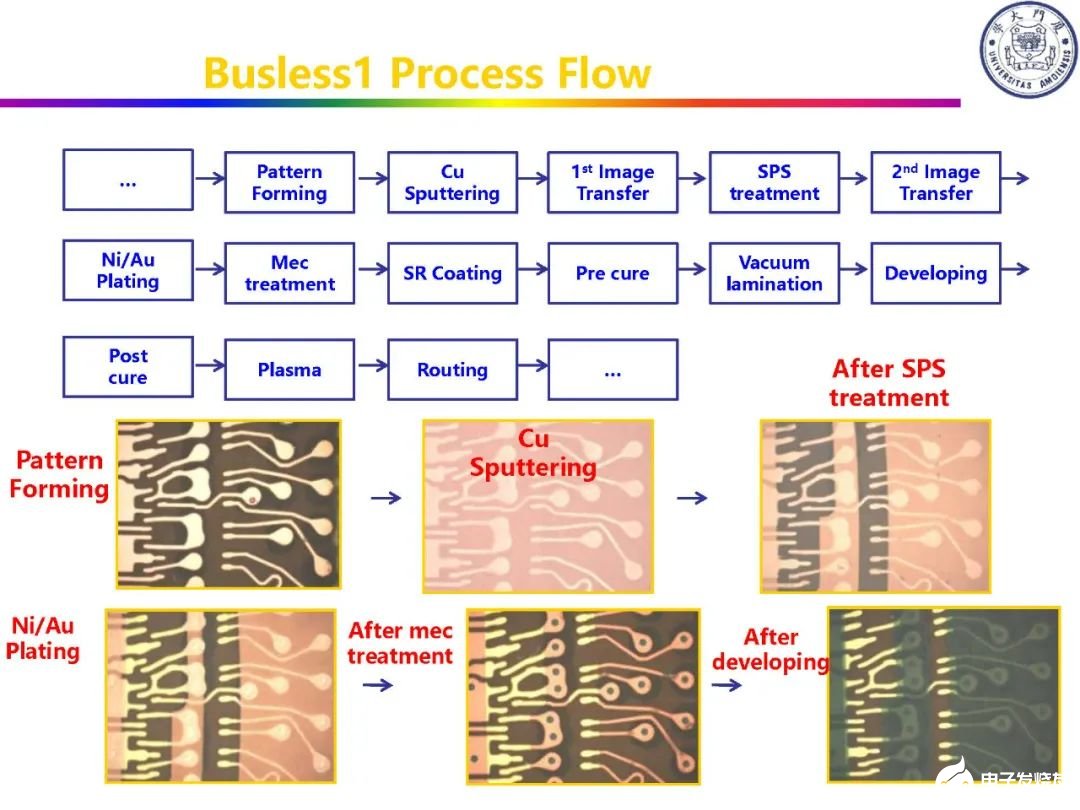
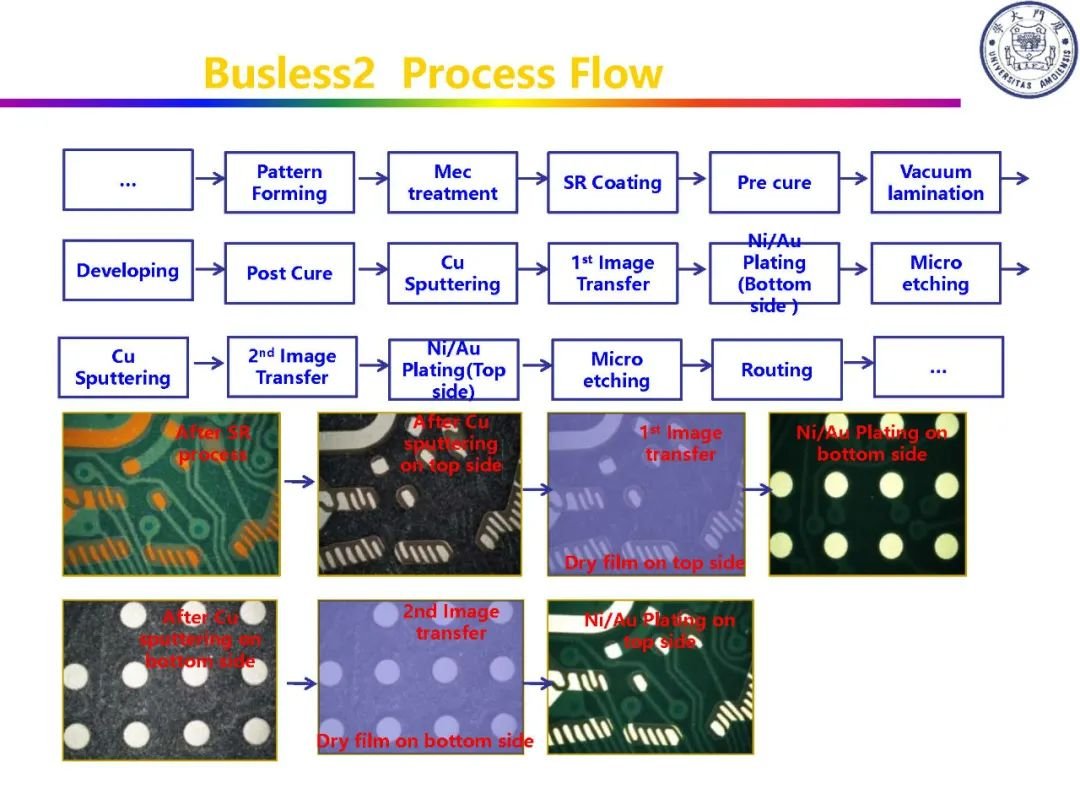
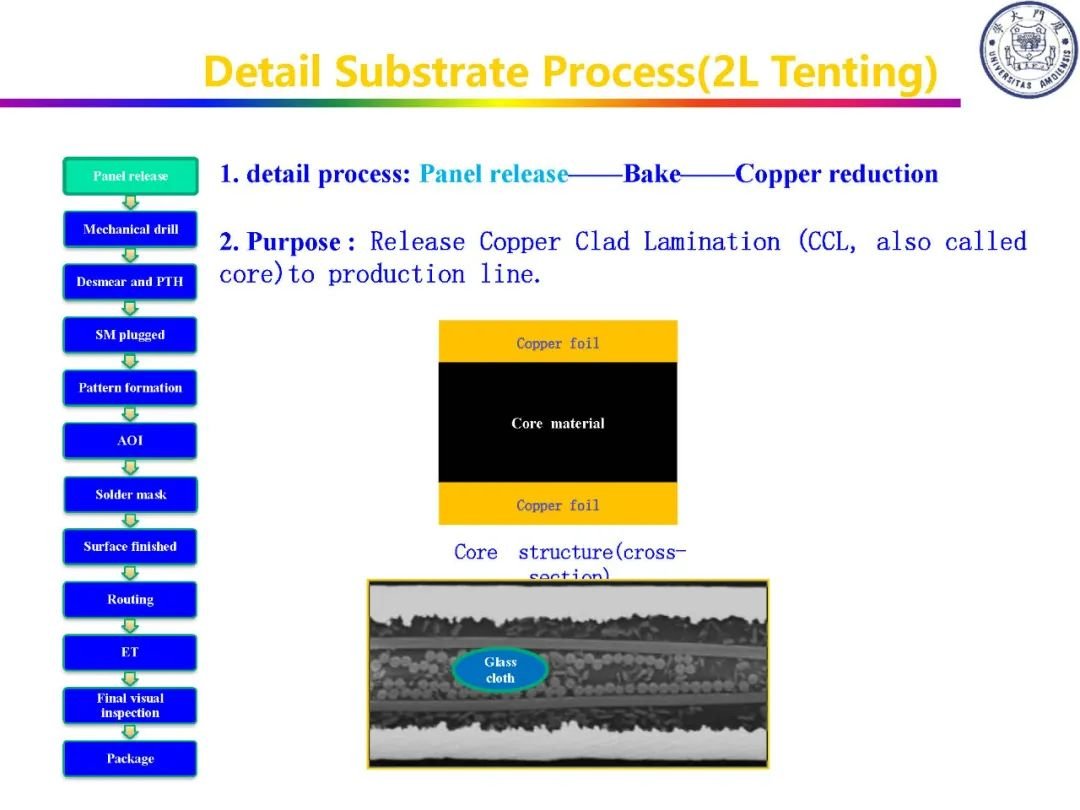
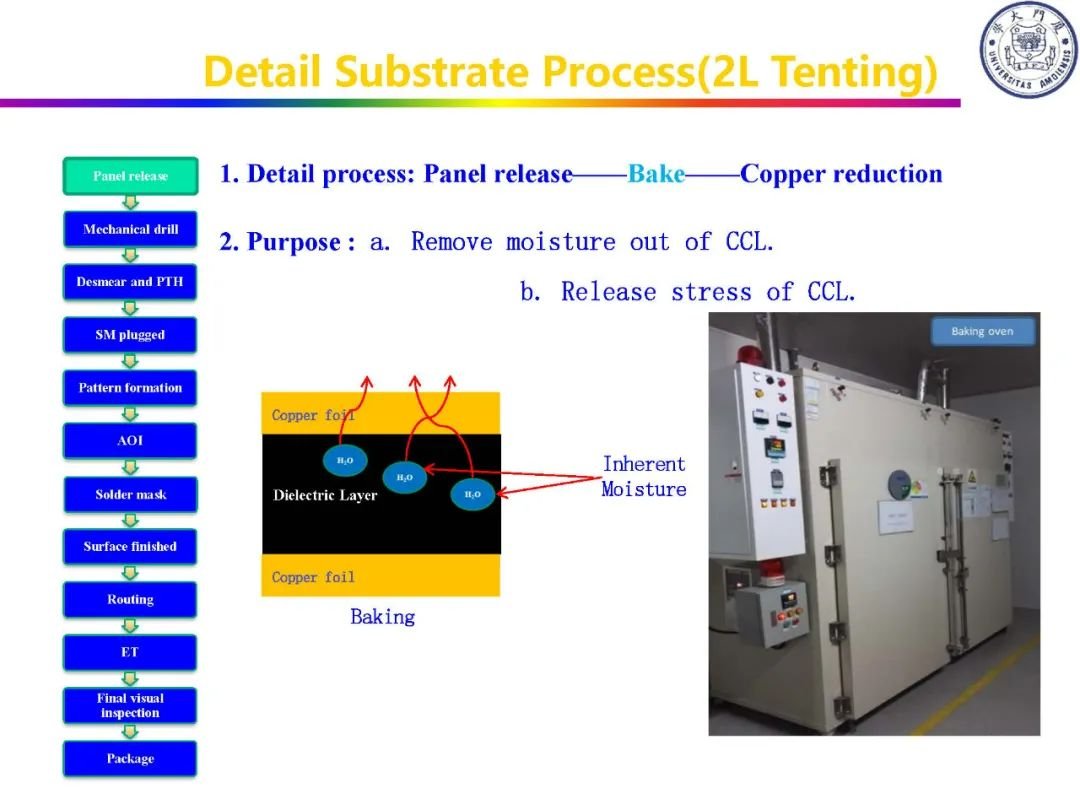
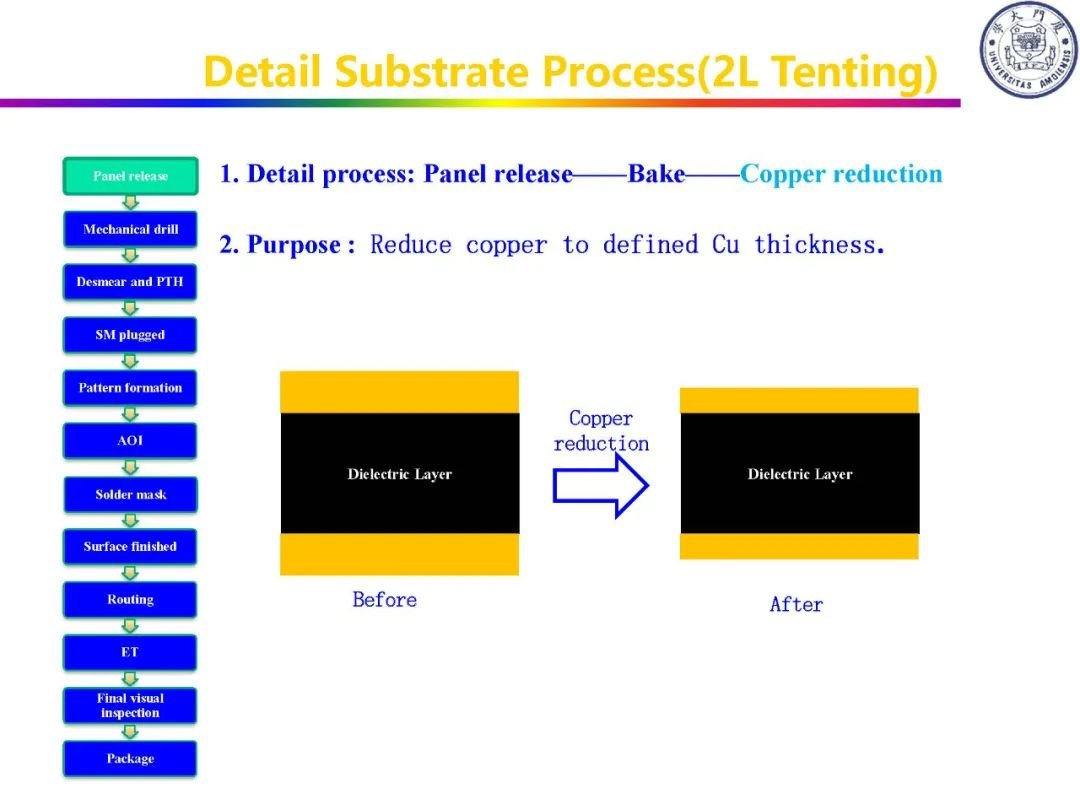
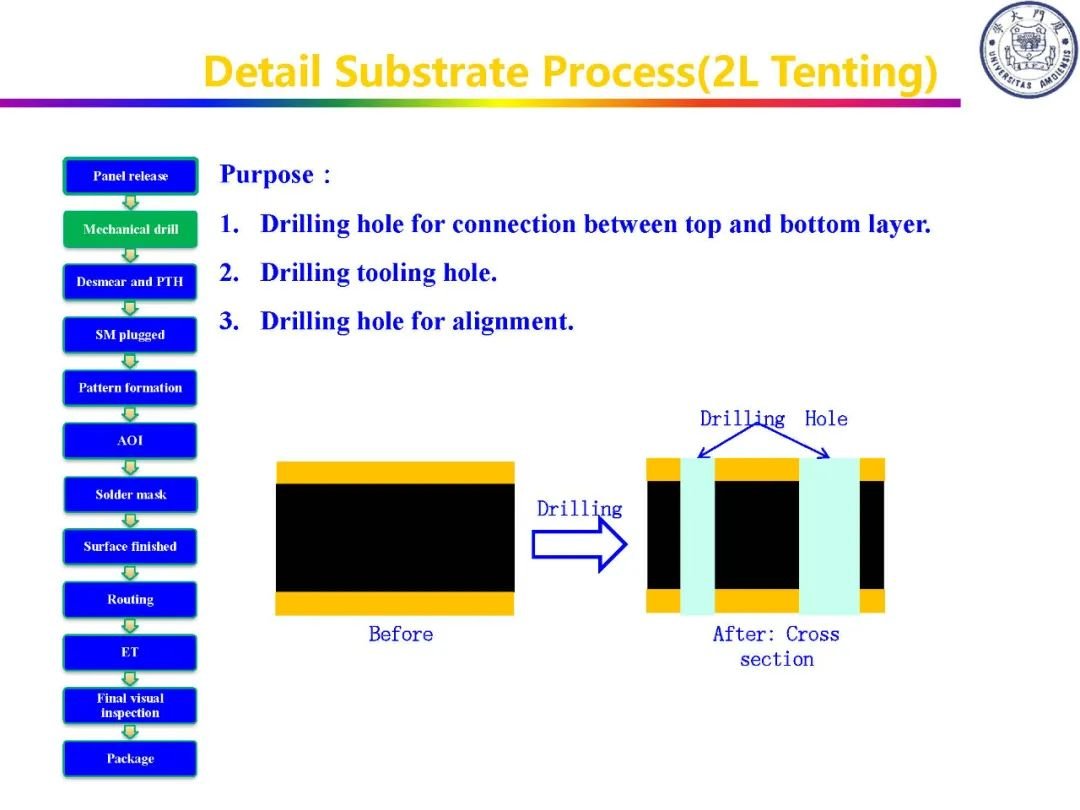
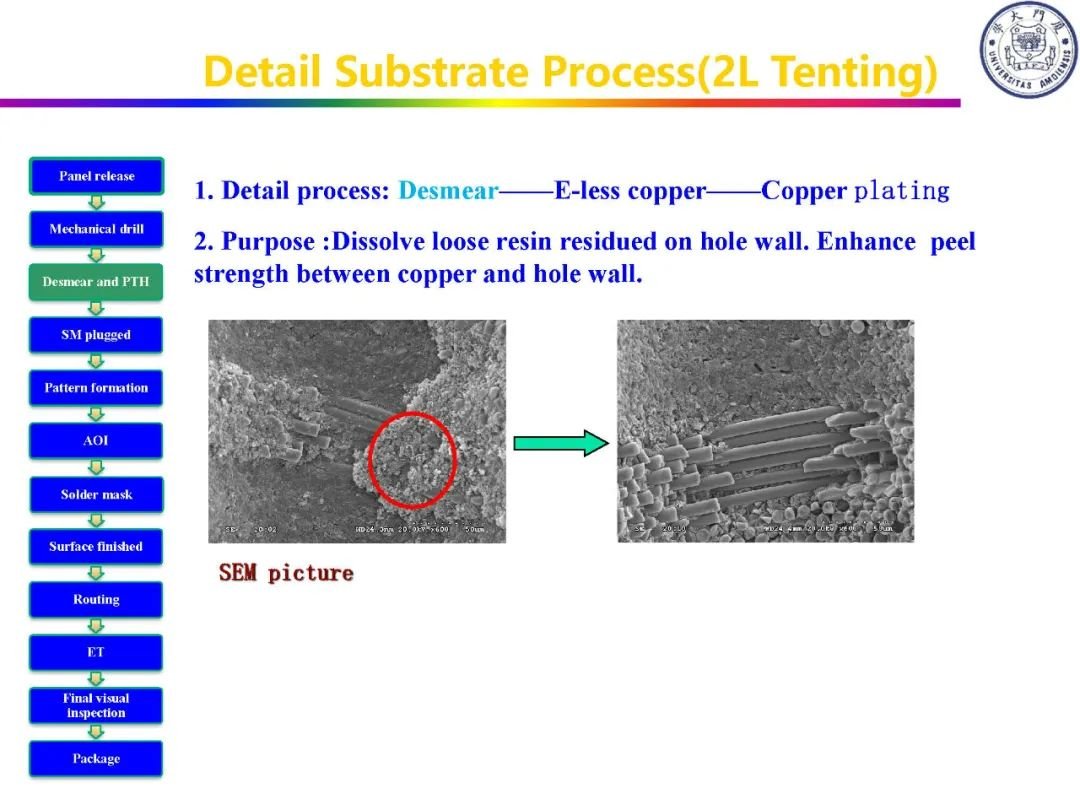
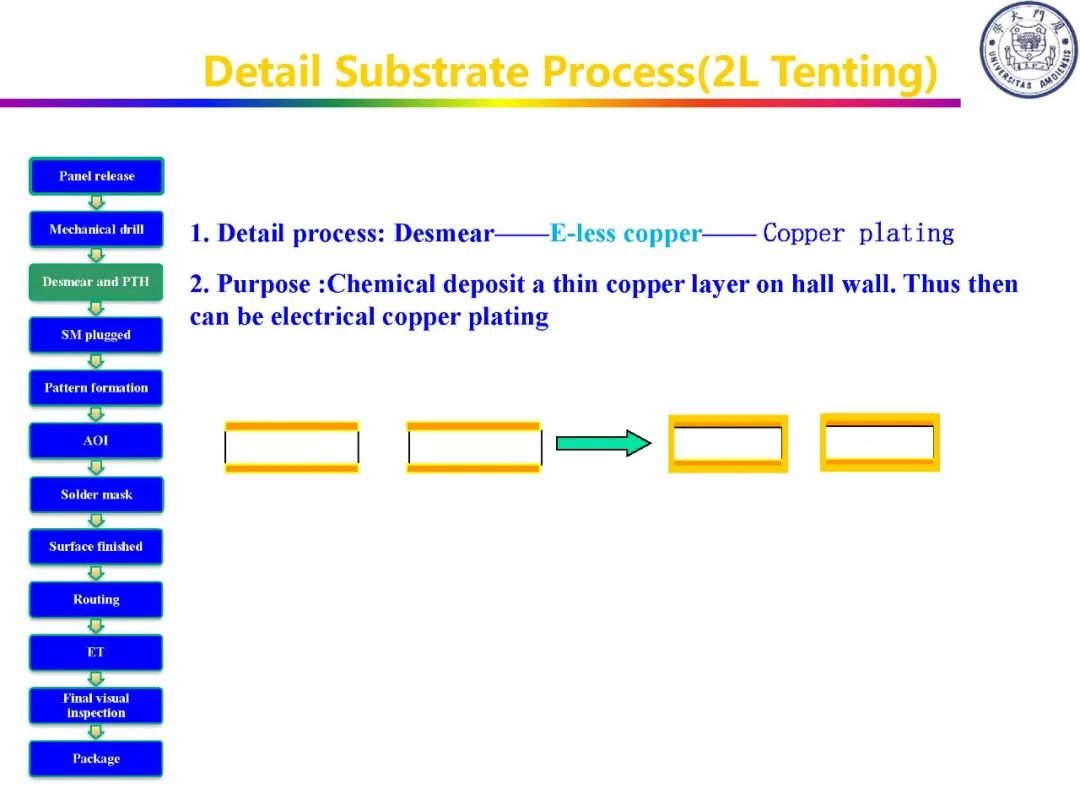
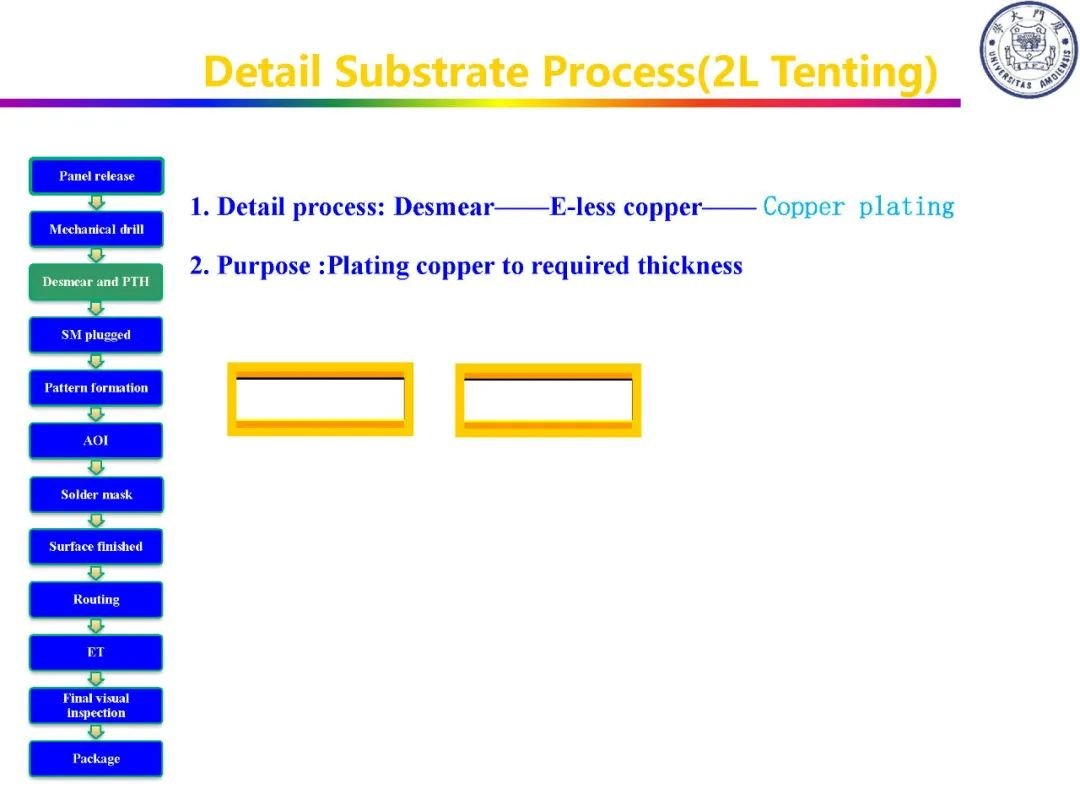
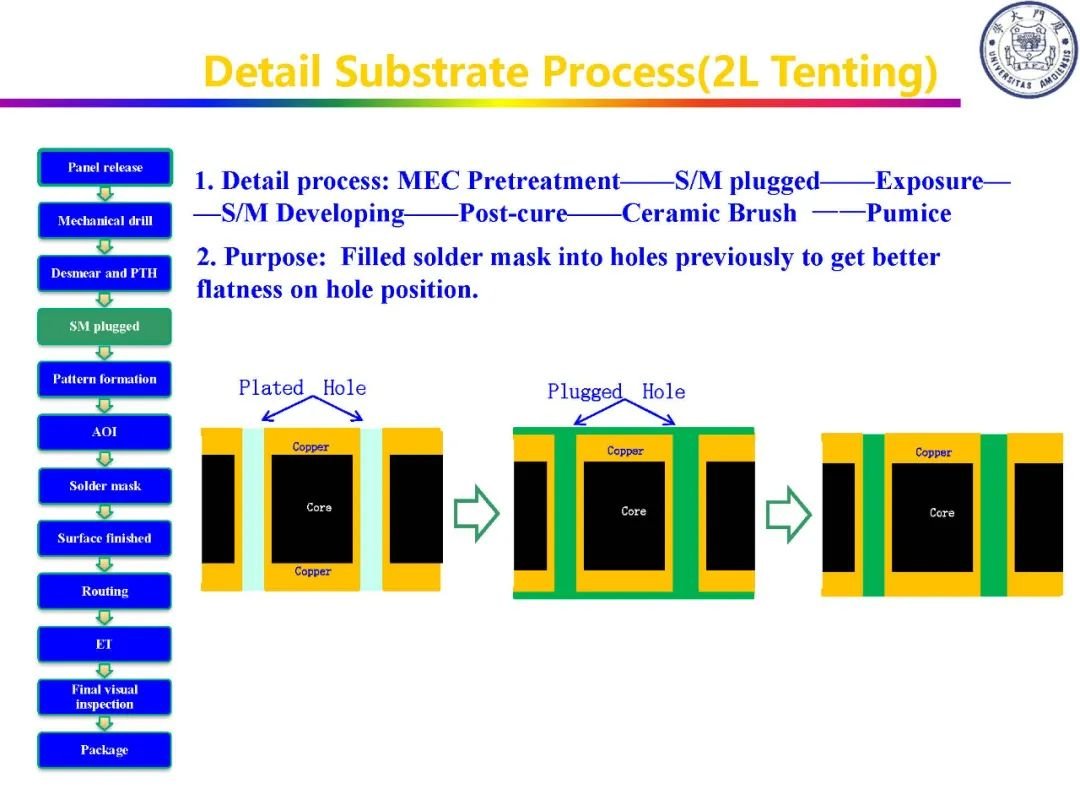
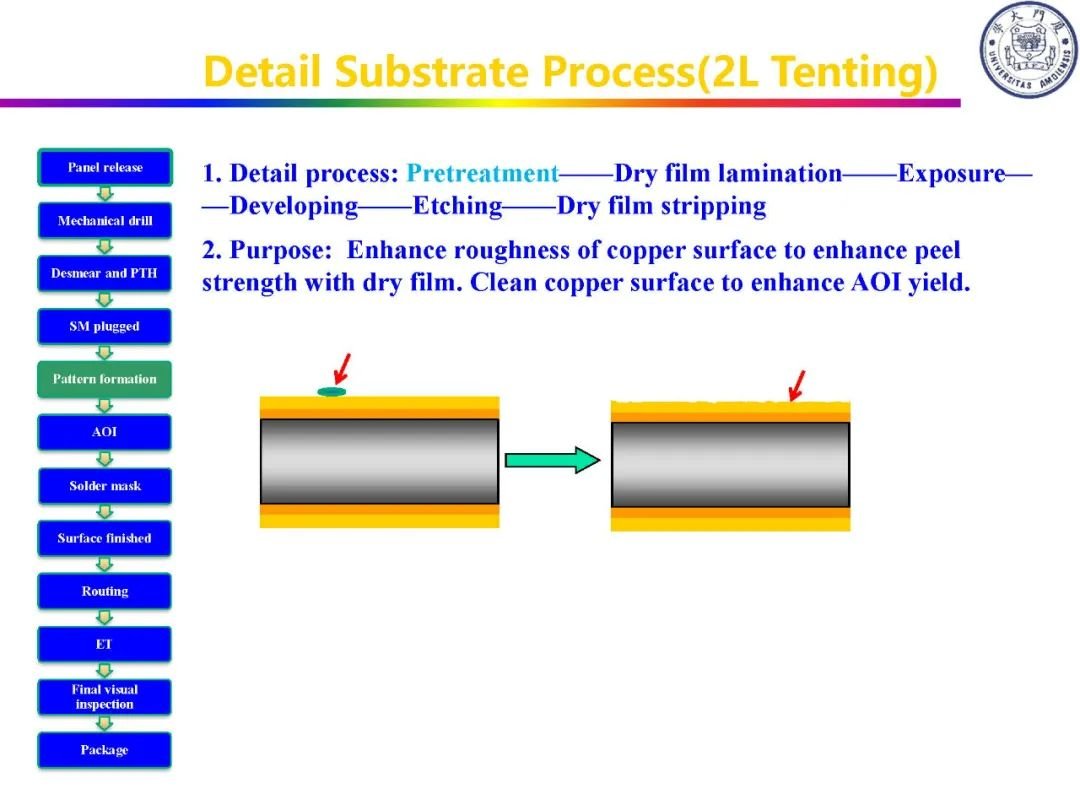
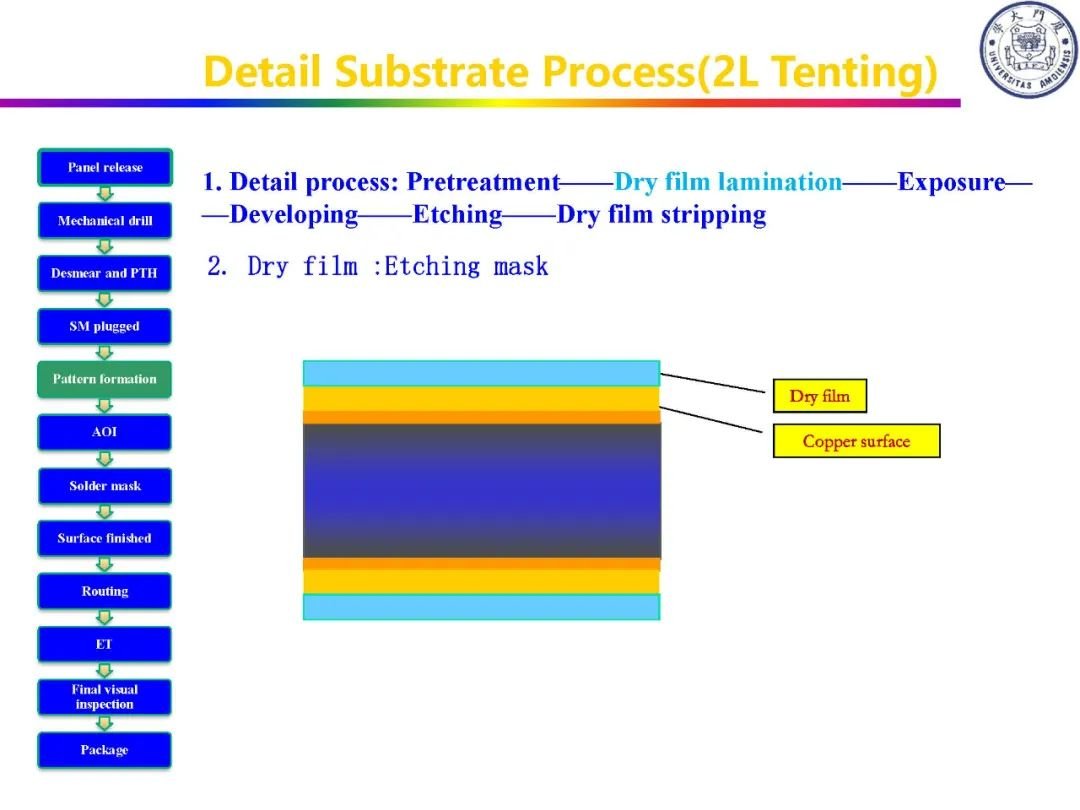
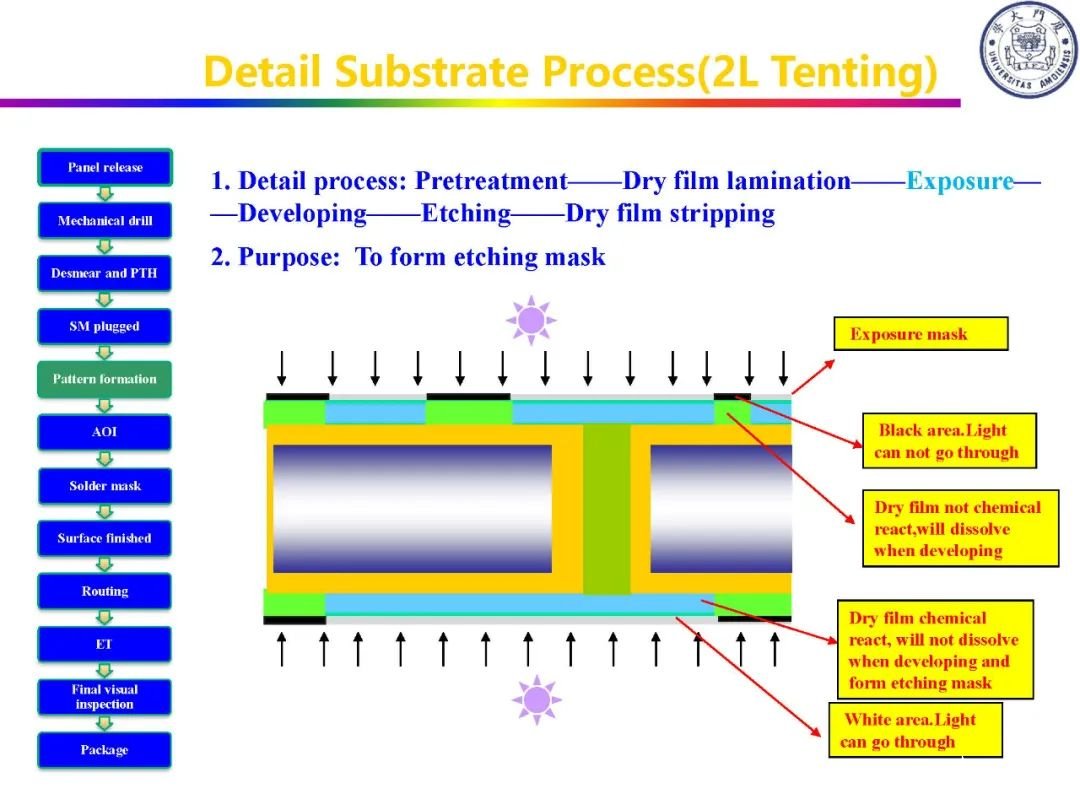
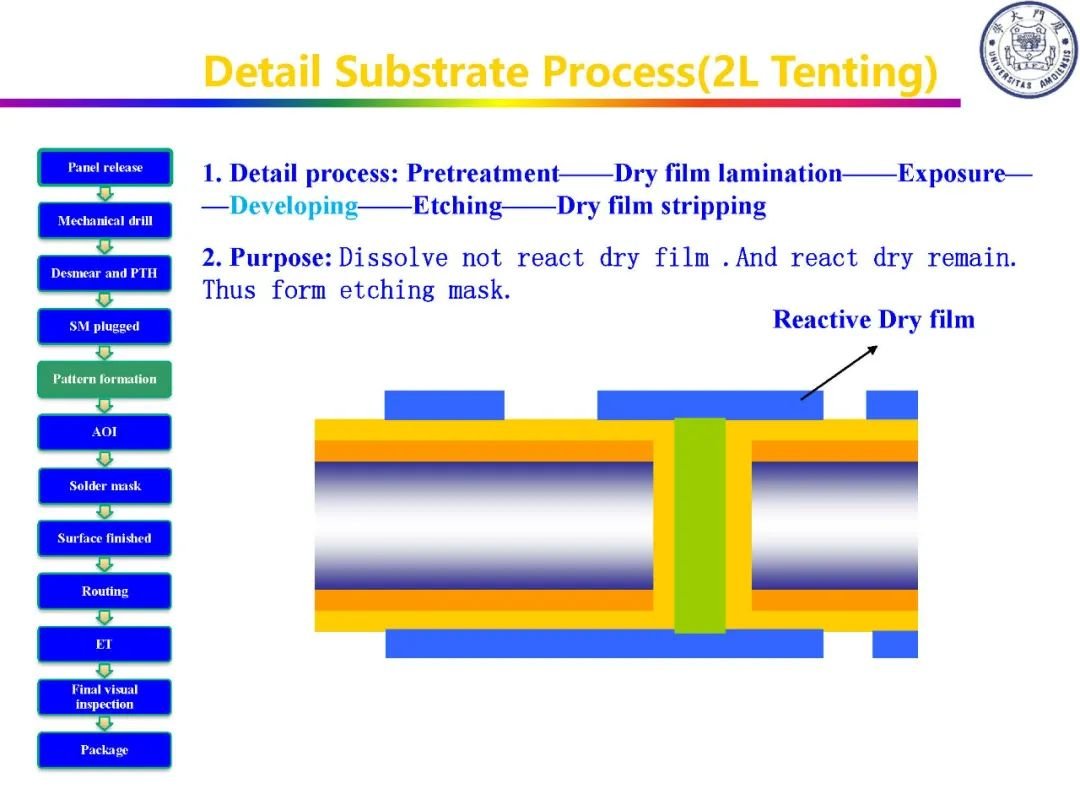
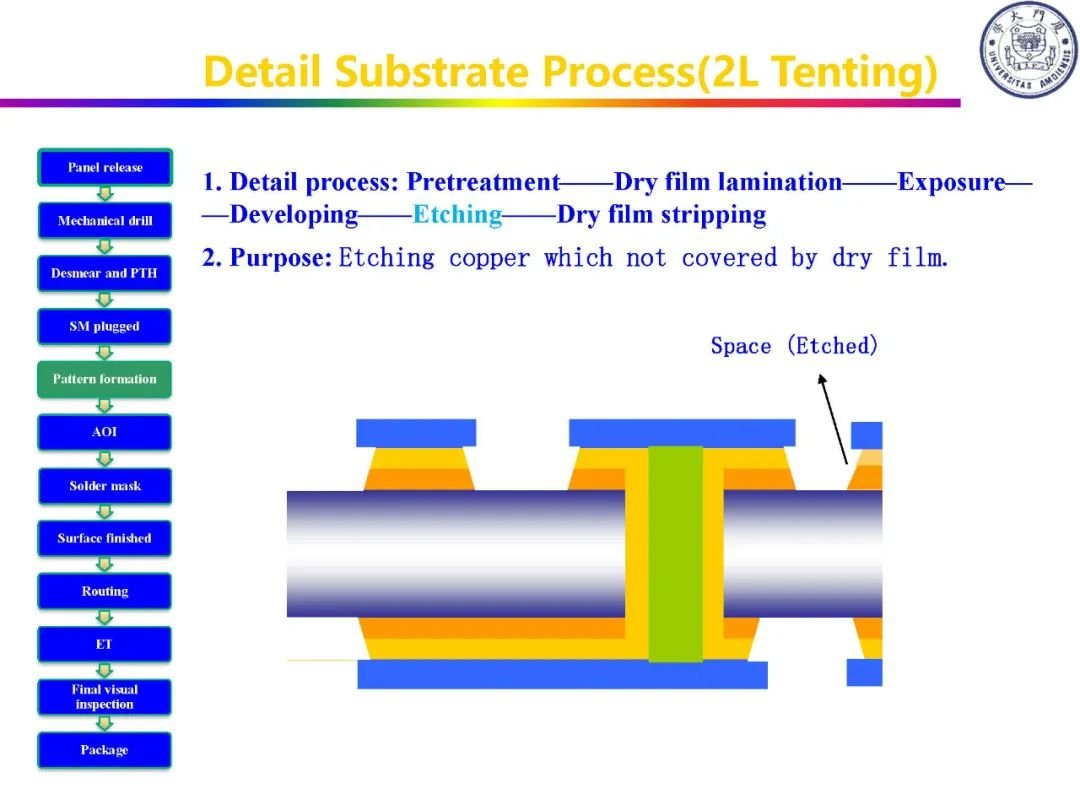
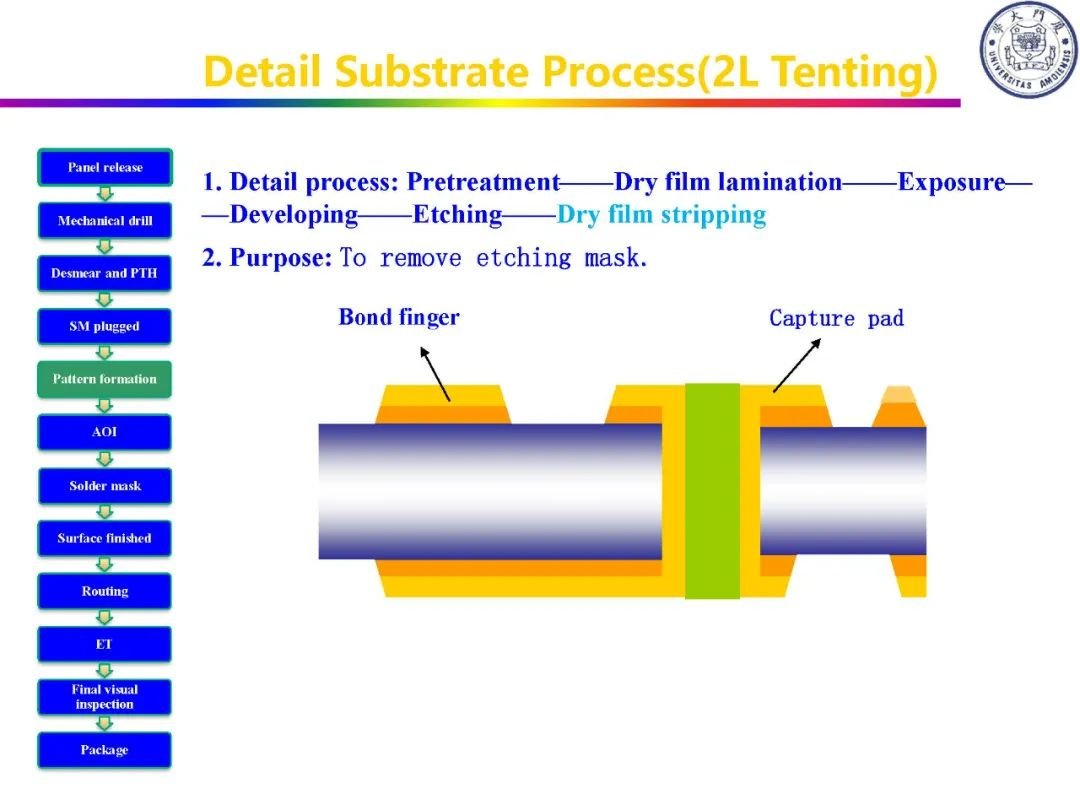
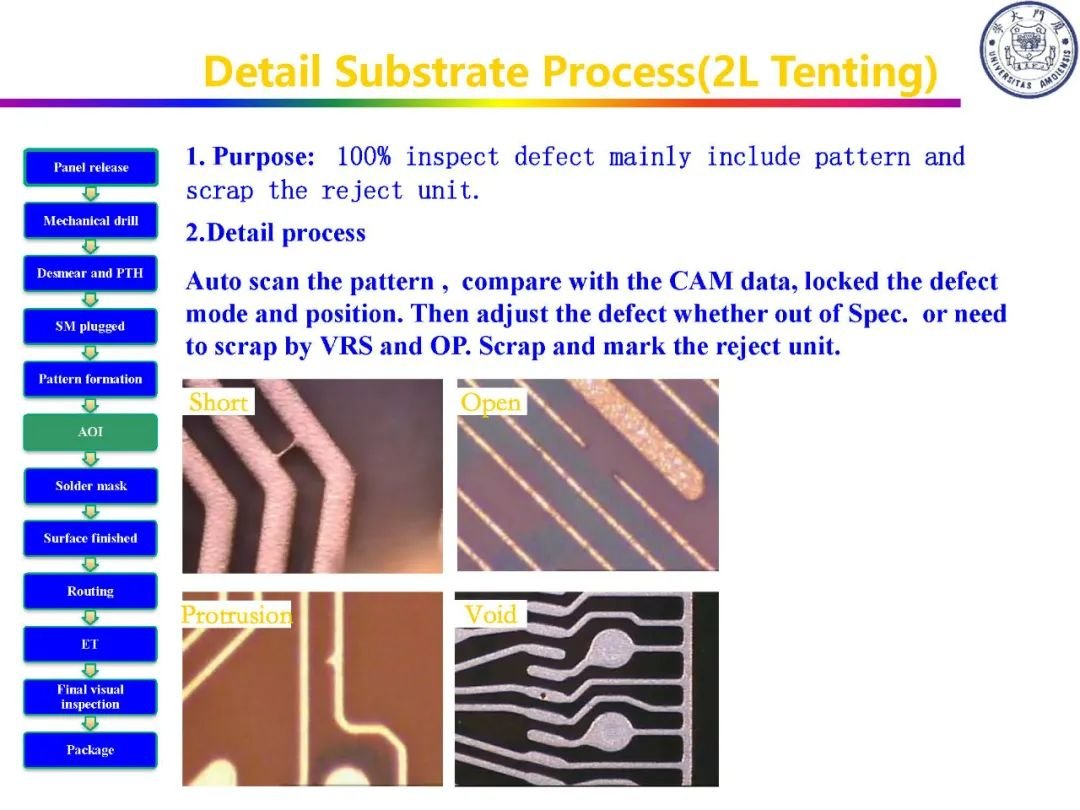
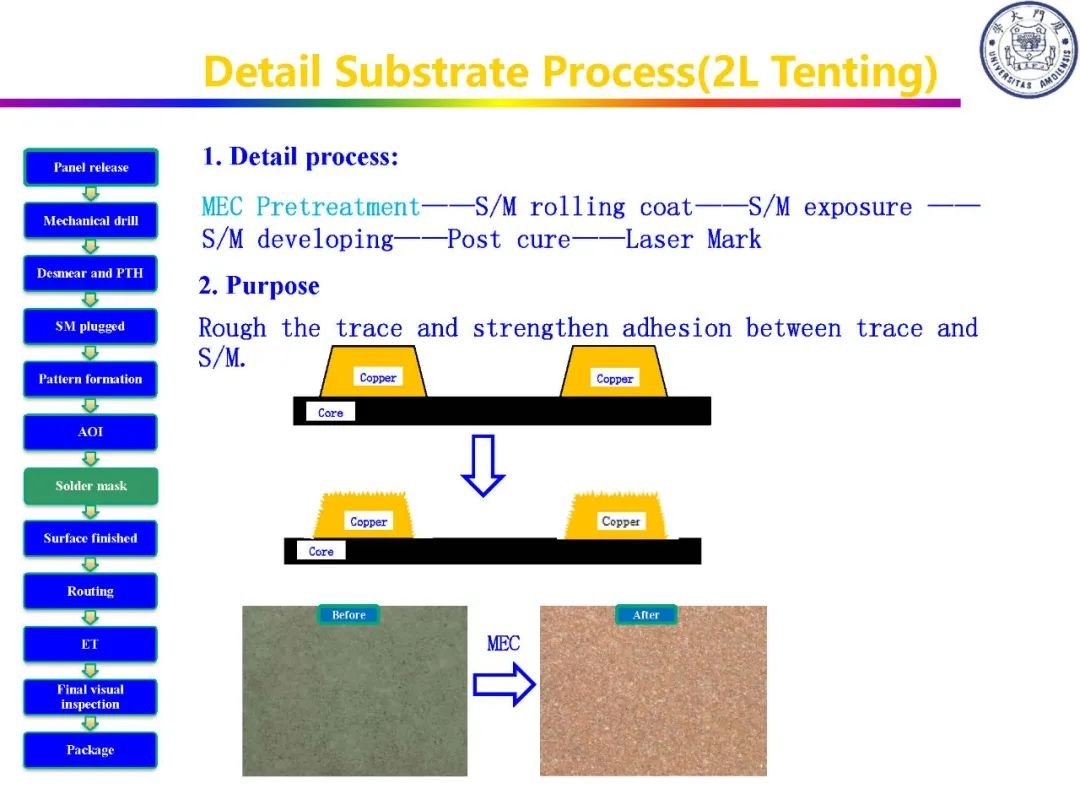
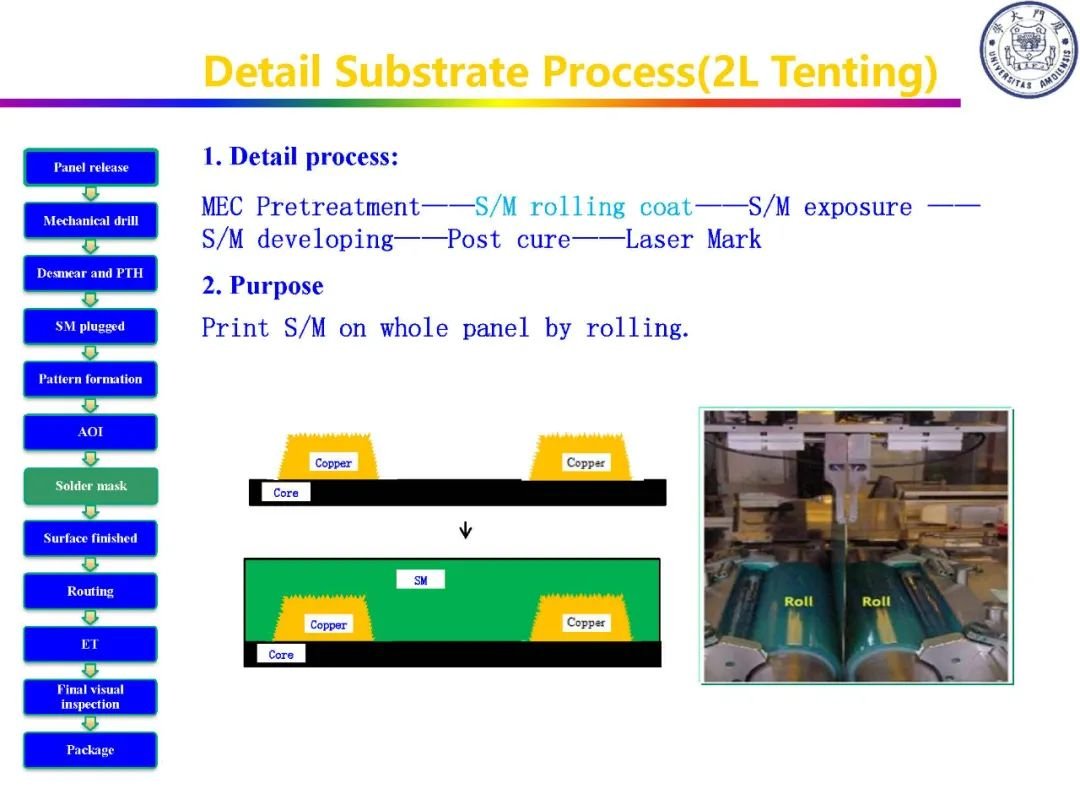
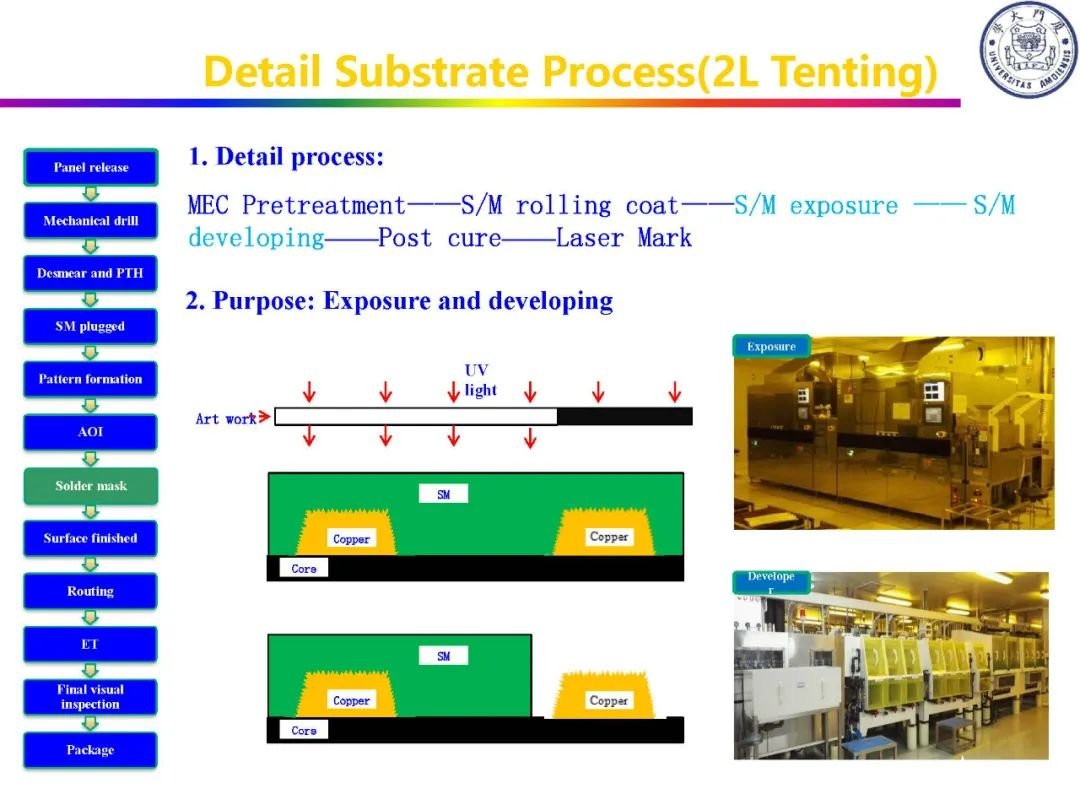
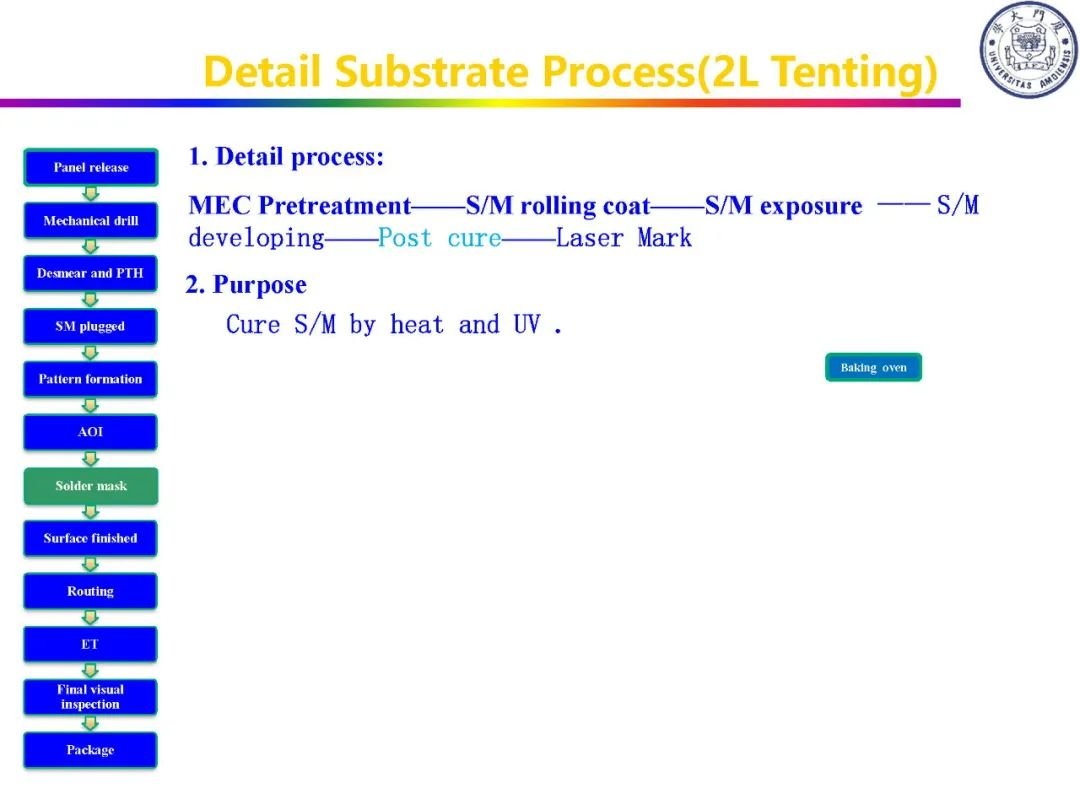
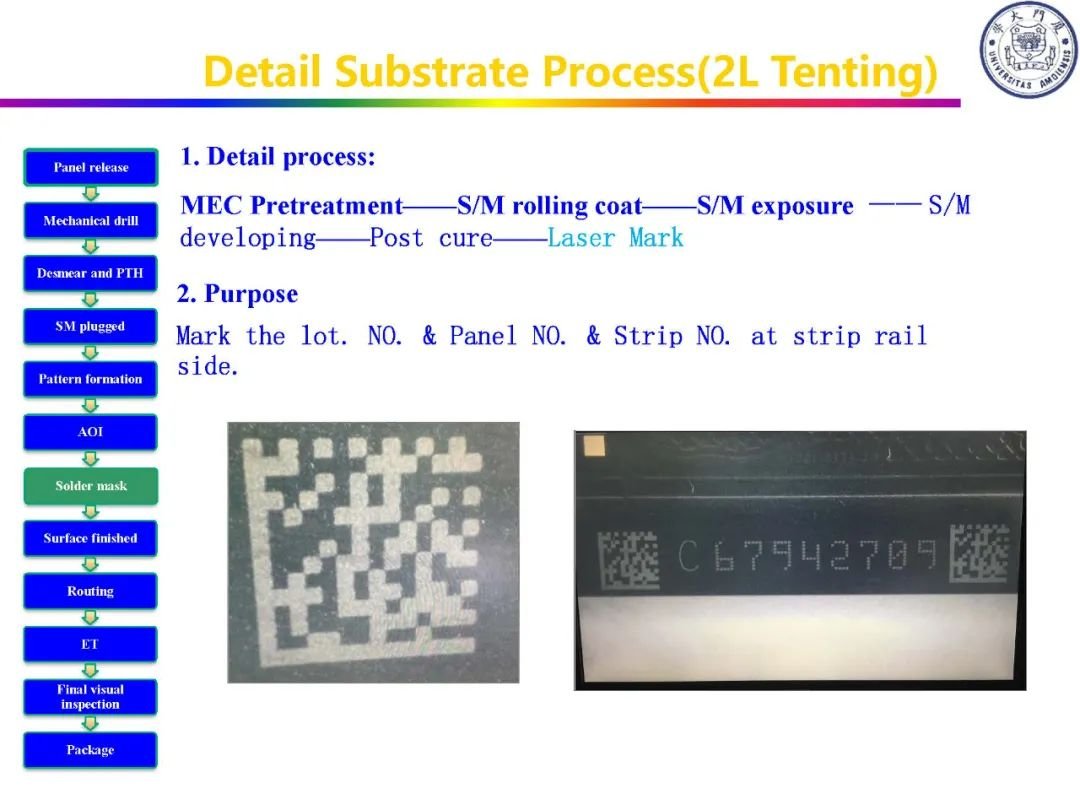
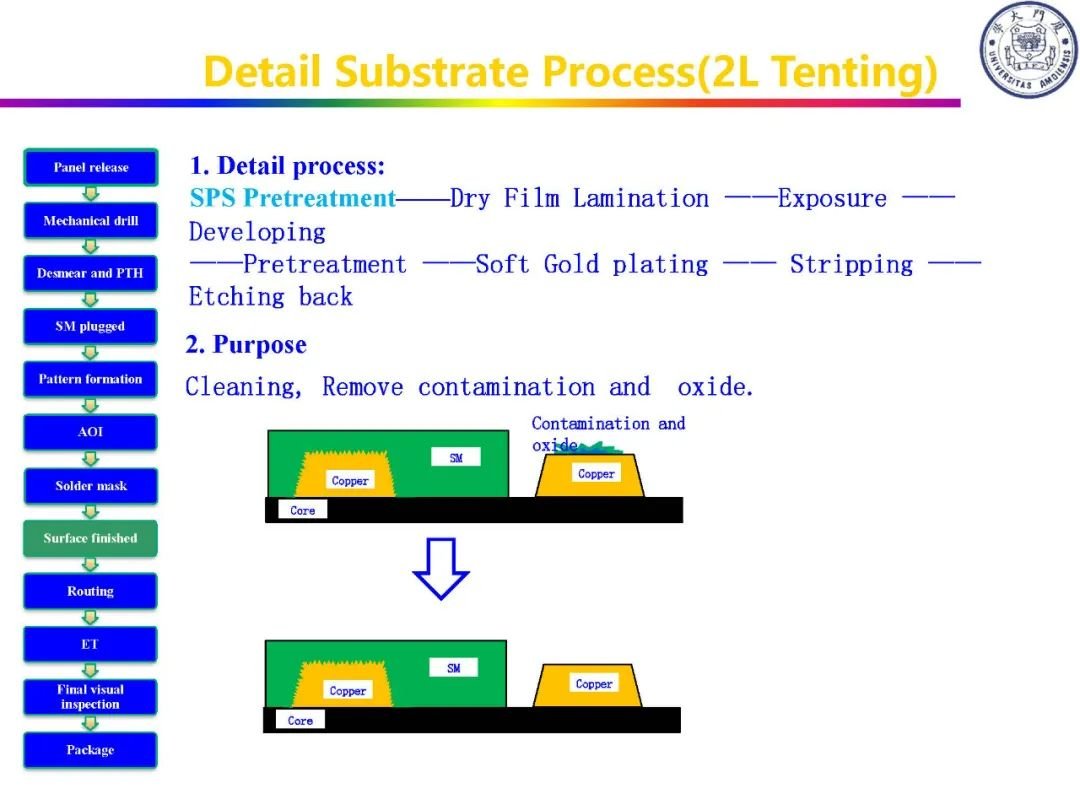
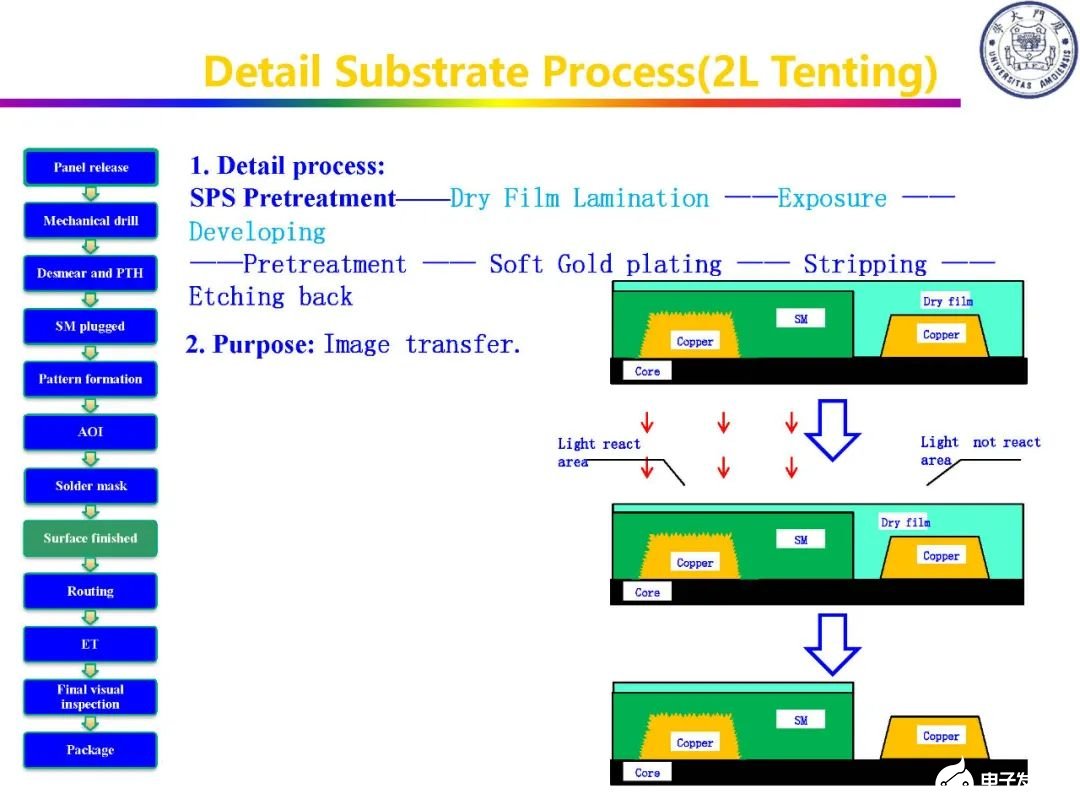
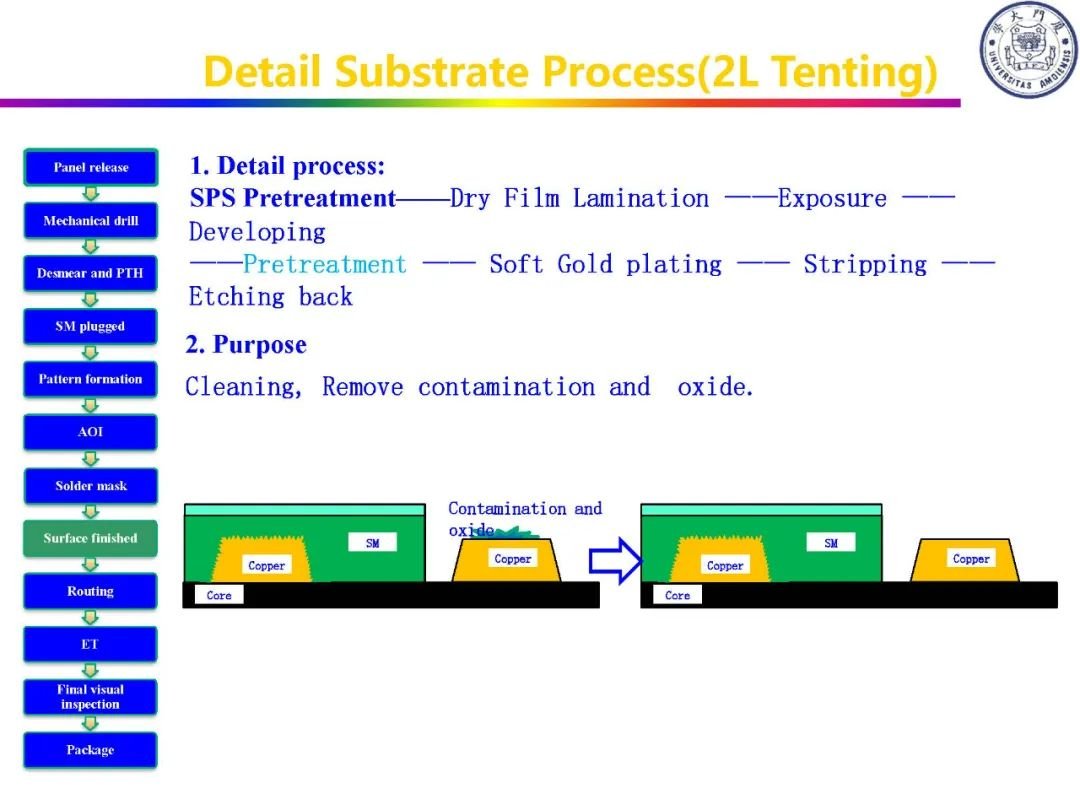
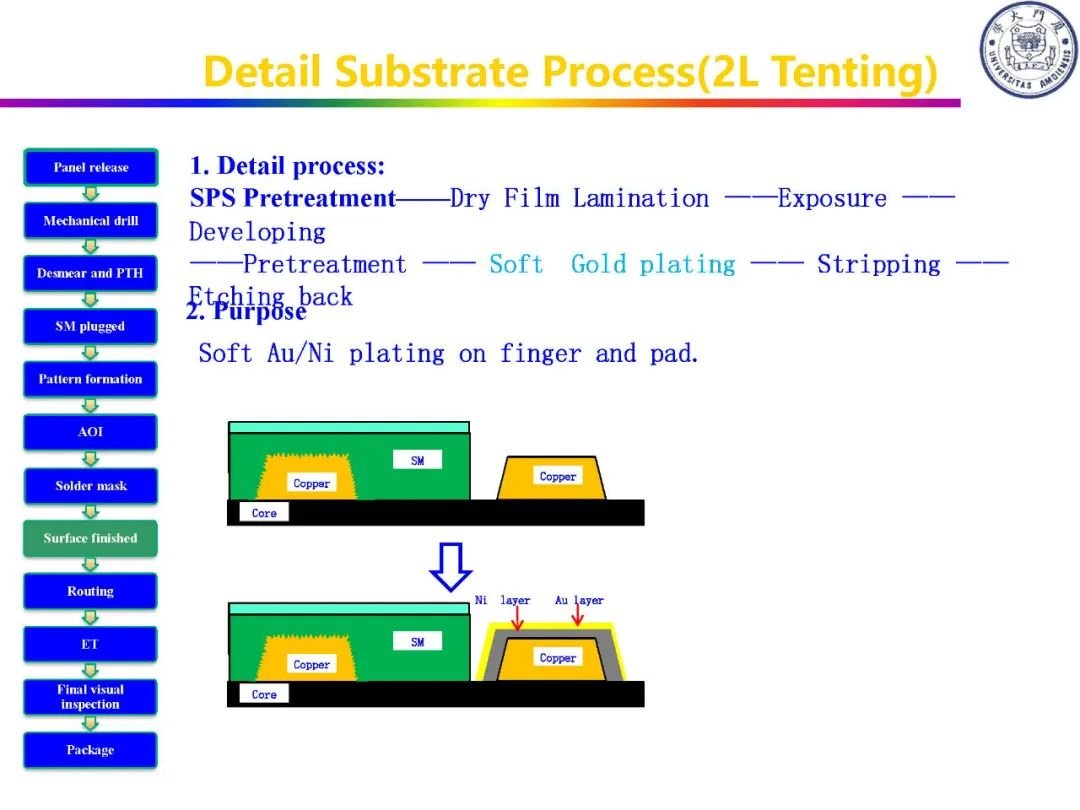
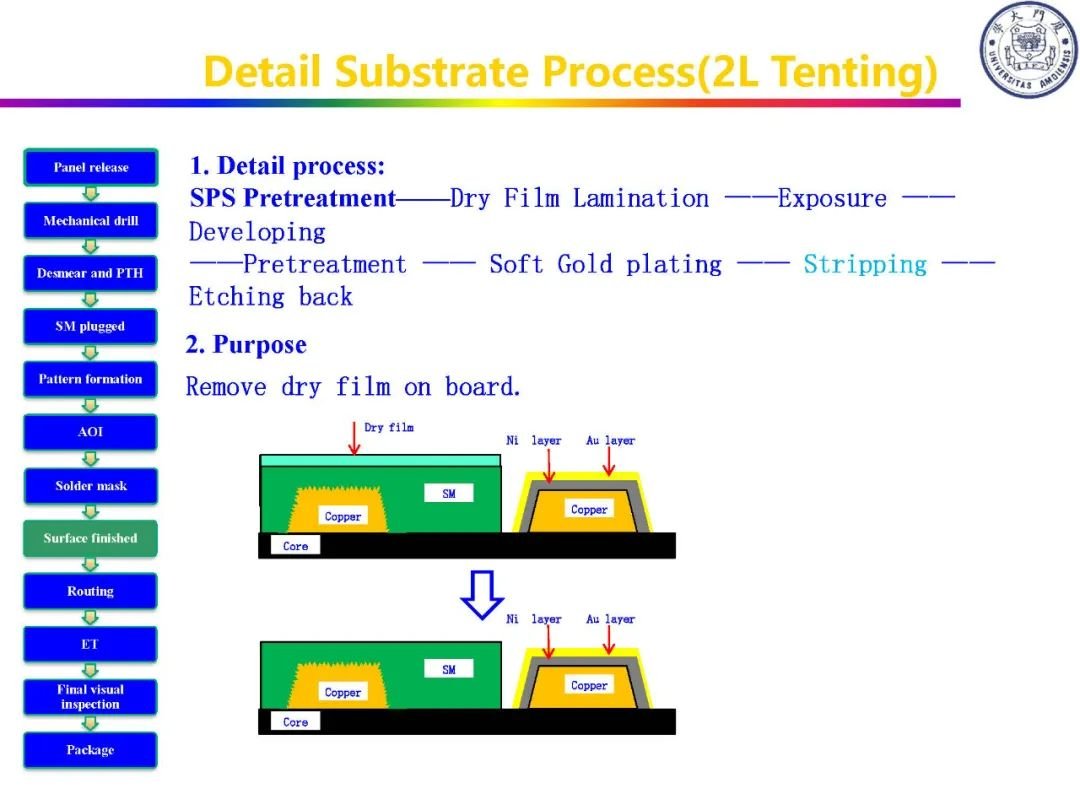
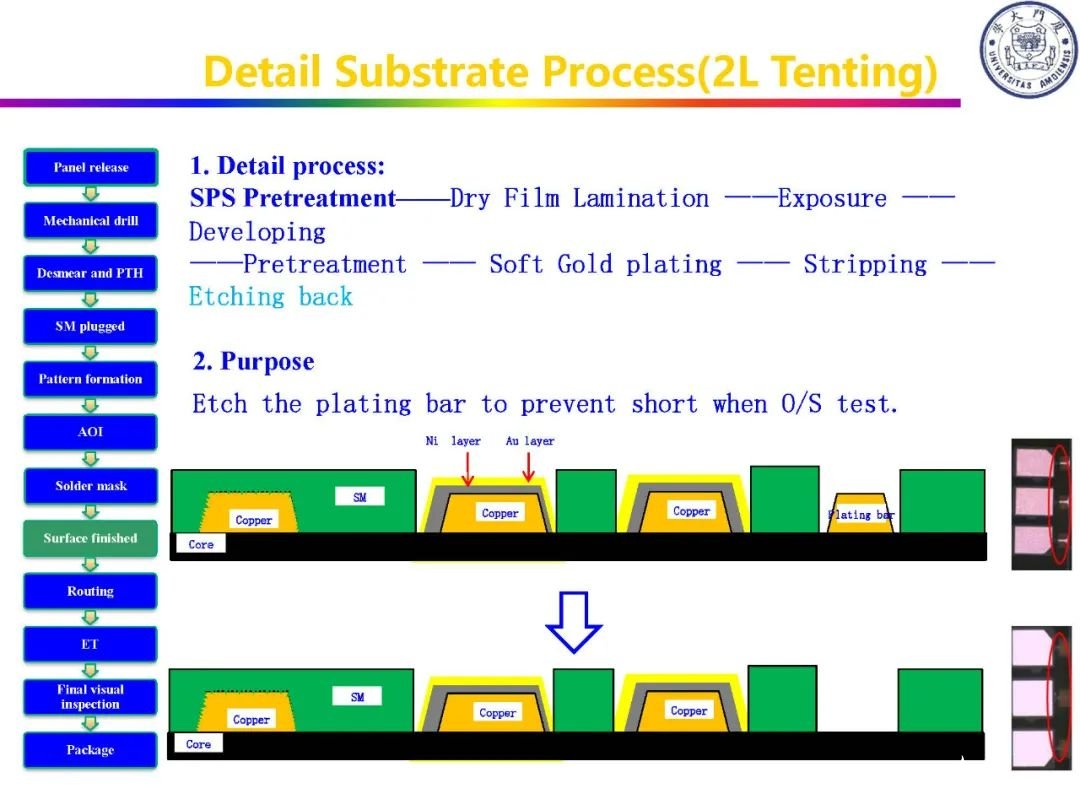
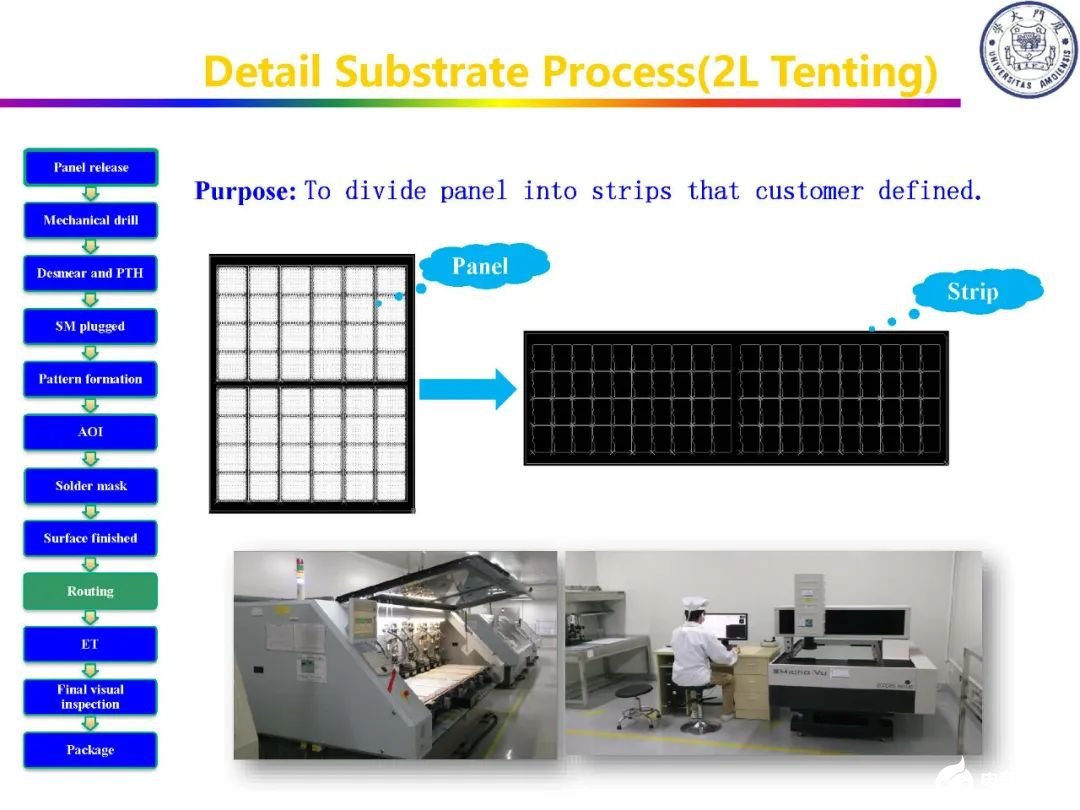
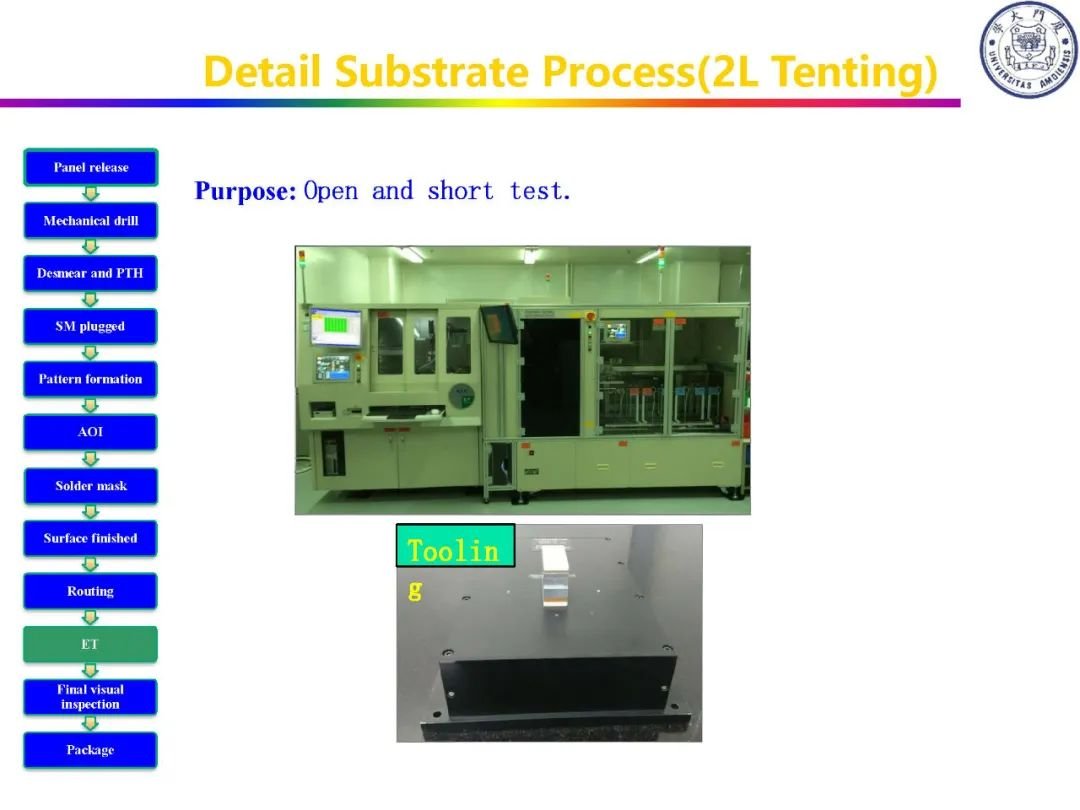
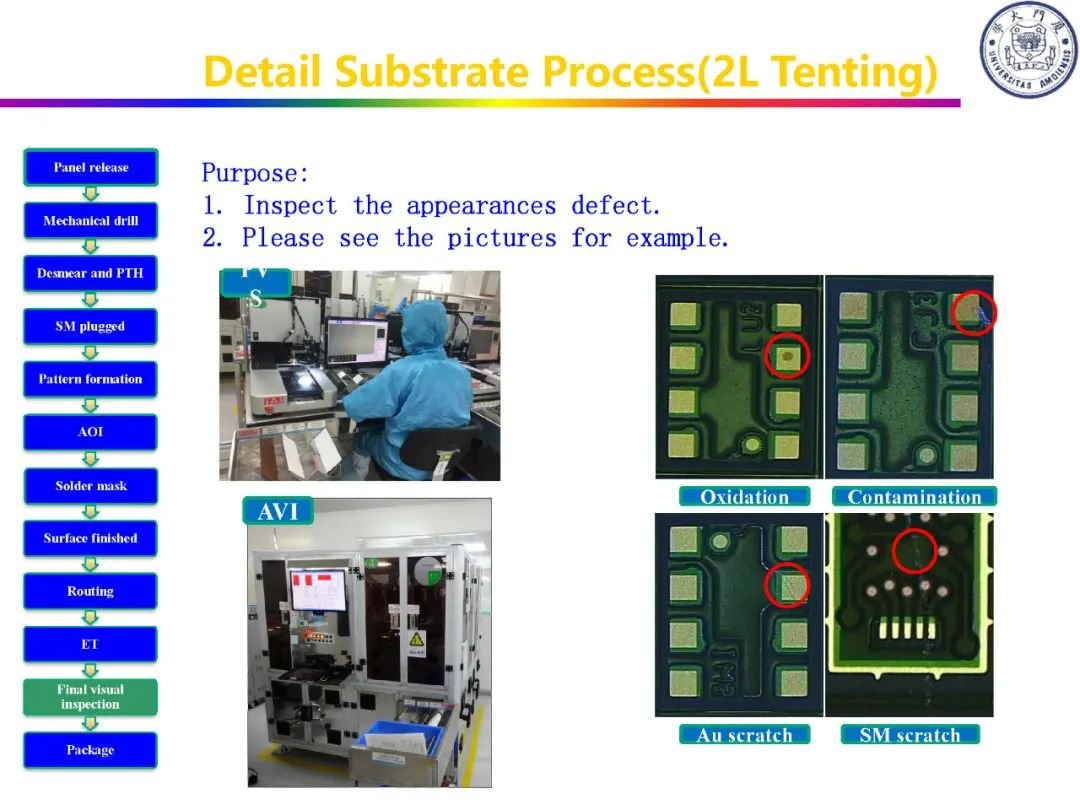
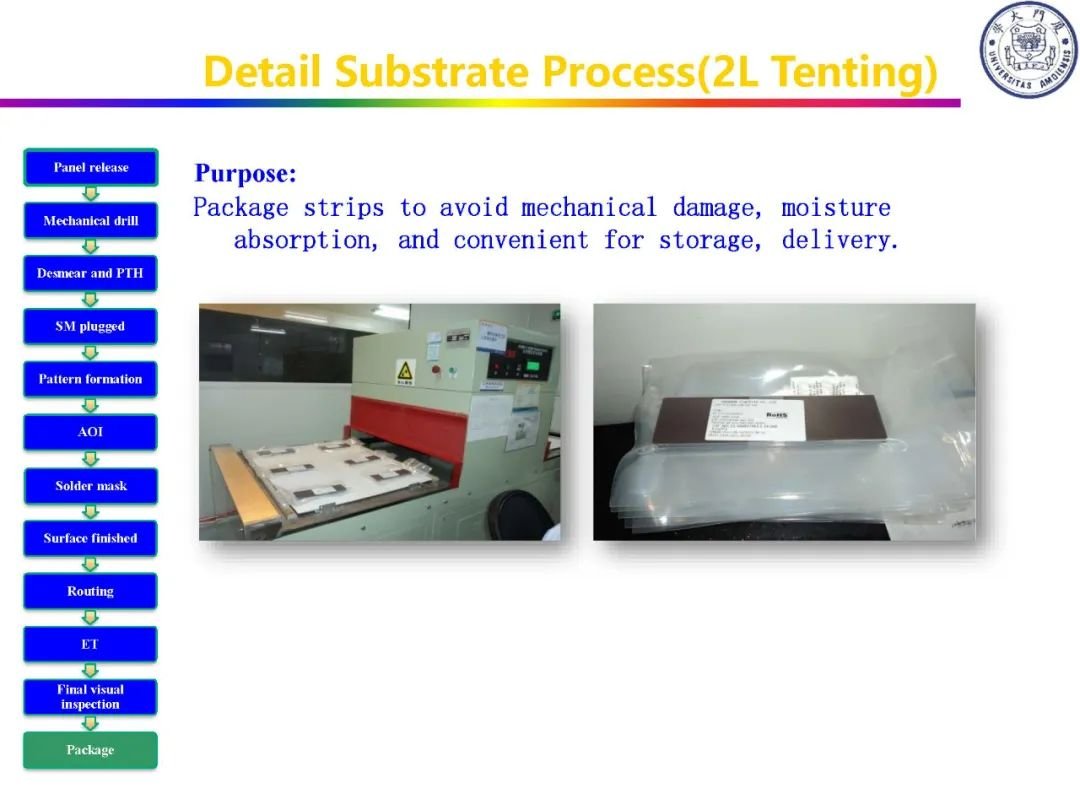

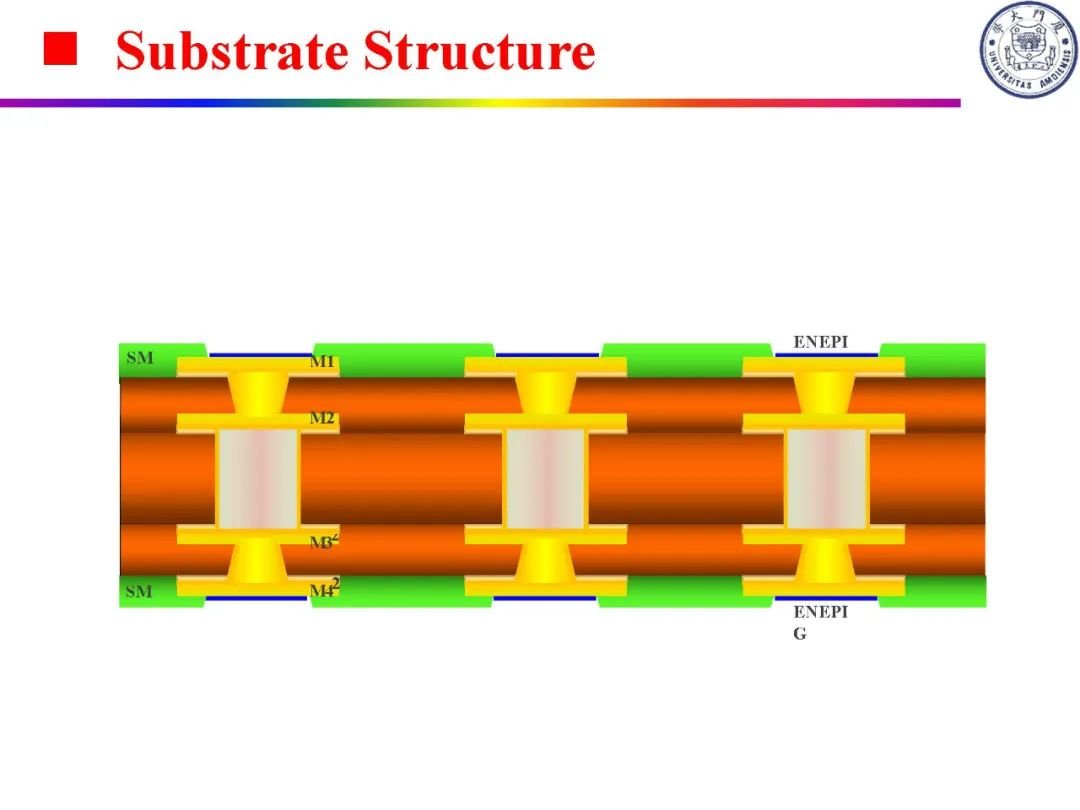


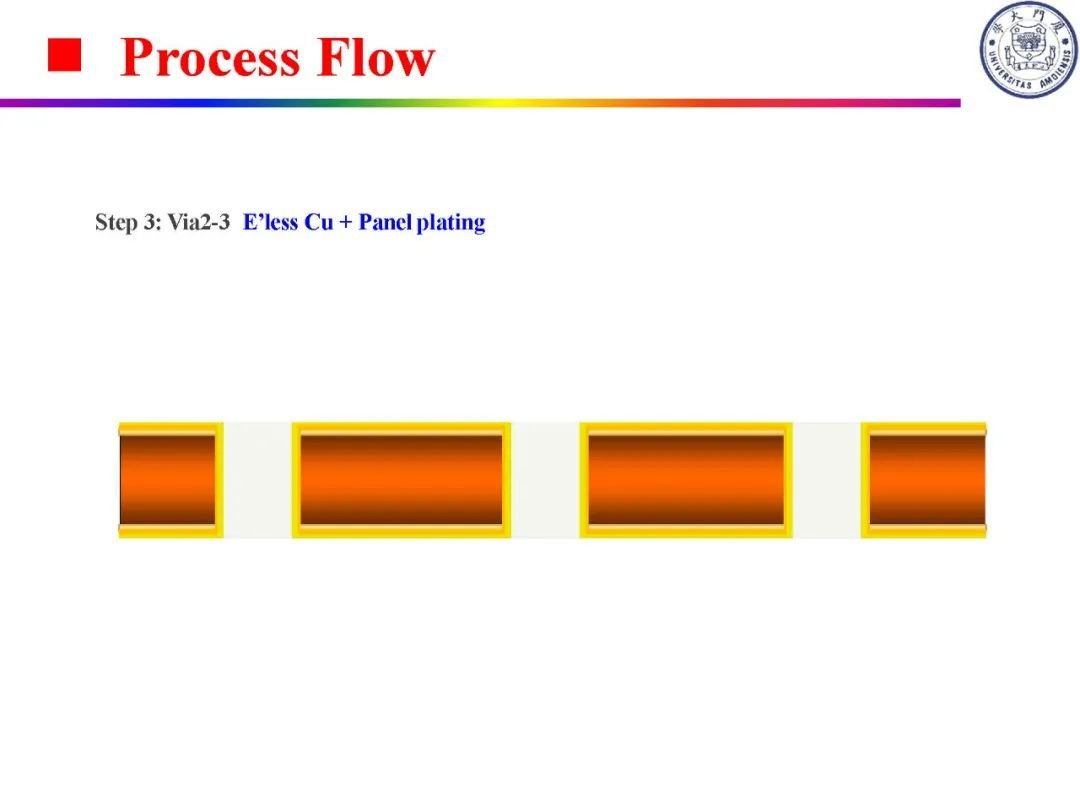


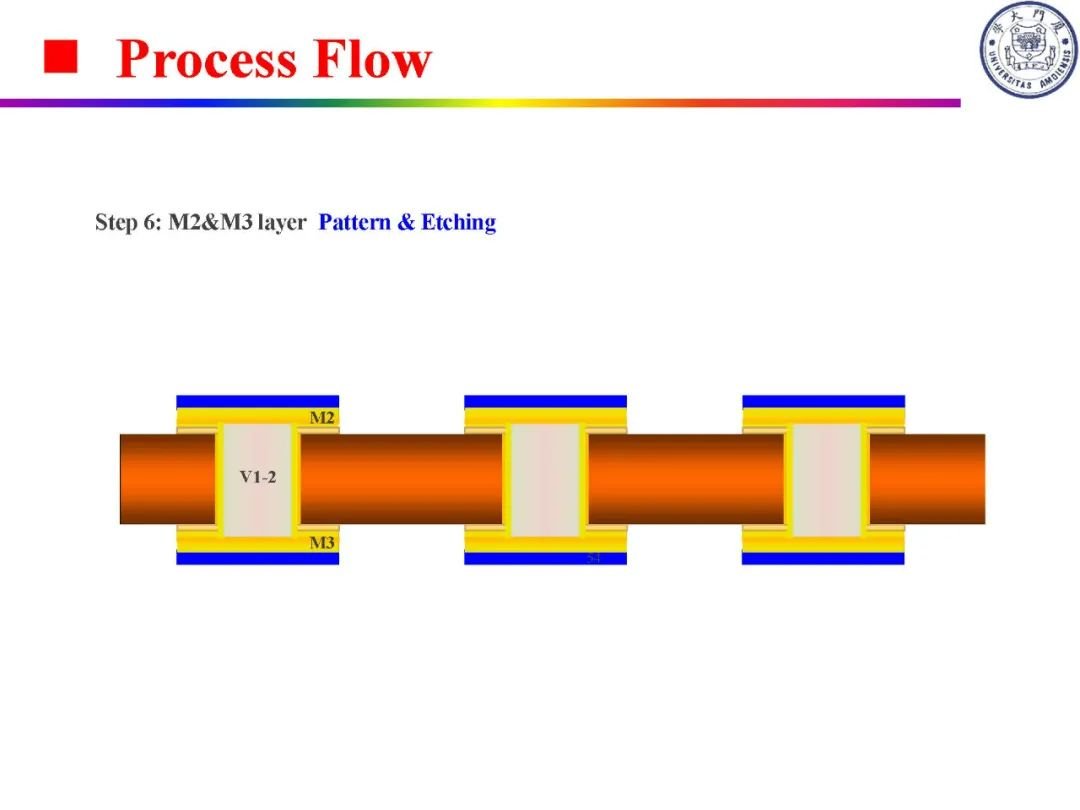

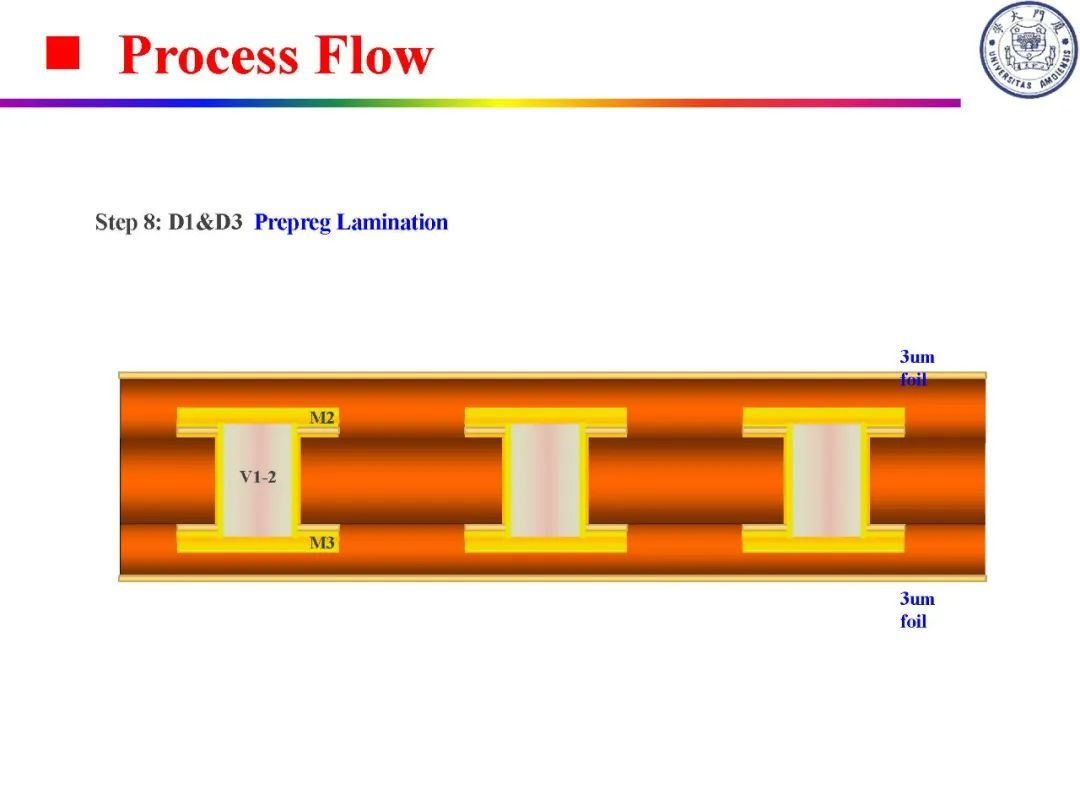
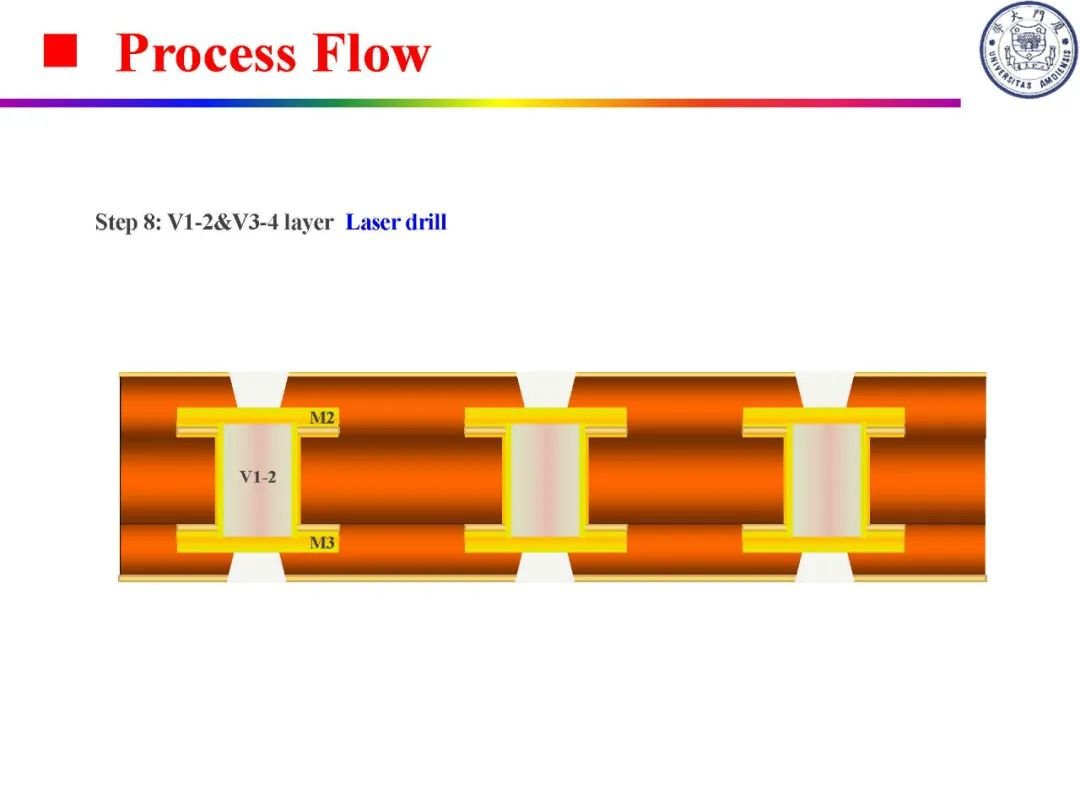
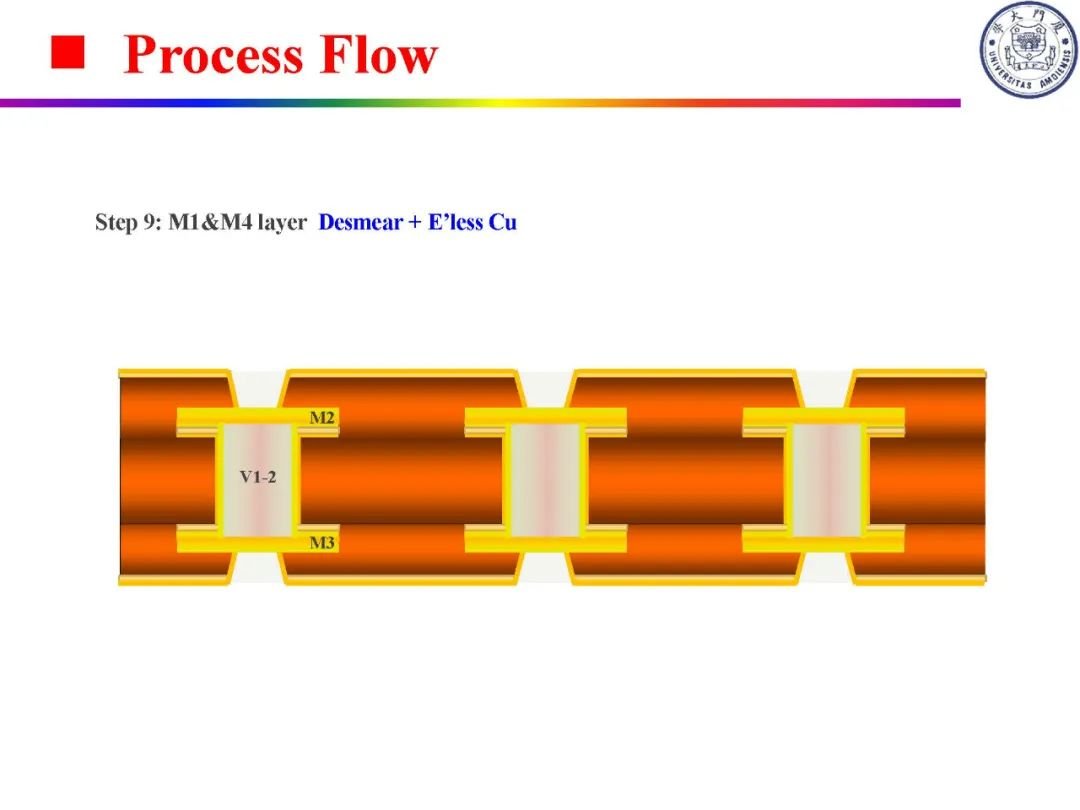
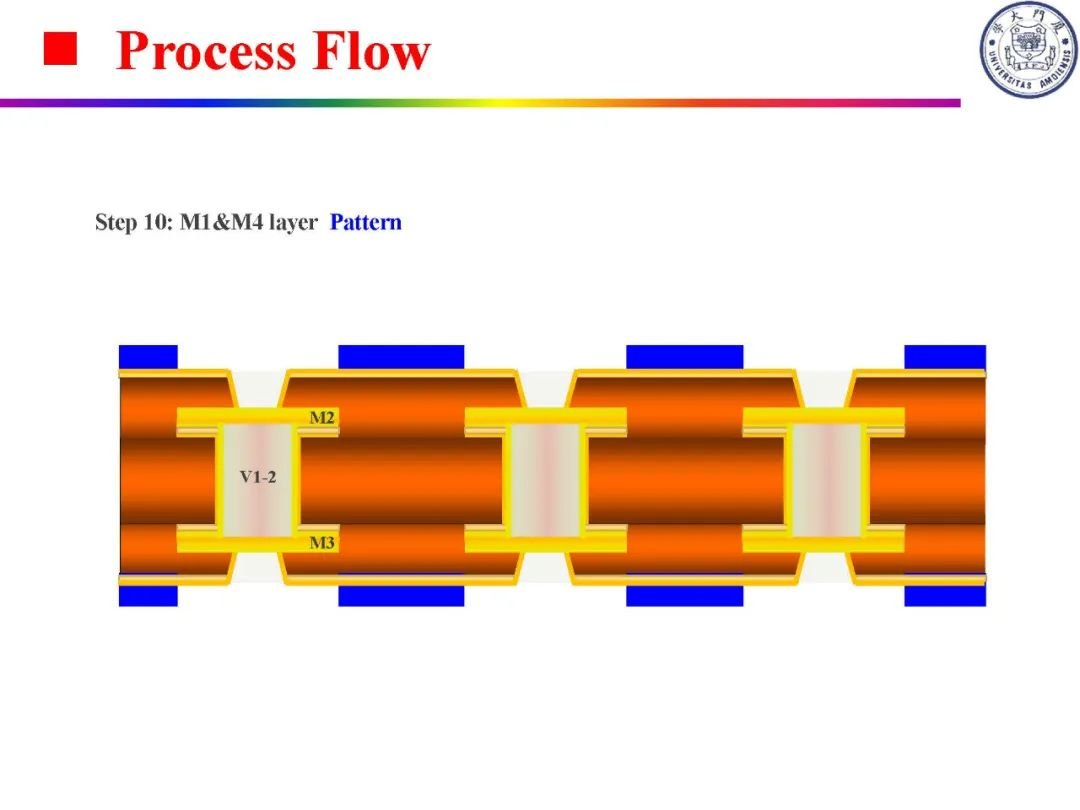
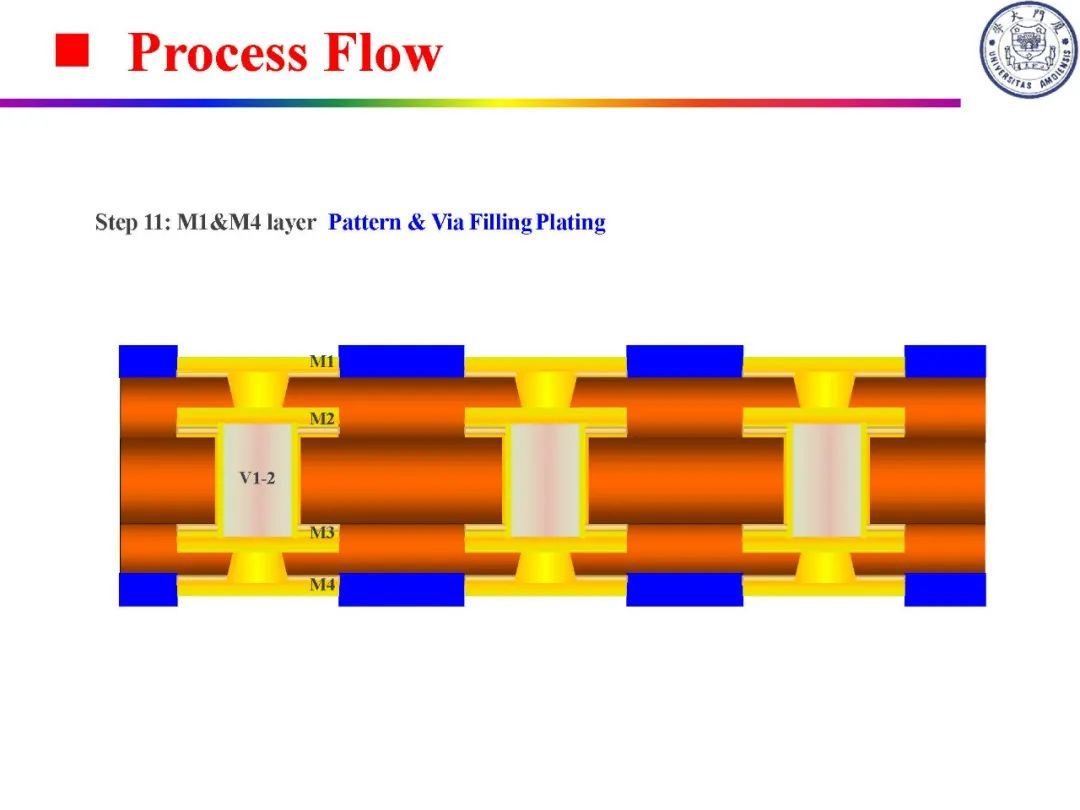

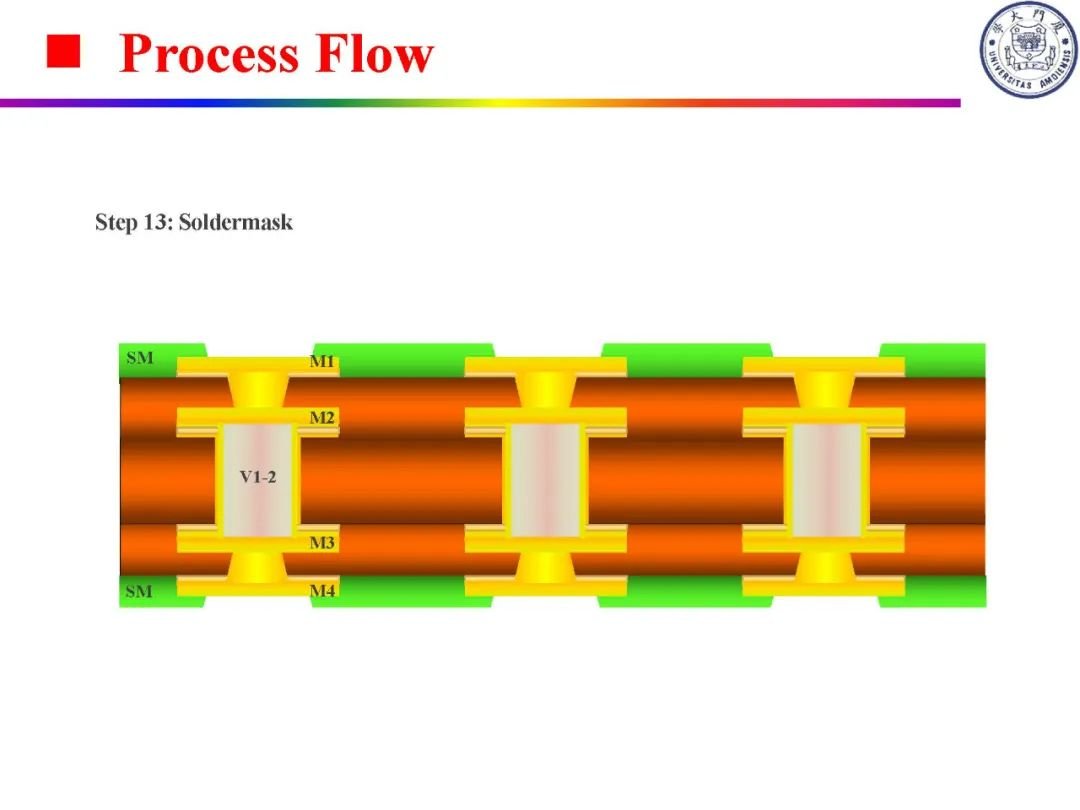
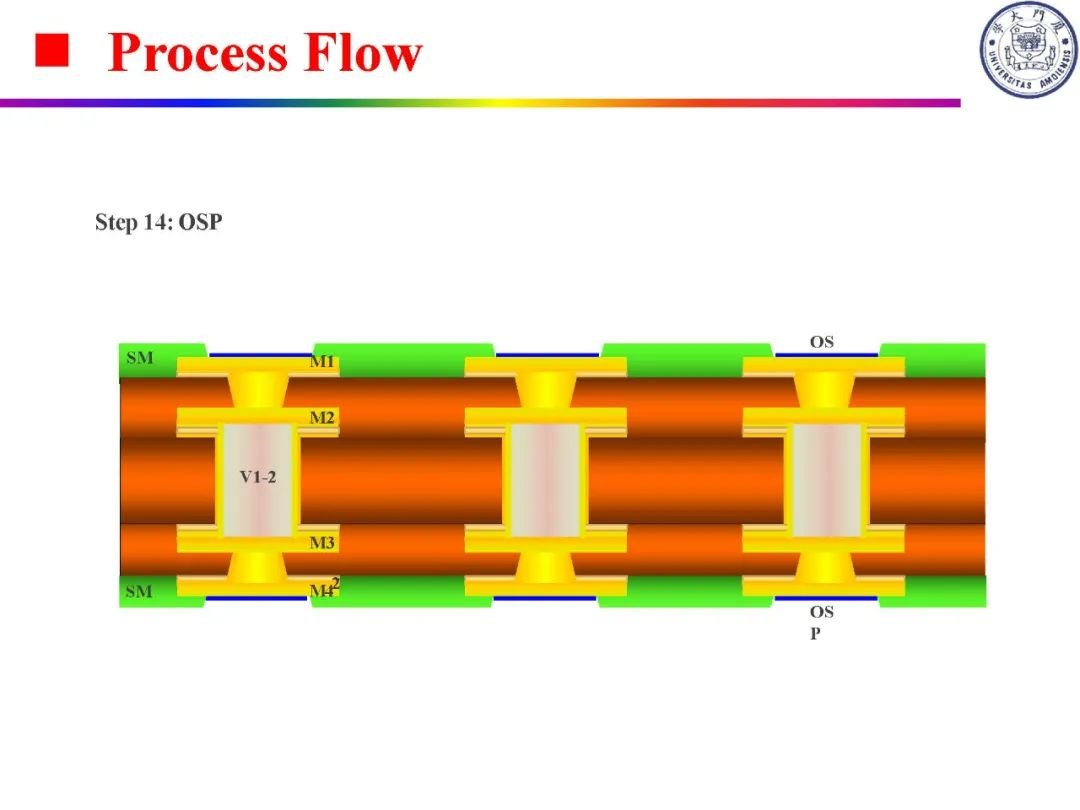
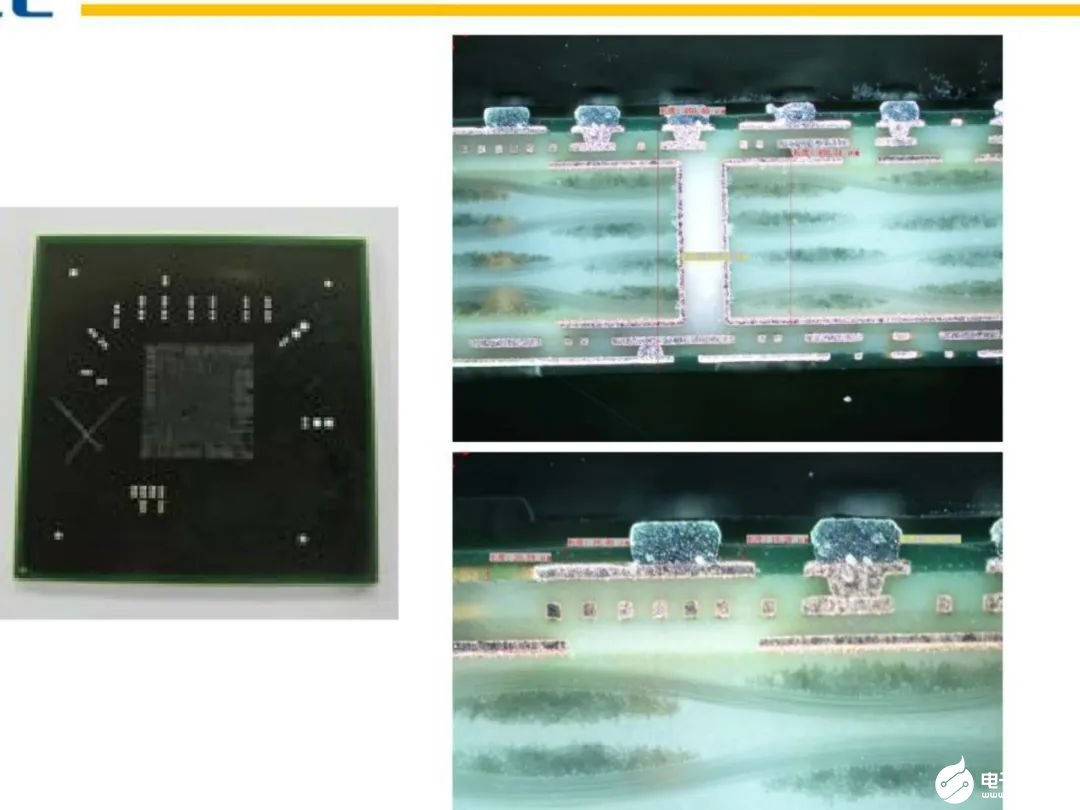

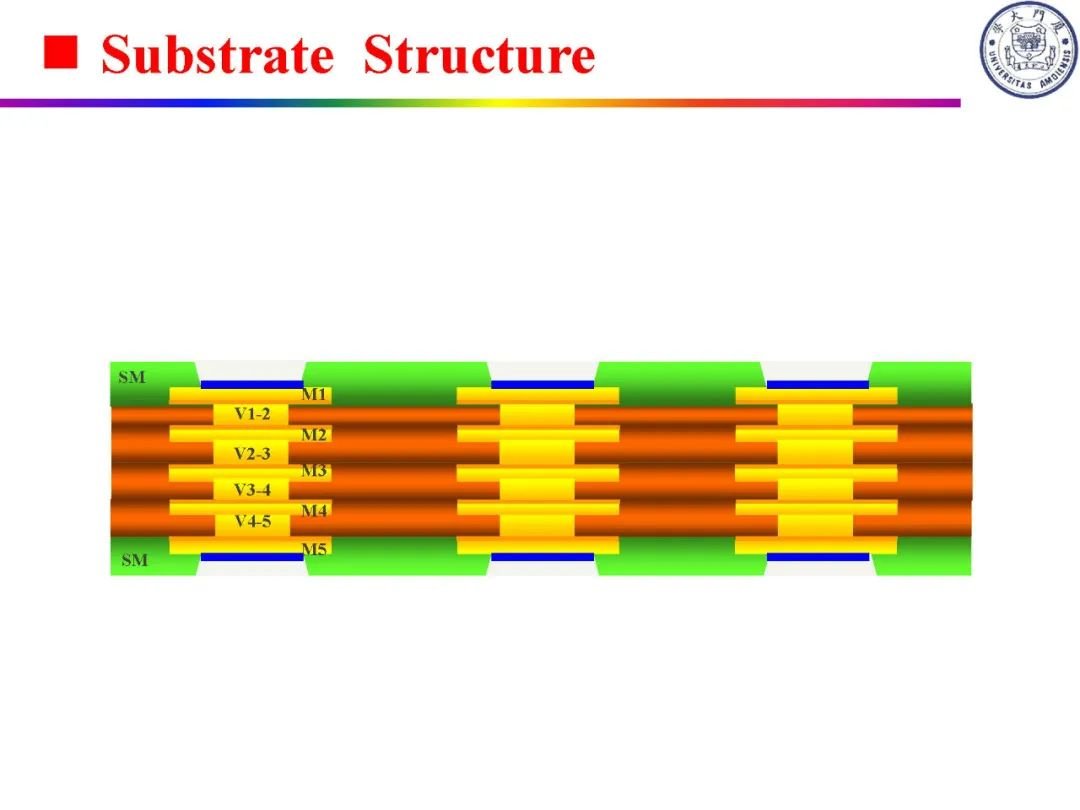
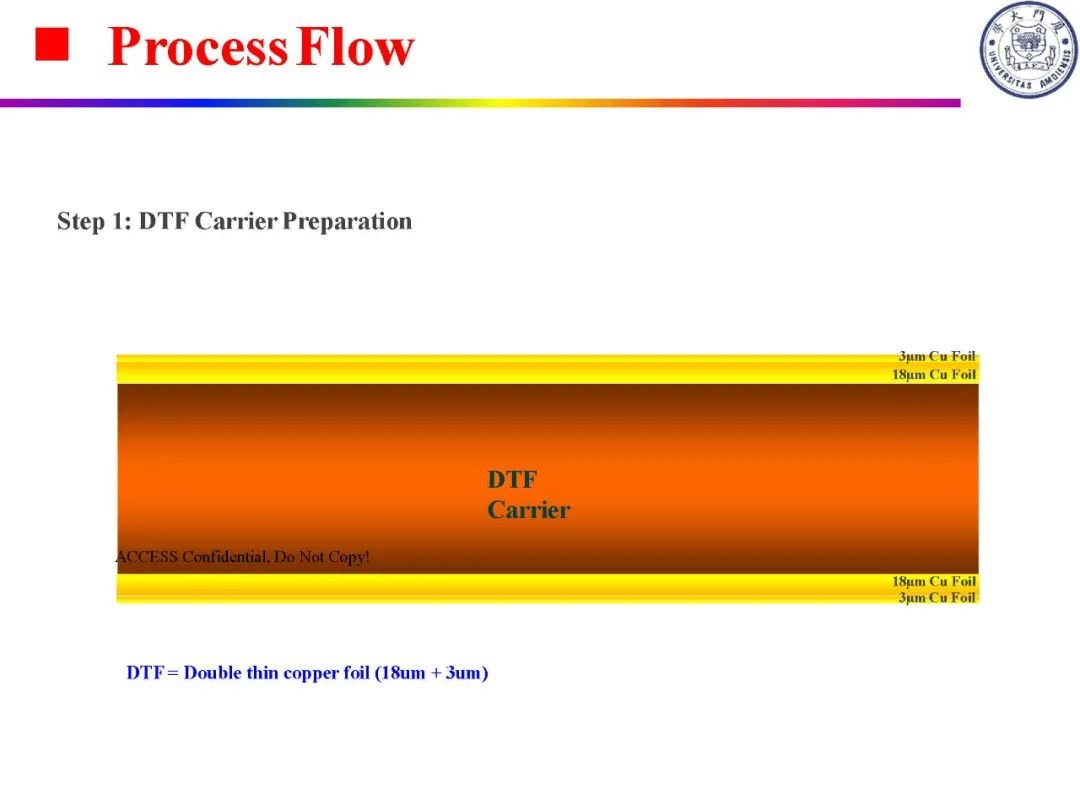
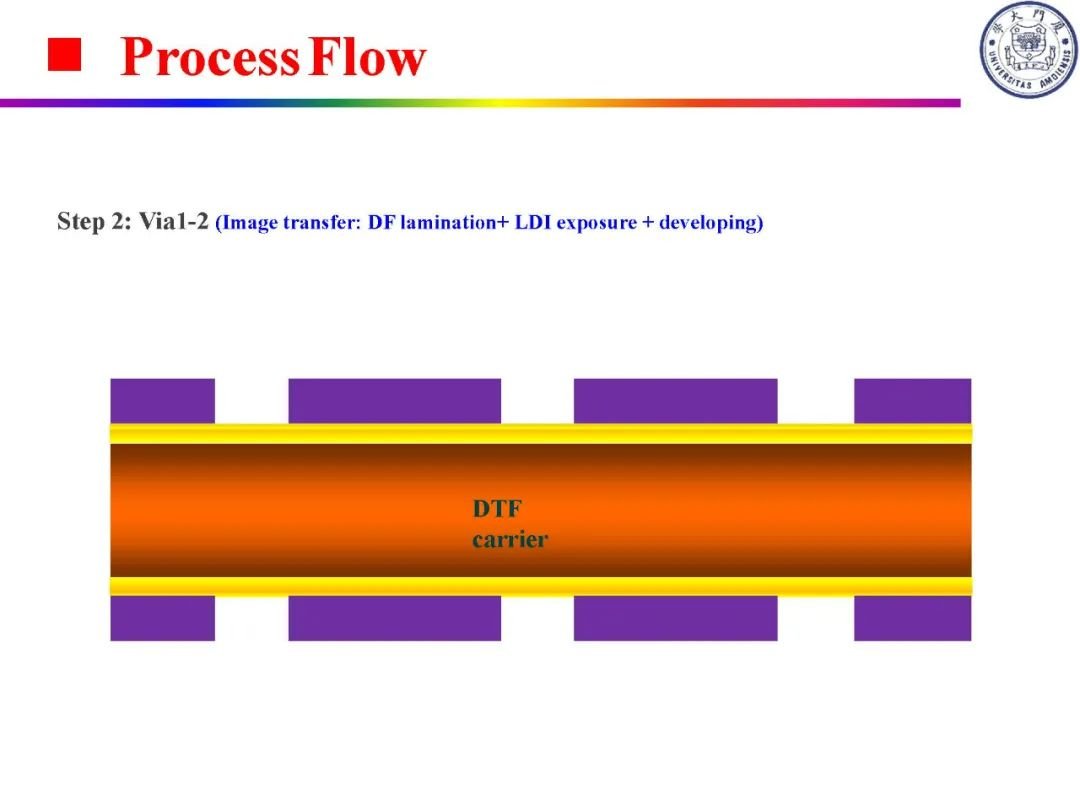
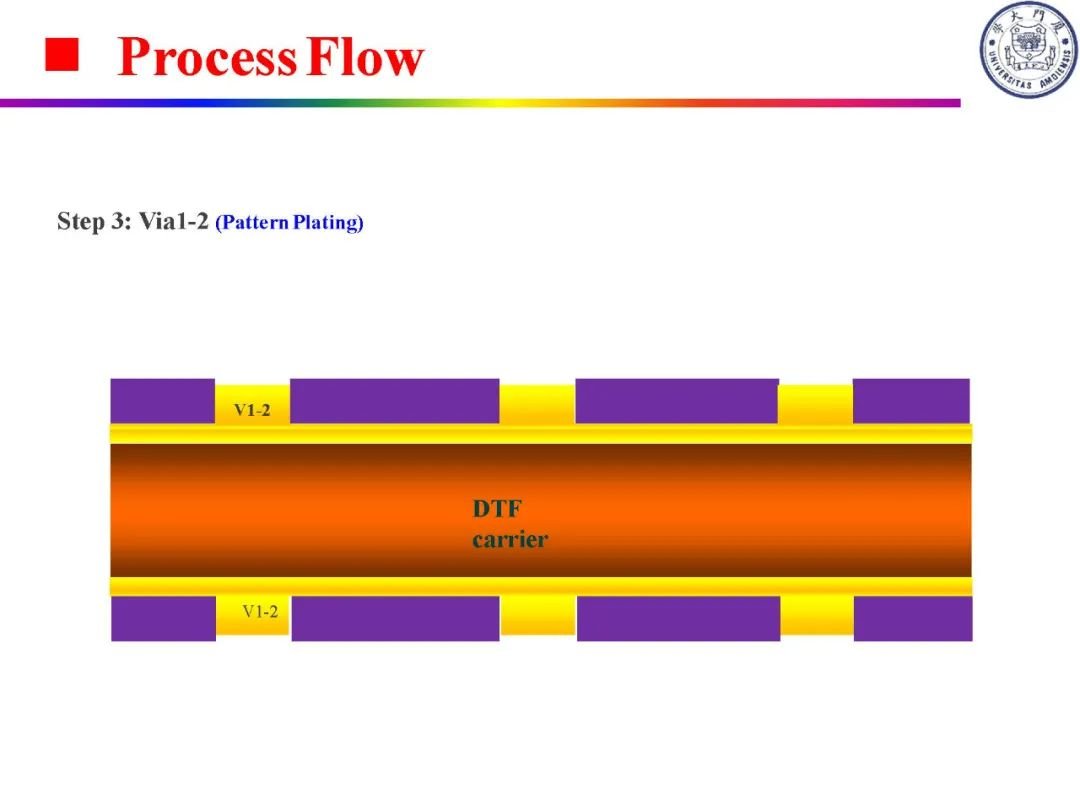
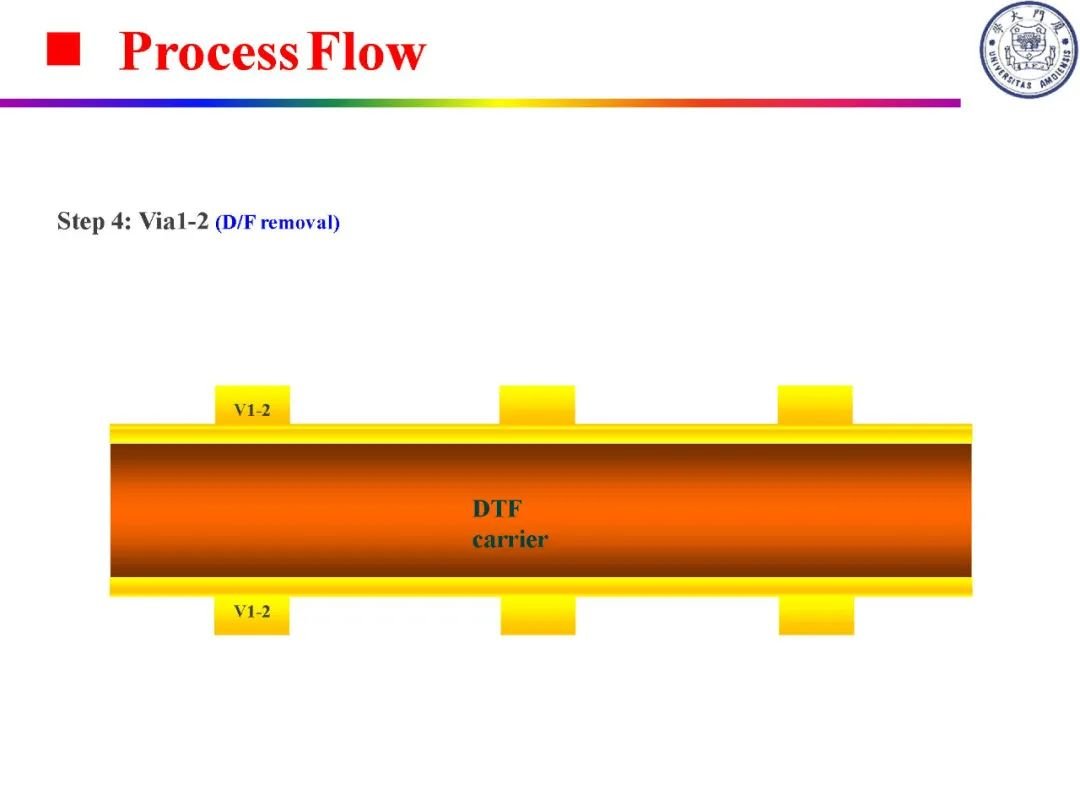
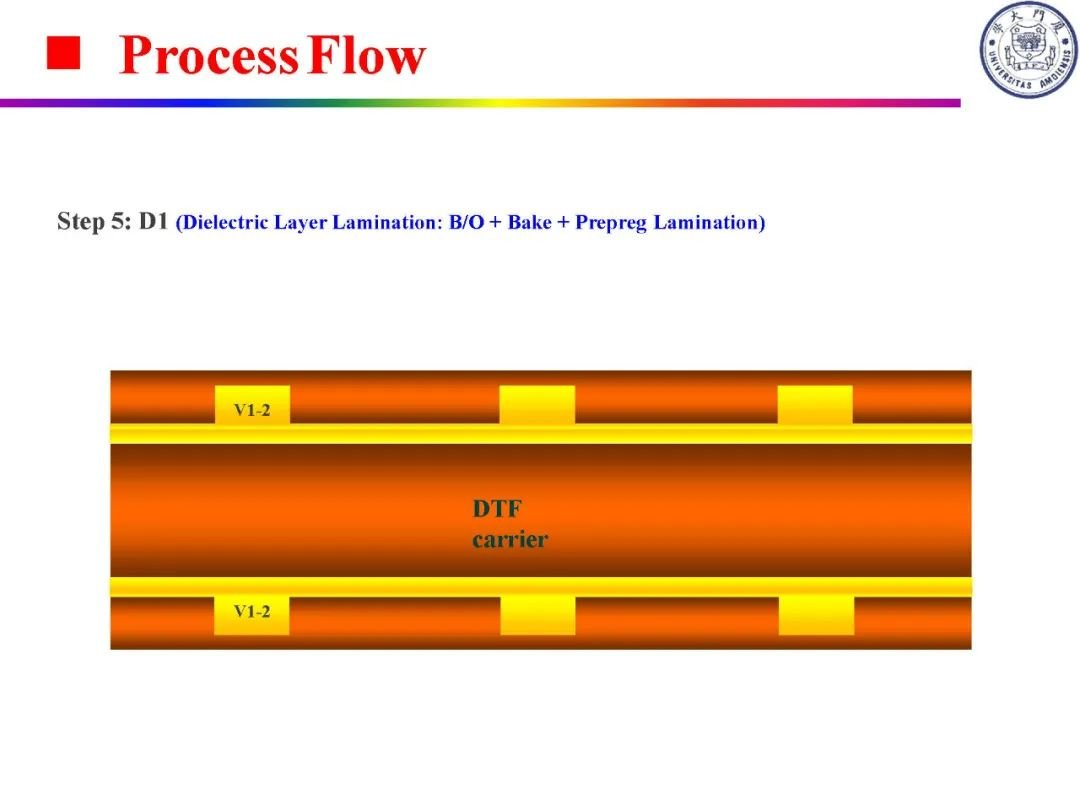
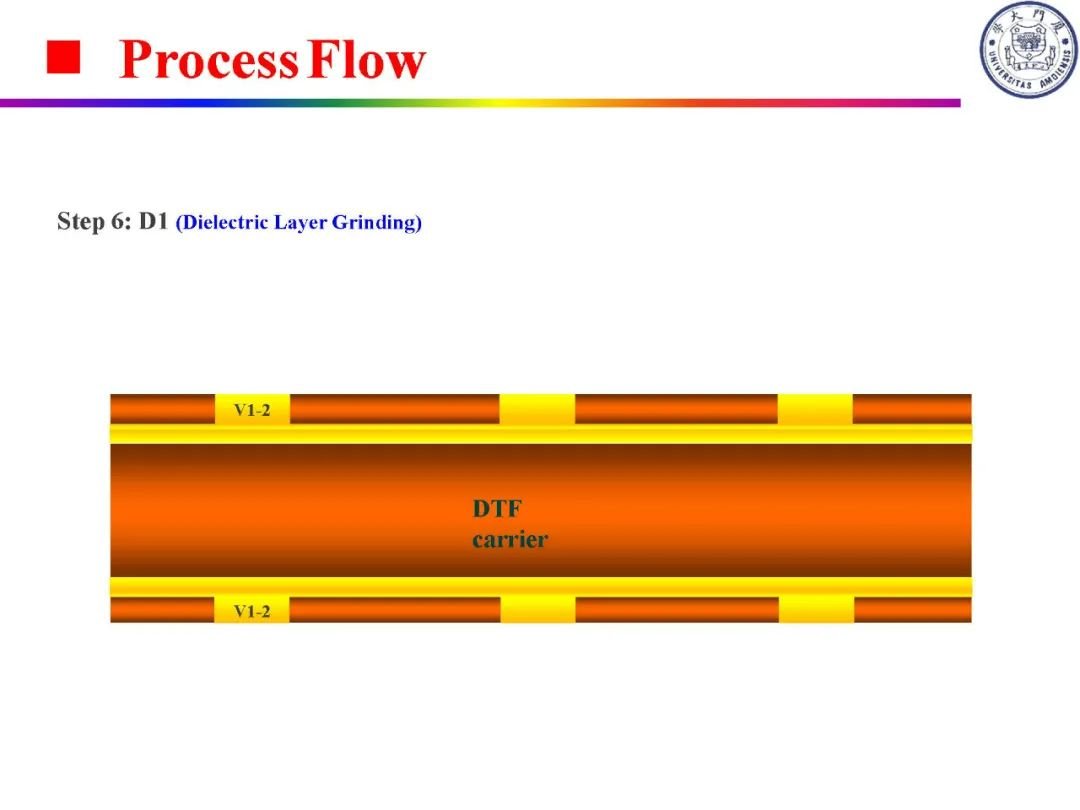
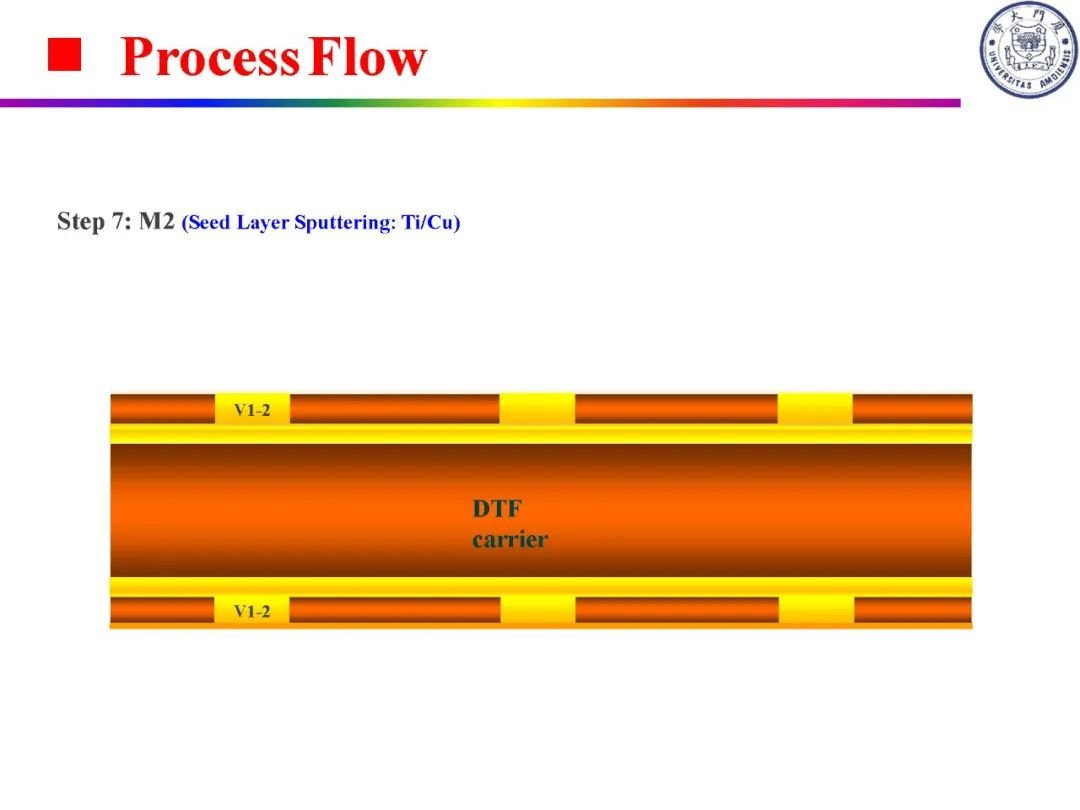
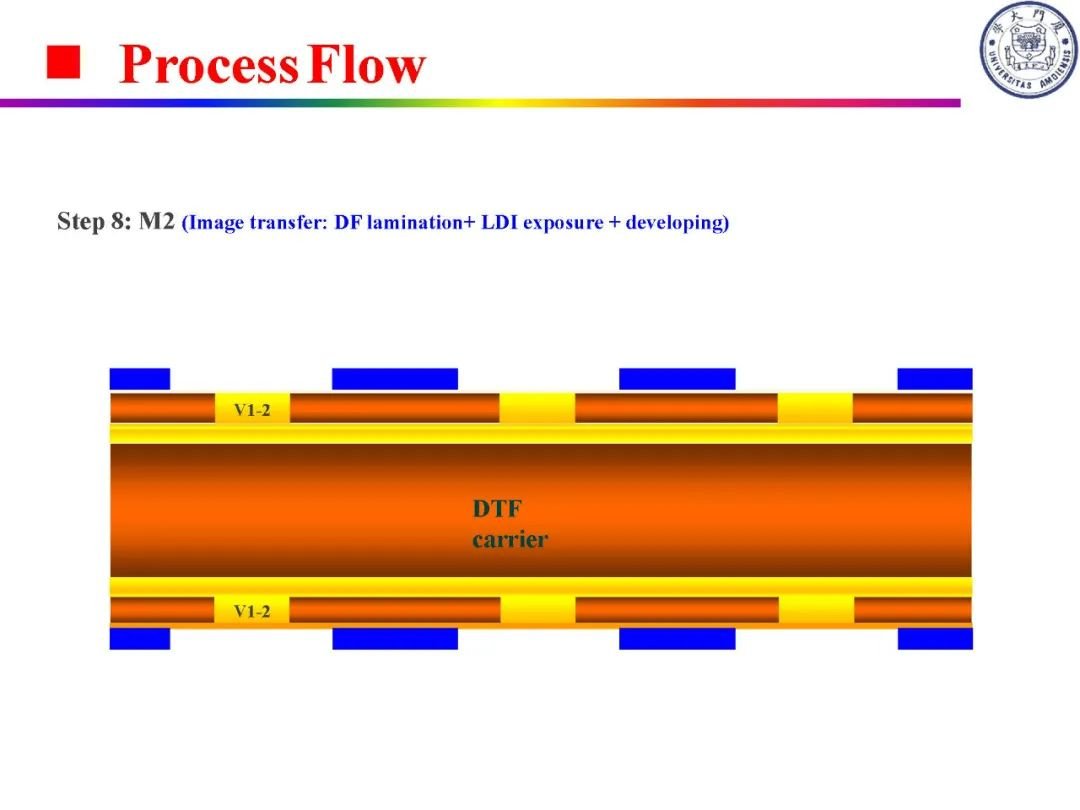
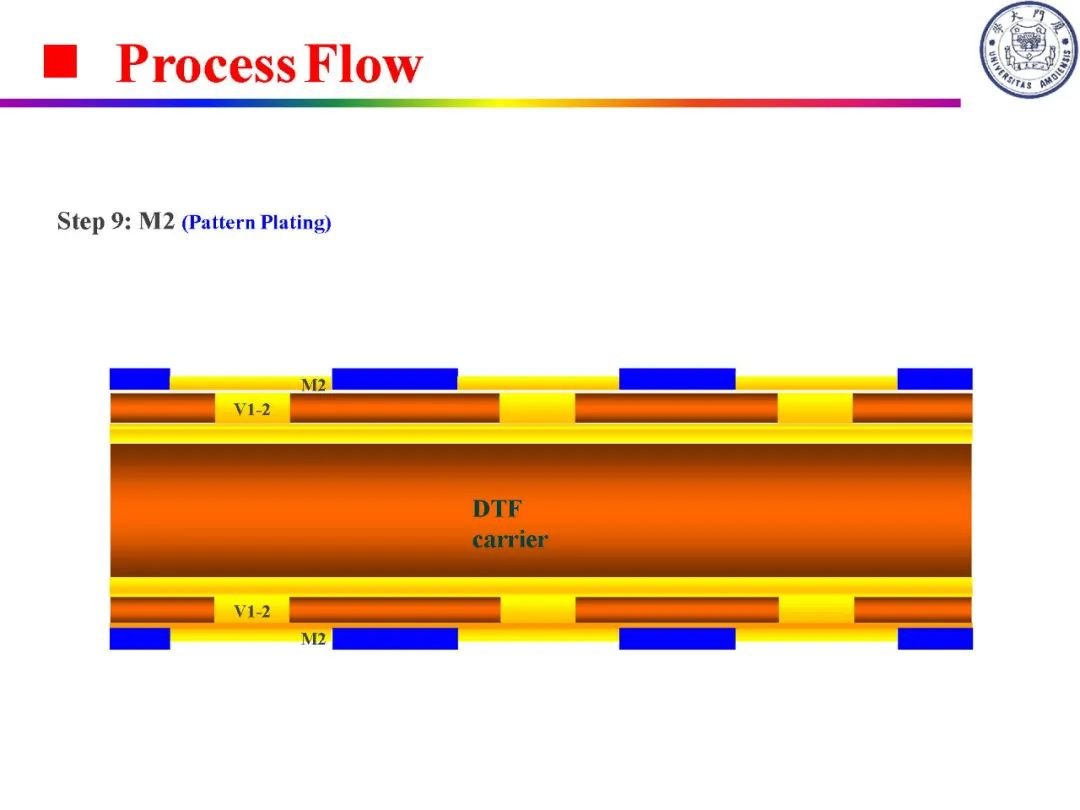
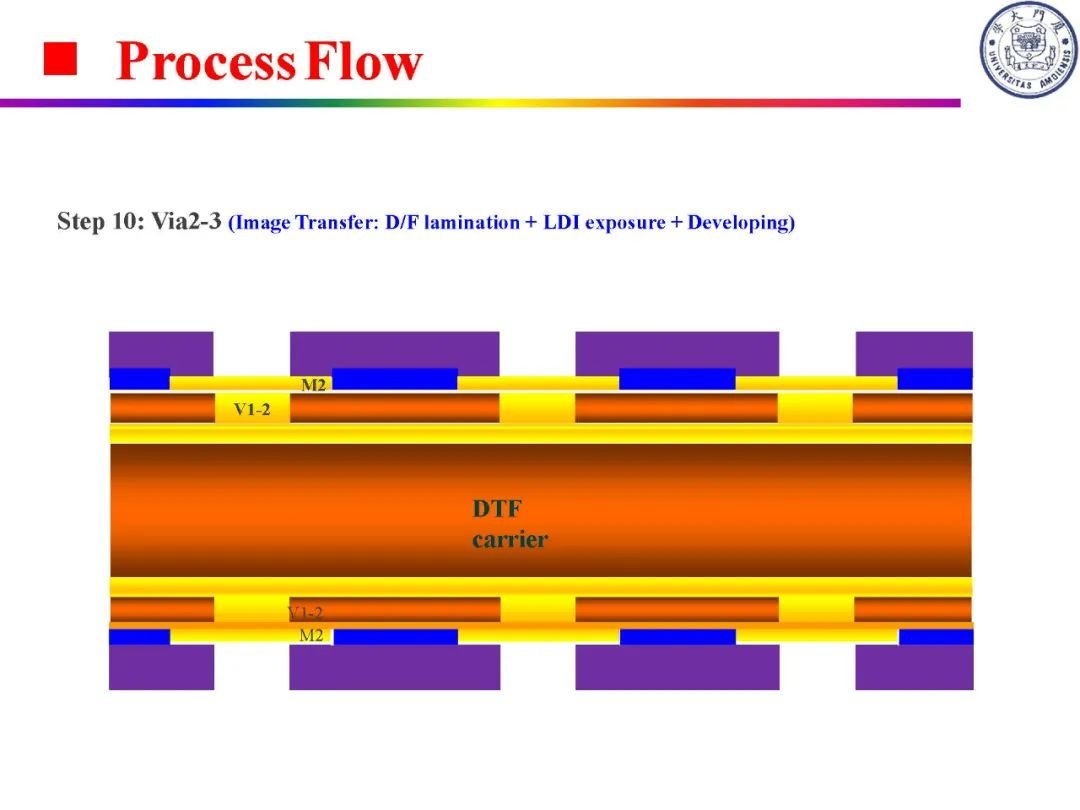
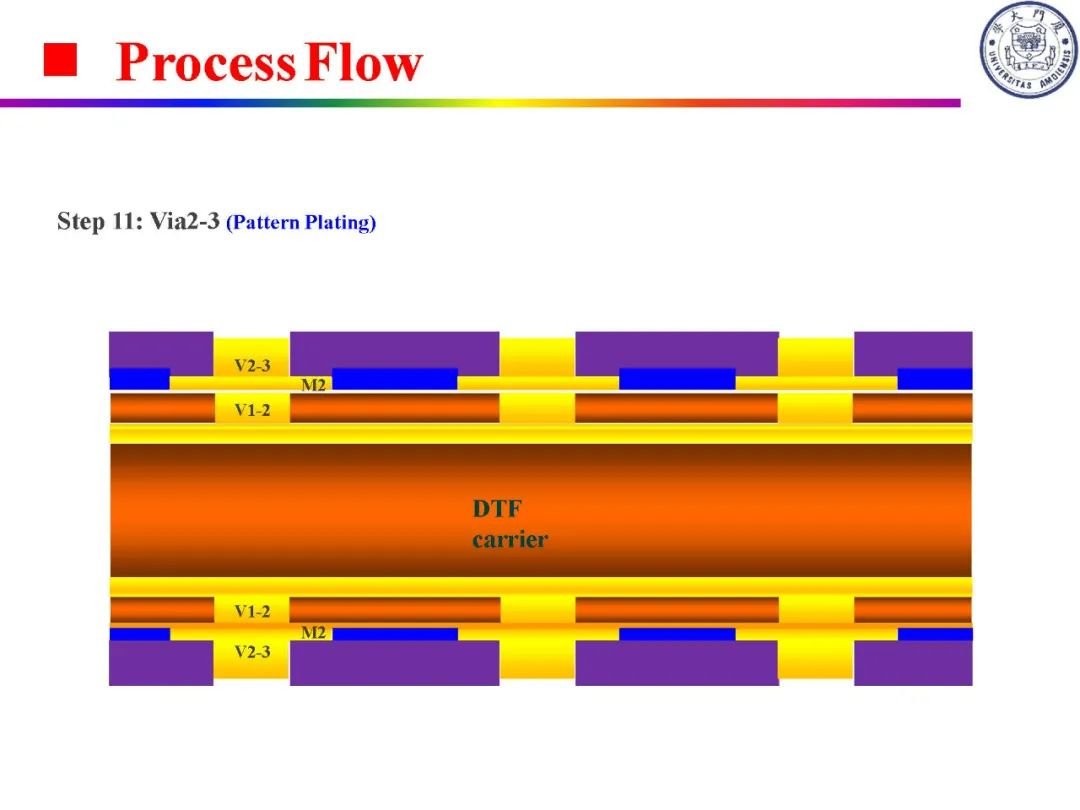
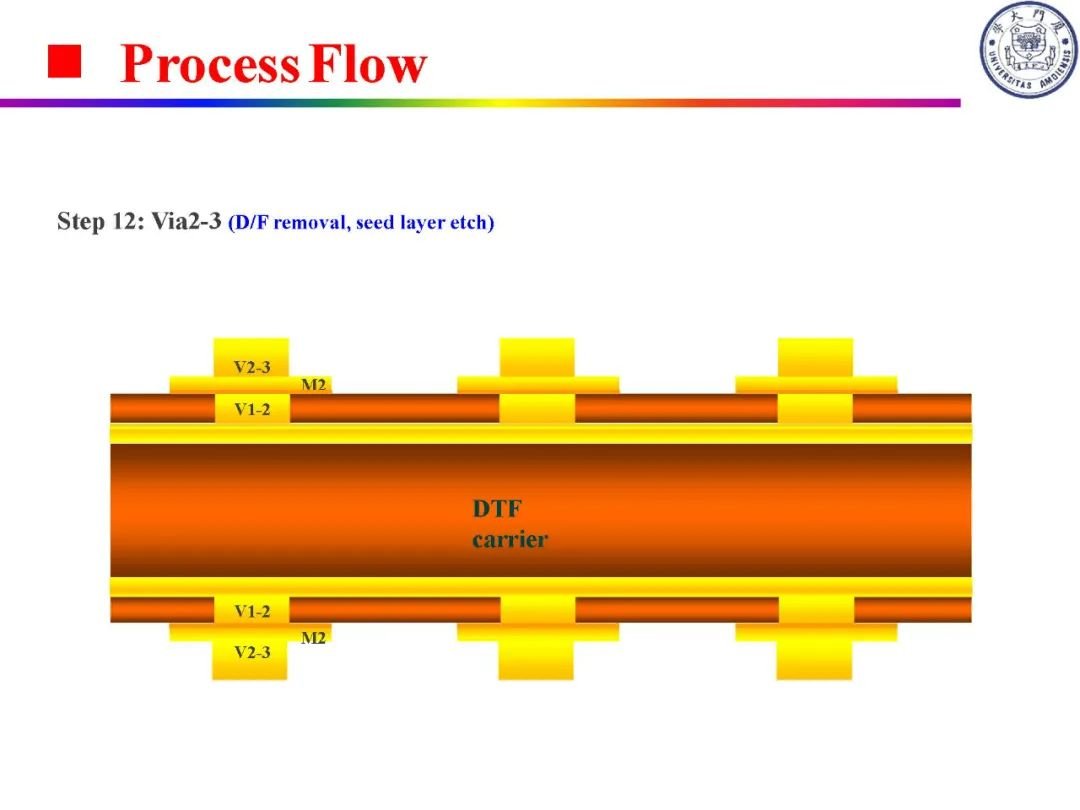
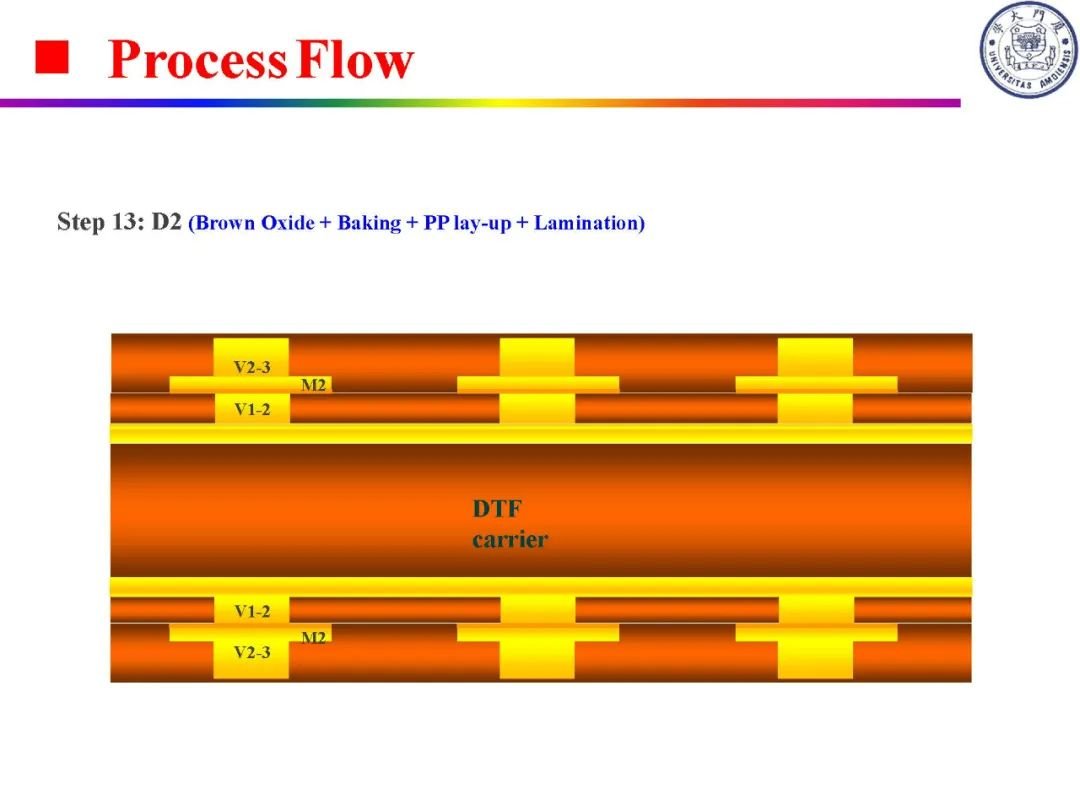
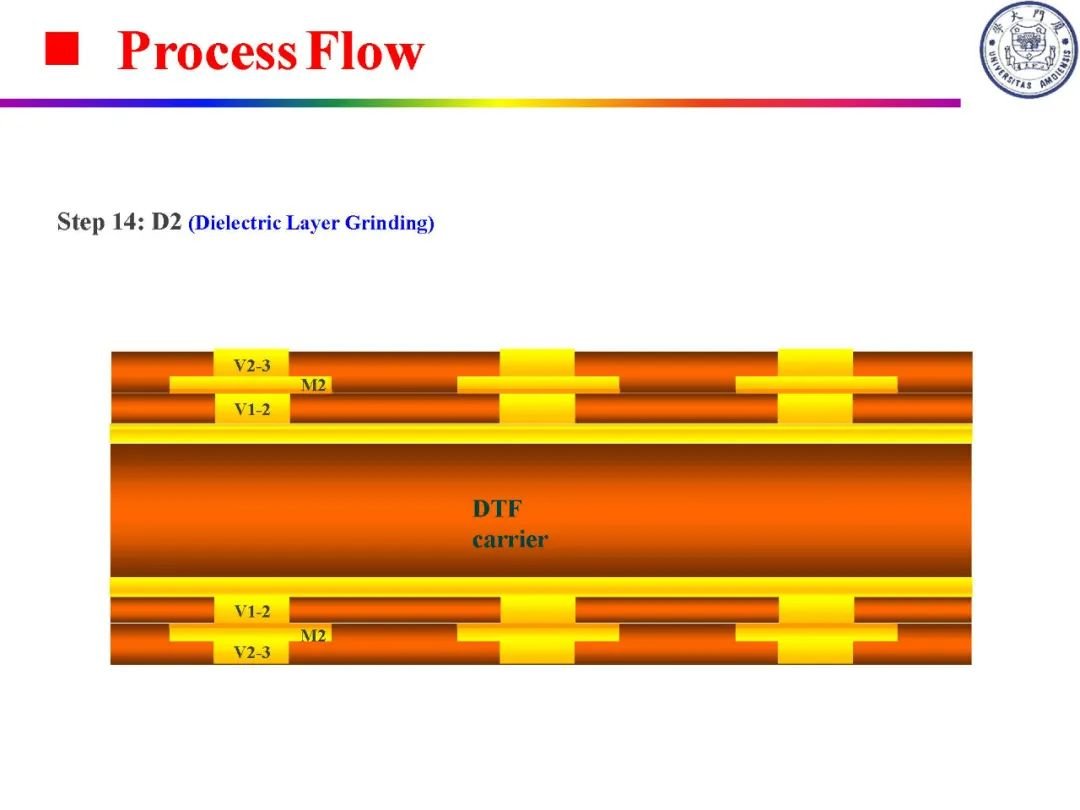
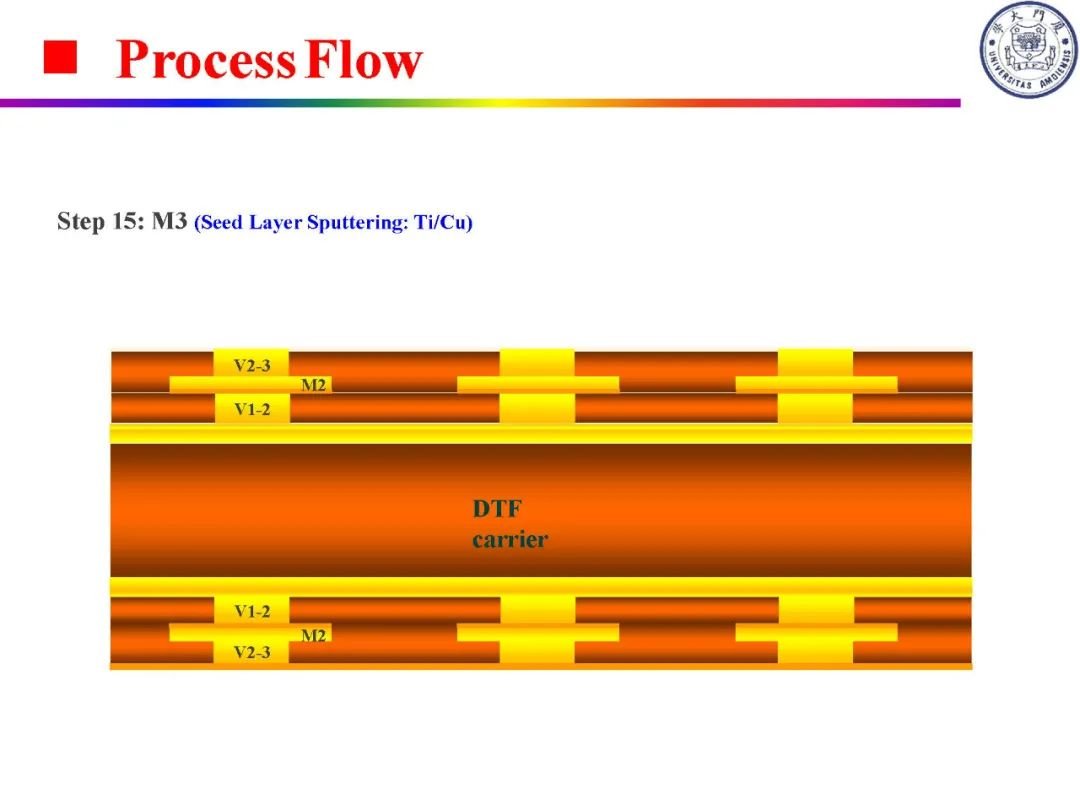
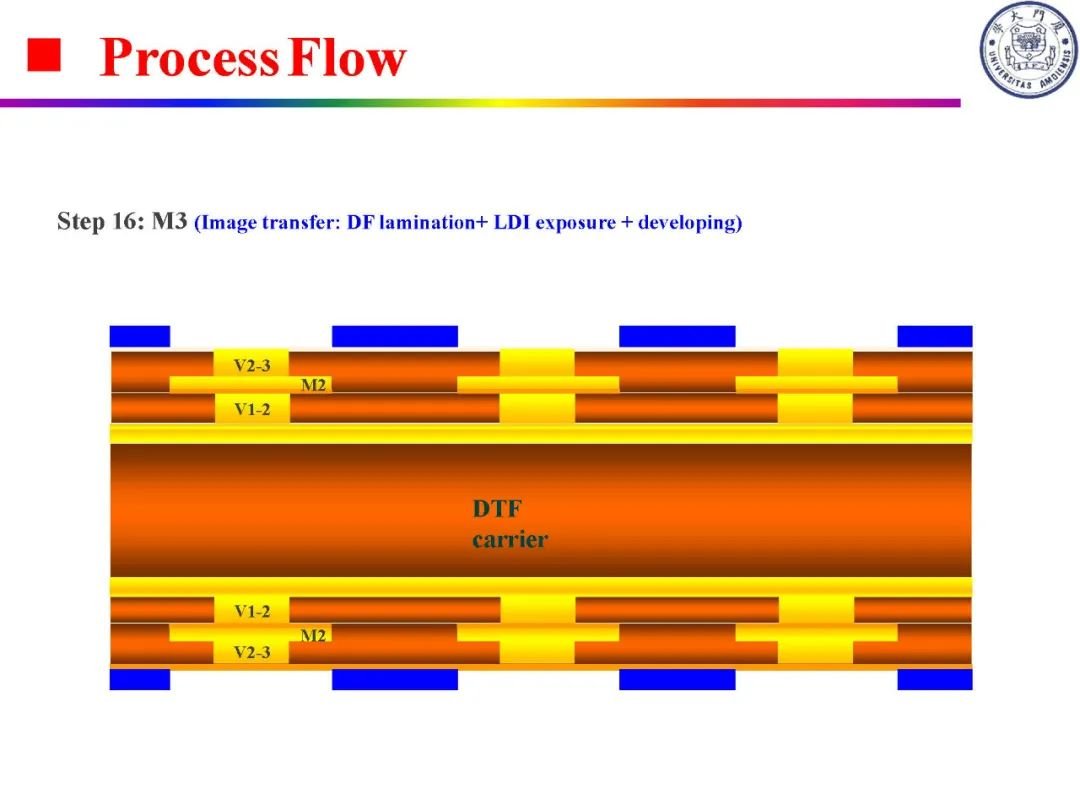
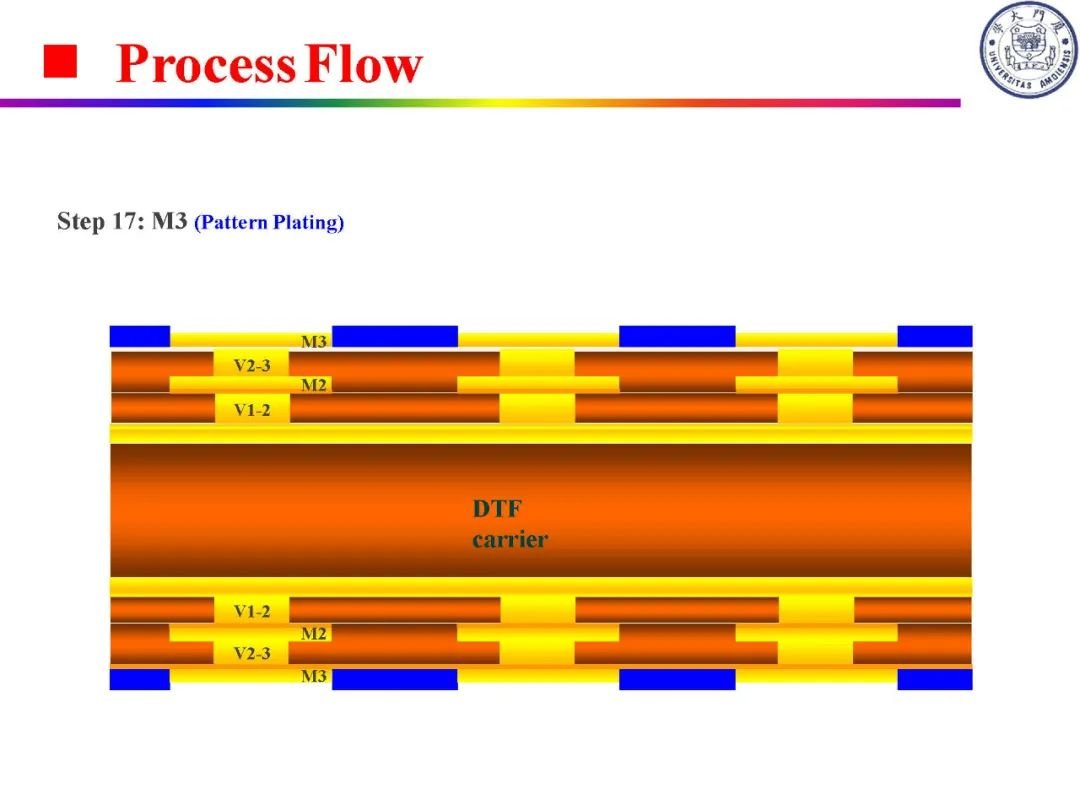
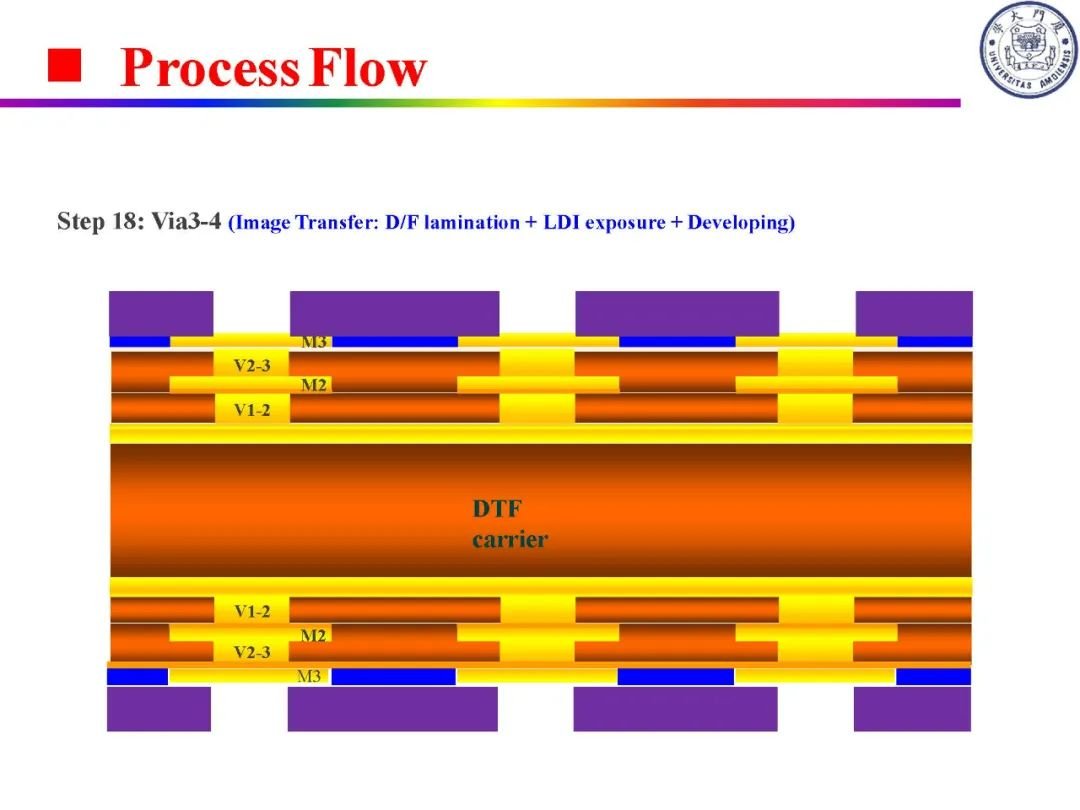
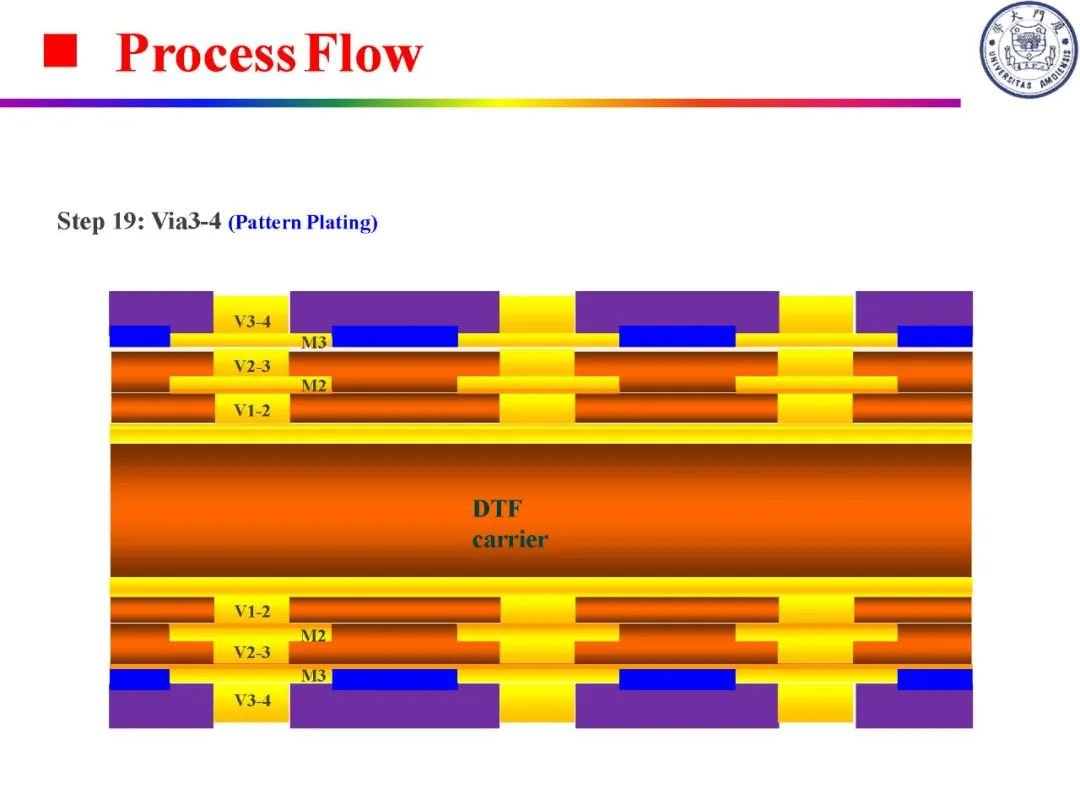
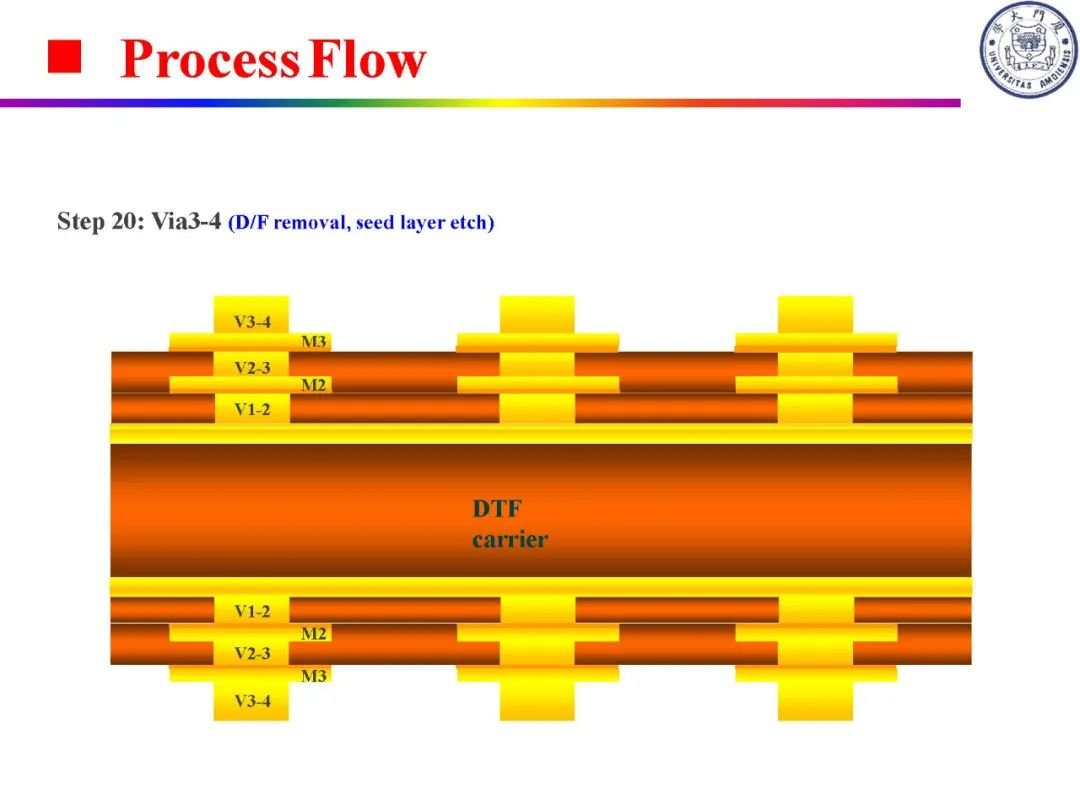
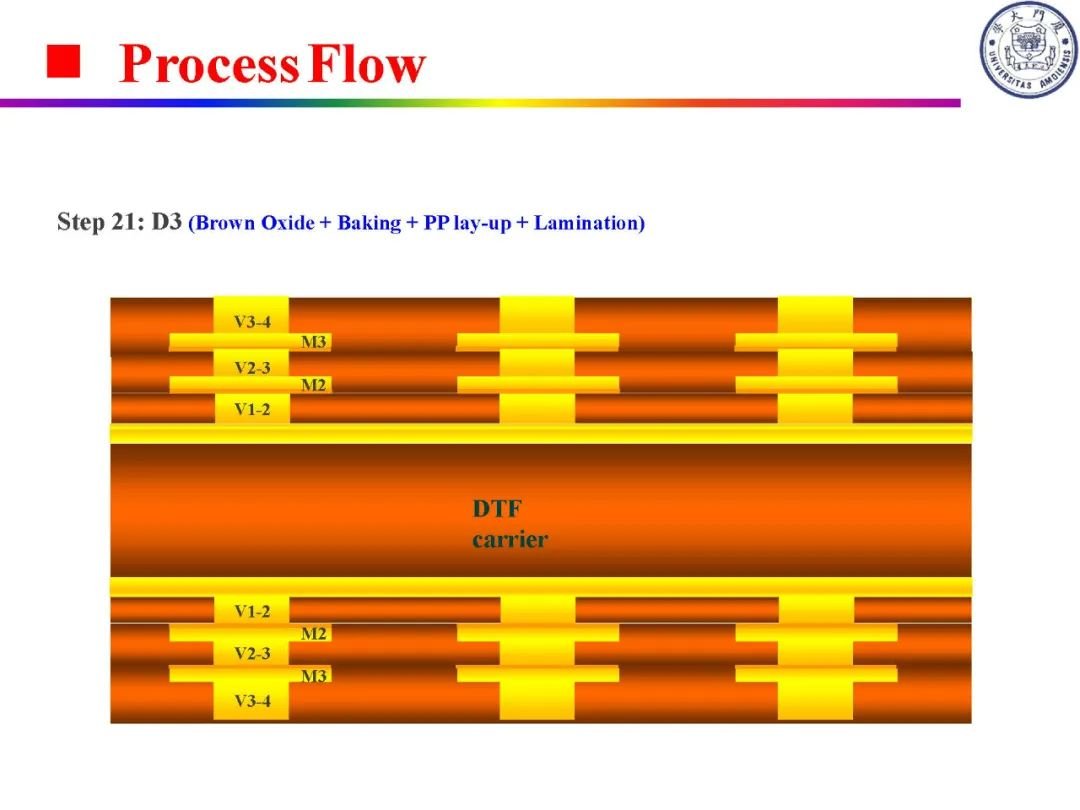
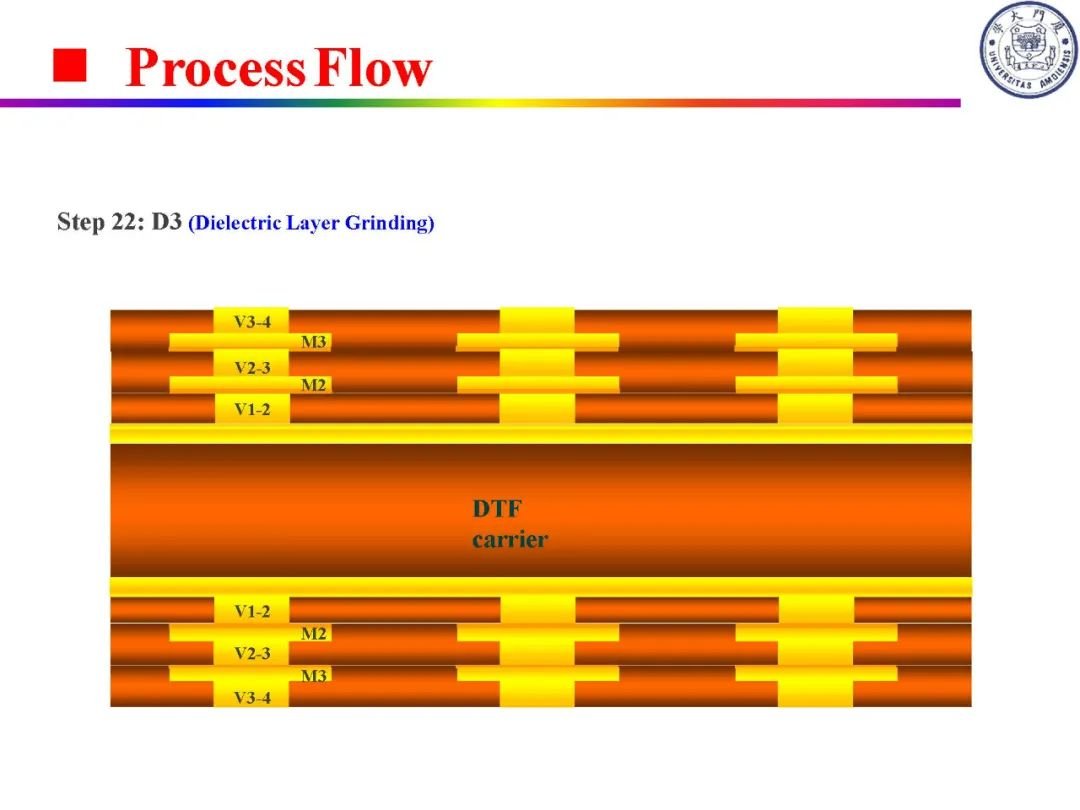
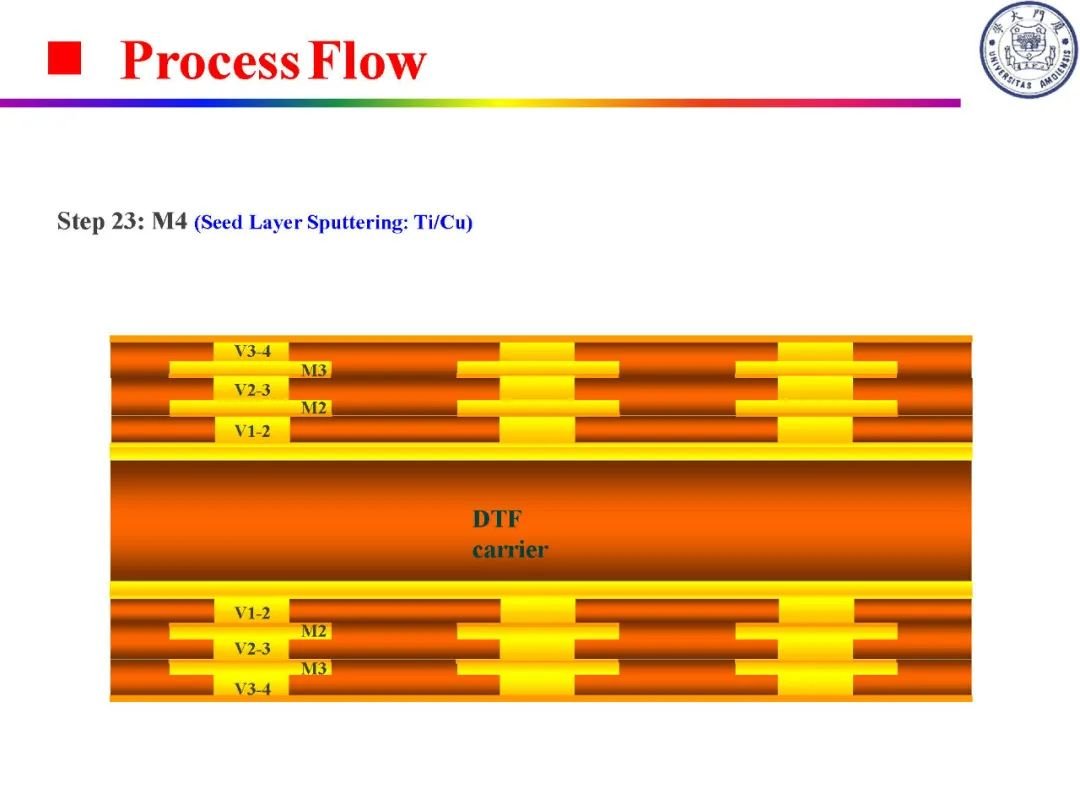
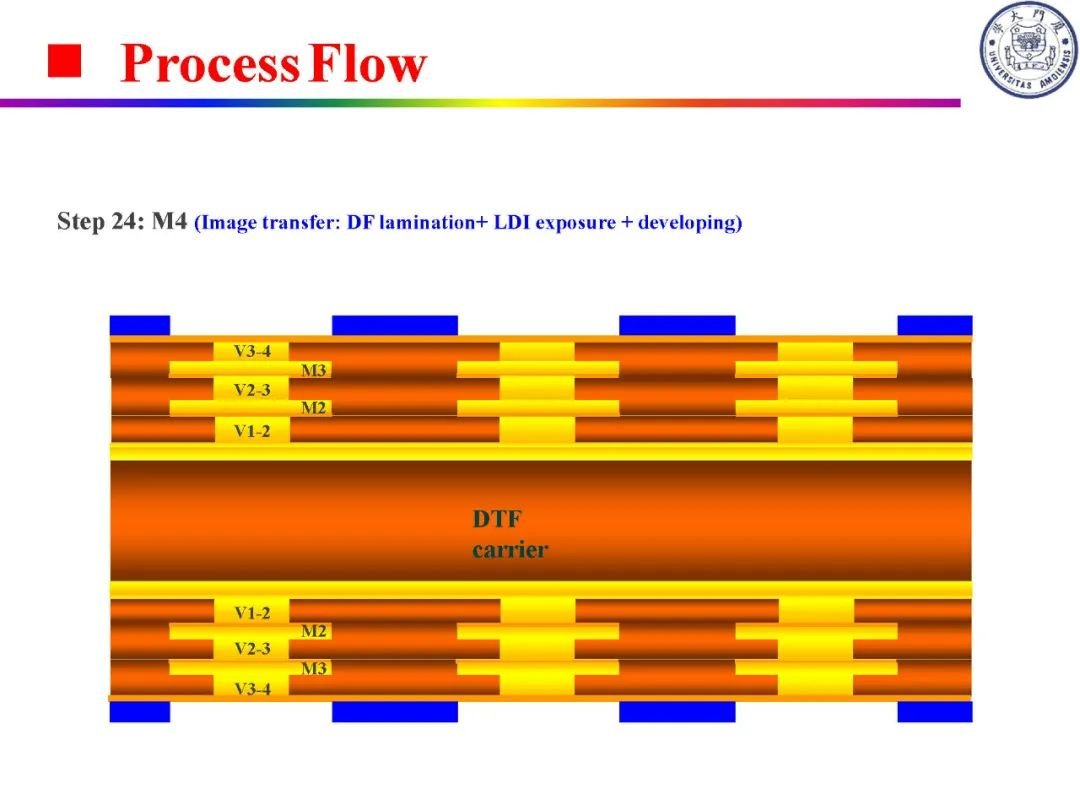
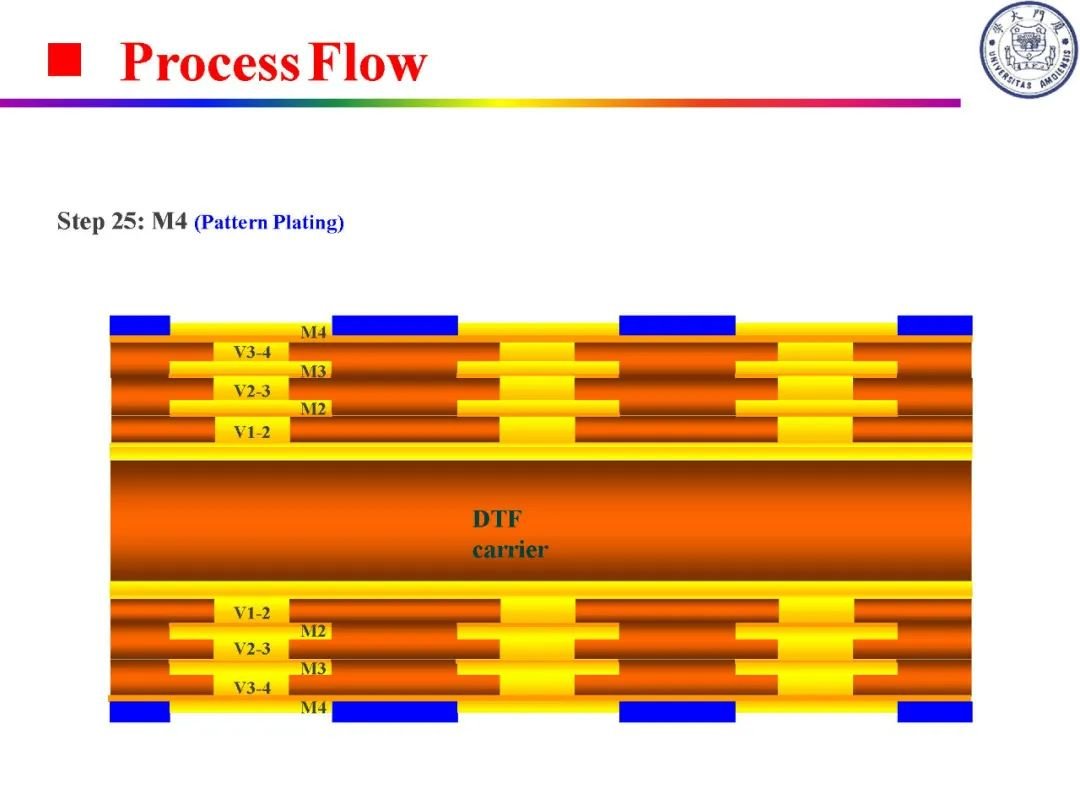
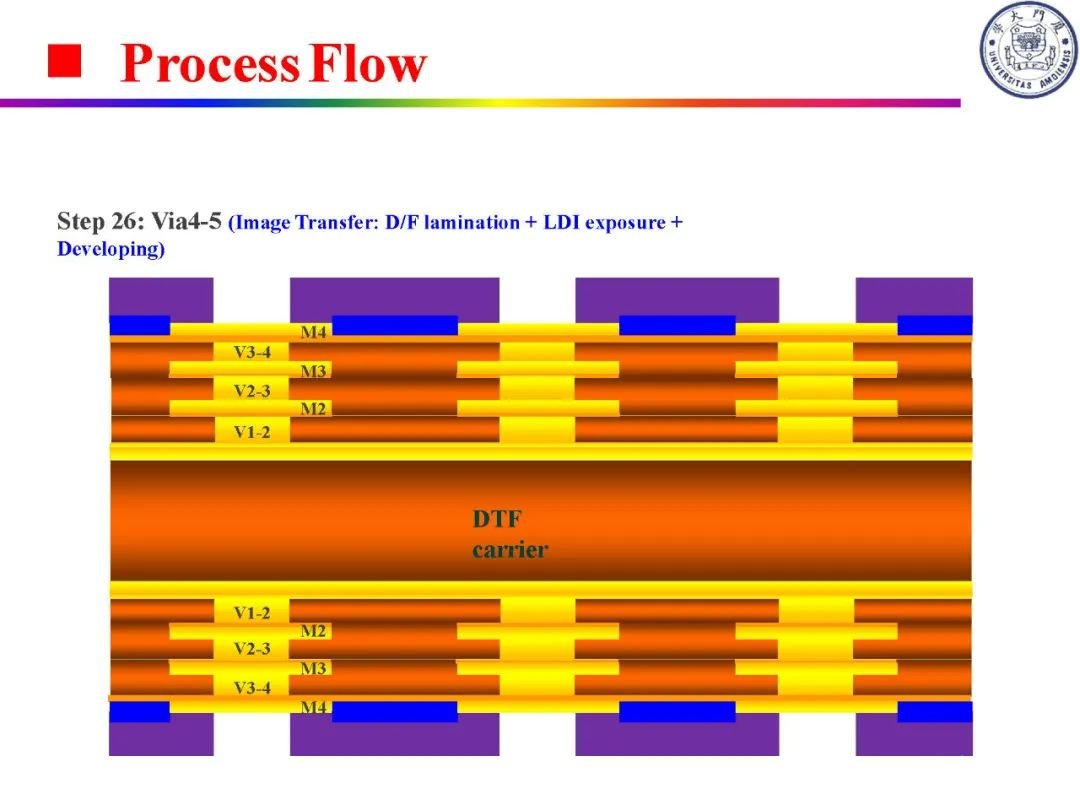
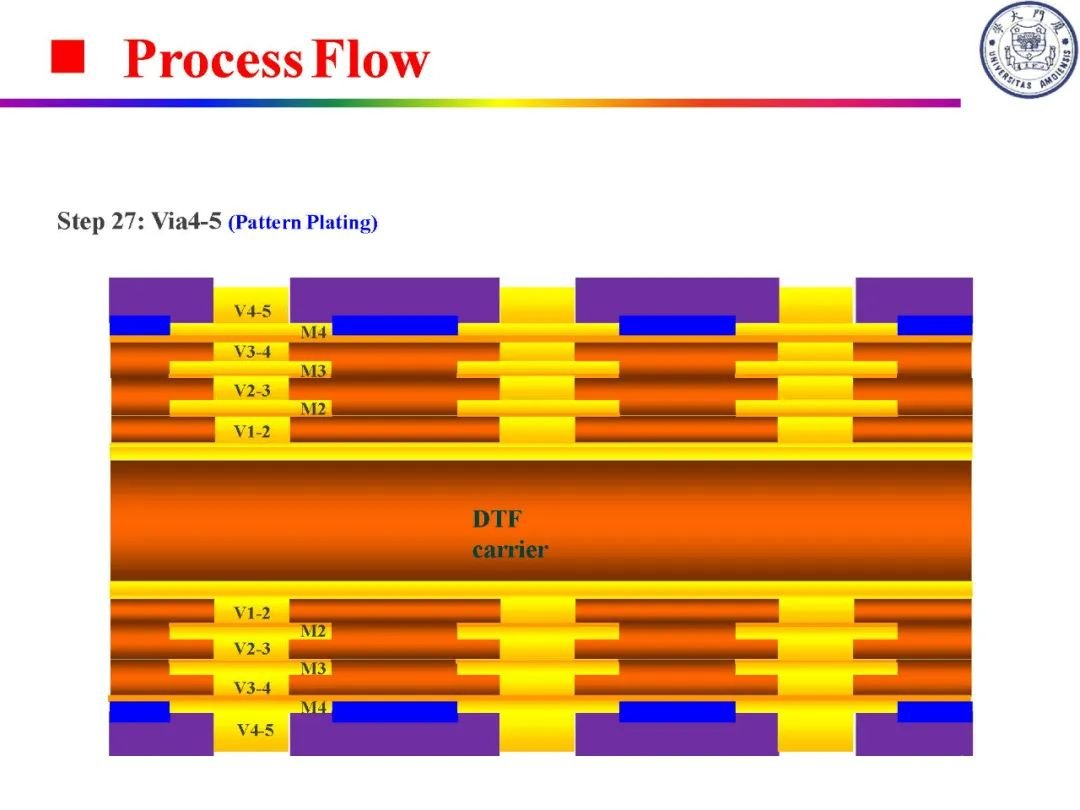
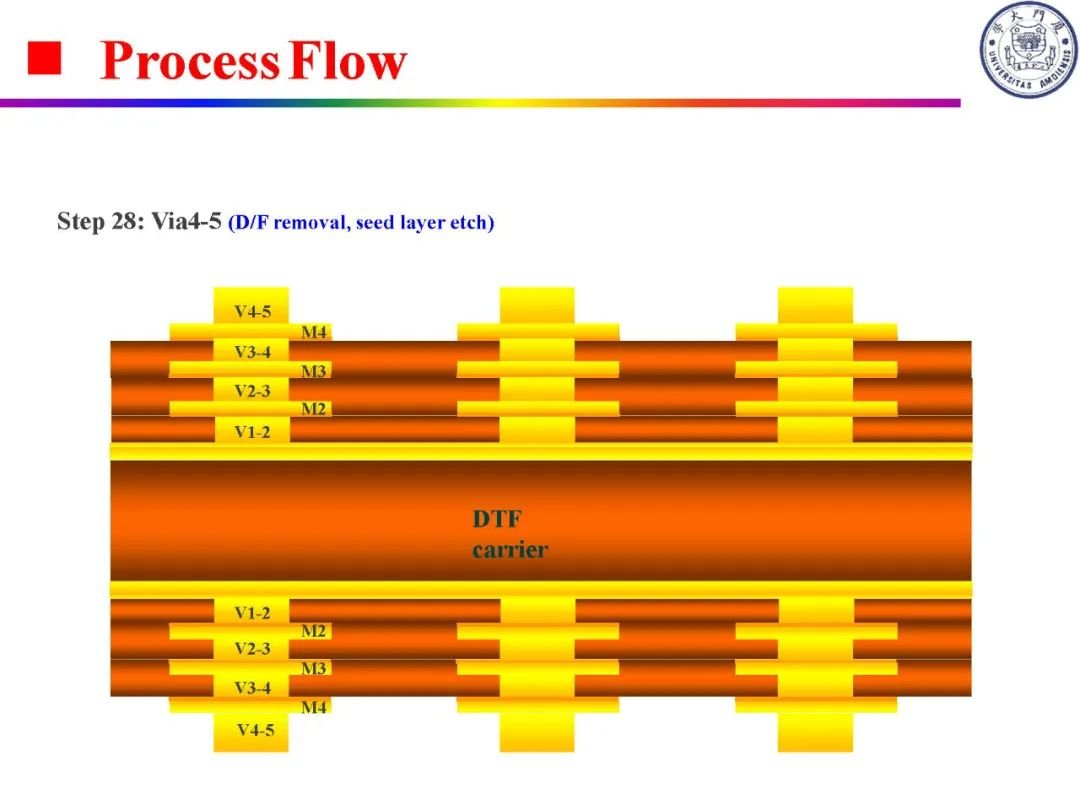
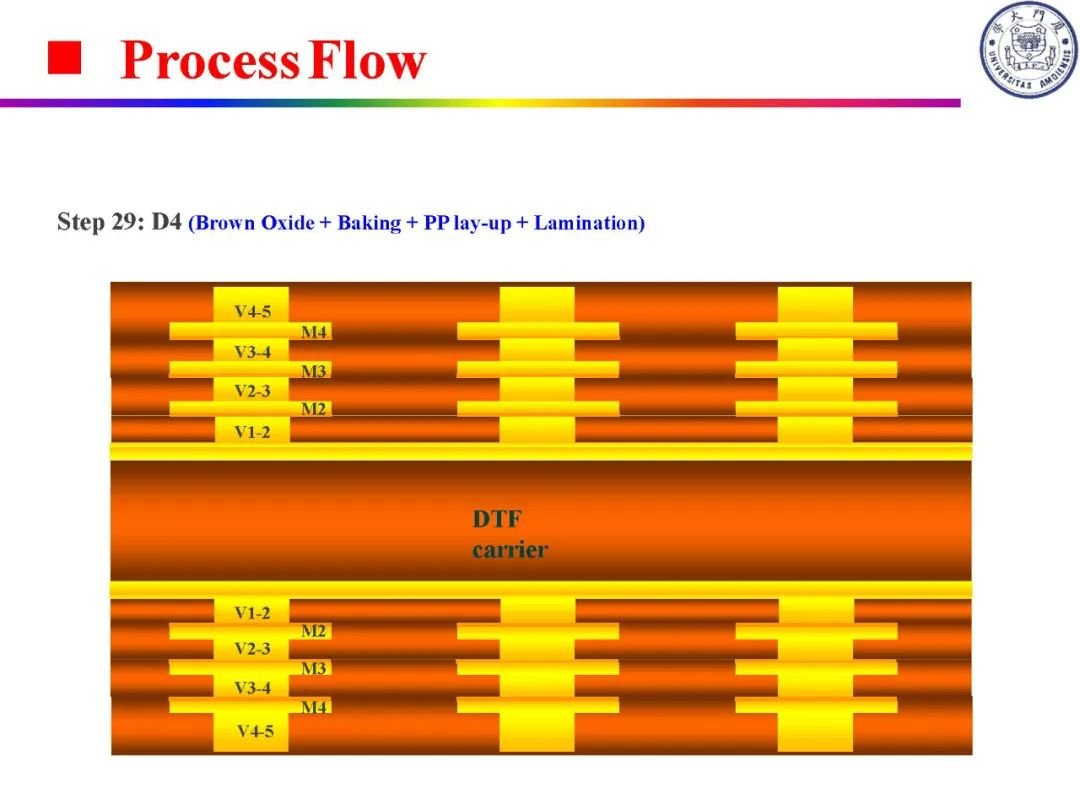
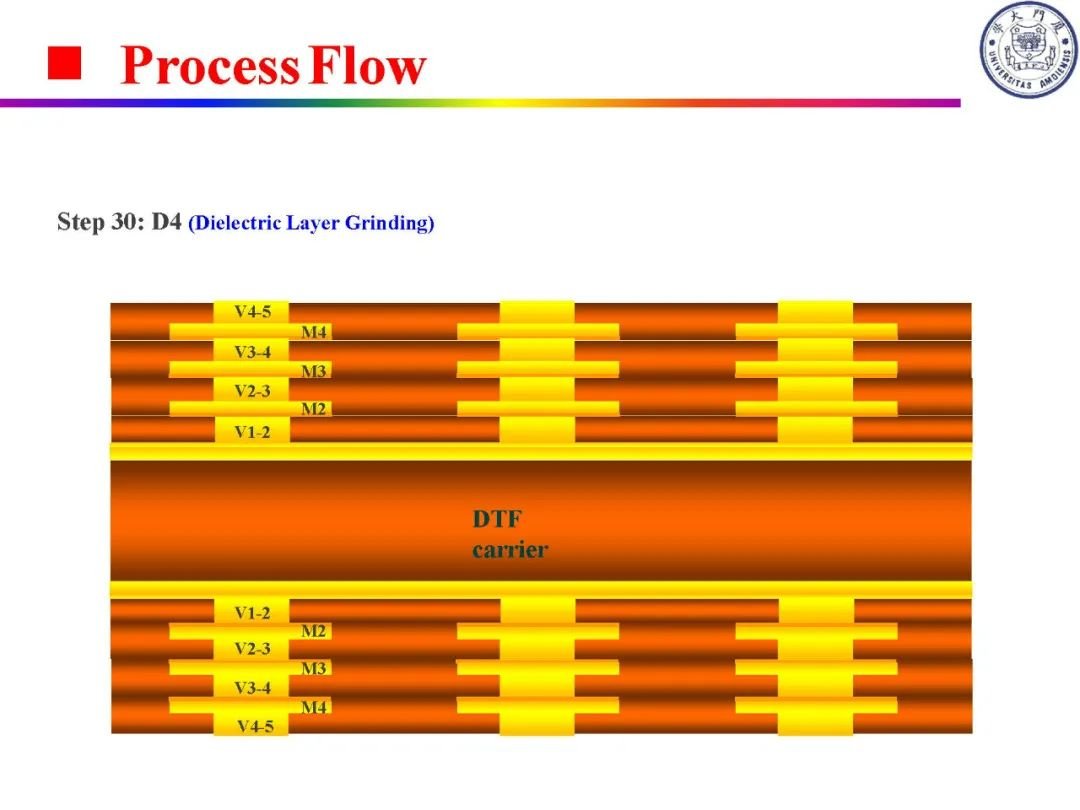
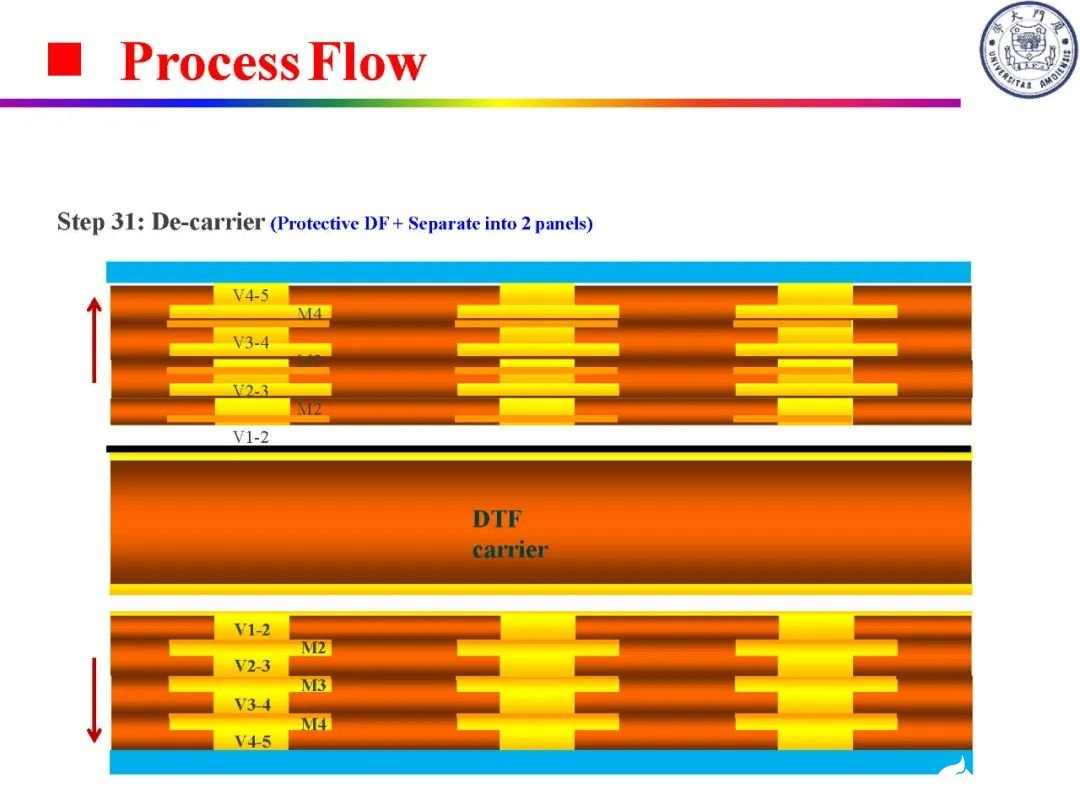
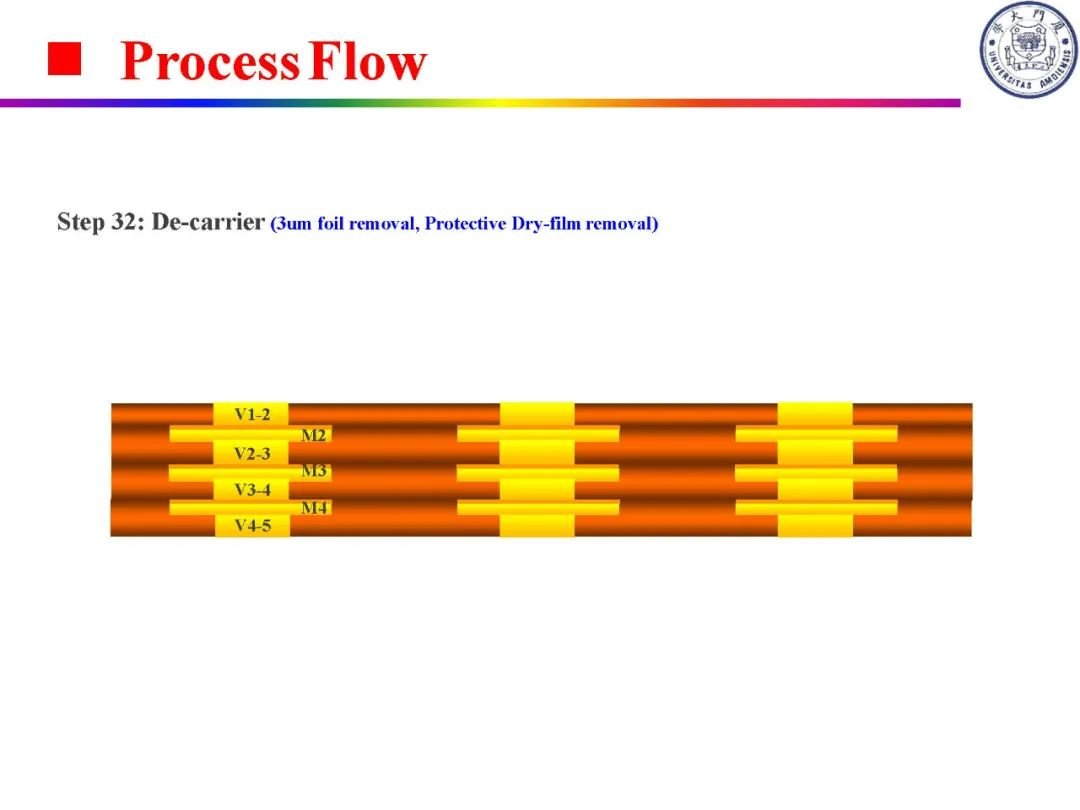
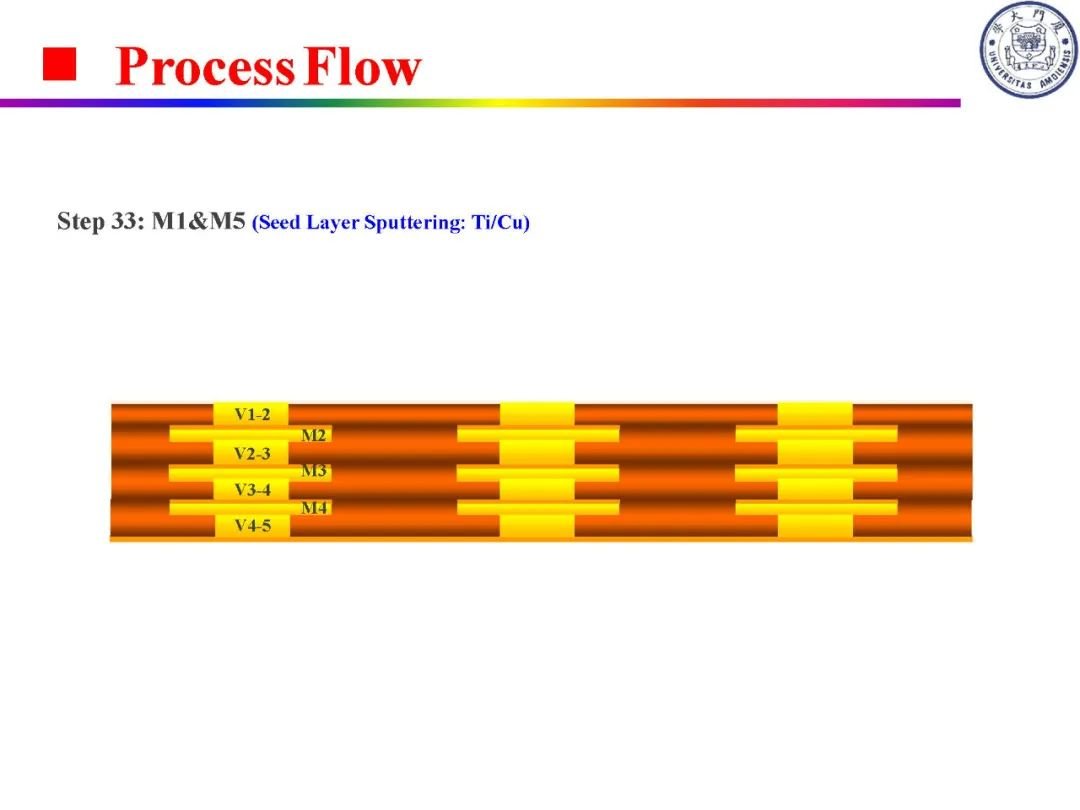
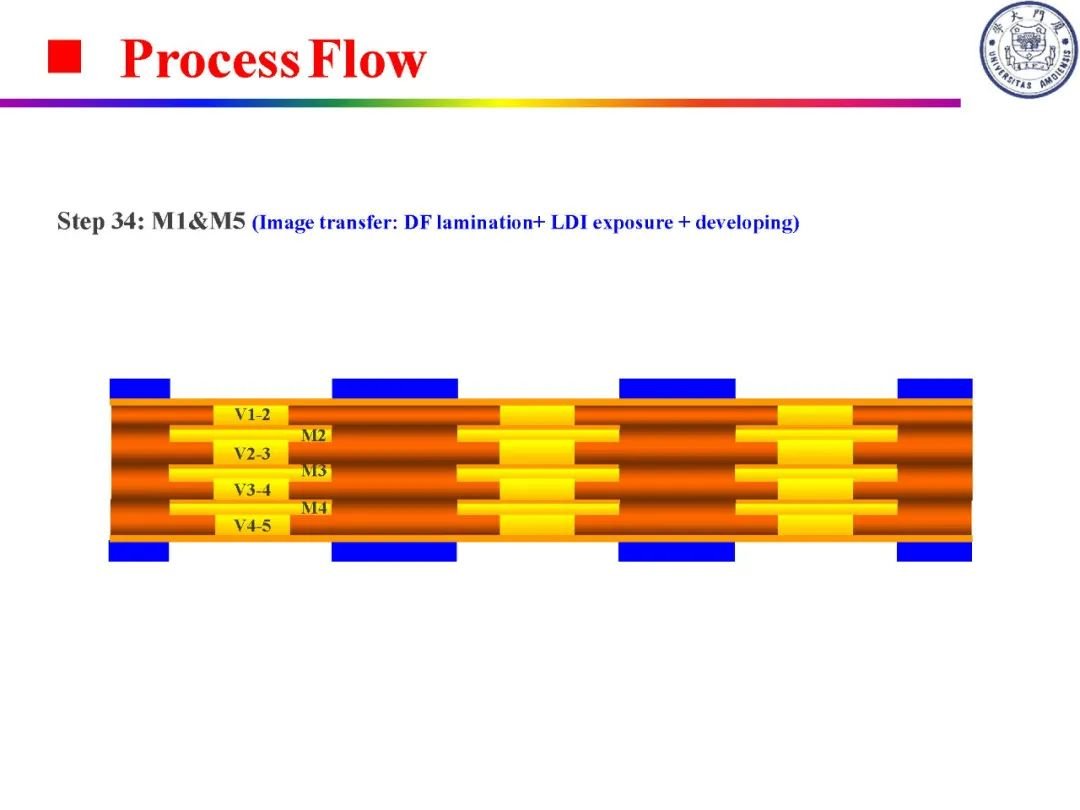
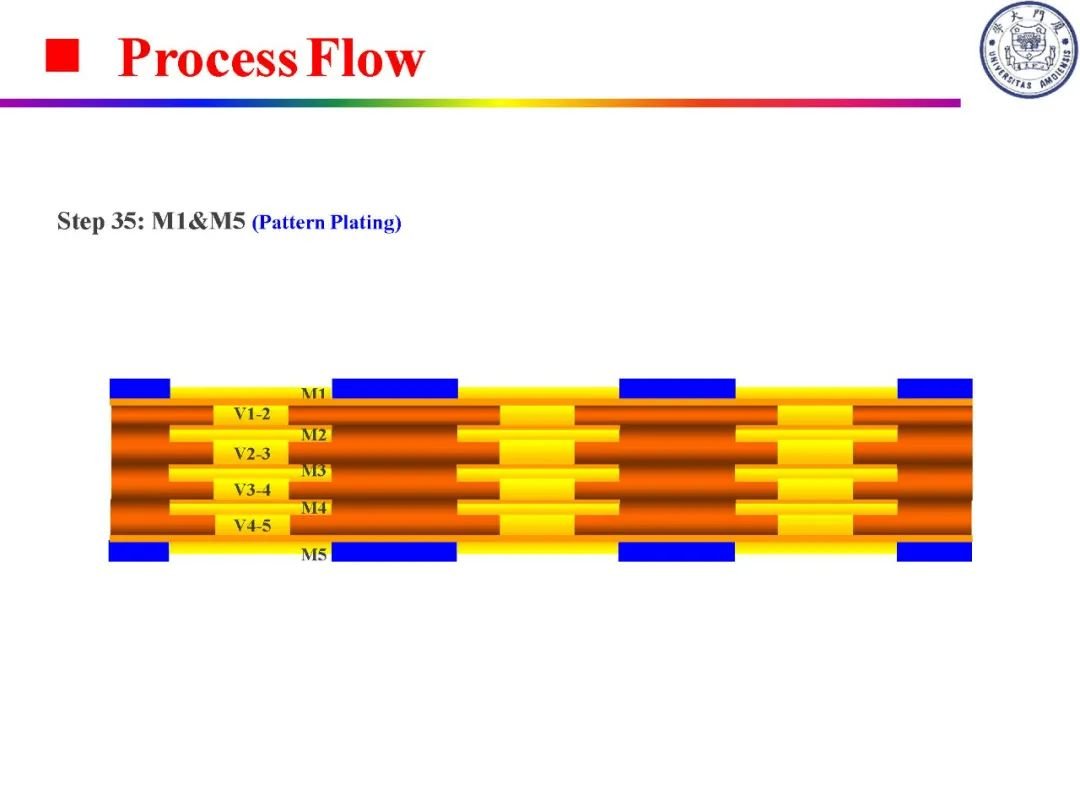
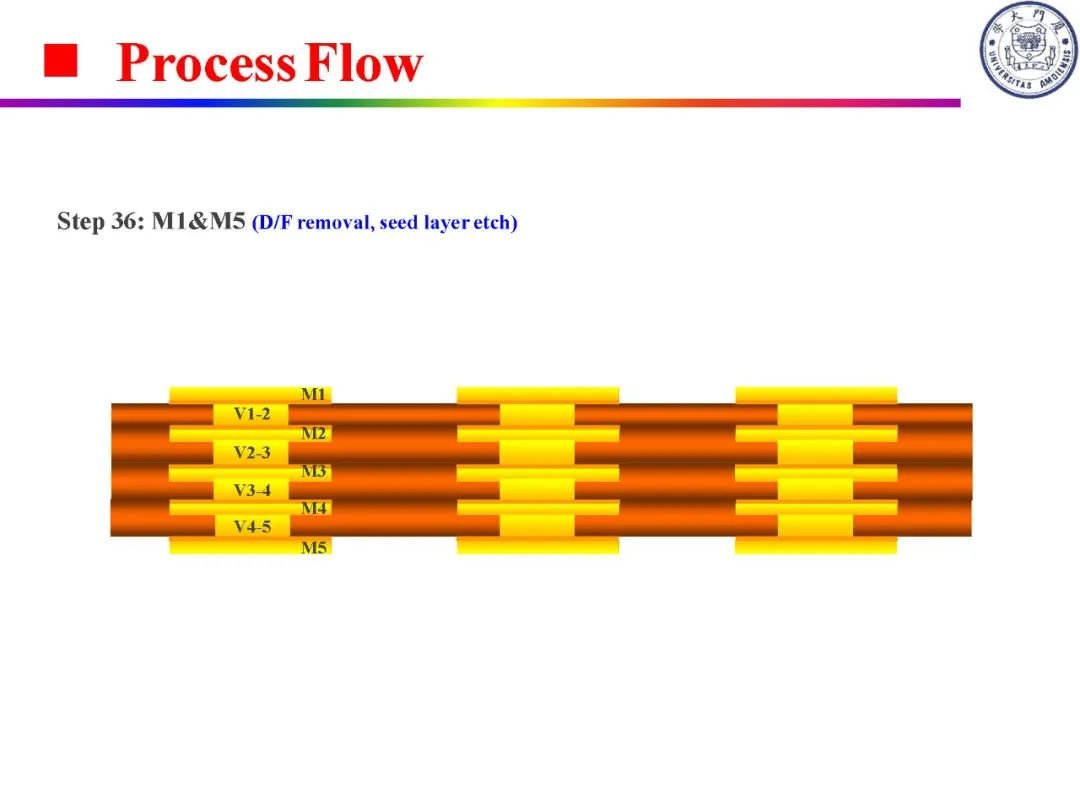
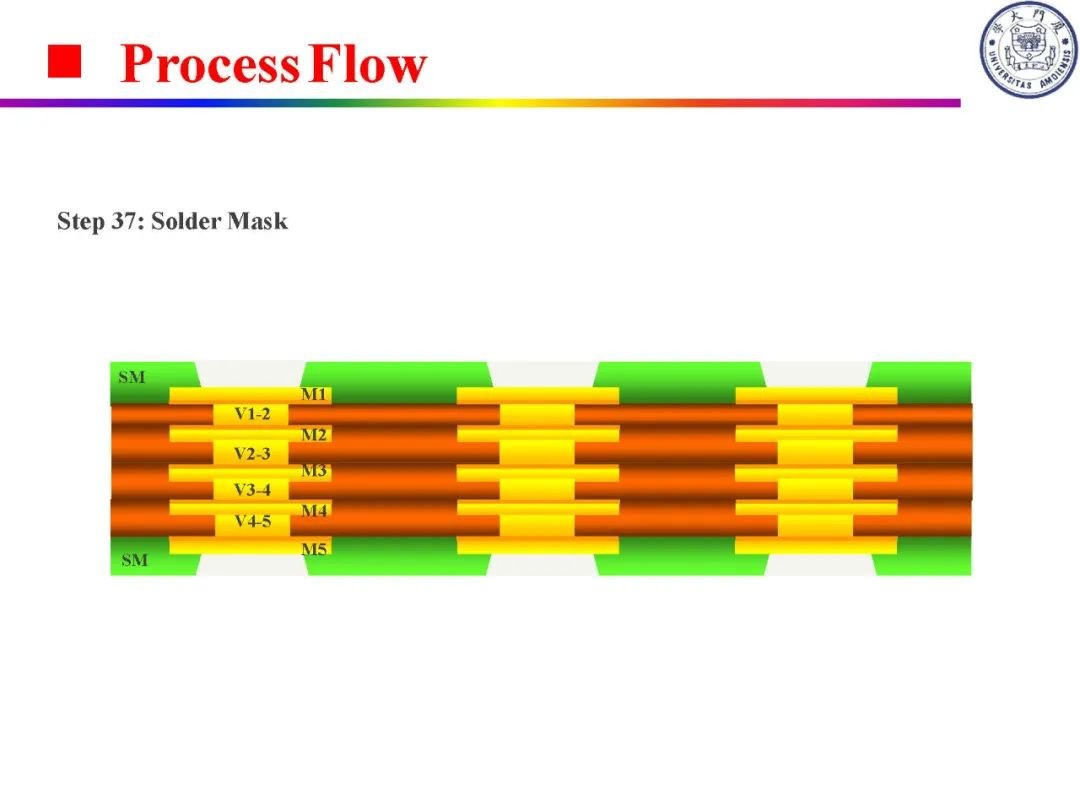
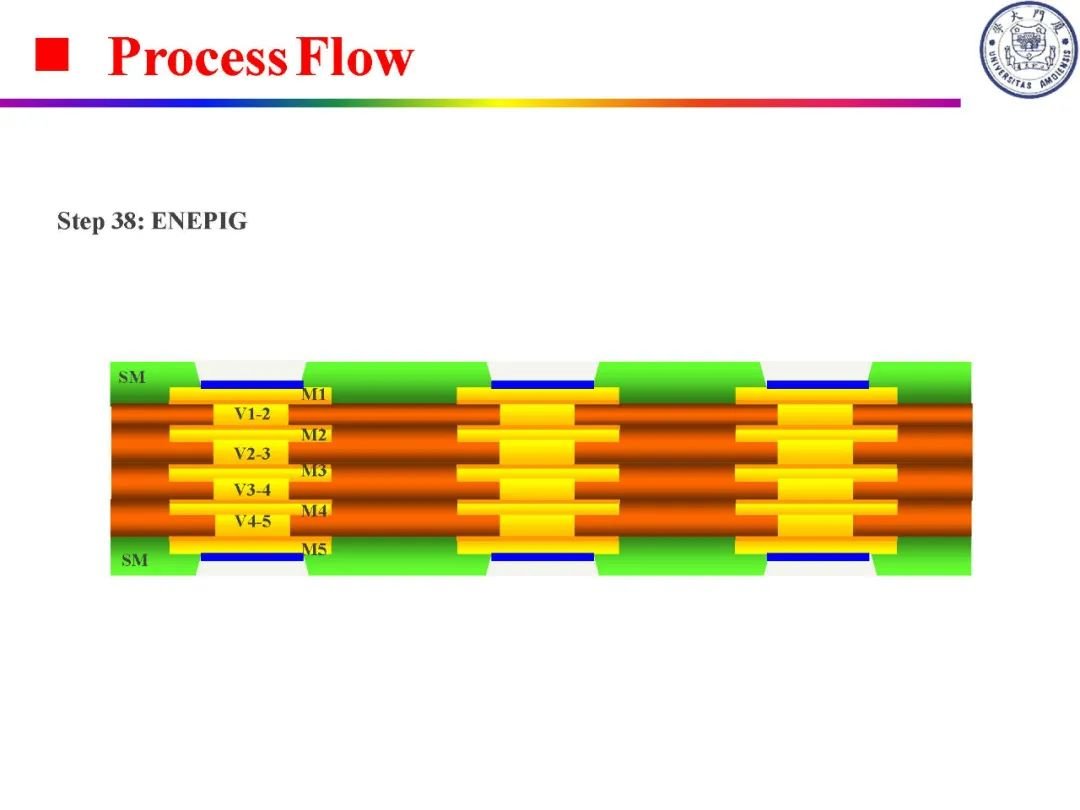

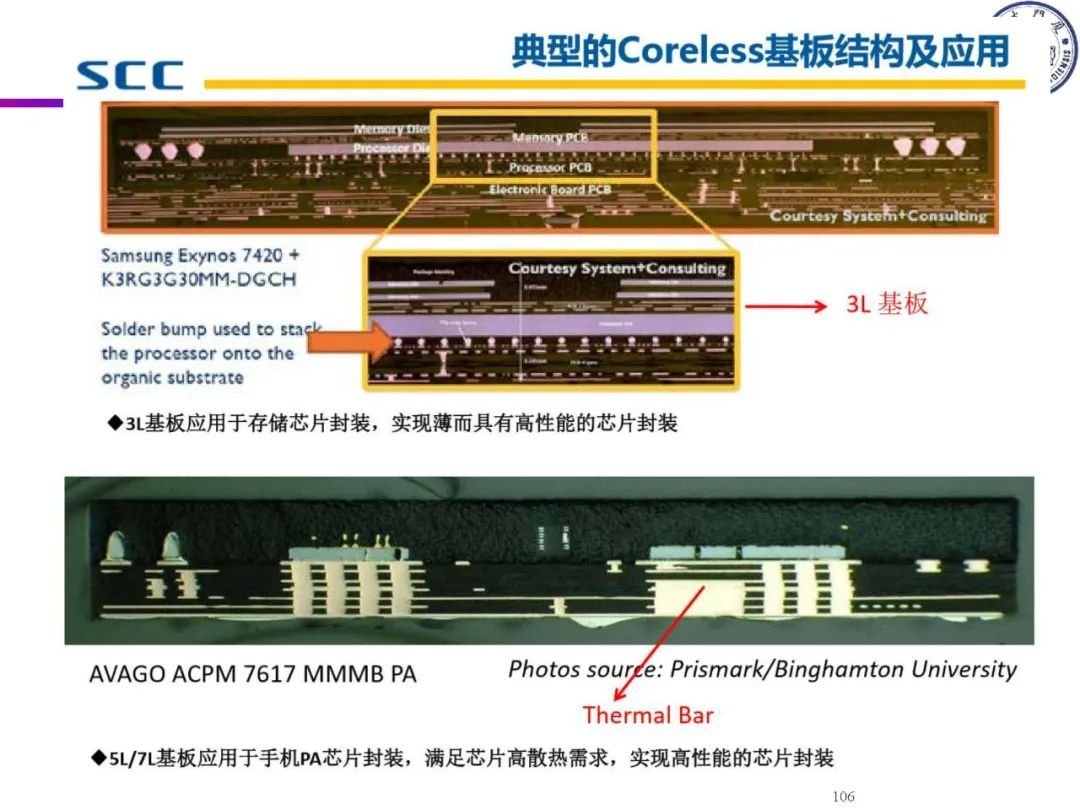
审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
基板
+关注
关注
2文章
324浏览量
24085 -
电子封装
+关注
关注
0文章
94浏览量
11417
发布评论请先 登录
相关推荐
热点推荐
苹果抢跑!自研AI服务器芯片选定玻璃基板,先进封装迎来终极方案?
电子发烧友网报道(文/梁浩斌)苹果AI芯片,瞄准了玻璃基板。近日供应链消息称,三星电机已经向苹果公司提供了半导体玻璃基板的样品,预计苹果将在其自研AI服务器芯片封装中应用玻璃

陶瓷基板技术全面解析——高端电子封装的核心基石
陶瓷基板作为高端电子封装领域的核心基础材料,是连接芯片与系统、保障电子器件稳定运行的“桥梁”,其性能表现、应用场景与市场竞争力,核心由基底材料特性与制造工艺
半导体先进封装之“2.5D/3D封装技术”的详解;
如有雷同或是不当之处,还请大家海涵。当前在各网络平台上均以此昵称为ID跟大家一起交流学习! 讲到半导体封装,相信大家现阶段听到最多的就是“先进封装”了。 其实先进

华宇电子分享在先进封装技术领域的最新成果
11月6日,在第21届中国(长三角)汽车电子产业链高峰论坛上,公司发表了题为“华宇电子车规级芯片封装技术解决方案新突破”的主题演讲,分享公司在先进
Chiplet与异构集成的先进基板技术
半导体产业正处在传统封装边界逐步消解的转型节点,新的集成范式正在涌现。理解从分立元件到复杂异构集成的发展过程,需要审视半导体、封装和载板基板之间的基本关系在过去十五年中的变化。

玻璃基板技术的现状和优势
玻璃基板正在改变半导体封装产业,通过提供优异的电气和机械性能来满足人工智能和高性能计算应用不断增长的需求。随着摩尔定律持续放缓,通过先进封装实现系统集成已成为达到最佳性能成本比的主要方

详解先进封装中的混合键合技术
在先进封装中, Hybrid bonding( 混合键合)不仅可以增加I/O密度,提高信号完整性,还可以实现低功耗、高带宽的异构集成。它是主要3D封装平台(如台积电的SoIC、三星的X-Cube

先进Interposer与基板技术解析
传统封装方法已无法满足人工智能、高性能计算和下一代通信技术的需求。晶体管尺寸已缩小至个位数纳米量级,但传统印刷线路板技术仍局限于20到30微米的线宽。这种三个数量级的差距造成了根本性瓶颈,Interposer和
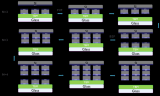
DPC陶瓷基板:高精密电子封装的核心材料
在电子器件不断向高性能、小型化、高可靠性发展的趋势下,陶瓷基板因其优异的导热性、绝缘性及热稳定性,成为大功率电子封装的理想选择。其中,直接镀铜陶瓷基
大族数控亮相2025封装基板国产化技术开发及应用研讨会
近日,在“2025封装基板国产化技术开发及应用研讨会”上,大族数控新激光产品中心研发总监兼总工程师陈国栋先生发表《mSAP/SAP制程微小孔绿色制造》专题演讲,在国家“双碳”战略背景下,该方案聚焦
PEEK注塑电子封装基板的创新应用方案
随着电子设备向高性能、小型化和高可靠性方向发展,电子封装基板材料的选择变得尤为关键。传统陶瓷基板(如氧化铝、氮化铝)因其优异的绝缘性和耐热性



 先进电子封装-基板技术详解
先进电子封装-基板技术详解


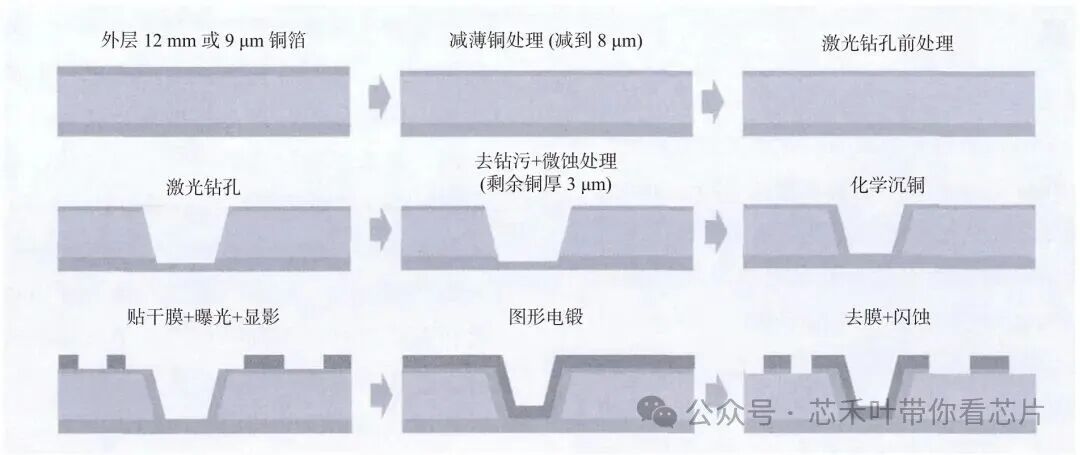





评论