据科创板30日报道,康宁韩国业务总裁Vaughn Hall周三表示,康宁希望利用其特殊的专有技术,扩大其在半导体玻璃基板市场的份额。“我对玻璃基板未来的发展寄予厚望,它似乎比目前芯片封装工艺中广泛使用的有机材料基板更具竞争优势。”
康宁目前供应两种用于芯片生产的玻璃基板产品,一种用于处理器中中介层的临时载体,即承接芯片(die)之间互联所用介质的玻璃基板;另一种用于DRAM芯片中晶圆(wafer)减薄的玻璃基板产品。未来,康宁正准备推出玻璃芯,用于芯片封装,公司正在向多个潜在客户提供样品。
当前,中国大陆为康宁全球最大的玻璃基板生产基地。玻璃基板主要供应给当前部署TGV技术路线的基板厂、封装厂和实验室。
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。
审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
463文章
54463浏览量
469596 -
半导体
+关注
关注
339文章
31279浏览量
266710 -
封装
+关注
关注
128文章
9339浏览量
149065
发布评论请先 登录
相关推荐
热点推荐
与NOKIA大咖共叙 | 玻璃芯技术的优势所在
。 观点精选 玻璃是一种性能卓越的材料 。它支持实现 传统PCB材料无法达成的技术方案 ,其精度与功能可媲美 半导体级别 。但本质而言,玻璃仅是基础载体,关键在于通过 专项工艺赋予

键合玻璃载板:半导体先进封装的核心支撑材料
(UV)、加热或机械方式解键合移除。 需要注意区别玻璃载板与玻璃基板,玻璃载板属于临时支撑工具,可重复使用3-4次,而玻璃
玻璃芯片基板成功实现激光植球技术新突破
紫宸激光焊锡应用ApplicationofVilaserSoldering高效节能绿色环保行业领先微型化浪潮下的封装革命在5G通信、人工智能、自动驾驶等技术的推动下,半导体器件正朝着更高集成度、更小

TGV产业发展:玻璃通孔技术如何突破力学瓶颈?
在后摩尔时代,芯片算力提升的突破口已从单纯依赖制程工艺转向先进封装技术。当硅基芯片逼近物理极限,2.5D/3D堆叠技术通过Chiplet(芯粒)拆分与异构集成,成为突破光罩限制的核心路
【海翔科技】玻璃晶圆 TTV 厚度对 3D 集成封装可靠性的影响评估
一、引言
随着半导体技术向小型化、高性能化发展,3D 集成封装技术凭借其能有效提高芯片集成度、缩短信号传输距离等优势,成为行业发展的重要方向 。玻璃晶圆因其良好的光学透明性、化学稳定

玻璃中介板技术的结构和性能优势
半导体行业持续推进性能和集成度的边界,Chiplet技术作为克服传统单片设计局限性的解决方案正在兴起。在各种Chiplet集成方法中,玻璃中介板代表了一个突破性进展,提供了传统硅基或有机基板无法实现
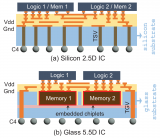
用于高性能半导体封装的玻璃通孔技术
半导体行业正在经历向更紧凑、更高效封装解决方案的转型。随着移动设备和物联网(IoT)应用对更小、更薄且具有增强电气可靠性的封装提出需求,研究人员将注意力转向3D封装技术。虽然硅

「行业动态」玻璃基技术:透明基板上的中国智造革命
CHIPSAILING 从实验室的意外发现,到撬动千亿市场的核心材料,玻璃基板如何悄然重塑半导体与生物识别的未来? 1970年,康宁实验室的化学家们面对一块“失败”的微晶
TGV技术:推动半导体封装创新的关键技术
随着半导体行业的快速发展,芯片制造技术不断向着更高的集成度、更小的尺寸和更高的性能迈进。在这一过程中,封装技术的创新成为了推动芯片性能提升的关键因素之一。TGV(

MEMS制造中玻璃的刻蚀方法
在MEMS中,玻璃因具有良好的绝缘性、透光性、化学稳定性及可键合性(如与硅阳极键合),常被用作衬底、封装结构或微流体通道基板。玻璃刻蚀是制备这些微结构的核心工艺,需根据精度要求、结构尺



 康宁计划扩大半导体玻璃基板市占 拟推出芯片封装用玻璃芯
康宁计划扩大半导体玻璃基板市占 拟推出芯片封装用玻璃芯









评论