来源:EEPW,谢谢
编辑:感知芯视界 Link
根据最新市场消息。苹果正积极与多家供应商商讨将玻璃基板技术应用于芯片开发,以提供更好散热性能,使芯片在更长时间内保持峰值性能。同时,玻璃基板的超平整特性使其可以进行更精密的蚀刻,从而使元器件能够更加紧密地排列在一起,提升单位面积内的电路密度。
在“摩尔定律”(半导体芯片的晶体管密度每24个月翻一番)逐渐失效的时代,当谈论芯片设计的下一步发展时,人们关注的焦点包括填充更多内核、提高时钟速度、缩小晶体管和3D堆叠等,很少考虑承载和连接这些组件的封装基板。玻璃基板的应用将为芯片技术带来革命性的突破,并可能成为未来芯片发展的关键方向之一。
什么是玻璃基板?
芯片基板是用来固定晶圆切好的晶片(Die),封装的最后一步的主角,基板上固定的晶片越多,整个芯片的晶体管数量就越多。自上世纪70年代以来,芯片基板材料经历了两次迭代,最开始是利用引线框架固定晶片,到90年代陶瓷基板取代了引线框架,而现在最常见的是有机材料基板。
有机材料基板加工难度小,还可以高速信号传输,一直被视作是芯片领域的领军者。但是有机材料基板也存在一些缺点,就是其与晶片的热膨胀系数差异过大,在高温下,晶片和基板之间的连接容易断开,芯片就被烧坏了。
需要通过热节流仔细控制芯片温度,代表芯片只能在有限时间维持最高性能,再降回较慢速度,以降低温度。因此,有机基板的尺寸受到很大限制,在有限的尺寸下容纳更多的晶体管,基板的材料选择至关重要。
在这个背景下,玻璃基板应运而生。玻璃基板具有卓越的机械、物理和光学特性,能够构建更高性能的多芯片SiP,在芯片上多放置50%的Die。相比之下,玻璃基板具有独特的性能,比如超低平面度(极为平整)、更好的热稳定性和机械稳定性:由于玻璃材料非常平整,可改善光刻的聚焦深度,同样面积下,开孔数量要比在有机材料上多得多,玻璃通孔(TGV)之间的间隔能够小于100微米,这直接能让晶片之间的互连密度提升10倍;此外,玻璃基板的热膨胀系数与晶片更为接近,更高的温度耐受可使变形减少50%,可以降低断裂的风险,增加芯片的可靠性。这些优势使得玻璃基板成为了下一代高密度封装的理想选择。
相较于传统有机基板,玻璃芯基板的厚度可以减少一半左右,玻璃基板不仅功耗更低,而且信号传输速度更快,有望为服务器和数据中心中的大型耗电芯片带来速度和功耗优势。玻璃通孔现在正被成功应用于玻璃基板上,与以往相比,新一代处理器将在更小的体积内实现更多的组件,从而提高了设备的紧凑性和性能。
玻璃基板的易碎性、缺乏与金属线的黏合力以及通孔填充的均匀性等问题,也为制造过程带来了不小的挑战:选择适合的玻璃基板材料并确保它与芯片材料的兼容性是一个挑战,这涉及到材料的热膨胀系数、机械性能、介电特性等方面的匹配;玻璃基板上的连接技术需要具有高度的可靠性和稳定性,以确保芯片与外部电路的连接质量;与传统塑料封装相比,玻璃基板封装的制造成本可能较高,如何确保在大规模生产中保持一致的质量和性能也是需要解决的问题。
玻璃基板的特性非常适合Chiplet,由于小芯片设计对基板的信号传输速度、供电能力、设计和稳定性提出了新的要求,在改用玻璃基板后就可以满足这些要求。
另与硅相比,玻璃的高透明度和不同反射系数也为检测和测量带来了难度。许多适用于不透明或半透明材料的测量技术在玻璃上都不太有效,可能导致讯号失真或丢失,影响测量精度。更重要的是,玻璃基板需要建立一个可行的商业生产生态系统,这包括必要的工具和供应能力。
芯片领域的新宠
尽管仍存在诸多挑战,以及缺乏可靠性数据等,但其无与伦比的平整度和热性能为下一代紧凑型高性能封装提供了基础,让玻璃基板作为芯片下一代重要技术的潜力不容忽视。
用玻璃材料取代有机基板似乎正在成为业内共识,或者至少是未来一个非常重要的技术路径。从英特尔的率先入局,到三星、苹果等企业闻风而入,随着有机基板逐渐达到能力极限,各大科技巨头都在使出浑身解数。
早在十年前,英特尔就开始寻找有机基板的真正替代品,一种能够与大型芯片完美配合的基板,在亚利桑那州的CH8工厂试生产玻璃基板。作为封装基板领域的探索引领者,2023年9月,英特尔推出基于下一代先进封装的玻璃基板展示了一款功能齐全的测试芯片,计划于2030年开始批量生产,该芯片使用75微米的玻璃通孔,纵横比为20:1,核心厚度为1毫米。
英特尔的新技术不仅仅停留在玻璃基板的层面,还引入了Foveros Direct(一种具有直接铜对铜键合功能的高级封装技术),为可共同封装光学元件技术(CPO)通过玻璃基板设计利用光学传输的方式增加信号,并联合康宁通过CPO工艺集成电光玻璃基板探索400G及以上的集成光学解决方案。
英特尔与设备材料合作伙伴展开了密切合作,与玻璃加工厂LPKF和德国玻基公司Schott共同致力于玻璃基板的产品化。另外,英特尔还带头组建了一个生态系统,已经拥有大多数主要的EDA和IP供应商、云服务提供商和IC设计服务提供商。“现在是齐心协力实现封装领域下一次转型的时候了。”英特尔表示。
玻璃基板可为英特尔带来巨大的竞争飞跃,可以看到它已被添加到最新的路线图产品中。英特尔正朝着2030年在单个封装上集成1万亿个晶体管的目标前进,玻璃基板将是推动这一目标落地的强有力支持。
三星自然无法直视英特尔玻璃基板业务上鹤立鸡群,终于在今年宣告了加速玻璃基板芯片封装研发。2024年3月,三星集团子公司三星电机宣布与三星电子和三星显示器组建联合研发团队(R&D),三星电子预计将专注于半导体和基板的集成,而三星显示器将处理与玻璃加工相关的方面,以在尽可能短的时间内开发玻璃基板并将其商业化。
成立“新军团”加码研发,这足以见得三星对玻璃基板的重视。事实上,三星电机已在CES上就宣布计划于2025年生产样品、2026年大规模生产玻璃基板,比英特尔更快地实现商业化。而在这项技术领域中,除了英特尔和三星,已有多个强劲对手入局。
3月25日,LG Innotek也宣布入局玻璃基板的开发,将半导体基板做到第一是他们的业务目标。在回答有关发展半导体玻璃基板业务的问题时,其CEO表示:“我们半导体基板的主要客户是美国一家大型半导体公司,该公司对玻璃基板表现出极大的兴趣。当然,我们正在为此做准备。”
日本DNP公司展示新开发成果玻璃基板,示意图甚至完全从封装中省略了细间距载板,暗示这部分可能不再需要。据介绍,使用玻璃基板可以实现更精细的间距,因此可以实现极其密集的布线,因为它更硬并且不易因高温而膨胀。DNP表示相信玻璃将在倒装芯片球栅阵列等高端芯片封装中取代树脂,提出了在2027年大规模量产TGV玻璃基板的目标。
作为全球第一大基板供应商,日本Ibiden也在去年10月宣布,拟将玻璃基板作为一项新业务研发。据知情人士透露,当前Ibiden正处于半导体封装用玻璃芯基板技术的探索阶段。
SK集团旗下的Absolics,去年又投资了6亿美元,计划在乔治亚州科文顿建一座月产能达4000块的玻璃基板工厂。Absolics表示随着微处理的性能提升已达到极限,半导体行业正在积极利用异构封装,但现有的半导体载板必须通过称为硅中介层的中间载板连接到半导体芯片,而内置无源元件的玻璃载板可以在相同尺寸下集成更多的芯片,功耗也减少了一半。
英特尔和三星的积极部署,可以理解为是其迎战台积电的一大策略。当前,在先进工艺领域台积电依旧领先,而在先进封装领域台积电CoWoS实力雄厚,拥有较高的专利壁垒。英特尔和三星除在工艺层面加紧布局之外,先进封装领域也需要寻求新的路径实现追赶甚至超越,而玻璃基板成为一个最佳的“跳板”,虽然不能在最高级别取代CoWoS/EMIB的需求,但可以提供比当前有机基板更好的信号性能和更密集的布线。
有行业专家表示,台积电对玻璃基板虽然还没有相关动作,但应该也在密切关注。台积电在CoWoS领域火力全开,接连获得大厂订单享受红利,因而并不急于投入巨资押注玻璃基板,仍将继续沿着现有路径升级迭代,以保持领先地位不可撼动。而一旦台积电觉得时机成熟,将会大幅加码。
AI高算力需求成为引爆点
玻璃基板不仅是材料上的革新,更是一场全球性的技术竞赛。玻璃基板可能成为各国共同完成的新领域,除基板制造商外,将吸引全球IT设备制造商和半导体企业参与。玻璃基板有望应用在人工智能、高性能存储与大模型高性能计算(基于光电子的计算和射频、硅光集成、高带宽存储器)、6G通信领域。
ChatGPT、Sora彻底引爆了人工智能,对数据中心和传输效率提出了更高的要求,尤其是对低功耗、高带宽的光模块的需求更加迫切。高算力Chiplet芯片离不开Cowos、FOEB等先进封装平台,AI芯片尺寸/封装基板越来越大,玻璃基封装被提上日程。未来AI芯片是各家抢占的高地,玻璃技术成为提效降本的翘板,用在需要更大外形封装(即数据中心、人工智能、图形)和更高速度功能的应用程序和工作负载,期望玻璃基板能够构建更高性能的多芯片系统级封装(SiP)。
英伟达指出,AI所需的网络连接带宽将激增32倍,继续使用传统光模块将导致成本翻倍和额外的20-25%功耗。共封装光学技术将硅光模块和CMOS芯片封装集成,使用玻璃基板,从玻璃基板边缘进行插拔互联,有望降低现有可插拔光模块架构的功耗达50%,成为满足AI高算力需求的高效能比解决方案。
值得注意的是,从当前行业进展来看,封装基板要过渡到玻璃基板,预计还需要一些时间。玻璃芯基板的良性发展需要产业链上下游建立一个完整的生态系统,从材料端层层向下到制程端、设备端等,都需要革新。材料选择、制程工艺的选择、自动化传输、结构堆栈的设计这些都会影响最后的良率,供应链需进行一番整合,才有办法达成量产的可能性。
在短时间内,芯片基板市场的主流还依旧会是有机材料,毕竟技术迭代完成商业化转身也需要一个过渡时期,但可以肯定的是,有机材料在芯片基板舞台上的重要性会逐渐被玻璃取代,玻璃和有机基板将在未来几年共存。有预测称,一旦实现玻璃基板的规模商业化,其将成为基板行业新的游戏规则改变者。
*免责声明:本文版权归原作者所有,本文所用图片、文字如涉及作品版权,请第一时间联系我们删除。本平台旨在提供行业资讯,仅代表作者观点,不代表感知芯视界立场。
今日内容就到这里啦,如果有任何问题,或者想要获取更多行业干货研报,可以私信我或者留言
审核编辑 黄宇
-
芯片
+关注
关注
463文章
54379浏览量
468992 -
封装
+关注
关注
128文章
9317浏览量
149021 -
AI
+关注
关注
91文章
40941浏览量
302517 -
玻璃基板
+关注
关注
1文章
105浏览量
11097
发布评论请先 登录
苹果抢跑!自研AI服务器芯片选定玻璃基板,先进封装迎来终极方案?

FT 5000 Smart Transceiver:下一代智能网络芯片的卓越之选
DirectScan 技术解析:下一代半导体电子束检测的创新路径与应用

玻璃基板技术的现状和优势

Microchip推出下一代Switchtec Gen 6 PCIe交换芯片
下一代100T网络交换拓扑 | Marvell与Samtec联合推出卓越解决方案

Telechips与Arm合作开发下一代IVI芯片Dolphin7
适用于下一代 GGE 和 HSPA 手机的多模/多频段 PAM skyworksinc

先进Interposer与基板技术解析
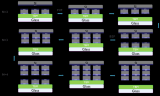



 下一代芯片重要技术 —— 玻璃基板,封装竞争新节点?
下一代芯片重要技术 —— 玻璃基板,封装竞争新节点?








评论