确保BGA封装产品的长期供货支持
在缓解供应链内容的第一章,我们回顾了半导体器件摆脱传统引线框架封装的原因及历史。总而言之,这些花费昂贵修整和成型工序的封装类型:PDIP、PLCC、PQUAD和PGA等,以及市场已转向基于基板的球栅阵列封装(BGA)、四方扁平无引线封装(QFN)和双边扁平无引线封装(DFN)。
在缓解供应链内容的第二章,我们深入研究了QFN和DFN封装技术的发展及其对低引脚数产品带来的好处。引线框封装成本昂贵和加工复杂性是推动行业采用QFN和DFN技术的主要因素。
在缓解供应链内容的第三章,我们介绍了硅、制造工艺和晶圆存储,以及如何在生产难题中发挥作用以缓解供应链中断。
本章是缓解供应链中断系列的第四章,我们将探讨多引脚产品向基于基板的BGA封装的变迁。
为何采用基板BGA封装?
早期多数采用的PGA阵列封装技术,时至当今主流的BGA封装技术,是允许高数据量进出封装的关键。BGA是在封装的底面贴装PCB电路板,而非沿封装周围排列连接,引脚面积因此显著缩小。阵列封装成功实现将数百个信号从IC传输至PCB板。
认识到阵列封装相对于双列直插封装(DIP)和四方扁平封装(QFP)的性能和密度优势后,我们来谈谈从PGA到BGA的市场转向。核心的技术差异是BGA采用表面贴装连接PCB,而PGA采用通孔技术连接PCB。考虑到自动化和复杂性的生产成本,表面贴装技术更受欢迎。另外,BGA元器件的封装过程更简单,成本也更低。
BGA封装基于基板安装IC晶圆,旨在通过阵列焊球连接IC焊盘。BGA封装可根据特定应用的需要采用引线键合或倒装芯片配置。倒装芯片中可通过重布线层将信号连接至焊球,从而最少化基板内的布线。焊球取代焊线的封装技术,实现了产品的高性能。这些基底被制造成包括基底网格的基板形式。可实现并行处理多个元件的封装操作。该制程完成后,基板被切割成最终的芯片。BGA的焊球取代了PGA的电气引脚。在封装的底部通过表面贴装技术将 IC连接到PCB焊球阵列。
罗彻斯特电子位于马萨诸塞州纽伯里波特的工厂具备BGA封装的生产能力,能够生产包括BGA在内的多种封装产品。支持从PGA或QFP封装迁移至BGA封装的需求,包括从封装到测试的流程。这种迁移帮助客户保持相同的信号链路,从而保留了同样的板级信号完整性分析。罗彻斯特电子旨在为客户提供可针对现有设计直接替代的且无需更改软件的设计服务。
封装、基板和引线框的复产
行业放弃引线框封装的原因在于,新技术性能追求零引线接合,以及继续降低引线框架体积的成本十分高昂。
罗彻斯特电子预见到这一趋势,决定同时投入基于引线框的封装以及基于基板的QFN和BGA封装。罗彻斯特电子拥有数十亿片芯片和晶圆的库存,其中大多数需要引线框封装,因此这一决定十分合乎逻辑。罗彻斯特电子不仅投入PLCC封装的昂贵修整和成型——即使世界上最大的封装厂及其他许多封装厂已不再提供该封装——还在美国建立了自有的标准封装厂,基本支持所有的封装类型。
罗彻斯特电子封装、基板和引线框的复产:
能够重新引入大多数封装技术
可支持RoHS/锡铅引脚电镀
JEDEC标准封装和定制化封装
可提供基板和引线框的设计服务
可提供认证服务
-
pcb
+关注
关注
4417文章
23965浏览量
426173 -
晶圆
+关注
关注
53文章
5449浏览量
132760 -
BGA封装
+关注
关注
4文章
126浏览量
19130
原文标题:缓解供应链中断:多引脚产品最佳选择之球栅阵列(BGA)封装
文章出处:【微信号:罗彻斯特电子,微信公众号:罗彻斯特电子】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
一文掌握BGA封装技术:从基础到可靠性测试,推拉力测试机如何保障品质?

GT-BGA-2003高性能BGA插座
罗彻斯特电子为客户提供厂内BGA封装元器件重新植球服务
一文详解封装基板的制备工艺
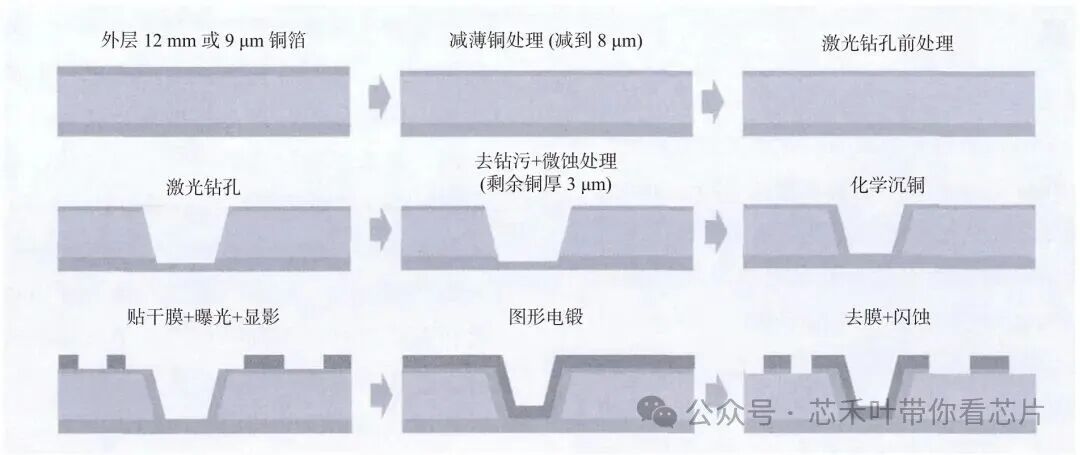
激光锡焊技术在BGA封装的应用场景

FICT FC-BGA基板GigaModule-2系列产品的核心优势


IPC-6921有机封装基板国际标准即将落地


GT-BGA-2002高性能BGA测试插座
BGA芯片阵列封装植球技巧,助力电子完美连接

紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力

解析LGA与BGA芯片封装技术的区别




 为何采用基板BGA封装?探讨多引脚产品向基于基板的BGA封装的变迁
为何采用基板BGA封装?探讨多引脚产品向基于基板的BGA封装的变迁




评论