在半导体工艺制程中,由于经常需要制备复杂的微结构,可能每一次光刻的需求都天差地别,有时需要正性光刻胶提升分辨率,有时需要负性的光刻胶做剥离(Lift-off),有时需要厚的光刻胶做深槽刻蚀。那么它们是如何满足这些需求的?经常使用的光刻胶有哪些,以及它们的原理是什么?
光刻胶按照种类可以分为正性的、负性的。正胶受到紫外光照射的部分在显影时被去除,负胶受到紫外光曝光的地方在显影后被留下。
正胶
正胶成分:通常正胶主要由光敏剂、树脂和溶剂组成。市场上的光刻胶体系有很多,我们以常规DQN双组分体系正性光刻胶为例,以便理解。其主要有三部分组成:酚醛树脂(Novolac)、光敏剂重氮醌(DQ)、二甲苯(溶剂)。
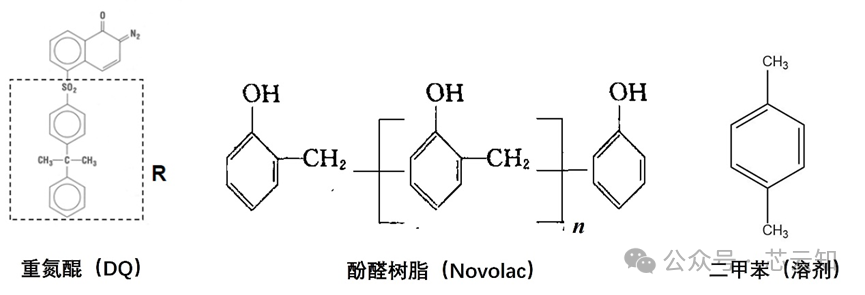
曝光原理:DQ体系利用的是Wolff重排反应,其中DQ中的α-重氮醌在光照下放出氮气和醌自由基,再发生1,2-重排反应生成醌酮,然后在水的作用下,酮基进一步转化为羧基,可以与碱性显影液发生酸碱反应,加速溶解。最终,曝光的区域显影速度快,实现正胶图形化。

负胶
负胶成分:负胶主要由聚合物单体、光敏剂和溶剂构成。光敏剂通常可以产生自由基从而引发单体发生聚合,形成三维的分子网,使可溶性变为不溶性,从而实现图案的转移。以SU-8光刻胶为例,主要成分为:SU-8的单体、三芳基硫盐的光敏剂、溶剂PGMEA。

曝光原理:首先,三芳基硫盐在紫外光的作用下,发生分解产生氟锑酸和三芳基锍六氟锑,然后氟锑酸使得SU-8单体中的环氧基开环及重构,使得该环氧基团上使相邻的碳上缺少一个电子,最后在结构的活性化后再与其他单体分子中的环氧基团聚合,实现分子链的相连,使胶转变为不溶性,胶体固化。
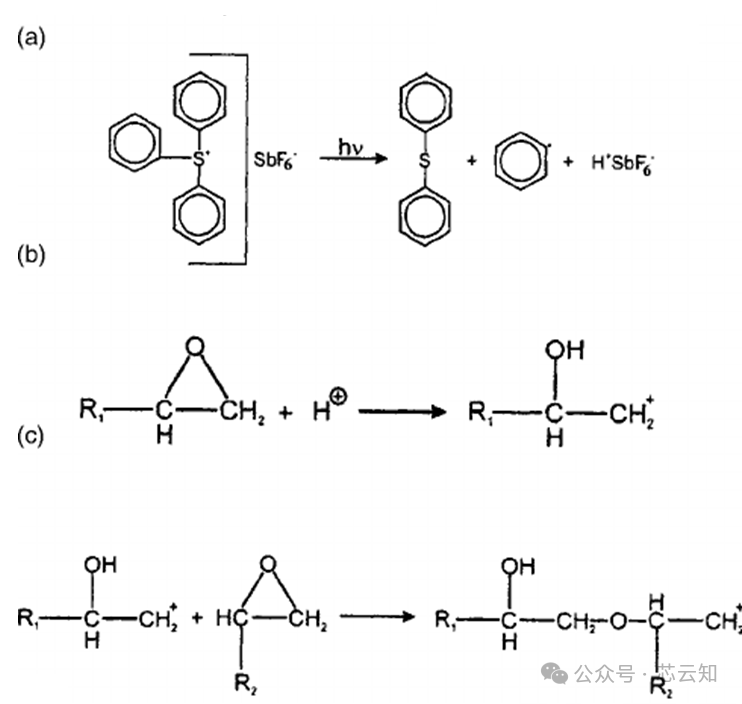
正负光刻胶对比
如何选择正负光刻胶是半导体工艺中最重要的一部分。表1对比了正负光刻胶的性能。一般来讲,对于要求高分辨率和精密结构的器件,通常使用正性光刻胶,其制程简单、成本较低以及可以提供良好的图案解析度。通过选择合适的曝光剂、显影剂和后续处理步骤,可以实现对正胶的精确控制,从而实现复杂的器件结构。
而负胶由于其分子高度交联化,使其具有良好的耐化学性,热稳定性,抗刻蚀性,通常适用于制造一些微结构或是复杂的三维形态,例如,微流控芯片,微型管道、微型阻塞阀门等微流体器件。

光刻胶指标
由于不同型号的光刻胶的性能各不相同,所以在选择一款合适的光刻胶时,通常可以参考以下指标:
分辨率(Resolution):指光刻胶能够实现的最小特征尺寸,通常以线宽或线间距来表示。分辨率越高,光刻胶能够实现的更小的结构尺寸。
显影速度(DevelopmentRate):指显影剂去除光刻胶未曝光区域的速度。较快的显影速度有助于提高制程的生产效率。
曝光灵敏度(ExposureSensitivity):指光刻胶对曝光光源的敏感程度,通常与曝光剂的浓度和曝光时间有关。曝光灵敏度越高,所需的曝光能量越小。
溶解度(Solubility):指光刻胶在显影液中的溶解性能,影响着显影过程的速度和控制性。
耐化学性(ChemicalResistance):指光刻胶在制程中所能承受的化学处理,如腐蚀剂、清洗剂等的抵抗能力。
干膜厚度(Dry FilmThickness):指涂覆在基片上的光刻胶的厚度,直接影响着最终图案的尺寸和形状。
热稳定性(ThermalStability):指光刻胶在高温处理过程中的稳定性,如烘烤、退火等。
以下是半导体工艺中常用的光刻胶,具体的参数和性能还需要工艺人员进行调试。

审核编辑:黄飞
-
光刻胶
+关注
关注
10文章
284浏览量
29759 -
半导体工艺
+关注
关注
18文章
104浏览量
26048
原文标题:一文读懂光刻胶
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
半导体光刻胶企业营收靓丽!打造光刻胶全产业链 博康欲成国产光刻胶的中流砥柱
Futurrex高端光刻胶
光刻胶残留要怎么解决?
Microchem SU-8光刻胶 2000系列
光刻胶
光刻胶在集成电路制造中的应用
光刻机工艺的原理及设备
半导体材料市场构成分析
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓
《炬丰科技-半导体工艺》IC制造工艺
一种半导体制造用光刻胶去除方法
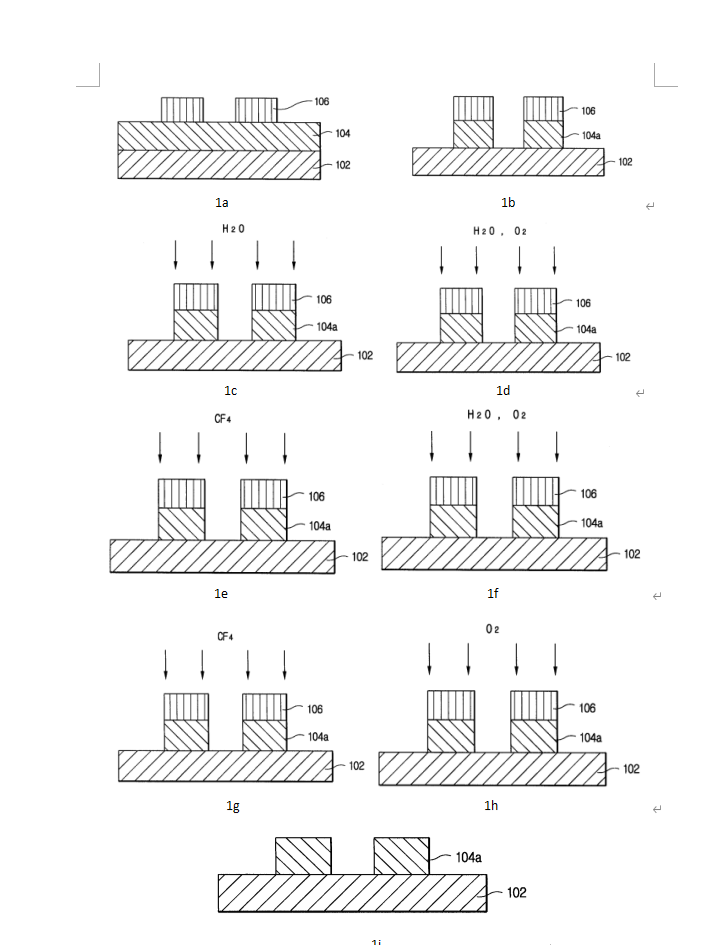




 一文读懂半导体工艺制程的光刻胶
一文读懂半导体工艺制程的光刻胶










评论