据日本研究人员报告,通过减少碳污染来避免碳污染源导致的“迁移率崩溃”,氮化镓(GaN)的电子迁移率性能创下新高 。
住友化学株式会社、京都大学、名古屋大学、可持续材料与系统研究所(IMaSS)组成的研究团队报告称,一样品的碳浓度([C])低至1.4x1014/cm3,却显示出1480cm2/(V-s)的创纪录室温迁移率(μRT),温度为62K时,最大μMAX为14,300cm2/(V-s),同样创下记录。研究人员指出,该样品的μMAX值几乎是先前记录的两倍。
研究团队采用无石英氢化物气相外延(QF-HVPE)生长方法,严格控制硅(Si)、碳、氧的污染。石英是结晶二氧化硅。这种材料通常用于高温工艺设备中。
除了实现创纪录的迁移率性能外,该团队还寻求从经验上理解碳污染造成的“崩溃”,以期充分发挥GaN的能力,制造出更高效、更紧凑的功率器件,借此为电动汽车制造逆变器,并为可再生能源制造功率转换器。
制造GaN常会用到金属有机III族氮化物生长方法,其中碳污染是一个特殊问题,利用该方法进行制造时,金属离子镓、铟、铝会与有机成分相连,生成三甲基镓等前驱体。甲基(CH3)由碳和氢组成。Sumitomo等人的无石英氢化物气相外延法则避免了有机化学,从而避免加入不受控的碳。
研究人员先利用他们的空隙辅助分离法制备出2英寸独立GaN衬底,再用无石英氢化物气相外延工艺在其上生长材料,最后利用所生长材料制备出用于霍尔测量的样品。通过背面抛光去除生长衬底后,测试样品由6mm x 6mm的方形n型GaN层组成。
生长GaN层耗时5至8小时,生长后整体厚度为300-500µm。去除衬底后,材料厚度为200-400µm。生长温度为1050°C,生长压力为大气压。生长衬底的穿透位错密度(TDD)是均匀的,介于1x106/cm2和3x106/cm2之间。
样品污染包括放置在氨气(NH3)N源气体流道的一小块碳。碳块大小控制杂质浓度(见表),杂质浓度由二次离子质谱法(SIMS)测定。从材料的中心开始,用于霍尔测量的铝/钛电极放置在方形样品的四角上。
表1:三种样品的Si和C杂质浓度以及霍尔测量结果

利用20K至300K(RT,室温)时霍尔参数的温度依赖性来评估散射机制对降低迁移率的影响,例如电离杂质(II)、声学形变势(DP)、极性光学声子(POP)、压电(Piez)效应等散射机制。研究发现,迁移率在不同的低温下会有所升高,达到峰值(μMAX),然后随着温度接近室温而下降(μRT)。
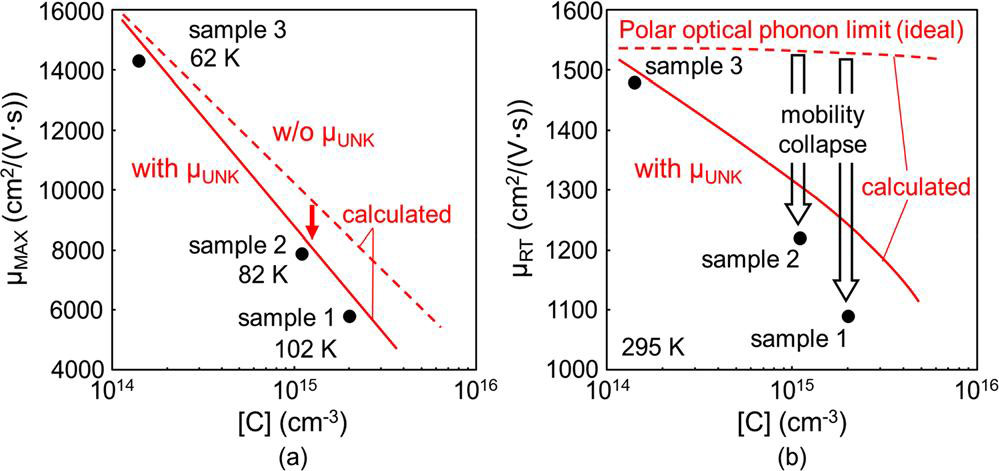
△ 图1:(a)[C]与μMAX的关系,(b)[C]与μRT的关系。观测到的数据标为实点。红色虚线代表传统理论,红色实线代表根据假设额外迁移率影响μUNK计算得出的数值。
针对μMAX和μRT随碳浓度变化的数据,研究人员比较了他们所得数据与传统理论所得数据(图1)。在μMAX的低温条件下,主要的迁移率来自杂质散射。虽然测量值低于传统预期值,但差异相对较小。然而,在室温条件下,原预计声子散射对迁移率的影响会占主导地位,但测量结果仍然显示碳的存在会产生很大影响,从而导致“迁移率崩溃”。
研究团队以经验为主,尝试用术语μUNK(图2)来描述对迁移率的“未知”影响。在无未知(UNK)影响和未知影响随T-1.5变化的情况下,分别计算总迁移率。温度随T-1.5变化时,拟合结果更佳。

△ 图2:样品(a)1、(b)2、(c)3的霍尔迁移率与温度的函数关系。黑色实点代表实验数据。灰色、蓝色、橙色、绿色实线分别是算出的μII、μDP、μPOP、μPiez影响的霍尔迁移率,不含μUNK(虚线)和含μUNK(实线)。
必须记住,“散射”的增加会降低载流子迁移率,因此迁移率影响,至少在简单理论中,以倒数总和(Σi1/μi)的形式结合在一起,从而得出有效迁移率的倒数(1/μeff)。
附加影响的大小变化(μUNK= K/T1.5)近似于1/[C]的趋势(图3)。μUNK的温度指数在1和2之间时,在拟合实验数据方面具有类似能力。

△ 图3:样品1-3的μUNK指前因子K与[C]之间的关系,以及先前报告的数据。
研究团队评论道:“传统理论已考虑电离杂质散射,因此图3中K对[C]的依赖性有力表明,碳杂质诱发了电离杂质散射之外的其他散射机制。深碳受体周围局部应变引起的散射就是一种可能性。”
审核编辑:刘清
-
电动汽车
+关注
关注
156文章
12717浏览量
237425 -
逆变器
+关注
关注
306文章
5243浏览量
218199 -
氮化镓
+关注
关注
67文章
1923浏览量
120237 -
GaN
+关注
关注
21文章
2391浏览量
84926 -
载流子
+关注
关注
0文章
136浏览量
8060
原文标题:除碳可提高GaN电子迁移率
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
维信诺率先推出高迁移率ALD全氧化物技术的量产解决方案
Wolfspeed CGHV40050:高性能GaN HEMT的卓越之选
Wolfspeed CGHV35150:S波段雷达系统的理想GaN HEMT
Wolfspeed CMPA0527005F:高性能GaN HEMT的技术解析
氮化镓GaN FET/GaN HEMT 功率驱动电路选型表
PC5200 700V_10A GaN HEMT驱动器数据手册
键合率达95%!三菱电机推进 GaN-on-Diamond 新技术

CGH40006P射频晶体管
小米公布射频器件研发成果:低压硅基GaN PA首次实现移动端验证

新型超快速单脉冲技术解决传统迁移率测量挑战
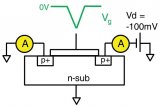
Leadway GaN系列模块的功率密度
基于传输线法(TLM)的多晶 In₂O₃薄膜晶体管电阻分析及本征迁移率精准测量




 除碳可提高GaN电子迁移率?
除碳可提高GaN电子迁移率?

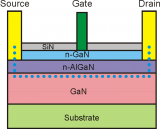




评论