日前,华为技术有限公司公布一项全新专利,命名为“封装结构及其制造方法、板级架构以及电子设备”,专利公开编号为CN117577594A,申请日期为2022年8月。
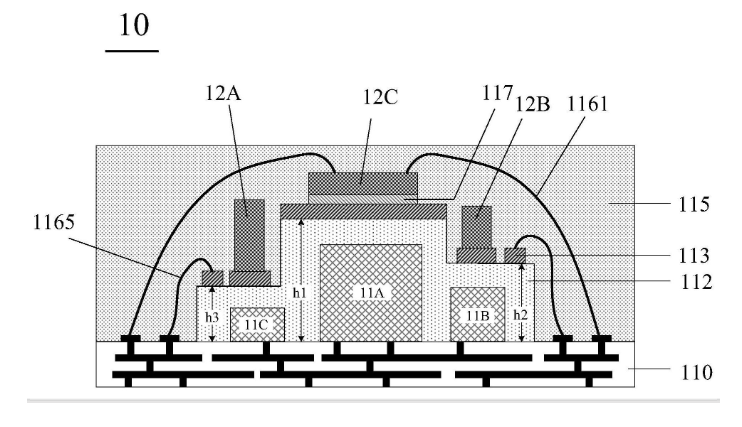
据悉,该新型专利涉及封装结构设计、制造流程、板级架构以及相应的电子设备等多方面内容。具体而言,创新性的封装结构由基板、多种不同功能的元器件、第一和第二塑封层以及金属布线层组成。巧妙地将基板上方的第一塑封层依照元器件的高度进行规划,极大地节省了高度方向的使用空间,进一步提升了封装结构的堆叠密度;此外在第一塑封层顶部还设置有金属布线层,用以配合第二塑封层将元器件稳固地安装并实现基板间的电气连通。相较于传统的封装结构,新发明在此基础上减少了一块基板的使用量,有效地降低了生产成本。同时,由于第二元器件直接被安装在第一金属布线层上,从而使整个装置具备显著的散热功效。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
元器件
+关注
关注
111文章
4529浏览量
88778 -
电子设备
+关注
关注
2文章
1952浏览量
52589 -
专利
+关注
关注
3文章
562浏览量
39030 -
华为技术
+关注
关注
0文章
40浏览量
7206
发布评论请先 登录
相关推荐
华为公布“基于人体通信的电子设备、通信装置和系统”专利
近日,华为在国家知识产权局官网公布了一项名为“基于人体通信的电子设备、通信装置和系统”的专利。该专利公开号为CN117438779A,展示了
华为技术有限公司获得一种电子设备的专利
该专利的简要描述显示,该设计主要应用于终端技术领域,特别是涉及到一种新型的电子设备构造。它采用独特的结构设计,通过将屏幕边缘的弯曲幅度加大并取消中间架构周围的中框,使得屏幕可以直接与

芯片封装
更复杂)替代以前的小芯片时,其封装体占用印刷板的面积保持不变或更小。正是由于CSP产品的封装体小、薄,因此它的手持式移动电子设备中迅速获得了应用。在1996年8月,日本Sharp公司就
发表于 12-11 01:02
华为公布一项“半导体封装”专利
华为封装新专利对麒麟的解决方案——对于麒麟9000s的量产,国内和国外从发售之日起,便不停的研究,最终也没得出什么结果。但拆机结果有两点:第一,麒麟9000s比麒麟9000大了一圈;第二,麒麟9000s散热方面做了特殊
发表于 11-10 11:31
•354次阅读

荣耀“芯片及电子设备”专利公布
根据专利摘要,本申请提供一种芯片及电子设备,基板和器件层,基板包括支持层和防热层,支持层和防热层按芯片厚度方向层层连接。部件一层一层地堆积在支撑层离开防热层的表面。散热层由散热部和间隔部组成,散热部和间隔部按芯片厚度方向和垂直方向排列和连接。

荣耀“屏幕组件及电子设备”专利公布
根据专利摘要,本申请涉及显示器领域,旨在解决因外部力量容易受损的显示器弯折部分的认知问题,并提供屏幕元件和电子设备。画面组件有显示面板,盖子,支架。盖子一侧的表面是第一个板面。
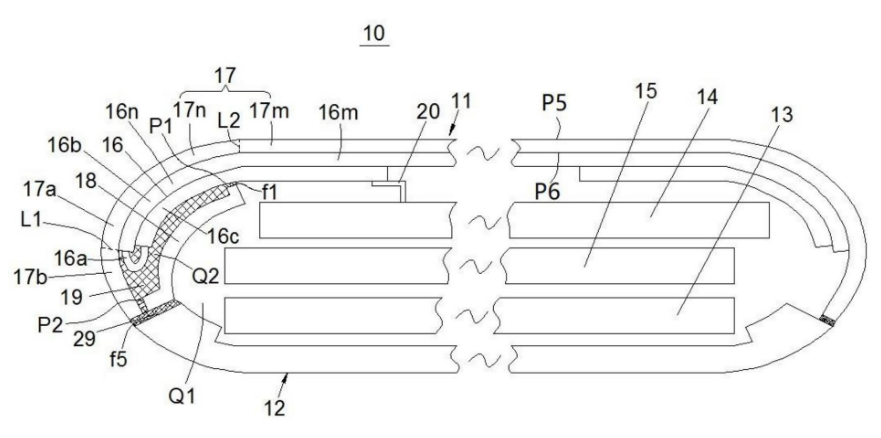
华为公开“芯片封装结构、其制备方法及终端设备”等专利
CN116648780A专利芯片封装结构包括第一芯片、第二芯片、第一重布线层、第二重布线层和垂直硅桥;其中,第一芯片和垂直硅桥并排设置在第一重布线层上,第二重布线层设置在垂直硅桥和第一芯片上





 华为公布封装结构、封装方法、板级架构及电子设备专利
华为公布封装结构、封装方法、板级架构及电子设备专利


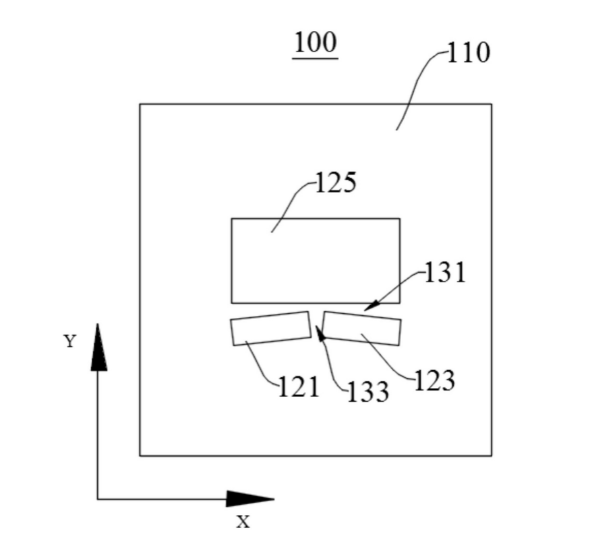


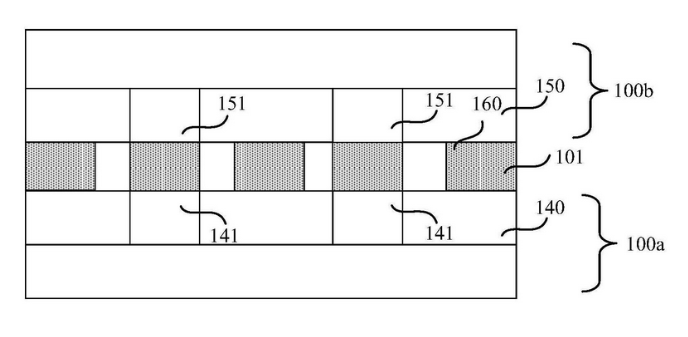











评论