最近,华为技术有限公司新增了多项专利信息。其中一项专利名称为“芯片堆叠结构及其形成方法、芯片封装结构、电子设备”,公开号码为cn116504752a。
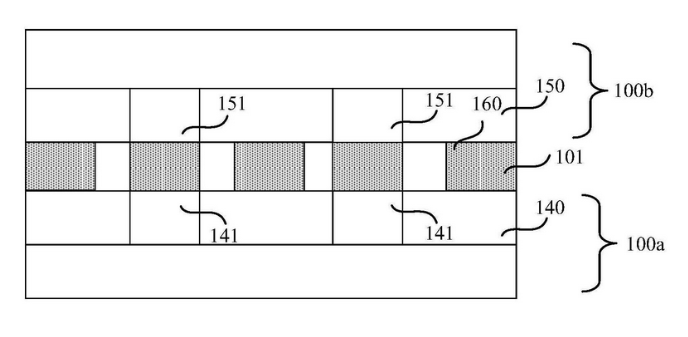
芯片技术领域的应用概要,用于简化芯片堆叠结构及其形成方法、芯片封装结构、电子设备、芯片堆栈结构的制造技术。该芯片的堆叠结构至少包括两个堆叠的芯片,每一个芯片包括电线层,电线层设有电具组。其中至少有两个芯片:堆叠的第一个芯片与第二个芯片,第一个芯片与第二个芯片之间通过耦合层电连接。结合层包括第1区,围绕第1区的第2区,第1区和第2区以外的第3区。结合层的第一区域,第一芯片层的投影法和第一芯片层的前工具结构至少部分一致。金属相层设置在第一,第三区域。
说明书中提到,它将用于简化芯片堆叠结构及其形成方法、芯片封装结构、电子设备技术和芯片堆栈结构的制造技术。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
封装
+关注
关注
128文章
9332浏览量
149047 -
芯片技术
+关注
关注
1文章
177浏览量
18492 -
堆叠
+关注
关注
0文章
37浏览量
17117 -
芯片封装
+关注
关注
14文章
623浏览量
32396
发布评论请先 登录
相关推荐
热点推荐
航空电子设备覆冰测试有哪些方法?需要用到哪些设备?怎么测试?
飞行安全。在测试中,通常会模拟低温、湿度和风速等环境条件,并通过喷水或其他方法在航空电子设备的表面形成冰层。通过监测和记录覆冰过程中的各种数据,可以评估设备在覆冰

真空共晶炉/真空焊接炉——堆叠封装
大家好久不见!今天我们来聊聊堆叠封装。随着信息数据大爆发时代的来临,市场对于存储器的需求也水涨船高,同时对于使用多芯片的堆叠技术来实现同尺寸器件中的高存储密度的需求也日益增长。那么,什

【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
为我们重点介绍了AI芯片在封装、工艺、材料等领域的技术创新。
一、摩尔定律
摩尔定律是计算机科学和电子工程领域的一条经验规律,指出集成电路上可容纳的晶体管数量每18-24个月会增加一倍,同时芯
发表于 09-15 14:50
探究P2/O3相堆叠结构对钠离子电池正极材料性能的影响
钠离子电池成本低、资源丰富,但其正极材料在深度脱钠时存在不利相变,影响离子传输和循环稳定性。P型堆叠结构虽利于钠离子扩散,但高脱钠态下易向O型堆叠转变,形成传输障碍。此研究聚焦于钠离子

汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利2025年4月30日消息,国家知识产权局信息显示,深圳市汉思新材料科技有限公司取




 华为公布“芯片堆叠结构及其形成方法、芯片封装结构、电子设备”专利
华为公布“芯片堆叠结构及其形成方法、芯片封装结构、电子设备”专利









评论