从国家知识产权局官网获悉,华为技术有限公司日前公开了一项名为“具有改进的热性能的倒装芯片封装”专利,申请公布号为CN116601748A。
据了解,该专利实施例提供了一种倒装芯片封装、一种装备有应用封装结构的电路的装置以及一种组装封装的方法,更直观来说,就是一种提供芯片与散热器之间的接触方式,能帮助改善散热性能。
该专利可应用于CPU、GPU、FPGA(现场可编程门阵列)、ASIC(专用集成电路)等芯片类型,设备可以是智能手机、平板电脑、可穿戴移动设备、PC、工作站、服务器等。

专利提到,近来,半导体封装在处理性能方面的进步对热性能提出了更高的要求,以确保稳定操作。

就此而言,倒装芯片封装在热性能方面具有优势,因其结构特征是芯片通过其下方凸块与基板连接,能够将散热器定位在芯片的顶表面上。
为提高冷却性能,会将热润滑脂等热界面材料(TIM)涂抹到芯片的顶表面,并夹在芯片和散热器的至少一部分之间。从降低TIM中的热阻以改善封装的热性能的角度来看,优选使TIM的厚度更小。

据了解,相较此前难以精细控制TIM厚度的散热方案,华为这项专利中的热界面材料的厚度由模制构件中的壁状结构的高度限定。
由于能在模制过程中轻松控制由模具化合物组成的壁状结构的高度,因此可以将热界面材料的厚度调节到所需的小厚度,从而实现改进的热性能。
华为“具有改进的热性能的倒装芯片封装专利”摘要如下:
提供了一种倒装芯片封装(200),其中,所述倒装芯片封装包括:至少一个芯片(202),用于与基板(201)连接;形成在所述基板(201)上的模制构件(209),以包裹所述至少一个芯片(202)的侧部分并使每个芯片(202)的顶表面裸露,其中,所述模制构件(209)的上表面具有与每个芯片(202)的顶表面连续的第一区域、涂抹粘合剂(210)的第二区域以及放置成包围每个芯片(202)的顶表面的壁状结构(209a),并且第一区域和第二区域由壁状结构(209a)分隔;散热器(206),放置在每个芯片(202)的顶表面上方,并通过填充在第二区域中的粘合剂(210)粘合到模制构件(209);热界面材料(205),所述热界面材料(205)填充在由所述第一区域、所述每个芯片(202)的顶表面、所述散热器(206)的底表面的至少一部分和所述壁状结构(209a)的第一侧形成的空间区域中。
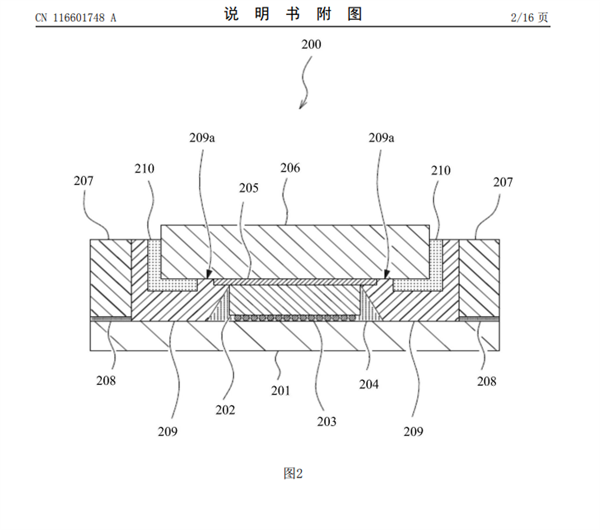
根据华为发明的实施例的倒装芯片封装示意性横截面视图
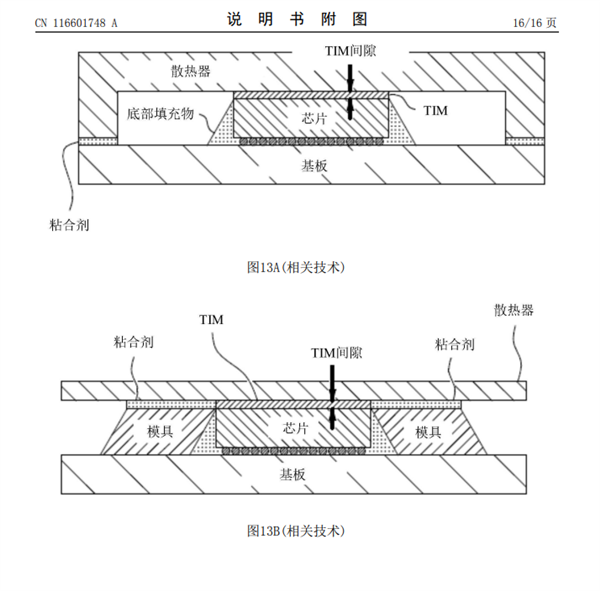
传统倒装芯片封装示例
-
华为
+关注
关注
218文章
36190浏览量
262694 -
gpu
+关注
关注
28文章
5271浏览量
136070 -
芯片封装
+关注
关注
14文章
623浏览量
32396
原文标题:华为公布倒装芯片封装最新专利:改善散热 CPU、GPU等都能用
文章出处:【微信号:hdworld16,微信公众号:硬件世界】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
CPU散热器粘接用导热胶怎么选?性能与应用全解析 |铬锐特实业

英伟达Rubin GPU采用钻石铜散热,解决芯片散热难题

AI芯片发展关键痛点就是:CoWoS封装散热

QDPAK顶部散热封装简介




 华为公布倒装芯片封装最新专利:改善散热 CPU、GPU等都能用
华为公布倒装芯片封装最新专利:改善散热 CPU、GPU等都能用











评论