碳化硅(Silicon Carbide,SiC)功率器件因其宽禁带、耐高压、高温、低导通电阻和快速开关等优点备受瞩目。然而,如何充分发挥碳化硅器件的性能却给封装技术带来了新的挑战。传统封装技术在应对碳化硅器件的快速开关特性时面临诸多问题,例如杂散电感参数大、高温工作可靠性差以及多功能集成封装与高功率密度需求等。
1.低杂散电感封装技术
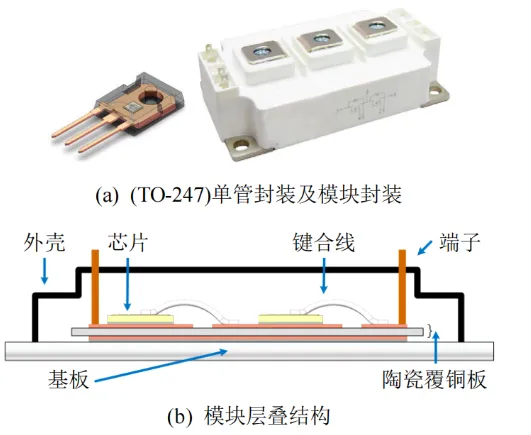
单管翻转贴片封装: 借鉴BGA封装技术,采用单管的翻转贴片封装,通过金属连接件将芯片背部电极翻转到正面电极相同平面位置,从而消除金属键合线,减小体积,提高导通电阻。
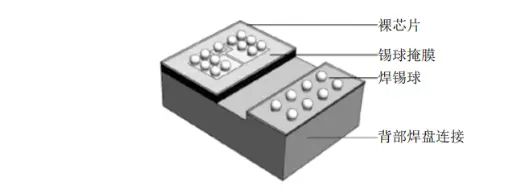
DBC+PCB混合封装: 结合DBC工艺和PCB板,利用金属键合线将芯片上表面连接到PCB板,控制换流回路在PCB层间,减小电流回路面积,有效降低杂散电感参数,提高性能。
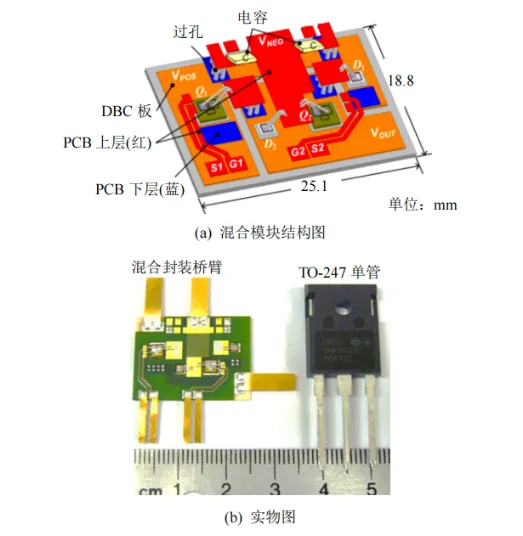
芯片正面平面互连封装: 采用平面互连的连接方式,如端子直连焊接方法,实现芯片正面的连接,减小电流回路,改善温度循环特性和可靠性。
2.高温封装技术
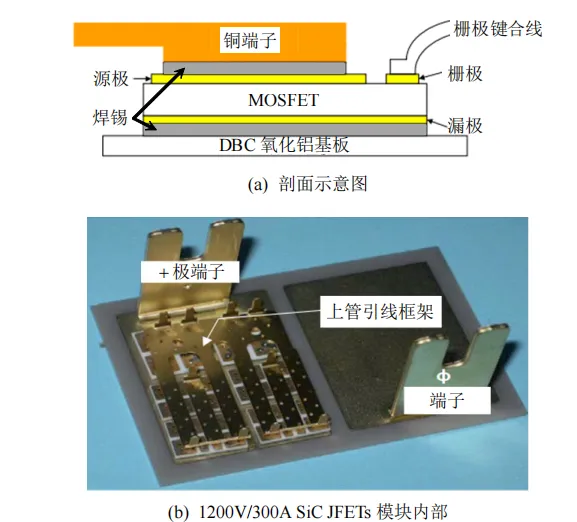
柔性PCB板结合烧结银工艺: 将柔性PCB板结合烧结银工艺用于封装,取代键合线,实现电气连接,有效降低杂散电感参数,减小体积,提高功率密度。
埋入式封装: 将芯片置于陶瓷定位槽中,采用绝缘介质填充缝隙,覆盖金属铜,实现电极连接,降低模块在高温时的层间热应力,提高正反向特性。
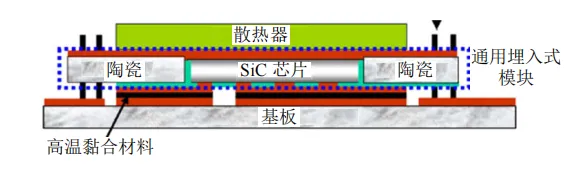
3.多功能集成封装技术
平面直连封装: 消除金属键合线,将电流回路从DBC板平面布局拓展到芯片上下平面的层间布局,减小回路面积,实现低杂散电感参数。
双面散热封装和三维封装: 通过改变封装方式,实现更好的散热效果,提高功率密度。
通过对这三个关键技术方向的分析,我们可以看到,碳化硅功率器件的封装技术正在不断创新和发展。这些技术的应用将在提高器件性能、可靠性和适应更广泛应用的同时,推动碳化硅功率器件在电力电子领域的更广泛应用。
审核编辑 黄宇
-
封装
+关注
关注
128文章
9330浏览量
149047 -
功率器件
+关注
关注
43文章
2221浏览量
95478 -
碳化硅
+关注
关注
26文章
3546浏览量
52664
发布评论请先 登录
基本半导体碳化硅功率器件在有源滤波器APF中的应用

技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径
碳化硅 (SiC) MOSFET 功率器件热设计基础与工程实践

简单认识博世碳化硅功率半导体产品
Wolfspeed碳化硅技术实现大规模商用
碳化硅功率器件的基本特性和主要类型
碳化硅器件的应用优势

EAB450M12XM3全碳化硅半桥功率模块CREE
简述碳化硅功率器件的应用领域
碳化硅功率器件在汽车领域的应用
基本半导体携碳化硅功率器件亮相PCIM Europe 2025




 碳化硅功率器件封装的关键技术
碳化硅功率器件封装的关键技术



![[新启航]<b class='flag-5'>碳化硅</b> TTV 厚度测量<b class='flag-5'>技术</b>的未来发展趋势与创新方向](https://file1.elecfans.com/web3/M00/20/D6/wKgZPGhd-raAI0RYAACIgEePWXY565.png)



评论