作为中国电子产业的领军企业,华为最近在芯片领域取得了一系列突破。除了麒麟9000S芯片的研发,华为还公布了多条专利信息。其中一项便是关于晶圆制造的,这将有利于提高晶圆对准效率和对准精度。
根据企查查公开的信息显示,这项新专利的名称为“晶圆处理装置和晶圆处理方法”,申请日期为2022年6月2日,申请公布日为2023年12月12日,申请公开号为CN117219552A。

(图片来源:企查查)
根据专利摘要显示,本公开的实施例涉及晶圆处理装置和晶圆处理方法。
晶圆处理装置包括:晶圆载台,晶圆载台可沿旋转轴线旋转;机械臂,包括机械手,用于搬运晶圆并将晶圆放置在晶圆载台上;控制器;以及校准组件(包括:光栅板,相对于晶圆载台固定;光源,相对于光栅板固定;以及成像元件,固定设置在机械臂上,并且适于接收从光源发出的、透过光栅板的光)。
其中,控制器被配置成基于成像元件对接收到的光的检测,控制机械臂或机械臂上的调整装置来调整晶圆的位置;其中,在晶圆载台承载晶圆的情况下,光栅板和成像元件分别位于晶圆载台的上表面所在平面相对两侧,上表面用于承载晶圆。
专利摘要指出,本公开的实施例提供的装置和方法,能够提高晶圆对准效率和对准精度。


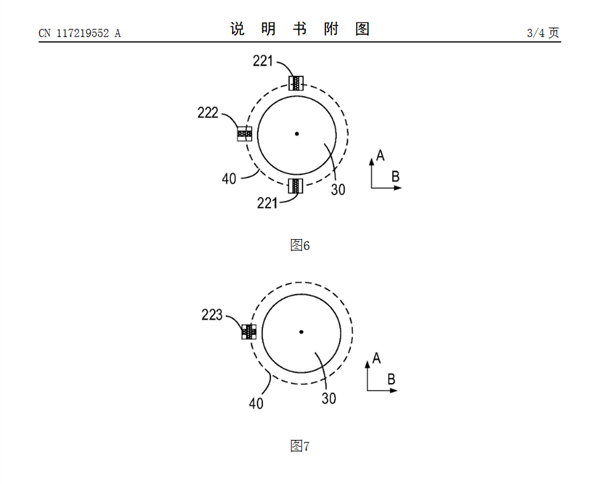
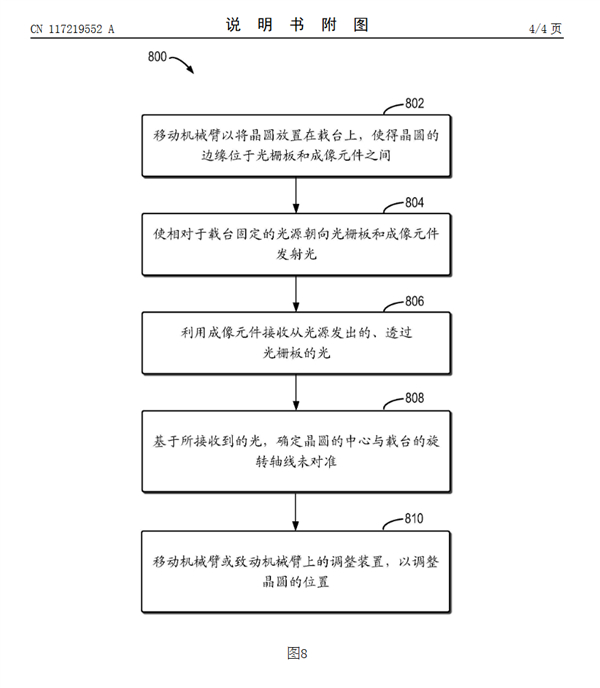
(专利原理示意图)
这些年,华为虽然遭受了外界的打压,但却丝毫没有影响其在科研领域的研究,尤其是专利数量方面,一直在不断攀升。
未来,我们可以期待华为在芯片领域的更多创新和突破,为中国科技发展贡献更多的力量。
免责声明:本文转自网络,版权归原作者所有,如涉及作品版权问题,请及时与我们联系,谢谢!
加入粉丝交流群
张飞实战电子为公众号的各位粉丝,开通了专属学习交流群,想要加群学习讨论/领取文档资料的同学都可以扫描图中运营二维码一键加入哦~(广告、同行勿入)
原文标题:华为公布新专利:晶圆处理技术再升级!
文章出处:【微信公众号:fcsde-sh】欢迎添加关注!文章转载请注明出处。
-
模拟技术
+关注
关注
17文章
473浏览量
40937 -
张飞电子
+关注
关注
56文章
176浏览量
13931
原文标题:华为公布新专利:晶圆处理技术再升级!
文章出处:【微信号:fcsde-sh,微信公众号:fcsde-sh】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录




晶圆处理前端模块的技术特点与服务体系




 华为公布新专利:晶圆处理技术再升级!
华为公布新专利:晶圆处理技术再升级!










评论