美国国防高级研究计划局表示,计划明年夏天授予一份合同,建立美国先进微电子制造中心。
该计划被称为“下一代微电子制造”,将资助研究和设备,以创建一个国内尖端制造技术原型制作中心,DARPA 希望该中心将为美国半导体工业基地带来领先优势。目标是到 2029 年实现这一能力。
该中心将专注于 3D 异构集成微系统(3DHI)——一种先进的微电子制造方法。3DHI 研究的前提是,通过以不同的方式集成和封装芯片组件,制造商可以分解内存和处理等功能,从而显着提高性能。
这一技术领域不仅可以改变美国的工业基础,而且包括全球微电子生产领导者台湾在内的其他国家也对此有着浓厚的兴趣。
“目前,美国还没有具备3DHI研发综合能力的开放制造中心,”DARPA在11月20日的计划公告中表示。“预计微电子创新的下一波主要浪潮将来自通过先进封装集成异质材料、设备和电路的能力,DARPA 提议专门为下一代 3DHI 建立一个国家加速器。”
7月,该机构选择了11个团队开始该中心的基础工作。DARPA 本周表示,计划为该计划的接下来两个阶段选择一个团队,每个阶段的奖金高达 4.2 亿美元。
根据这种伙伴关系(称为其他交易协议),选定的团队还将资助部分工作。DARPA 计划于 11 月 28 日向业界通报这一努力。
美国从台湾和中国大陆出口大部分先进半导体,这两个国家在全球市场占据主导地位。近年来,人们越来越担心这些为汽车、手机和国防部主要武器提供动力的关键微系统过度依赖外国供应链。
DARPA 通过 NGMM 等努力关注前瞻性技术,这与美国政府通过《创造半导体生产有益激励措施》(CHIPS 法案)来促进当今国内半导体工业基础的更广泛努力不同。该措施于 2022 年获得国会通过,并将持续到 2026 年,并为半导体劳动力改善工作、研发和制造提供资金。它还为国内制造设施和设备的投资提供 25% 的税收抵免。
虽然《CHIPS 法案》的重点是在短期内支撑美国的供应基础,但 DARPA 在这一领域的努力却着眼于“下一波创新”。
NGMM 是这些努力的核心,隶属于该机构的电子复兴计划 2.0,旨在解决影响美国国家安全和商业行业的技术挑战。
NGMM 第一阶段将重点关注购买设备、创建基础制造工艺以及建立适合 3DHI 系统的自动化和模拟软件。第二阶段的重点是创建硬件原型、自动化流程和开发仿真功能。
DARPA 表示:“该计划的最终目标是在非联邦实体拥有和运营的现有设施中建立一个自我维持的 3DHI 制造中心,并可供学术界、政府和工业界的用户使用。” “衡量成功的标准是能否以合理的成本支持各种高性能 3DHI 微系统的设计、制造、组装和测试,并以支持快节奏创新研究的周期时间。”
DARPA 发布关于建立国内 3D 异构集成 (3DHI) 微系统研发和制造中心的RFI
美国国防高级研究计划局 (DARPA) 微系统技术办公室 (MTO) 正在请求信息来指导建立国内研发 (R&D) 中心,用于制造三维异构集成 (3DHI) 微系统。
DARPA 下一代微系统制造 (NGMM) 计划的第 0 阶段目前正在分析和确定制造代表性 3DHI 微系统所需的软件工具、硬件工具、工艺模块、电子设计自动化 (EDA) 工具以及封装和组装工具。
该计划的下一阶段(第一阶段和第二阶段)旨在为学术界、中小型企业、国防和商业公司以及政府组织的利益相关者创建先进异构互连组件的运营研发能力。涉及的技术包括但不限于化合物半导体、光子学和微机电系统 (MEMS),除了数字逻辑和存储器之外,还延伸到电源、模拟和射频 (RF) 领域。该计划的最终结果将是一个可供利益相关者访问的开放式研发中心,以全面解决 3DHI 原型的设计、封装、组装和测试问题。
在第一阶段,NGMM 计划将在现有设施中建立一个中心,提供最先进的数字、射频、光子或功率器件的封装、组装和测试。DARPA 将资助升级和/或修改现有硬件工具、软件工具和 EDA 工具以执行 3DHI(研发)所需的劳动力、设备、材料和用品。第一阶段还将重点开发基线工艺模块,以及初始商用前的 3DHI 试验线能力(稳定的封装和装配工艺)和相关的 3D 装配设计套件 (3D-ADK)。
第二阶段将进一步优化3DHI工艺模块,加大研发力度以提高封装自动化,并实施该中心的运营访问模型,该中心将开始与外部微电子组织开展合作研究工作。第二阶段完成后,预计 NGMM 中心的监督将从 DARPA 转移到另一个政府机构,并且持续的工艺成熟将开发创新 3DHI 微系统的小批量生产能力。此外,该中心还将实现 NGMM 内开发的设备、工艺和设计的技术转让,以支持在外部商业和国防封装设施上制造这些微系统。
微电子创新的下一波主要浪潮预计将来自于通过先进封装集成异质材料、器件和电路的能力,从而产生一个延伸到三维的紧密耦合系统,其性能超过了当今单片方法的性能。行业领导者目前在一小部分商业产品中使用适度不同的硅数字技术的 3D 集成,从堆叠动态随机存取存储器(DRAM) 到互补金属氧化物半导体 (CMOS) 成像器再到高性能计算。当今成熟的集成技术,即使是那些通常被称为 3DHI 的技术,也主要集中在低功耗前沿 CMOS、传统 CMOS 和硅基存储器上。然而,广泛影响防御系统的机会依赖于扩展可集成和组装的微电子类型。
此外,推进数字集成需要增加远远超出当今最先进水平的互连密度。DARPA 向异构集成的扩展还包括用于互连的射频和光子学的化合物半导体、用于计算的新型存储器件以及用于电力电子的宽带隙和超宽带隙半导体。
目前,美国没有具备持续3DHI研发能力的开放获取中心。除极少数例外,从事 3DHI 研究的美国公司都依赖离岸设施,例如台积电(台湾)和校际微电子中心(比利时 IMEC)。开放式的国内 3DHI 研发中心将引发更广泛的创新浪潮,促进共享学习,并确保初创企业、学术界和国防工业基地能够参与小批量产品的 3DHI 研发。
NGMM 计划旨在强调将不同材料系统整合到同一封装中的 3DHI 微系统,例如用于互连的光子学、用于计算的新型存储器件、用于电力电子的宽带隙和超宽带隙半导体以及增材制造的无源元件。在本 RFI 中,3DHI 是指将来自不同材料系统的单独制造的组件堆叠在单个封装内,以产生在功能和性能方面提供革命性改进的微系统。具体来说,这些微系统将不同的晶圆或芯片集成到垂直堆叠的架构中。
-
3D
+关注
关注
9文章
3034浏览量
115864 -
微电子
+关注
关注
18文章
415浏览量
43041 -
DARPA
+关注
关注
4文章
72浏览量
28777
原文标题:美国斥巨资,发展3D异构集成
文章出处:【微信号:wc_ysj,微信公众号:旺材芯片】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
3D IC设计中的信号完整性与电源完整性分析

2D材料3D集成实现光电储备池计算


西门子EDA重塑3D IC设计:突破高效协同、可靠验证、散热及应力管理多重门

三维集成电路与晶圆级3D集成介绍
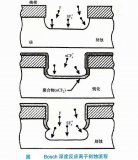
【海翔科技】玻璃晶圆 TTV 厚度对 3D 集成封装可靠性的影响评估

玩转 KiCad 3D模型的使用

iTOF技术,多样化的3D视觉应用
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm




 美国斥巨资,发展3D异构集成
美国斥巨资,发展3D异构集成









评论