双色红外探测器具有抗干扰能力强、探测波段范围广、目标特征信息丰富等优点,因此被广泛应用于导弹预警、气象服务、精确制导、光电对抗和遥感卫星等领域。双色红外探测技术可降低虚警率,实现复杂背景下的目标识别,从而显著提高系统性能。碲镉汞材料、量子阱材料和锑化物Ⅱ类超晶格材料均可用于制备双色红外探测器。其中,InAs/GaSb Ⅱ类超晶格材料因其带隙灵活可调、电子有效质量更大、大面积均匀性高等特点以及成本优势,成为制备双色探测器的优选材料。
据麦姆斯咨询报道,近期,华北光电技术研究所和中国科学院半导体研究所的科研团队在《红外》期刊上发表了以“InAs/GaSb Ⅱ类超晶格双色红外焦平面器件的干法刻蚀与湿法腐蚀制备对比研究”为主题的文章。该文章第一作者为温涛高级工程师,主要从事红外探测器器件方面的研究工作。
本文所采用的InAs/GaSb Ⅱ类超晶格长/长波双色材料是在N型GaSb衬底上,用分子束外延(MBE)技术生长背靠背的NMπP-PπMN结构来实现的。我们分别采用干法刻蚀工艺路线和湿法腐蚀工艺路线制备了面阵规模为320×256、像元中心距为30 μm的InAs/GaSb Ⅱ类超晶格长/长波双色红外焦平面器件,然后对其进行了性能测试,并对两种工艺路线制备的器件的台面形貌、接触孔形貌、伏安特性和中测性能进行了对比研究。
实验
如图1所示,材料采用NMπP-PπMN背靠背结构实现长/长波双色红外探测。图1中,红色通道(上方深色区域)和蓝色通道(下方深色区域)均采用p-πM-n结构,通道内势垒层选用本征掺杂的M结构来抑制产生复合电流和隧穿电流。M结构中,在InAs/GaSb中间插入AlSb层,形成InAs/GaSb/AlSb/GaSb,使能带结构呈“M”形。N型上下电极和接触层以及势垒层均采用了18 ML/3 ML/5 ML/3 ML的InAs/GaSb/AlSb/GaSb M结构。其中,N型接触层的厚度约为0.5 μm,掺杂浓度在10¹⁸ cm⁻³量级。蓝色通道吸收层采用弱p型掺杂10.5 ML/7 ML的InAs/GaSb超晶格,而红色通道则将弱p型掺杂12.5 ML/7 ML的InAs/GaSb作为吸收区。两通道的中间P型接触层通过P型掺杂8 ML/12 ML的InAs/GaSb连接在高P型GaSb中间层的两端。当上电极偏压为正值时,红色通道处于反偏状态(即处在工作模式),下方的蓝色通道处于导通状态。反之,当上电极偏压为负值时,蓝色通道处于反偏状态(即处在工作模式),上方的红色通道处于导通状态。

图1 InAs/GaSb Ⅱ类超晶格长/长波双色材料的结构示意图
制作InAs/GaSb Ⅱ类超晶格红外焦平面器件时,首先需要形成台面结构,将像元隔离,接着需要制备台面上与台面下的接触孔,最后在接触孔上覆盖电极以便实现像元的电学引出。完成电极制备的InAs/GaSb Ⅱ类超晶格长/长波双色器件如图2所示。台面成型及接触孔制备工艺通常有干法刻蚀和湿法腐蚀两种方式。湿法腐蚀工艺简单且无损伤,但不可避免地存在钻蚀且各向同性,常被用于像元中心距较大的面阵器件制备。干法刻蚀工艺各向异性,几乎无钻蚀,但不可避免地存在刻蚀损伤,常被用于像元中心距较小的面阵器件制备。
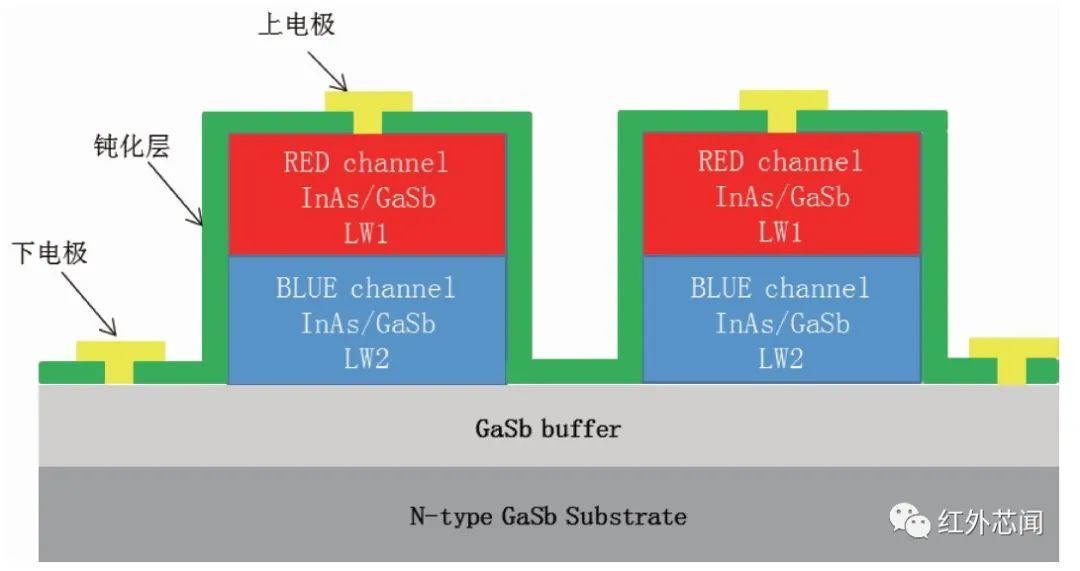
图2 InAs/GaSb Ⅱ类超晶格长/长波双色器件的结构示意图
实验采用一片2 in长/长波双色InAs/GaSb Ⅱ类超晶格材料(NMπP-PπMN背靠背结构)并将其划为A、B两片,然后通过光刻制备320×256(30 μm)焦平面阵列。采用由磷酸、柠檬酸、双氧水、水配置而成的腐蚀液对A片进行台面湿法腐蚀,并通过感应耦合等离子体(ICP)设备以及三氯化硼体系对B片进行台面干法刻蚀。台面制备完成后,利用等离子体增强化学气相沉积(PECVD)设备对A、B两片进行SiO₂表面钝化并完成接触孔光刻。A片通过氟化铵缓冲液湿法腐蚀接触孔,B片通过ICP设备以及三氟甲烷体系干法刻蚀接触孔,接着溅射Ti/Pt/Au金属化体系并通过剥离工艺形成电极。经伏安测试后,A、B两片分别进行划片、清洗、表面筛选和倒装互连,最后将混成芯片分别封入杜瓦并在77 K下对其进行性能测试。器件尺寸通过扫描电镜及测量显微镜测得,台阶深度通过台阶仪测试得到,伏安曲线通过半导体参数分析仪测得,器件形貌通过共聚焦显微镜以及扫描电镜观察和分析。
结果与讨论
台面形貌对比
台面成型是台面结焦平面器件制备的关键工序。台面的钻蚀程度、表面粗糙度、侧壁形貌对焦平面器件的信号及噪声具有直接的影响。InAs/GaSb Ⅱ类超晶格双色器件的有源层较厚(通常为8 ~ 10 μm),需要形成深台面结构以实现像元之间的物理隔离。
图3所示为A片(湿法腐蚀)制备的台面形貌。可以看出,由于湿法腐蚀的各向同性,在向下腐蚀的同时也向两侧钻蚀,导致湿法腐蚀后台面的占空比较小。经计算可知,湿法腐蚀台面后红色通道的占空比仅为25.8%,蓝色通道的占空比为65.7%。同时,两个方向的台面侧壁形貌还存在明显的差异,且侧壁坡度很不均匀。这些都会影响器件的性能。
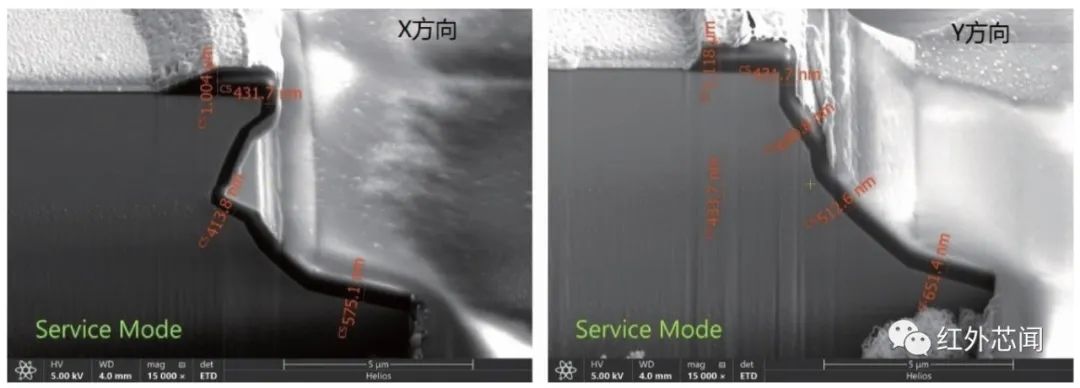
图3 A片(湿法腐蚀)台面形貌的扫描电镜图
图4为B片(干法刻蚀)制备的台面形貌。可以看出,由于干法刻蚀利用了等离子体的各向异性刻蚀,钻蚀很小,占空比较大。经计算可知,干法刻蚀台面后红色通道的占空比为62.7%,蓝色通道的占空比为76.5%。同时干法刻蚀后台面侧壁坡度均匀,有利于钝化层的覆盖。
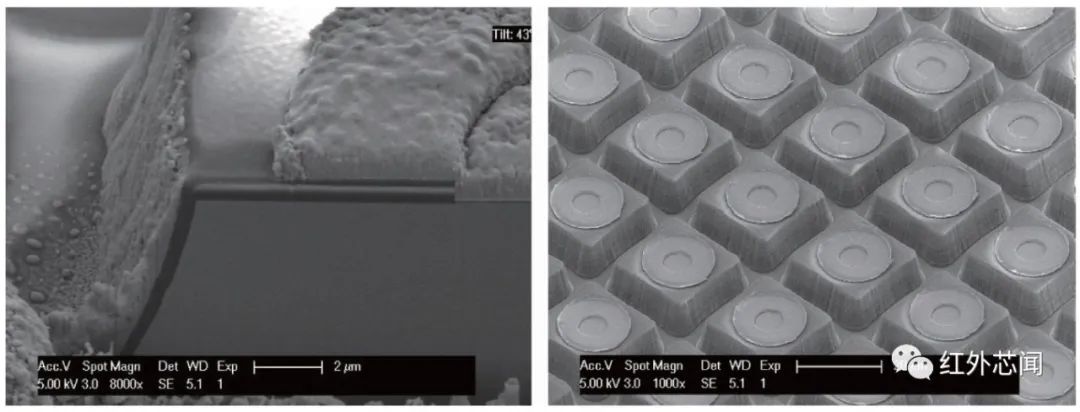
图4 B片(干法刻蚀)台面形貌的扫描电镜图
接触孔形貌对比
接触孔形貌对器件电极的台阶覆盖好坏具有直接的影响。图5(a)所示为A片(湿法腐蚀)制备的接触孔形貌。可以看出,由于湿法腐蚀的横向钻蚀,电极孔腐蚀后直径较大,但侧壁坡度较缓,有利于金属体系的覆盖。图6(b)所示为B片(干法刻蚀)制备的接触孔形貌。可以看出,干法刻蚀后电极孔侧壁比较陡直,这种形貌并不利于金属层的台阶覆盖。在电极制备完成后,侧壁处有明显的空隙。由于后续工艺要通过铟柱进行倒装互连,铟可能通过这些缝隙扩散到超晶格材料表面而导致漏电,严重影响器件的长期可靠性。
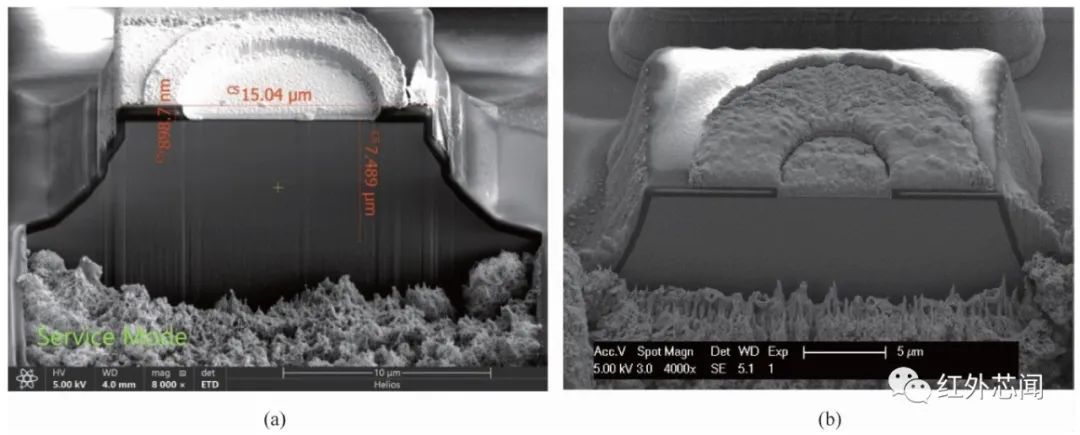
图5 用湿法(a)/干法(b)工艺制备接触孔后的形貌对比图
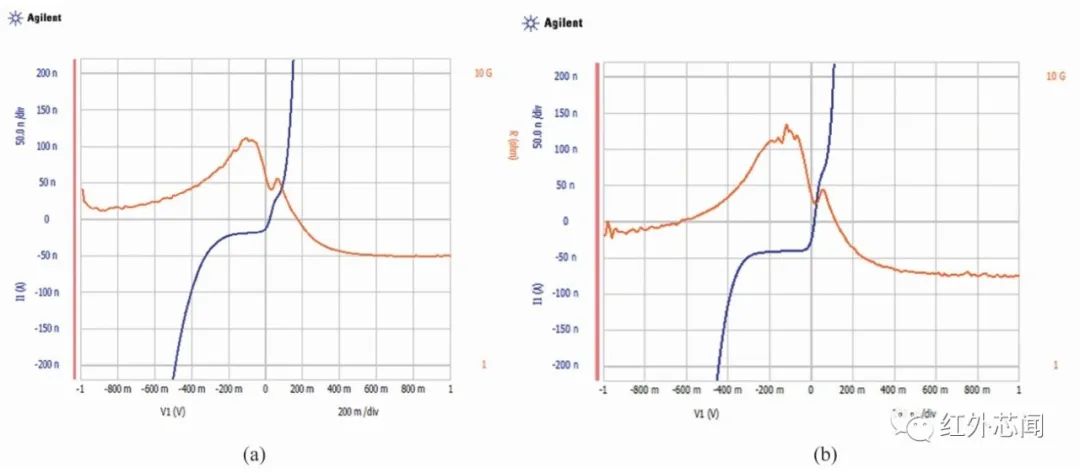
图6 湿法(a)/干法(b)工艺芯片在77 K下的伏安曲线对比图
伏安曲线对比
红外焦平面芯片的伏安特性是评价器件性能的重要参数。其中,光电流与器件的信号值相关,阻抗最大值与器件的优值因子RA直接相关。图6为湿法/干法工艺芯片在77 K下的伏安曲线对比图。具体测试结果如下:湿法工艺芯片红色通道的阻抗最大值为1.9 MΩ,相应电流为29.5 nA;蓝色通道的阻抗最大值为61.2 MΩ,相应电流为-18.7 nA。干法工艺芯片红色通道的阻抗最大值为2.4 MΩ,相应电流为72.5 nA;蓝色通道的阻抗最大值为137.9 MΩ,相应电流为-40.3 nA。可以看出,干法工艺芯片的阻抗值明显比湿法工艺芯片高,且光电流较大。
中测结果对比
表1列出了湿法/干法工艺芯片封入杜瓦后在77 K下的中测性能对比数据。可以看出,湿法工艺芯片无论是红色通道还是蓝色通道,其信号值都明显比干法工艺芯片小,平均峰值探测率及噪声等效温差也都明显比干法工艺芯片差,仅在盲元率方面略优于干法工艺芯片。在响应率非均匀性指标上,红色通道是干法工艺路线略优,蓝色通道是湿法工艺路线略优。
结束语
本文采用InAs/GaSb Ⅱ类超晶格长/长波双色材料,分别基于干法刻蚀工艺路线和湿法腐蚀工艺路线,通过台面成型、表面钝化、开接触孔、电极制备和倒装互连等工艺,获得了面阵规模为320×256、像元中心距为30 μm的InAs/GaSb Ⅱ类超晶格长/长波双色混成芯片。分别将其封入杜瓦,并在77 K下进行了性能测试。结果表明,用湿法工艺制备的器件信号弱,性能相对较差,不过有效像元率相对较高;用干法工艺制备的器件信号强,性能相对较好,但盲元率相对较高,电极台阶覆盖相对较差。该研究为InAs/GaSb Ⅱ类超晶格双色焦平面器件的后续优化奠定了基础。然而目前制备的长/长波双色InAs/GaSb Ⅱ类超晶格面阵器件还存在一些问题。比如,无论是用湿法工艺制备的器件还是用干法工艺制备的器件,其红色通道伏安曲线的平坦区较短,阻抗值较小,各项性能指标明显比蓝色通道差,后续还需要进一步优化。
审核编辑:彭菁
-
芯片
+关注
关注
463文章
54673浏览量
471160 -
工艺
+关注
关注
4文章
728浏览量
30431 -
卫星
+关注
关注
18文章
1886浏览量
70533 -
器件
+关注
关注
4文章
372浏览量
28904
原文标题:InAs/GaSb Ⅱ类超晶格双色红外焦平面器件的干法刻蚀与湿法腐蚀制备对比研究
文章出处:【微信号:MEMSensor,微信公众号:MEMS】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
干法刻蚀在工艺制程中的分类介绍(干法刻蚀关键因素研究)
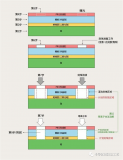
释放MEMS机械结构的干法刻蚀技术
【转帖】干法刻蚀的优点和过程
释放MEMS机械结构的干法刻蚀技术
两种基本的刻蚀工艺:干法刻蚀和湿法腐蚀
GaN材料干法刻蚀工艺在器件工艺中有着广泛的应用




 基于干法刻蚀工艺路线和湿法腐蚀工艺路线研究
基于干法刻蚀工艺路线和湿法腐蚀工艺路线研究



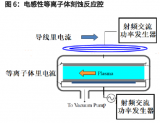




评论