华为技术有限公司日前公开了一项名为“具有改进的热性能的倒装芯片封装”专利,申请公布号为CN116601748A。
该专利实施例提供了一种倒装芯片封装、一种装备有应用封装结构的电路的装置以及一种组装封装的方法。
更直观来说,就是一种提供芯片与散热器之间的接触方式,能帮助改善散热性能。可应用于CPU、GPU、FPGA(现场可编程门阵列)、ASIC(专用集成电路)等芯片类型,设备可以是智能手机、平板电脑、可穿戴移动设备、PC、工作站、服务器等。
专利提到,近来,半导体封装在处理性能方面的进步对热性能提出了更高的要求,以确保稳定操作。就此而言,倒装芯片封装在热性能方面具有优势,因其结构特征是芯片通过其下方凸块与基板连接,能够将散热器定位在芯片的顶表面上。
一般来说,为提高冷却性能,会将热润滑脂等热界面材料(TIM)涂抹到芯片的顶表面,并夹在芯片和散热器的至少一部分之间。从降低TIM中的热阻以改善封装的热性能的角度来看,使TIM的厚度更小。
相较此前难以精细控制TIM厚度的散热方案,华为这项专利中的热界面材料的厚度由模制构件中的壁状结构的高度限定。由于能在模制过程中轻松控制由模具化合物组成的壁状结构的高度,因此可以将热界面材料的厚度调节到所需的小厚度,从而实现改进的热性能。
倒装芯片封装技术将有望促使电子设备的设计更加灵活多样。由于倒装封装可以使芯片更加紧凑地布置在电路板上,产品的尺寸可以进一步减小,从而为手机、平板电脑、智能穿戴设备等带来更轻薄的外观。同时,也将极大改善手机设备的散热问题。
但这种封装技术也存在很多的技术限制,比如倒装封装要求在芯片背面进行复杂的布线和连接,这对制造工艺的要求较高,可能会增加生产成本。其次是可靠性问题。由于倒装封装将芯片直接暴露在外,容易受到外界环境的影响,需要更强的保护措施来确保芯片的稳定运行。
由于该技术目前还处在专利阶段,何时真正能够应用尚未可知。一般来说,一项专利技术从技术验证阶段到最终商用会有一定的周期,也有一些技术本身就是作为技术储备,有可能也会永远得不到应用。
按照华为当前的现状,芯片封装这类技术很有可能在商用量产上会有更大的难度。
在消费市场,宇凡微也公布了最新的射频芯片合封技术,专利号CN 218677151 U,本实用新型属于半导体封装技术领域,提供了一种集成MCU和射频芯片的封装体,即可同时实现微控制芯片(MCU)和射频芯片的功能。
主要由2.4g芯片或433m芯片,加上mcu合封而成,该射频合封芯片,一经推出在遥控市场受到广泛的欢迎,超高性价比在消费市场是制胜的法宝,能帮助商家减少各方面的成本。具体请访问宇凡微官网。
审核编辑:汤梓红
-
芯片
+关注
关注
463文章
54463浏览量
469612 -
cpu
+关注
关注
68文章
11332浏览量
225964 -
华为
+关注
关注
218文章
36212浏览量
262717 -
封装技术
+关注
关注
12文章
605浏览量
69373
发布评论请先 登录
基本半导体推出第三代碳化硅MOSFET顶部散热封装系列产品

超细间距倒装芯片灌封胶渗透与空洞控制 |铬锐特实业

研华科技携手森云智能率先完成一项重要技术突破
华为Pura80发布,一项卡脖子传感器技术获突破,一项传感器技术仍被卡脖子!
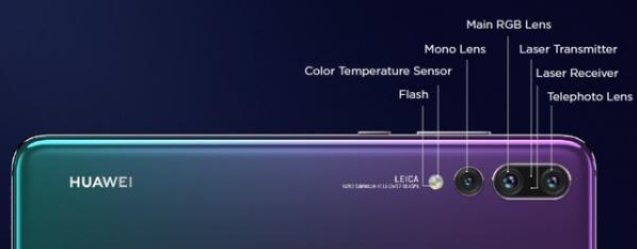



 华为公布一项倒装芯片封装技术:能大幅改善CPU散热
华为公布一项倒装芯片封装技术:能大幅改善CPU散热












评论