碳化硅硬度高,耐磨性好,碳化硅晶片硬度大,莫氏硬度分布在 9.2~9.6之间,化学稳定性高,几乎不与任何强酸或强碱发生反应,切割划片很有难度。
深圳西斯特科技在碳化硅晶圆切割方面积累了丰富的经验,现将部分案例整理如下,供各位朋友参考。更多方案细节欢迎来电来函咨询。
划切案例一
►
材料情况
晶圆规格 | 6寸 |
晶圆厚度 | 0.175mm |
划片槽宽度 | 100um |
Die size | 3.0*2.54mm |
►
工艺参数
设备型号 | TSK-S20 |
主轴转速 | 35000rpm |
进刀速度 | 0.8mm/s |
刀片高度 | 0.15/0.05mm |
►
切割方案
推荐刀片 | SST 2000-R-70-ECB |
切割模式 | 单刀切断 |
品质标准 | 正面离保护线>10um 背面<50um 侧崩<芯片厚度1/4 |
其他 | 先激光开槽 |
►
划切效果
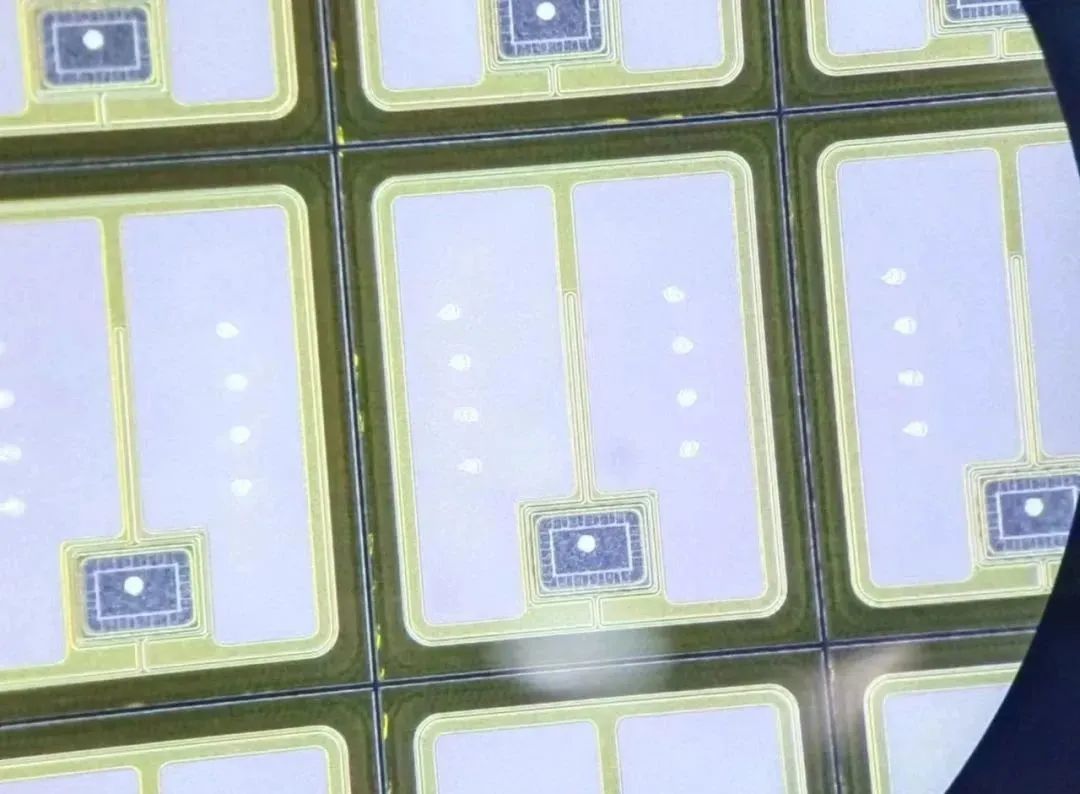

划切案例二
►
材料情况
晶圆规格 | 4寸 |
晶圆厚度 | 0.38mm |
划片槽宽度 | 80um |
Die size | 4.3*4.3mm |
►
工艺参数
设备型号 | DISCO 6340 |
主轴转速 | 35000rpm |
进刀速度 | 3mm/s |
刀片高度 | 0.28/0.05mm |
►
切割方案
推荐刀片 | SST 3000-R-70 DCB |
切割模式 | Step |
品质标准 | 正面离保护线10um 背崩<40um |
其他 | SD3500-N1-50 CD先开槽 |
►
划切效果

划切案例三
►
材料情况
晶圆规格 | 8寸 |
晶圆厚度 | 0.2mm |
划片槽宽度 | 100um |
Die size | 5.37*4.46mm |
►
工艺参数
设备型号 | DISCO 6362 |
主轴转速 | 45000/35000rpm |
进刀速度 | 2mm/s |
刀片高度 | 0.2/0.05mm |
►
切割方案
推荐刀片 | 3500-R-70 CCG 2000-R-50 EGF |
切割模式 | Step |
品质标准 | 正面离保护线20um 背崩<50um |
►
划切效果

-
晶圆
+关注
关注
53文章
5449浏览量
132749
发布评论请先 登录
技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径
晶圆切割机技术升级 破解碳化硅/氮化镓低损伤切割难题

Wolfspeed成功制造出单晶300mm碳化硅晶圆
破局300mm!Wolfspeed碳化硅晶圆取得关键突破
简单认识博世碳化硅功率半导体产品
重大突破!12 英寸碳化硅晶圆剥离成功,打破国外垄断!
【新启航】碳化硅 TTV 厚度与表面粗糙度的协同控制方法

碳化硅器件的应用优势

探针式碳化硅衬底 TTV 厚度测量仪的操作规范与技巧

【新启航】探针式碳化硅衬底 TTV 厚度测量仪的操作规范与技巧

【新启航】碳化硅衬底 TTV 厚度测量中表面粗糙度对结果的影响研究

激光干涉法在碳化硅衬底 TTV 厚度测量中的精度提升策略

【新启航】如何解决碳化硅衬底 TTV 厚度测量中的各向异性干扰问题




 碳化硅晶圆划切方案集合
碳化硅晶圆划切方案集合





评论