关键词:SMT贴片技术,EMC材料,导电泡棉,国产高端材料
导语:SMT是表面组装技术(表面贴装技术)(Surface Mount Technology的缩写),称为表面贴装或表面安装技术。是目前电子组装行业里最流行的一种技术和工艺。它是一种将无引脚或短引线表面组装元器件(简称SMC/SMD,中文称片状元器件)安装在印制电路板(Printed Circuit Board,PCB)的表面或其它基板的表面上,通过回流焊或浸焊等方法加以焊接组装的电路装连技术。
SMT贴片
SMT是表面组装技术(表面贴装技术)(Surface Mounted Technology的缩写),是目前电子组装行业里最流行的一种技术和工艺。SMT贴片指的是在PCB基础上进行加工的系列工艺流程的简称, PCB(Printed Circuit Board)为印刷电路板。
SMT贴片技术
一
SMT简介
SMT的全称是Surface mounttechnology,中文意思为表面贴装技术,SMT设备是指用于SMT加工过程需使用的机器或设备,不同厂家根据自身实力规模以及客户要求,配置不同的SMT生产线,可分为半自动SMT生产线和全自动SMT生产线,每条SMT生产线的机器设备不尽相同,但以下这些SMT设备是一条比较完整丰富的配置线。
二
SMT的特点
组装密度高、电子产品体积小、重量轻,贴片元件的体积和重量只有传统插装元件的1/10左右,一般采用SMT之后,电子产品体积缩小40%~60%,重量减轻60%~80%。可靠性高、抗振能力强。焊点缺陷率低。高频特性好。减少了电磁和射频干扰。易于实现自动化,提高生产效率。降低成本达30%~50%。节省材料、能源、设备、人力、时间等。
电子产品追求小型化,以前使用的穿孔插件元件已无法缩小电子产品功能更完整,所采用的集成电路(IC)已无穿孔元件,特别是大规模、高集成IC,不得不采用表面贴片元件产品批量化,生产自动化,厂方要以低成本高产量,出产优质产品以迎合顾客需求及加强市场竞争力。
电子元件的发展,集成电路(IC)的开发,半导体材料的多元应用电子科技革命势在必行,追逐国际潮流。
三
SMT设备简介
上板机:PCB板子放在架子内自动送板到吸板机;
吸板机:吸取PCB放置于轨道上,传送到锡膏印刷机;
锡膏印刷机:将锡膏或贴片胶准确地漏印到PCB的焊盘上,为元器件贴装做好准备。用于SMT的印刷机大致分为三种:手动印刷机、半自动印刷机和全自动印刷机;
SPI:SPI是Solder Paste InspecTIon的简称,中文叫锡膏检查机,主要用于检测锡膏印刷机印刷PCB板的品质,检测锡膏印刷的厚度、平整度、印刷面积等;
贴片机:利用设备编辑好的程序将元件准确安装到印刷线路板的固定位置上,贴片机可分高速贴片机和多功能贴片机,高速贴片机一般用于贴装小的chip元件,多功能乏用贴片机主要贴装卷状、盘状或管状的大元件或异性元件,特点是贴装精确度高、但贴装速度不如高速机;
接驳台:传送PCB板的装置;
回流焊:位于SMT生产线中贴片机的后面,提供一种加热环境,将焊盘上的焊锡膏熔化,使表面贴装元器件与PCB焊盘通过焊膏合金牢固地结合在一起;
下板机:通过传输轨道,自动收PCBA;
AOI:自动光学辨识系统,是英文(Auto OpTIcal InspecTIon)的缩写,国内叫做自动光学检测仪,现在已经普遍应用在电子行业的电路板组装生产线的外观检查并取代以往的人工目检。当自动检测时,机器通过摄像头自动扫描PCB,采集图像,测试的焊点与数据库中的合格的参数进行比较,经过图像处理,检查出PCB上缺陷,并通过显示器把缺陷显示/标示出来,供维修人员修整;
X-RAY:主要用于检测各类工业元器件、电子元件、电路内部的贴装品质。
四
SMT贴片检验
SMT贴片检验这一步骤,可以规范SMT加工的工艺质量要求,以确保产品品质符合要求。下面一起来看看SMT贴片检验有哪些标准?
一、SMT贴片锡膏工艺:1、PCB板上印刷的喷锡的位置与焊盘居中,无明显的偏移,不可影响SMT元器件的粘贴与上锡效果。2、PCB板上印刷喷锡量适中,不能完整的覆盖焊盘,少锡、漏刷。3、PCB板上印刷喷锡点成形不良,印刷喷锡连锡、喷锡成凹凸不平状,喷锡移位超焊盘三分之一。
二、SMT贴片红胶工艺:1、印刷红胶的位置居中,无明显的偏移,不可以影响粘贴与焊锡。2、印刷红胶胶量适中,能良好的粘贴,无欠胶。3、印刷红胶胶点偏移两焊盘中间,可能造成元件与焊盘不易上锡。4、印刷红胶量过多,从元件体侧下面渗出的胶的宽度大于元件体宽的二分之一。
三、SMT贴片工艺:1、SMT元器件贴装需整齐、正中,无偏移、歪斜。2、SMT元器件贴装位置的元器件型号规格应正确,元器件应反面。元器件贴反(不允许元件有区别的相对称的两个面互换位置,如:有丝印标识的面与无丝印标识的面上下颠倒面),功能无法实现。3、有极性要求的贴片元器件贴装需按正确的极性标示加工。器件极性贴反、错误(二极管、三极管、钽质电容)。4、多引脚器件或相邻元件焊盘应无连锡、桥接短路。5、多引脚器件或相邻元件焊盘上应无残留的锡珠、锡渣。
回流焊
所谓的Reflow,在表面贴装工艺(SMT)中,是指锭形或棒形的焊锡合金,经过熔融并再制造成形为锡粉(即圆球形的微小锡球),然后搭配有机辅料(助焊剂)调配成为锡膏;又经印刷、踩脚、贴片、与再次回熔并固化成为金属焊点之过程,谓之Reflow Soldering(回流焊接)。此词之中文译名颇多,如再流焊、回流焊、回焊(日文译名)熔焊、回焊等;笔者感觉这只是将松散的锡膏再次回熔,并凝聚愈合而成为焊点,故早先笔者曾意译而称之为“熔焊”。但为了与已流行的术语不至相差太远,及考虑字面并无迂回或巡回之含意,但却有再次回到熔融状态而完成焊接的内涵,故应称之为回流焊或回焊。
图1左图SMT现场安装之锡膏印刷机,为了避免钢板表面之锡膏吸水与风干的烦恼起见,全机台均保持盖牢密封的状态。右为开盖后所见钢板、刮刀及无铅锡膏刮印等外貌。SMT无铅回流焊的整体工程与有铅回流焊差异不大,仍然是:钢板印刷锡膏、器件安置(含片状被动组件之高速贴片,与异形零件大形组件之自动安放)、热风回焊、清洁与品检测试等。不同者是无铅锡膏熔点上升、焊性变差、空洞立碑增多、容易爆板、湿敏封件更易受害等烦恼,必须改变观念重新面对。事实上根据多年量产经验可知,影响回焊质量最大的原因只有:锡膏本身、印刷参数以及回焊炉质量与回焊曲线选定等四大关键。掌握良好者八成问题应可消弭之于无形。
锡膏的制造与质量
1、锡膏组成与空洞
锡膏是由重量比88-90%的焊料合金所做成的微小圆球(称为锡粉Powder),与10-12%有机辅料

图2锡稿回焊影响其锡性与焊点强度方面的因素很多,此处归纳为五大方向,根据多年现场经验可知,以锡膏与印刷及回焊曲线(Profile)等三项占焊接品质之比重高达七八成以上,以下本文将专注于此三大内容之介绍,至于机器操作部分将不再著墨。(即通称之Flux助焊剂)所组成;由于前者比重很大(7.4-8.4)而后者的比重很轻(约在1-1.5),故其体积比约为1:1。SAC无铅焊料之比重较低(约7.4),且因沾锡 较差而需较多的助焊剂,因而体积比更接近1:1。故知锡粉完成愈合形成焊点之回焊后,其浓缩后的体积将不足印膏的一半。一旦外表先行冷却固化,深藏在内的有机物势必无法逃出,只好被裂解吹胀成为气体。此即锡膏回焊之各种焊点中,气洞或空洞(Voiding)无所不在的主要成因,其数量与大小均远超过波焊。
图3无铅锡膏中之锡粉(Powder指微小球体)约占重量比88-90%,必须正圆正球形才能方便印刷中的滑动。由于硬度较软容易被压伤,故搅拌时要小心。左二图即为无铅锡粉之放大图。右图为锡膏中大小锡粉搭配成型的印著画面。现行无铅锡膏以日系SAC305为主(欧系SAC3807,或美系SAC405等次之),日系尚另有SZB83,及SCN等。至于AIM公司的著名锡膏CASTIN(Sn2.5Ag0.8Cu0.5Sb)之四元合金在亚太地区则很少见到。
2、锡粉制造与质量
将原始焊锡合金在氮气环境中先行熔成液态,继以离心力容器将之甩出来成为小球状的锡粉;或采氮气强力喷雾法,在氮气高塔中冷却及下降而成为另一种锡粉。---待续

图4锡粉是从熔融液锡所成形而调制,左图为氮气塔中利用强力氮气喷成粉体之情形,右为液锡在离心力设备上甩出成粉的另一种制程。之后分别用筛子筛选出各种直径的小球,然后再按尺寸大小采重量比例去与助焊剂调配与混合,即成为回焊用的锡膏。
对于锡粉的基本要求比起助焊剂来较为简单,其质量重点只要求外形一定要正圆球形,以符合印刷作业中向前滚动的条件。其次是直径尺寸应大小匹配互补,以减少印刷后贴件或踩脚时的坍塌(Slump)。第三项质量是外表所生成的氧化物不可太厚,否则

在助焊剂未能彻底清除下,熔融愈合中将会被主体排挤出去而成为不良的锡球。不过一旦外表完全无氧化物时,也较有机会发生“冷熔”(Cold Welding)现象进而容易堵死钢板开口。通常要求开口之宽度以并迭5-7颗主要锡球为原则。
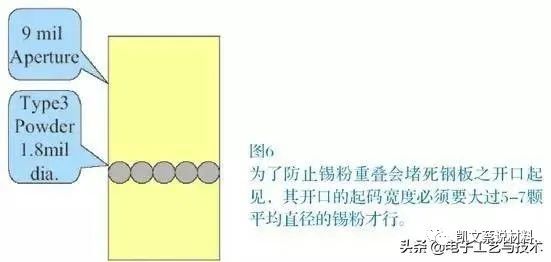
3、助焊剂之成份及品质
助焊剂(Flux)之成份非常复杂,已成为影响锡膏乃至于回焊质量之最关键部份,且更成为品牌好坏的主要区别所在。其主要成份有树脂(Resin)、活化剂(Activator)、溶剂(Solvent)、增黏剂(Tackifier即摇变剂)、流变添加剂(Rheological Additives)亦称抗垂流剂(Thixotropic Agent,或称摇变剂或触变剂或流变剂等)、表面润湿剂(Surfactant)、腐蚀抑制剂等,现简要说明于后:树脂——也就是整体助焊剂的基质,一向以水白式松香(Rosin或称松脂)为主,常温中80-90%为固体形式的松脂酸(Abietic Acid),高温中将熔融成为液体并展现活性 (常温中不具活性),可用以去除焊料或待焊底材等某些表面轻微的氧化物。活化剂——以二元式固体有机酸为主(指含两个羧酸根COOH者),例如草酸、己二酸;其次是固态的卤化盐类〔例如二甲胺盐酸(CH3)2NHHCL〕等,在高温中亦可熔化成液态而得与各类氧化物进行反应,可将之去除并得以改善沾锡性。各种活化剂去锈(去除氧化物)的原理,其一可说明为有机酸或卤酸与各种金属氧化物在热能的协助下,进行多次化学反应,使之转变为可溶性金属卤化盐类而得以移除:
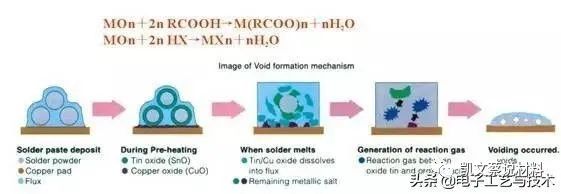
图7此图说明印妥之锡膏在预热中,会引发锡粉表面甚至铜垫的氧化,但到达峰温时,在助焊剂迅速发挥威力下可对各种氧化物进行化学反应并使之溶解,进而出现锡粉的熔融愈合。在此等反应进行的同时也将出现金属盐类与多量的气体,以致冷却后的焊点中免不了会出现空洞,其二为氧化还原反应,以甲酸(蚁酸)将金属氧化物予以还原,并再经后续之热裂解反应,最具代表性:
MO+2HCOOH→M(COOH)2+H2O
M(COOH)2→M+COn+H2
溶剂——以分子量较大的某些高级醇类,或醚类酮类等较常被采用,可用以溶解某些固态的有机物;例如M-Pyrols即为著名的溶剂化学品。
抗垂流剂——此剂可在锡膏运动或摇动(触动)中,出现较易流 动现象;但在静置时却又会坚持抗剪力,而具有不轻易移动 特性的化学品。如此将可使锡膏在刮刀推行印刷时容易滚动,一旦印着定位后的锡膏,则又可强力协助其保持固定不动的状态。此类添加剂以篦麻油衍生物为主,可增加锡膏的黏度及黏着力(Tack Force)。
4、锡膏等级与配制
按照J-STD-005锡膏规范(表2A与2B,见次页),依比例选出表列各种直径的锡粉,然后搭配助焊剂,于特殊“双行星轨道”之混搅机中进行轻柔搅拌(Double Planetary Mixing)中,在不伤及锡粉下可使均匀混合成为锡膏。此种“双行星”搅拌方式,是利用两具双拌桨,从同一轴心对容器内的膏体进行慢速旋转搅拌。该四桨叶是以其厚度方向从膏体的外缘连续划过,逐渐逼使内外膏料产生高效率的混合,只要划过3圈后,大部膏料均已完成彼此混合;旋转36圈后,任何一桨均已与全部成员完成接触,是一种很温柔但却高效的搅拌机。

锡膏在印刷刮刀之水平推行中不但要容易滚动,而且穿过钢板开口着落在PCB焊垫上还要黏牢,要求印后十小时以内,或于零件踩脚时,均不可发生坍塌的情形。故知其商品之难度颇高,质量亦非常讲究。锡膏是一种高单价的物料(以SAC305锡膏而言,每公斤即在N.T.2000元以上),一旦发现吸水则只有报废一途以减少后患。国际规范J-STD-005在其表2A与2B中,已将六种型式(Type)锡膏中的锡粉,按不同直径在重量百分比方面加以规定,以减少在印刷与踩脚时的坍塌,并在热风回焊中容易愈合成为良好的焊点。下列者即为各型锡膏中锡粉组成之百分比,其中最常用者为Type3(主要锡粉直径为35-38μm),其次是用于密距窄垫的Type4(锡粉直径以30μm为主),其它Type在组装业界较少使用(其它Type5 or 6系用于覆晶Flip Chip之封装)。

5、锡膏现场作业性品质
事实上锡膏质量之待检项目甚多,不同规范亦有不同的要求,一般在作业质量与后续可靠度方面,平均即有15-20项之多。供货商也并非在每次出货时都要每项必做。至于使用者则只需就其生产作业的必要性,且在无需精密昂贵仪器的条件下,以简易的手法检测其关键项目即可。以下五种质量项目即按此种观点而选列,可供使用者现场参考。
(1)愈合性(凝聚性或熔合性)试验
Solder Ball Test(IPC-TM-650之2.4.43),是在阳极处理过的铝板上,加印一个小圆饼形的锡膏(直径6.5mm厚度2mm),然后小心平置于小型锡池上,无铅锡池之温度设定为245-255℃。此时锡膏中的锡粉开始受热愈合成为一个圆顶型的焊饼,锡膏中已熔化的助焊剂则被不断挤出而向外扩张。放置5秒钟后即小心水平取下并放平,直到冷却后才以10-20倍放大镜去做检查。此试验是在检查锡粉愈合的能力如何?其中若已部份生锈而无法愈合之下,将随Flux向外扩散成为卫星状的小碎球。

图9此为锡膏规范中测试愈合性(Coalescence)的允收与拒收画面,其金属载板为阳极处理过的铝板,只做为传热的工具。良好的锡膏熔合后其锡粉会集中成球,其中氧化较严重锡粉,在无法熔合下,将被排挤出来随著助焊剂的扩散而向外流失,左二图即为流失者太多而遭到拒收的画面。
本试验选用Al2O3皮膜的铝板,是刻意将其当成传热载体而不使产生沾锡反应(即出现IMC),纯粹只在了解锡粉本身愈合能力的好坏而已。也可在完成锡膏印刷并于室温中放置24小时后,再进行愈合试验,以观察其抗湿及抗氧化的能力如何。前页之四图即为J-STD-005在3.7节中所列之有铅锡膏允收规格之图标画面。
至于无铅锡膏愈合能力的允收情形则目前尚无规格,预计J-STD-005A于2006下半年内发布后即可有所依循。下列之五图即为无铅膏在氧化铝板与铜板上另于回焊中所做愈合试验的比较。
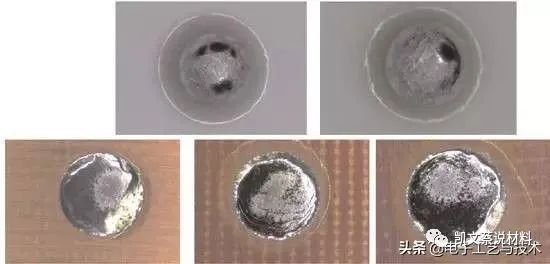
图10上图为锡膏在铝板上受热而愈合的画面,下三图锡膏在基材板铜面上的熔合情形。由于锡与铜之间会出现焊接反应并生成Cn6Sn5的IMC,故其愈合后的外观与铝铜板上不同。
(2)散锡性试验Spreading Test
焊锡性(Solderability)是说明金属表面可否进行焊接反应,并就其反应能力的好坏,以科学数据加以表达的质量。从沾锡天平(Wetting Balance)而言,即可用以测出引脚的沾锡时间(愈短愈好)与沾锡力量(愈大愈好)。然而此种精密试验,不但专业设备昂贵且相当耗时,而所得数据对生产现场的实用价值却不大。一般的焊锡性在波焊而言,讲究是通孔的上锡填锡能力;就SMT回焊而言,则专注于锡膏愈合后向外的散锡 性,以下将介绍简易做法的散锡性试验。
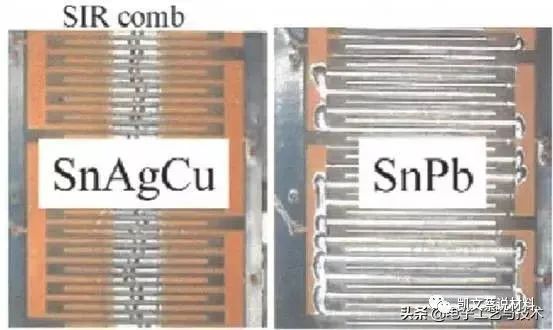
图11此为无铅与有铅两种锡膏,在窄铜面上散锡性的比较。相同条件下无铅锡膏的焊锡性就相形见拙了。
有铅焊料(63/37)之表面张力(Surface Tension)为0.506 N/m;但SAC305之表面张力却增为0.567N/m,比起前者要超出20%之多。表面张力加大即表内聚力(Cohesive Force)增加,而向外扩展的附着力(Adhesive Force)却减小。于是无铅锡膏在散锡性方面当然就比起有铅锡膏差了一截,若能在助焊剂的活化性能方面有所提升时,也许无铅膏还可展现较好的焊锡性。
日商对此做法是利用1.6mm厚的双面板,做出32mil(800μm)宽的多条并行线路,之后加全面印绿漆而留出线路中间2cm长的裸铜区(或另加做不同的表面处理以方便评比)。于是在此可焊区的中央印刷上直径950μm厚度150μm(6mil)的无铅锡膏,然后利用生产线的回焊曲线进行试焊,并观其向两侧散锡的能力。只需简单的量测已散锡的长短,即可知晓其可焊皮膜或锡膏品牌,在“散锡”(Spreadability)方面的质量好坏了。
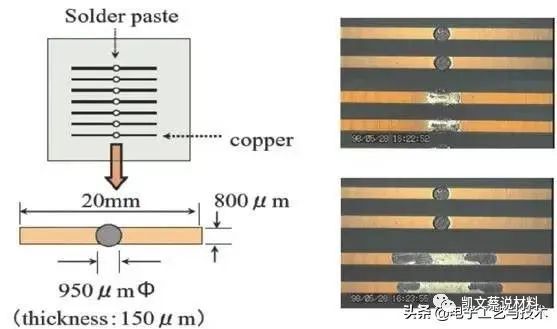
图12此为日本工业规范对锡膏在散锡性方面的试验方法,可针对锡膏品牌或可焊性表面处理进行散锡性的评比,孰优孰劣立见分晓。
(3)黏度试验Viscosity Test与黏度指数(Thixotropy)
每批进料锡膏之保证书中,虽已明列其黏度数据,但为确保其出货中的质量起见,亦应在入库前按J-STD-005之3.5节与IPC-TM-650之2.4.34.3节,抽检其黏度值。其做法是将已回温(5-6小时)的锡膏,开盖后先用搅拌刀从其刀口方向轻搅1-2分钟,再整罐置于专业黏度仪(例如Malcom之PCU201型)之测座上,并将感测头(Sensor)伸入膏体中,续以10 rpm的慢转速度,在25℃下取20分钟后的量测数据做为纪录即可。

图13左为业界所广用Malcom牌之锡膏粘度计PCL-2201,右为其试验平台之特写。
至于黏着指数(或称抗垂流指数Thixotropy)之质量项目,事实上美式锡膏规范J-STD-005并未列入,至于其新A版中是否已纳入则目前尚不得知。日本工业标准JIS-Z-3284则已实行多年,其做法是先求出上述10rpm在20分钟后的黏度值后,再分别另行测出3rpm的6分钟数据,及30rpm的3分钟数据。然后将此两种数据分别求取对数值(Log),此等读值应落在0.45-0.65之间。所谓的Thixotropy也就是控制Slump的能力如何的指标,可令读者较易体会其与抗坍塌性或抗垂流性之间的关系。也就是说印刷后较长时间的置放中(例如10小时),观察是否出现坍塌现象的质量。
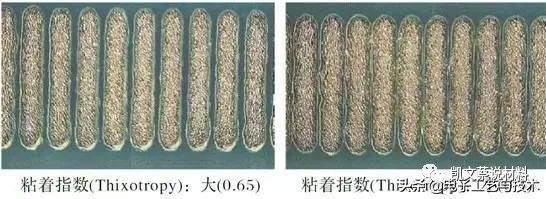
图14此为了解粘著指数所刻意印刷之锡膏,可做为现场对比之用。希望其数据能落在0.4与0.6之间,即最为理想最适合生产用途。
(4)黏着力(Tack Force)
按IPC-TM-650之2.4.44法,在室温环境(25℃,50%RH)中,于玻璃板面印着四个均等圆盘形的锡膏(直径6.5mm厚度0.2mm),再利用精密拉力计所加装之平头不锈钢探棒(直径5.1mm),对准所印之锡膏以2.0mm/s的降速压进锡膏中,并施以重力50g进行0.2秒的压着,然后另以10mm/s的升起速度将探棒缓缓拉起。此时可按下图纪录其向上拉脱时的最大力量,如此共做5次再求取其平均值,即为其纪录用的黏着强度或黏着力之数据(KN/m2)。
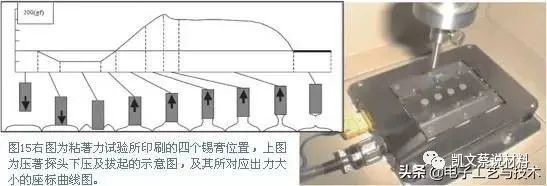
(5)印刷能力(Printability)
是指对密距(Fine Pitch)多垫区(例如QFP之连垫),或直径很小的圆垫等连续印刷多次,希望仍不致造成黏度值或抗垂流性的改变,甚至放置10小时仍未发生坍塌的情形。此种特性对于连续施工颇为重要,对现场而言此检验方法也并不困难,美式规范中亦未列入此项,日系规范可参考JIS-Z-3284附件5。下二图即为首印样与第30次印样的比较。

锡膏的管理与印刷
1、冷藏储存:锡膏是由锡合金的正圆小球,搭配一半体积的有机辅料,均匀掺和而成。但由于两者比重相差极大,放置过久后难免会出现分离沉淀的现象,且当储存温度较高时其分离现象还将更为恶化,甚至氧化现象也较容易发生,对印刷性与流变性乃至后来的焊锡性都会产生不良影响。故只能置于冰箱中(5-7℃)冷藏以保证其用途与寿命。
2、干燥环境:膏很容易吸水(Hygroscopic),一旦吸入水份后各种特性将大幅劣化,难免在后续作业中制造很多烦恼(例如锡球),故现场印刷环境中的相对湿度不可超过50%,温度范围应保持在22-25℃,并应彻底避免吹风以减少干涸的发生。否则会很容易失去印刷 并造成锡膏的氧化,进而亦将耗损掉助焊剂在除锈功能方面的能量,导致脚面与垫面原本应有除锈能力之不足,甚至可能引发坍塌搭桥、四处飞溅的锡球,并使得黏着时间(Tack Time)也为之缩短。
3、回温后开封使用
锡膏离开冰箱后,一定要在干燥的室温环境中,放置4-6小时达到其内外均温后才能开封使用。不要被容器外表已经不冷所骗过,必须内外彻底回温后才可开封 。凡当锡膏之整体温度低于室内之露点(Dew Point)时,锡膏外表会将空气中的水份予以冷凝而附着成水珠。所谓露点是指气温不断下降中,空气中的水气会持续增多,直到饱和(100%RH)为止,其所对应的温度即称为“露点”。冰箱取出的空杯其表面很快会有水珠附着就是这个道理。而且锡膏也不宜快速加温回温,以防助焊剂或其它有机物的分离。
未开封前已回温的锡膏,要连瓶一起放在公转与自转合并的搅拌机中,并就容器之不同位向予以定时转动,以达到内盛锡膏整体均质的目的。正确开封的锡膏,还要用小型压舌片采固定方向温和搅拌约1-3分钟,使整体之分布更为均匀,不宜强烈与过度搅拌,以免锡膏受损及在剪应力(Shear Force)方面的弱化,进而可能导致坍塌(Slumping)甚至焊后搭桥短路的发生。
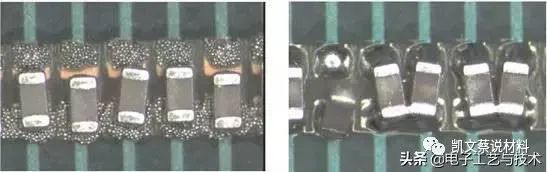
图17良好的锡膏不但在印刷时不可糊涂与变形,正常压力踩脚时也不可发生坍塌与移位,否则回焊一定会出现搭桥短路的麻烦。钢板上的锡膏若未能全数用完而必须刮回储存时,则应另外单独存放,不可与新膏混和。为了节省成本起见,当旧膏再次回到钢板上用于较低阶产品时,亦应另掺较多量的新膏以调和使用。搭配比例则以方便印刷之施工为原则,也有质量较严的业者则宁可不用旧膏。至于有铅与无铅锡膏当然是绝对不能混用,必须要将钢板彻底用溶剂(IPA)洗净,才能换膏。
4、钢板开口(Aperture)
通常无铅锡膏(例如SAC305)中的金属比重,较有铅者轻约17%(SAC305为7.44;有铅Sn63者为8.4),且无铅者之沾锡性较差,故助焊剂在比率上也会多加一些(达11-12%by wt),以加强去锈助焊之能力。如此将使得无铅锡膏对钢板之黏着性增大,在浓稠不易推动的状况中,印后必须要放慢向下之脱板速度,以减少印膏发生局部拉起与带走漏印的麻烦。
焊性良好的有铅锡膏,其钢板开口(Aperture)一般要比PCB的承垫(Pads)需小一点,一来可节省用膏,二来也可达到减少外溢短路的烦恼。但无铅锡膏的焊性较差,常需放大开口与承垫的比率为1:1,甚至超过承垫到达扩印(Overprint)的地步才行。事实上无铅锡膏愈合时的内聚力很大,很容易就会把外缘部份拉回到中央来。再者输送轨道上待印的PCB,到达定位上升触及钢板底面之际,其待印板底部的支撑一定要够强才行。也就是说在刮刀动态施压中板子不可出现下沉之变形,以减少诸多后患的发生。
印刷台面之左右为X轴,远近为Y轴,板厚为Z轴,必须要将正确的板厚读值输入计算机,以达到待印板上的钢板与轨道平齐,刮印中才不致造成刮刀的受损。其板厚要用千分卡(Caliper)仔细测量与输入才不致发生差错。
5、刮刀速度与压力
刮刀速度平均为1-3寸/秒,印速加快时印压也会增大,致使刮刀与钢板的磨擦加剧,连带温度上升又将破坏锡膏的抗剪力,进而会使黏度转稀,造成锡膏着落的不良与容易坍塌。以及于钢板下缘的溢出甚至搭桥短路,而且还会使得刮刀磨损增加。故通常只要找到良好印速后,即不可任意加快。但施工时若发现锡膏太稠、不易脱离钢板,着床性不佳时;则亦可稍行加速约1寸/秒,以便浓稠度得以减弱而方便施工。
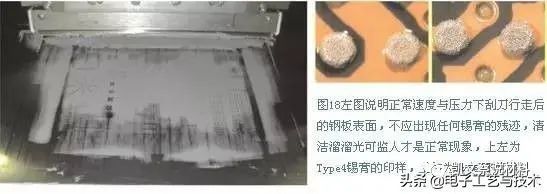
当刮刀用力向前推行的同时,也会产生一种向下的压力(Downward Pressure),迫使锡膏通过钢板开口而到达垫面。对无锡膏而言,每当行走1寸中将产生1-1.5磅的向下压力;此时所刮过的钢板表面应呈现清洁光泽的外观,正如同汽车挡风玻璃被雨刷刮过的整洁清爽一般,即为其最适压力的表征。换句话说良好刮压的钢板,其表面不应残留任何锡膏的痕迹。
凡当刮压太重时,则印膏中心处会出现掠过 的浮刮(Scooping)缺点,也会发生溢出(Bleed Out)情形。

图19左为刮刀下沉太多所造成印膏的浮刮现象。中为钢板开口不洁所引发的溢出与糊印,右为待印板印妥后下降脱模太快所造成的撕印。
有时可从着膏区的绿漆边缘处,看到一连串锡粒的残存,或外侧锡粒已被压扁者,均为已发生Bleed Out的明证。倘若刮压不足以致钢板表面尚留有锡膏残迹时,其藕断丝连下又将出现印膏局部被撕起带走的“撕印”(Torn Prints),更将引发覆盖不足或提早干涸等问题。事实上刮压与印速(Print Speed)成正比,只要降慢印速即可减轻刮压,此等由于重压而发生的问题也都将自然消失了。
刮刀不宜太长,否则涂抹面积太广,左右两侧超出待印区域之无效印面,只会造成提早干涸的负面效应而已。采用短刀时两侧溢出者应以手动方式移回印区之内,以免动静差别太久而造成锡膏的变性。
6、缓脱之降距(Separation Distance)
图20此亦为印后下降脱模太快所拉扯出现的狗耳(Dog Ear)现象。
当板面已完成锡膏印刷之作业,该加工板即将在各顶柱移开后,会先行自动缓降以脱离不锈钢模板。但由于模板开口与印膏两者尚有黏着力量,因而当板面的印膏欲自开口处下降脱离之际,其动作必须缓慢温柔,以免牵动印膏造成不良之狗耳(Dog Ear)现象。直到印膏已全部安全降离脱出模板开口为止,才可对待印板进行较快速的续降与平移动作。此段安全性缓降之落差即称之为“缓脱降距”。通常此段小心翼翼的降距约为0.1吋(即100mil)。困难印品如CSP等圆垫而言,其降速应保持在0.1-0.2 in/sec,至于其它不太关键的印垫则可加快到0.3-0.5 in/sec之降速。凡当生产已顺利时,此段降距的耗时还可予减缩短,以提高效率节省全线直通所需的时间。至于难度高的产品则应从延缓其降速做起,以减少质量问题。
是指待印板上升触及钢板底面之际,刻意在两板间预留出的细小间隙而言。此一小段垂直间隙,可协助钢板开口将锡膏释放在承垫上的动作,并稍可增加锡膏印着的厚度。但当锡膏之黏度较稀时,则此种垂直间隙则应加以减缩,以免印膏自着落区向外溢出(Bleed Out),进而导致相邻印膏间的搭桥短路。
在已校正之印机决定上述板隙之前,须先将待印板的精确板厚读值(包括绿漆白字在内)输入计算机中;一般均将其板隙设定为0,即所谓的轻贴式印刷(On Contact Printing)。此种设定值将可使钢板开口与承垫之间,出现一种密贴套圈式(Gasketing)的闭合作用,可防止印膏之外溢,并可得到分布均匀高矮一致的锡膏厚度。
使用过的钢板应加以清洁,务使底面与各开口中不致积累太多的残渣,甚至干涸结壳而不易清除。操作中钢板底面可常规采用滚动布轮(已沾IPA)式的初步清洁,若发现无法奏效时则可戴手套采己沾异丙醇(IPA)之抹布,或专用清洁液沾湿之抹布用力擦洗。此种专用清洁液应不至对开口中仍存在的锡膏造成伤害。通常每印完2-5板子时,即应对钢板底面进行初步清洁。
回流焊の原理与管理
所谓Reflow(译词有回流焊、回焊、再流焊、回流焊、回焊、熔焊等,其回焊为日文),是指利用输送带(Conveyor,指移动式不锈钢网或架空双轨)负载待焊板通过多道加热段(Heating Zones),在热空气或热氮气或搭配红外线,于全方位高效传热下,完成锡膏的熔融愈合(Coalescence)并冷却而成为焊点之谓也。早期的SMT技术亦曾利用远红外线(波长较长之IR)直接辐射式(Radiation)的加热方式,不过目前炉中的IR反到成了配角,帮忙主角热气对流去进行双重加热。或单纯只采用高效的循环热风或热氮气做为能量的来源。
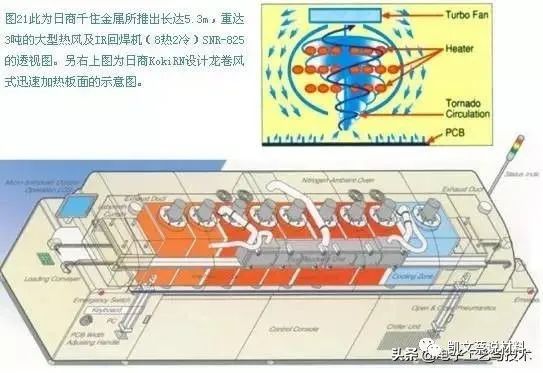
无铅回焊的最高目标,是要以最起码的热量,将板面所有待装的大小组件全数焊妥,并应避免施加过多热量造成组件与电路板的伤害。小心运用可移动式感热仪(Profiler),找出正确的回焊曲线将可达成此一目标。
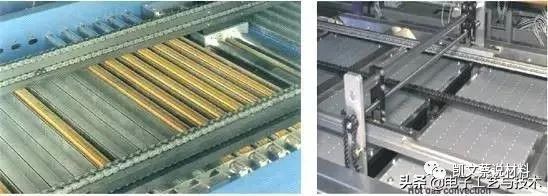
图22左图为IR(红外线)与热风两种热源共用的回焊炉,长条发橙光者即为IR热源,另外灰色有小孔之不锈钢者为热风出口。右图为单纯热风之回焊机。
-
锡膏
+关注
关注
1文章
1001浏览量
18393
发布评论请先 登录



 SMT表面贴装技术锡膏印刷步骤及工艺
SMT表面贴装技术锡膏印刷步骤及工艺



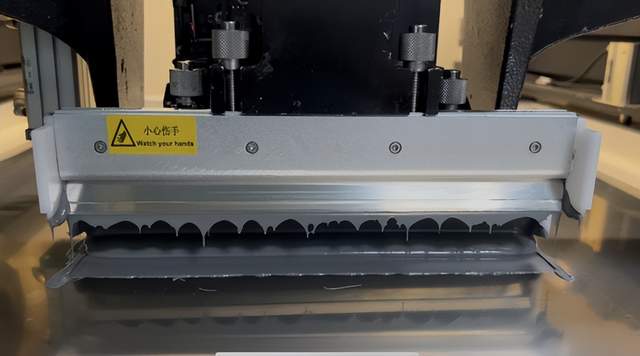








评论