声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
SiC
+关注
关注
32文章
3854浏览量
70097
发布评论请先 登录
相关推荐
热点推荐
博世碳化硅技术路线图持续演进
、第四代和第五代产品的逐步推出,碳化硅器件将在性能、成本与可靠性方面实现持续跃升,为电动汽车市场的规模化发展提供关键支撑。
技术突围与市场破局:碳化硅焚烧炉内胆的氮化硅陶瓷升级路径
耐火材料与纯碳化硅材料面临极限挑战时,氮化硅陶瓷的技术指标为这一领域提供了更具针对性的升级方案。
一、产品细节:氮化硅陶瓷的
发表于 03-20 11:23
碳化硅MOS管测试技术及仪器应用(上)
、保障系统可靠性的关键,而示波器作为信号捕获与分析的核心仪器,在动态特性表征中发挥着不可替代的作用。本文将系统阐述碳化硅MOS管的核心测试项目、技术要点,重点解析示波器及

【新启航】碳化硅外延片 TTV 厚度与生长工艺参数的关联性研究
一、引言
碳化硅外延片作为功率半导体器件的核心材料,其总厚度偏差(TTV)是衡量产品质量的关键指标,直接影响器件的性能与可靠性 。外延片的 TTV 厚度受多种因素影响,其中

碳化硅功率器件的基本特性和主要类型
随着全球对能源效率和可持续发展的关注日益加深,碳化硅(SiC)功率器件作为一种新兴的半导体材料,正在快速崛起。SiC以其优异的电气性能、高温稳定性和抗辐射性,成为现代电力电子技术中不可
碳化硅器件的应用优势
碳化硅是第三代半导体典型材料,相比之前的硅材料,碳化硅有着高击穿场强和高热导率的优势,在高压、高频、大功率的场景下更适用。碳化硅的晶体结构稳定,哪怕是在超过300℃的高温环境下,打破了传统材料下

【新启航】如何解决碳化硅衬底 TTV 厚度测量中的各向异性干扰问题
摘要
本文针对碳化硅衬底 TTV 厚度测量中各向异性带来的干扰问题展开研究,深入分析干扰产生的机理,提出多种解决策略,旨在提高碳化硅衬底 TTV 厚度测量的准确性与可靠性,为

B2M030120N SiC碳化硅MOSFET完美契合半导体射频电源对效率、可靠性和紧凑化的严苛需求
B2M030120N SiC碳化硅MOSFET完美契合半导体射频电源对效率、可靠性和紧凑化的严苛需求

EAB450M12XM3全碳化硅半桥功率模块CREE
模块的可靠性和耐用性。低电感设计:电感值为6.7 nH,有助于降低系统中的电感效应,提高功率转换效率。采用全新的第3代碳化硅MOSFETs:提供更好的性能和效率。集成化温度传感器
发表于 06-25 09:13
基本半导体碳化硅 MOSFET 的 Eoff 特性及其在电力电子领域的应用
。其中,关断损耗(Eoff)作为衡量器件开关性能的重要指标,直接影响着系统的效率、发热和可靠性。本文将聚焦于基本半导体碳化硅 MOSFET 的 Eoff 特性,深入探讨其技术优势及在电
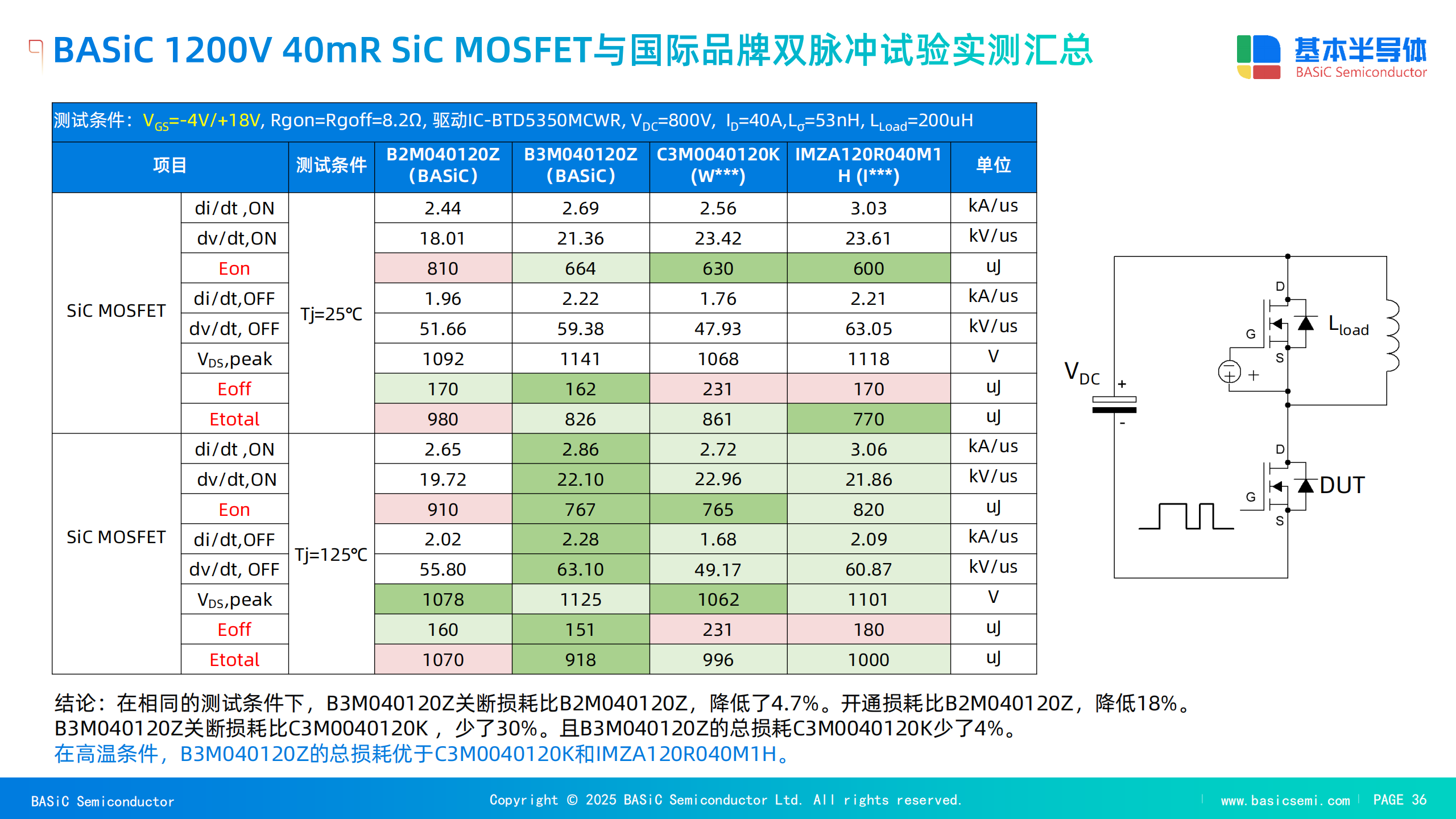
提供半导体工艺可靠性测试-WLR晶圆可靠性测试
潜在可靠性问题;与传统封装级测试结合,实现全周期可靠性评估与寿命预测。
关键测试领域与失效机理
WLR技术聚焦半导体器件的本征可靠性,覆盖以
发表于 05-07 20:34



 8.2.11 氧化层可靠性∈《碳化硅技术基本原理——生长、表征、器件和应用》
8.2.11 氧化层可靠性∈《碳化硅技术基本原理——生长、表征、器件和应用》




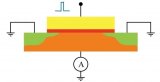

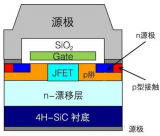



评论