一、引言
碳化硅外延片作为功率半导体器件的核心材料,其总厚度偏差(TTV)是衡量产品质量的关键指标,直接影响器件的性能与可靠性 。外延片的 TTV 厚度受多种因素影响,其中生长工艺参数起着决定性作用。深入研究碳化硅外延片 TTV 厚度与生长工艺参数的关联性,有助于优化生长工艺,提升外延片质量,推动碳化硅半导体产业发展。
二、碳化硅外延片生长工艺参数分析
2.1 温度参数
生长温度是碳化硅外延生长的关键参数之一。在化学气相沉积(CVD)生长过程中,温度影响反应气体的分解、吸附及表面迁移速率 。温度过高,反应气体分解过快,可能导致原子在衬底表面无序堆积,造成外延层表面粗糙,进而影响 TTV 厚度 ;温度过低,原子活性不足,生长速率降低,且容易出现成核不均匀现象,同样会使 TTV 厚度增大 。
2.2 气体流量参数
生长过程中,反应气体(如硅源、碳源气体)和载气的流量对外延片生长有重要影响 。气体流量配比不当,会导致硅、碳原子供应不均衡,影响外延层的均匀生长 。例如,硅源气体流量过高,可能在局部区域形成富硅层,造成外延片厚度不均匀,增大 TTV 。此外,气体流量还会影响反应腔内的流场分布,若流场不均匀,会使外延片不同区域的生长速率存在差异,导致 TTV 厚度变化 。
2.3 压力参数
反应腔压力也是影响碳化硅外延生长的重要参数 。在低压 CVD(LPCVD)和常压 CVD(APCVD)中,压力的变化会改变反应气体的扩散速率和表面反应动力学 。较低的压力有助于反应气体在衬底表面的均匀扩散,可提高外延层的均匀性,降低 TTV ;而压力过高时,气体分子间碰撞加剧,会影响原子在衬底表面的吸附和迁移,导致外延片厚度不均匀,使 TTV 增大 。
三、TTV 厚度与生长工艺参数的关联性
3.1 温度与 TTV 的关联
通过实验研究发现,在一定温度范围内,随着生长温度升高,碳化硅外延片 TTV 厚度呈现先减小后增大的趋势 。存在一个最佳温度区间,在此区间内,原子在衬底表面的迁移和吸附达到平衡,能够形成均匀的外延层,TTV 厚度最小 。超出该温度区间,无论是温度过高还是过低,都会破坏这种平衡,导致 TTV 厚度增加 。
3.2 气体流量与 TTV 的关联
气体流量与 TTV 厚度之间存在复杂的非线性关系 。合理调整硅源、碳源气体及载气的流量配比,可使外延层均匀生长,降低 TTV 。例如,当硅源气体流量与碳源气体流量保持合适比例时,硅、碳原子能够均匀沉积在衬底表面,外延片厚度均匀性提高 。若流量配比失衡,会导致局部区域生长过快或过慢,使 TTV 厚度增大 。
3.3 压力与 TTV 的关联
研究表明,反应腔压力与 TTV 厚度呈负相关关系 。在较低压力下,气体扩散均匀,外延片生长均匀性好,TTV 厚度较小 ;随着压力升高,气体扩散受限,外延片不同区域生长速率差异增大,TTV 厚度随之增加 。但压力过低也可能引发其他问题,如生长速率过慢等,因此需要在合适的压力范围内进行生长,以控制 TTV 厚度 。
高通量晶圆测厚系统运用第三代扫频OCT技术,精准攻克晶圆/晶片厚度TTV重复精度不稳定难题,重复精度达3nm以下。针对行业厚度测量结果不一致的痛点,经不同时段测量验证,保障再现精度可靠。

我们的数据和WAFERSIGHT2的数据测量对比,进一步验证了真值的再现性:

(以上为新启航实测样品数据结果)
该系统基于第三代可调谐扫频激光技术,相较传统双探头对射扫描,可一次完成所有平面度及厚度参数测量。其创新扫描原理极大提升材料兼容性,从轻掺到重掺P型硅,到碳化硅、蓝宝石、玻璃等多种晶圆材料均适用:
对重掺型硅,可精准探测强吸收晶圆前后表面;
点扫描第三代扫频激光技术,有效抵御光谱串扰,胜任粗糙晶圆表面测量;
通过偏振效应补偿,增强低反射碳化硅、铌酸锂晶圆测量信噪比;

(以上为新启航实测样品数据结果)
支持绝缘体上硅和MEMS多层结构测量,覆盖μm级到数百μm级厚度范围,还可测量薄至4μm、精度达1nm的薄膜。

(以上为新启航实测样品数据结果)
此外,可调谐扫频激光具备出色的“温漂”处理能力,在极端环境中抗干扰性强,显著提升重复测量稳定性。

(以上为新启航实测样品数据结果)
系统采用第三代高速扫频可调谐激光器,摆脱传统SLD光源对“主动式减震平台”的依赖,凭借卓越抗干扰性实现小型化设计,还能与EFEM系统集成,满足产线自动化测量需求。运动控制灵活,适配2-12英寸方片和圆片测量。

-
碳化硅
+关注
关注
26文章
3548浏览量
52664 -
外延片
+关注
关注
0文章
40浏览量
10071 -
功率半导体器件
+关注
关注
3文章
63浏览量
6455
发布评论请先 登录
【新启航】如何解决碳化硅衬底 TTV 厚度测量中的各向异性干扰问题

【新启航】碳化硅衬底 TTV 厚度测量设备的日常维护与故障排查

【新启航】国产 VS 进口碳化硅衬底 TTV 厚度测量仪的性价比分析

【新启航】碳化硅衬底 TTV 厚度测量中表面粗糙度对结果的影响研究

【新启航】探针式碳化硅衬底 TTV 厚度测量仪的操作规范与技巧

探针式碳化硅衬底 TTV 厚度测量仪的操作规范与技巧

碳化硅衬底 TTV 厚度测量中边缘效应的抑制方法研究

【新启航】碳化硅衬底 TTV 厚度不均匀性测量的特殊采样策略

【新启航】碳化硅 TTV 厚度测量中的各向异性效应及其修正算法

[新启航]碳化硅 TTV 厚度测量技术的未来发展趋势与创新方向
![[新<b class='flag-5'>启航</b>]<b class='flag-5'>碳化硅</b> <b class='flag-5'>TTV</b> <b class='flag-5'>厚度</b>测量技术的未来发展趋势与创新方向](https://file1.elecfans.com/web3/M00/20/D6/wKgZPGhd-raAI0RYAACIgEePWXY565.png)



 【新启航】碳化硅外延片 TTV 厚度与生长工艺参数的关联性研究
【新启航】碳化硅外延片 TTV 厚度与生长工艺参数的关联性研究

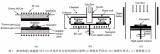



评论