减薄晶片有四种主要方法,(1)机械研磨,(2)化学机械平面化,(3)湿法蚀刻(4)等离子体干法化学蚀刻(ADP DCE)。四种晶片减薄技术由两组组成:研磨和蚀刻。为了研磨晶片,将砂轮和水或化学浆液结合起来与晶片反应并使之变薄,而蚀刻则使用化学物质来使基板变薄。
机械研磨
机械(常规)磨削–该工艺具有很高的稀化率,使其成为非常普遍的技术。它使用安装在高速主轴上的金刚石和树脂粘合的砂轮,类似于旋涂应用中使用的砂轮。研磨配方决定主轴的速度以及材料的去除率。为了准备机械研磨,将晶片放在多孔陶瓷卡盘上,并通过真空将其固定在适当的位置。晶圆的背面朝着砂轮放置,而砂带则放置在晶圆的前侧,以防止晶圆在减薄过程中受到任何损坏。当去离子水喷洒到晶圆上时,两个齿轮以相反的方向旋转,以确保砂轮和基材之间有足够的润滑。这也可以控制温度和减薄率,以确保不会将晶片切割得太薄。
总而言之,该过程分两个步骤:粗磨以〜5μm/ sec的速度进行大部分的细化。用1200至2000粗砂和poligrind精磨精磨。通常以≤1μm/ sec的速度去除〜30μm或更小的材料,并在晶片上提供最终的光洁度。1200粗砂的粗糙表面带有明显的磨痕,而2000粗砂的粗糙程度较小,但是仍然有一些磨痕。Poligrind是一种抛光工具,可提供最大的晶片强度,并消除了大部分的次表面损伤。
化学机械平面化(CMP)
化学机械平面化(CMP)–此过程使晶片变平并去除表面的不规则形貌。CMP使用小颗粒研磨化学浆料和抛光垫进行。尽管它倾向于清洁程度较低,但它比机械研磨提供了更多的平面化效果。化学机械平面化分为三个步骤:
1.将晶片安装到背面膜上,例如蜡架,以将其固定在适当的位置。
2.从上方涂抹化学浆,并用抛光垫将其均匀分布。
3.每次抛光都旋转抛光垫约60-90秒,具体取决于最终厚度规格。
CMP的稀化速度比机械研磨慢,每秒仅清除几微米。这将导致近乎完美的平整度和可控的TTV。
刻蚀湿蚀刻
湿蚀刻使用液体化学药品或蚀刻剂从晶圆上去除材料。这在仅晶圆部分需要减薄的情况下很有用。通过在蚀刻之前在晶片上放置一个硬掩模,变薄只会在没有衬底的部分衬底上发生。有两种执行湿法蚀刻的方法:各向同性(在所有方向均匀)和各向异性(在垂直方向上均匀)。此过程分为三个步骤:
1.液体蚀刻剂扩散到晶圆表面。液体蚀刻剂根据所需的厚度以及是否需要各向同性或各向异性蚀刻而变化。在各向同性蚀刻中,最常见的蚀刻剂是氢氟酸,硝酸和乙酸(HNA)的组合。最常见的各向异性蚀刻剂是氢氧化钾(KOH),乙二胺邻苯二酚(EDP)和氢氧化四甲铵(TMAH)。
2.薄薄的蚀刻剂流喷洒在旋转晶片的表面上,液体蚀刻剂与基板反应使基板变薄。尽管大多数反应以〜10μm/ min的速度进行反应,但反应速率可能会根据反应中使用的蚀刻剂而变化。
3.化学副产物从晶片表面扩散。
大气下游等离子体(ADP)干法蚀刻(DCE)ADP DCE是最新的晶圆减薄技术,与湿法蚀刻类似。代替使用液体,干式化学蚀刻使用等离子体或蚀刻剂气体去除材料。为了执行减薄过程,可以在目标晶圆上发射高动能粒子束,化学物质与晶圆表面发生反应或两者结合。干法刻蚀的去除速度约为20μm/ min,并且没有机械应力或化学物质,因此这种方法能够以高产量生产出非常薄的晶片。
审核编辑:汤梓红
-
等离子体
+关注
关注
0文章
147浏览量
15293 -
晶圆
+关注
关注
53文章
5446浏览量
132715 -
蚀刻
+关注
关注
10文章
431浏览量
16683 -
CMP
+关注
关注
7文章
162浏览量
27869 -
晶片
+关注
关注
1文章
413浏览量
33000
原文标题:简述晶圆减薄的几种方法
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
宜特晶圆:成功开发晶圆减薄达1.5mil(38um)技术
同茂线性马达谈新面世的高精密晶圆减薄机
单面晶圆减薄和处理研究报告
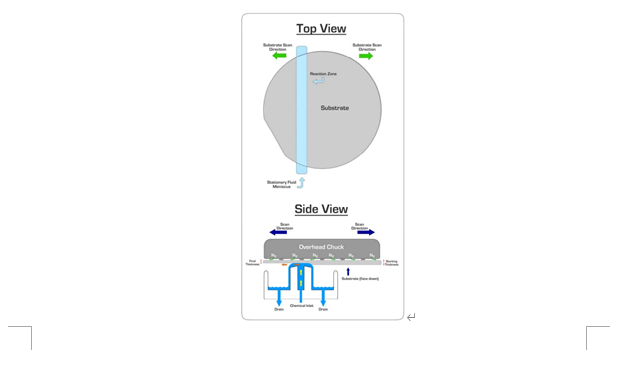
微机械结构硅片的机械减薄研究
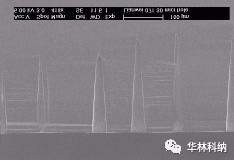
晶圆减薄工艺的主要步骤




 简述晶圆减薄的几种方法
简述晶圆减薄的几种方法









评论