11月14-16日,CSPT2022第二十届中国半导体封装测试技术与市场年会,在江苏南通国际会议中心隆重举行,普莱信智能总经理孟晋辉受邀出席,并做《后摩尔时代的封装技术,国产固晶设备的机遇与挑战》的主题演讲,普莱信智能的高端半导体封装设备解决方案,获得半导体同行的广泛认可。
本届大会以“主动有为,踔厉前行——共创封测产业新时代”为主题,吸引来自世界各地和国内1000多名代表出席本次大会,聚焦半导体封装测试产业核心环节,对先进封装工艺技术、封装材料、封装设备等行业热点问题进行研讨。
根据SEMI数据显示,预计2022年封装设备市场将增长8.2%至78亿美元,2023年将小幅下降0.5%至77亿美元。半导体封装设备中:固晶机、 划片机/检测设备、引线焊接设备、塑封/切筋成型设备等占比较大,分别约为30%、28%、23%、18%。近些年,全球半导体产能倒向有巨大需求市场的中国大陆,然而大量核心半导体设备长期依赖进口,封测设备基本被国外品牌垄断,国产化率整体上为5%左右。
由于中美贸易战加剧,美国《2022年芯片和科学法案》正式签署成法,美国对中国半导体行业的技术封锁越来越严重,加速半导体设备国产化势在必行。
本次大会上,普莱信智能总经理孟晋辉表示:“随着摩尔定律放缓,先进封装技术的不断推进,SiP技术、3D封装、Chiplet等技术成为行业新的增长动能,对于固晶设备在高精度、稳定的力控制、温度场及变形的控制等性能方面提出了更高的需求,普莱信智能的IC级固晶机在精度、速度、稳定性上完全媲美进口产品,贴装精度±10-25微米,广泛应用于SiP、Flip Chip等先进封装。”
普莱信智能作为高端半导体封装设备领军企业之一,拥有自主研发的运动控制器、伺服驱动、直线电机、机器视觉等底层核心技术平台。经过5年的发展,已经在多个领域打破国外技术垄断,为半导体封装、光通信封装、MiniLED巨量转移、功率器件封装等领域提供高端装备和智能化解决方案。产品覆盖:半导体封装的IC直线式高精度固晶机DA801、DA1201,倒装覆晶及固晶机DA1201FC;光通信封装的超高精度固晶机DA402,高精度无源耦合机Lens Bonder;MiniLED巨量转移的超高速刺晶机XBonder;功率器件封装的高速夹焊系统Clip Bonder等。所有产品在精度、速度、稳定性上完全媲美进口产品,已获得华天、UTAC、华润微等封测巨头的认可。
感谢来自世界各地的专家与合作伙伴,与我们共享这次CSPT 2022之旅,在未来,普莱信智能将继续携手合作伙伴,以高端半导体封装设备为中心,创新先进封装技术,为半导体封装设备国产替代贡献力量。
审核编辑:汤梓红
-
半导体
+关注
关注
336文章
30002浏览量
258477 -
封装
+关注
关注
128文章
9146浏览量
147909
发布评论请先 登录
Chiplet核心挑战破解之道:瑞沃微先进封装技术新思路

Chiplet封装设计中的信号与电源完整性挑战

普华基础软件亮相2025世界智能网联汽车大会
谷景电子出席联合飞机2025年供应商大会
普莱信成立TCB实验室,提供CoWoS、HBM、CPO、oDSP等从打样到量产的支持

先进封装转接板的典型结构和分类
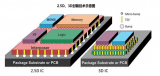
Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障

后摩尔时代:芯片不是越来越凉,而是越来越烫

普莱信Clip Bond封装整线设备,获功率半导体国际巨头海外工厂订单
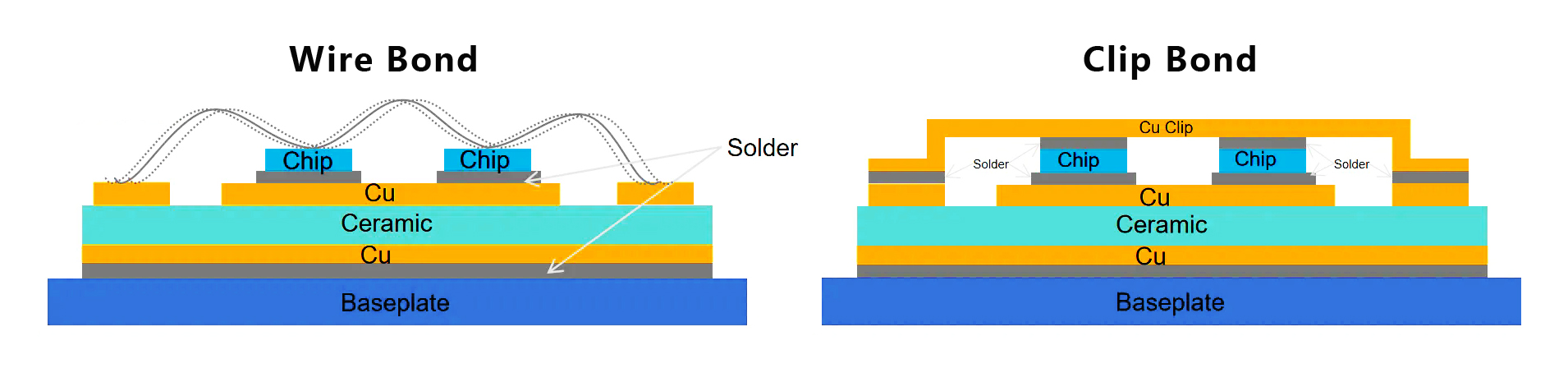
国产封装测试技术崛起,江西万年芯构建实力护城河

广电计量受邀参加后摩尔器件研讨会 携半导体综合技术解决方案亮相






 普莱信智能孟晋辉出席CSPT 2022,共探后摩尔时代的封装技术
普莱信智能孟晋辉出席CSPT 2022,共探后摩尔时代的封装技术















评论