导语
本文摘录自贾忠中老师著作《SMT核心工艺解析与案例分析》,本书分上下两篇。上篇汇集了表面组装技术的54项核心工艺,从工程应用的角度,全面、系统地对 SMT的应用原理进行了解析和说明,对深刻理解其工艺原理、指导实际生产有很大帮助;下篇精选了103个典型案例,较全面地讲解了实际生产中遇到的、由各种因素引起的工艺问题,对处理生产现场问题、提高组装的可靠性具有较强的指导、借鉴作用。
No. 021BGA焊点混装工艺型断裂
案例4
某带金属壳BGA焊接温度220℃,焊接时间18s,其焊接温度曲线如图2-59所示。根据一般经验,怀疑温度有点低,可能存在质量问题。

图2-59 某带金属壳BGA焊接温度曲线
分 析
(1)染色。一共染色四个BGA,拉开BGA后,可以看到绝大部分焊点是从PCB的焊盘与基材结合处拉开,也有部分是从焊盘侧拉开的,但都有空洞存在,如图2-60和图2-61所示。
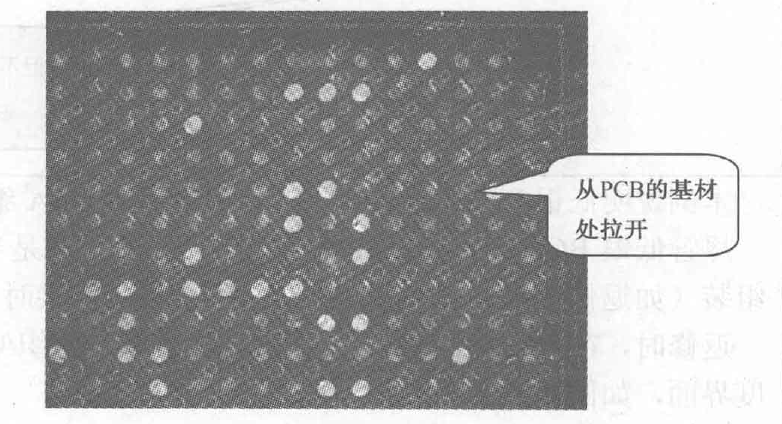
图2-60 从基材处拉开的情况
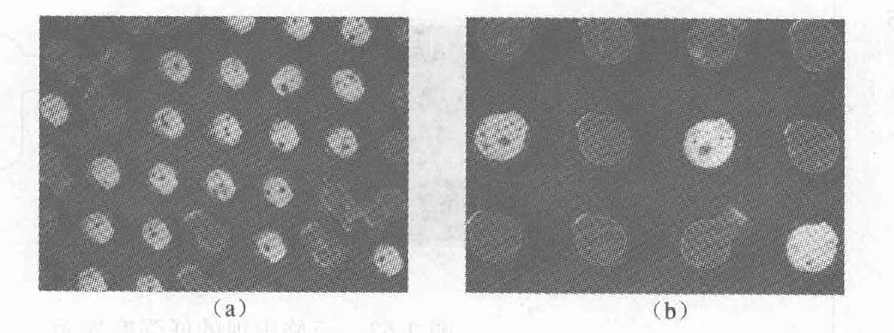
图2-61 从焊盘拉开的断裂情况
(2)切片。染色后切片情况如图2-62所示。
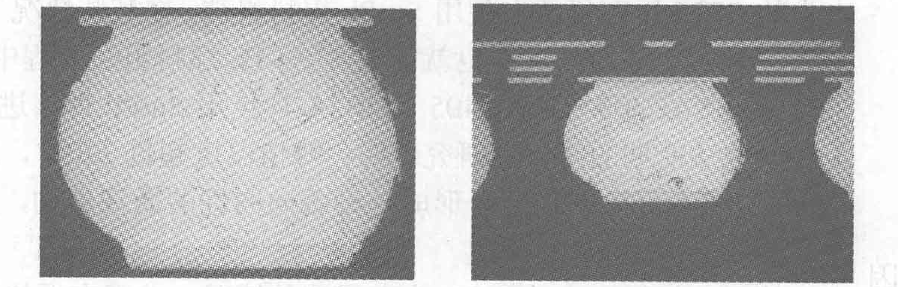
图2-62 染色后切片情况
曲线如图2-58所示。分析结果:
(1)焊点没有开裂,但存在一定的界面空洞。
(2)没有从BGA侧拉开的,全部是从PCB侧拉开,而且,80%从焊盘下的基材拉开,从PCB焊盘拉开的点仅占20%左右,且有一个显著特征,拉开界面存在小的空洞。
这一点与常见的BGA侧焊点开裂形成鲜明对比!
说 明
此案例具有典型意义: (1)220℃的焊接是可以接受的。理论上,温度低,BGA 的变形会更小。 (2)低温短时在一定条件下也是可行的。

审核编辑 :李倩
-
smt
+关注
关注
45文章
3237浏览量
77382 -
BGA
+关注
关注
5文章
588浏览量
52074 -
焊点
+关注
关注
0文章
150浏览量
13373
原文标题:技术分享丨BGA焊点混装工艺型断裂(六)
文章出处:【微信号:CEIA电子智造,微信公众号:CEIA电子智造】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
芯片基板热循环测试失败?可能是你的底部填充胶CTE 匹配没做好!

云台驱动板拆装工艺与硬件结构拆解分析



GT-BGA-2002高性能BGA测试插座
解析LGA与BGA芯片封装技术的区别

哪种工艺更适合高密度PCB?
高频混压板层压工艺
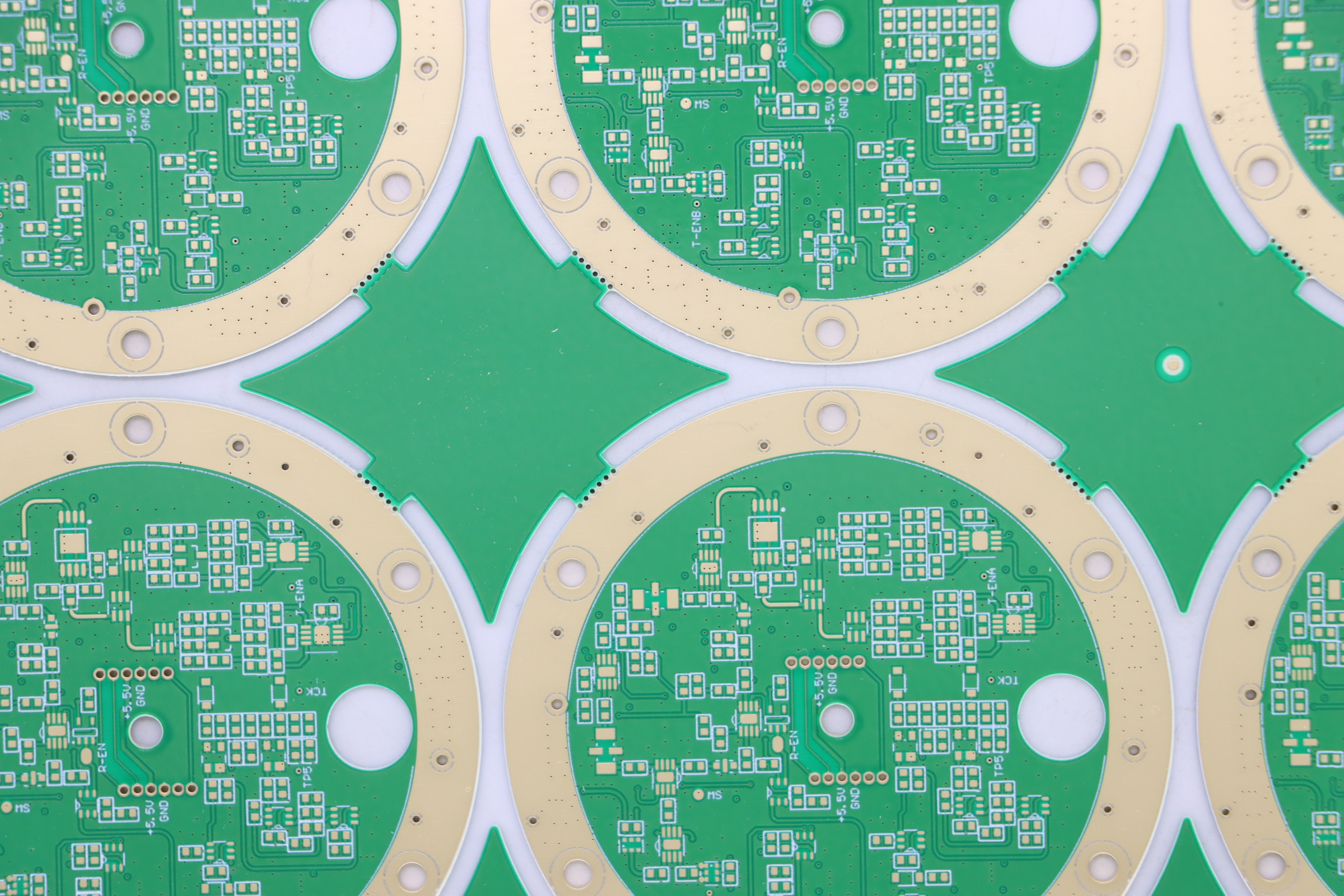
深入了解BGA芯片X-ray检测设备的核心优势与应用-智诚精展
焊点保护环氧胶水保护线路板上焊点,提高耐冲击力

探秘芯片焊点强度:详解推拉力测试机的工作原理、关键参数与结果解读
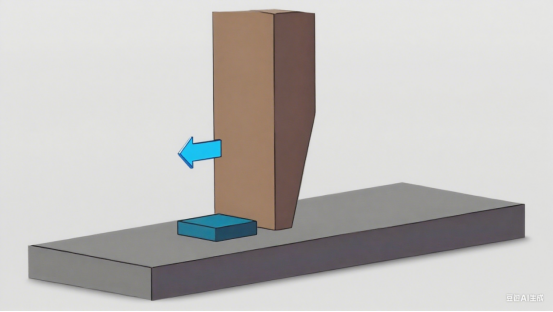
GT-BGA-2000高速BGA测试插座
基于硅基异构集成的BGA互连可靠性研究

晶振常见封装工艺及其特点




 BGA焊点混装工艺型断裂
BGA焊点混装工艺型断裂




评论