随着 3D-IC 的制造工艺的不断发展,3D-IC 的堆叠方式愈发灵活,从需要基板作为两个芯片互联的桥梁,发展到如今可以做到多颗芯片灵活堆叠,芯片设计团队要实现质量最佳、满足工期要求、具有成本效益的设计,面临着如何建立正确的 3D-IC 设计实现流程和如何实现设计数据&项目的高效管理的挑战。
解决这个挑战,就要求设计环境可以预先掌握设计意图、支持设计模型简化,进而达成系统的整体规划,获得系统级效应(如热和功耗)所提供的早期反馈,并透过实现和分析的无缝迭代达到同时兼顾芯片和封装效应的最佳系统设计效果。
Integrity 3D-IC 平台具有强大的数据管理功能,能够实现跨团队的一键数据同步与更新。同时,Integrity 3D-IC 支持灵活的 3D-IC 实现流程,配合其高效的数据管理机制,可以让用户在流程中的多个关键阶段接入内嵌的分析平台,进而实现整个系统的快速迭代和 ECO。
通过系统规划器为 3D 系统提供独特的层次化设计和优化功能
通过与 Innovus Implementation System 基于 Tcl 的实时直接集成,提供完整的堆叠管理、芯片到封装的信号映射以及先进的 Bump 和 TSV 规划功能
高效的数据库,可对每一层堆叠结构进行层次化的多级表示
Integrity 3D-IC 自底向上的实现流程
顶层规划
物理与逻辑连接的设计和优化
物理实现的自动化流程
与传统的芯片层次化设计一样,3D-IC 的实现流程也有自底向上与自顶向下之分,但无论哪种方法,其目标都是将设计划分成若干个芯片的数据包分别做物理实现。Integrity 3D-IC 可以轻松将两个芯片的数据包组合,并且在此基础上完成 3D 系统的布局规划和片间互联优化。与此同时,Integrity 3D-IC 平台拥有多种针对 Bump 规划以及优化的新特性,帮助用户达成更高性能的设计。
顶层规划
当用户已经有芯片的数据包,无论该数据包处于原型阶段还是已部分物理实现,Integrity 3D-IC 均可以利用其建立 3D-IC 系统顶层的堆叠与连接。并且 Integrity 3D-IC 可以支持灵活的顶层逻辑描述格式:用户可以使用常规的 verilog 网表或 Integrity 3D-IC 标准的连接描述文件格式,从而可以帮助用户快速将前端顶层系统设计转化为真实的顶层逻辑连接。
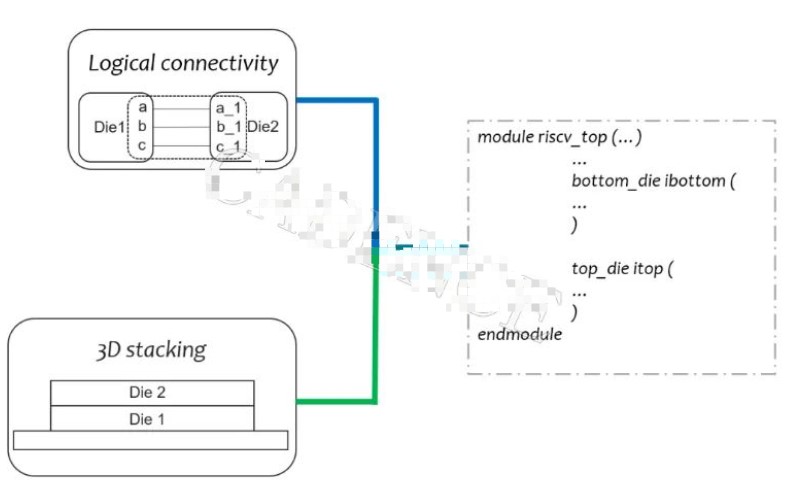
物理与逻辑连接的设计和优化
完成顶层设计后,我们需要对片间互联的 Bump 模式进行设计,并将信号与 Bump 关联以实现逻辑和物理的数据通路。通常这个过程需要跨团队多次迭代从而实现 Bump 数量和上下芯片间信号线长的平衡,这个迭代常常为了保留余量而过度设计,导致损失部分系统性能,如下图:

用户需要多次尝试以评估数据从 A 通道还是 B 通道传输才能得到最短的线长。当设计中存在数万乃至数十万个 Bump 的时候,这就变成一个难以完成的任务。
Integrity 3D-IC 可以根据设计的物理信息自动获得最优的信号与 Bump 关联方案,帮助用户用最短的时间得到最佳的 Bump pattern 设计。与此同时,对于一些需要用户定制的数据通路,工具可以根据用户提供的映射关系将所需的信号与 Bump 准确的关联。这个特性可以让用户如同堆乐高积木一般实现多芯片堆叠和信号通路设计。

物理实现的自动化流程
Integrity 3D-IC 支持完整的 3D-IC 物理实现流程。工具已经将 3D-IC 设计中所需要的特殊处理整合简化,如下图所示,对于用户而言,只需要在 floorplan 阶段针对 Bump 做标准流程处理,即可继续往下进行。而到了绕线的环节,工具的绕线引擎对于 Bump 的连接已经有着良好的支持,用户可以通过工具轻松的实现 Bump 绕线自动化。如图所示,工具可识别出 Bump 的位置并正确的连线打孔。

Integrity 3D-IC 的高效数据管理
iHDB (Integrity Hierarchical Database)
数据的同步
在 3D-IC 设计中,用户需要管理的不再是一颗芯片的数据,而是若干个芯片,跨越架构设计,后端实现,封装设计,设计签核的多团队,不同类型的数据管理。在项目进展过程中如果发生 ECO,通常需要经过层层沟通,耗时费力易出错。Integrity 3D-IC 提供了一套高效的数据管理架构(iHDB),并且可以通过工具将某一个步骤发生的 ECO 正确的传播到各个团队所需要的数据包中,从而避免了人为沟通检查的时间损耗。
iHDB(Integrity Hierarchical Database)
iHDB 的层次化框架如下图所示,它可以让用户将业界多种形式的标准数据转化成 iHDB 的层次化结构进行存储。并且其提供 Tcl 接口让用户可以轻松读写芯片不同阶段不同类型的数据。用户可以通过这个框架管理不同项目节点的存档,确保不同设计者之间交付的数据版本一致性,并可以实现快速的交叉检查。

数据的同步
在 3D-IC 设计过程中,用户可能在任意阶段做 ECO 或分析,Integrity 3D-IC 提供极为强大的数据同步功能,用户只需要用一条命令就可以完成数据的更新和同步,并可以直接在 Integrity 3D-IC 中启用分析签核工具读取更新过后的数据做分析。这可以大大提高不同团队之间互相交付输入件的效率,进而加快项目收敛。

凭借 Cadence 在模拟和数字 IC 设计,封装设计以及 PCB 设计领域提供的全方面 EDA 工具产品的集成,Cadence Integrity 3D-IC 通过统一的层次化数据库结构,利用 Cadence 业界领先的数字 / 模拟 / 封装以及签核技术,实现了让用户可以在系统规划和实现流程的早期就进行系统分析和设计迭代,达到系统 PPA 驱动的高性能 3D-IC 设计效果,同时可以避免高昂的过度设计成本。
审核编辑:刘清
-
IC设计
+关注
关注
38文章
1408浏览量
108503 -
TCL
+关注
关注
11文章
1817浏览量
91940
原文标题:3D-IC 设计之自底向上实现流程与高效数据管理
文章出处:【微信号:gh_fca7f1c2678a,微信公众号:Cadence楷登】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
Cadence分析 3D IC设计如何实现高效的系统级规划
Cadence 凭借突破性的 Integrity 3D-IC 平台加速系统创新
TSMC 和 Cadence 合作开发3D-IC参考流程以实现真正的3D堆叠
Cadence Integrity 3D-IC平台Ô支持TSMC 3DFabric技术,推进多Chiplet设计
Cadence Integrity 3D-IC平台进行工艺认证
Integrity™3D-IC平台助力设计者实现驱动PPA目标




 如何建立正确的3D-IC设计实现流程和实现项目高效管理的挑战
如何建立正确的3D-IC设计实现流程和实现项目高效管理的挑战



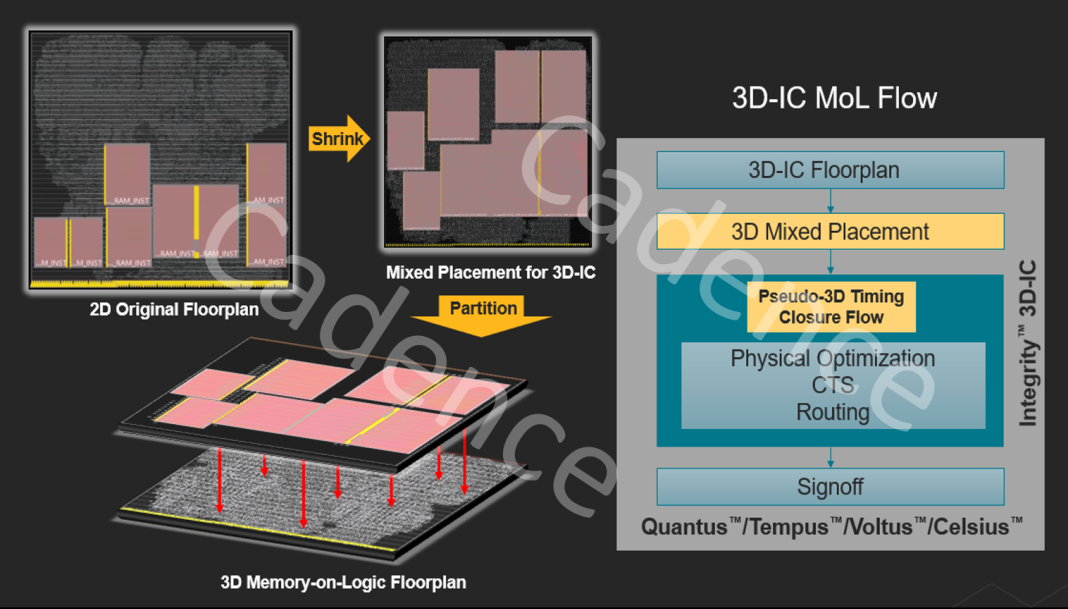



评论