这项研究首先集中于去除直接沉积在硅衬底上的193纳米厚的光刻胶和BARC层,使用傅里叶变换红外光谱(FTIR)和椭圆偏振光谱(SE)来评估去除效率,在第二部分中,研究了金属硬掩模/多孔低k镶嵌结构上蚀刻后光刻胶和BARC层的去除,扫描电子显微镜(SEM)和X射线光电子能谱(XPS)用于评估清洗效率,使用平面电容器结构确定暴露于等离子体和湿化学对低k膜的介电常数的影响。
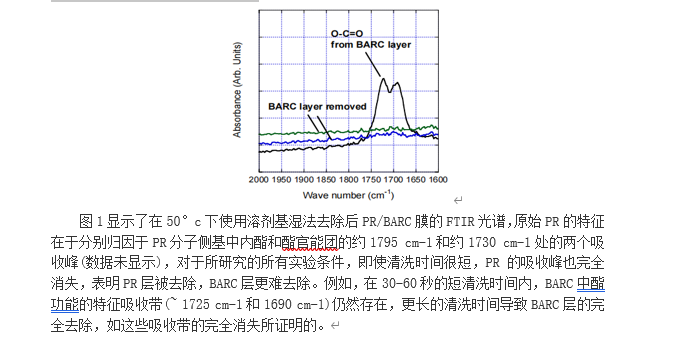
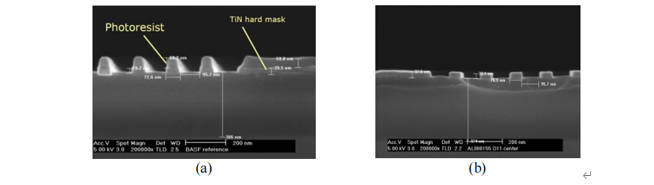
对图案化结构的横截面SEM检查表明,在几种实验条件和化学条件下可以实现蚀刻后PR的完全去除,其中在50℃和低兆声功率(10 W)下2分钟代表了有机溶剂基化学(例如化学1)的最佳条件,图3比较了使用化学清洗之前(a)和之后(b)的单镶嵌低k叠层,很明显,PR层被去除了,对轮廓的仔细检查和对残留在表面的层(锡)厚度的测量表明,BARC层也被清洗溶液完全去除。该结果证实了上面给出的XPS数据
通过传统的干法工艺,在同一等离子体室中进行低k图案化,包括BARC和锡开口、PR和BARC剥离以及随后的低k蚀刻,在PR/BARC湿法剥离的情况下,必须打破真空工艺顺序,这可能影响低k蚀刻的结果/性能,为了进一步了解PR湿法去除工艺的影响,随后使用标准蚀刻配方进行低k蚀刻,在湿法PR和BARC去除之后进行的多孔低k层的图案化产生了良好的低k轮廓。
在高兆频超声波功率下清洗时间在1-4分钟之间导致k值显著增加。然而发现在350℃下低压(Ar下3-5托)烘烤1分钟对该湿法工艺后的k值恢复具有有益的影响。
显然,在图中所示的条件下烘烤后,初始k值完全恢复,这些数据表明,即使用H2O/IPA冲洗,溶剂和最可能的其它化学物质仍然保留在低k膜内部,在高温烘烤期间被释放出来,此外,这意味着基于有机溶剂的清洗溶液不会与多孔低k材料反应,并保持其特性。
我们已经证明,对于具有90 nm间距的单镶嵌结构,使用各种化学物质并在不同的兆频超声波功率和清洗时间的实验条件下,PR和BARC层都被完全去除,所述实验条件的范围从10-100 W在2到3分钟之间,其中10 W/2分钟代表最温和的条件,电介质叠层的后续等离子体蚀刻表明,在湿法去除PR和BARC之后,可以获得良好的电介质轮廓,表明湿法工艺不影响多孔低k蚀刻的结果/性能。使用Chem1在50°C下清洗1-4分钟的湿法工艺,由于加入了溶剂和其他化学物质,导致多孔低介电常数的k值显著增加,然而,在低压氩气下350°C烘烤1分钟后,k值可以恢复。
审核编辑:符乾江
-
半导体
+关注
关注
336文章
29987浏览量
258368 -
光刻胶
+关注
关注
10文章
348浏览量
31551
发布评论请先 登录
中国打造自己的EUV光刻胶标准!
半导体湿法去胶原理

国产光刻胶突围,日企垄断终松动
行业案例|膜厚仪应用测量之光刻胶厚度测量

用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量

低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量






 使用全湿法去除Cu BEOL中的光刻胶和BARC
使用全湿法去除Cu BEOL中的光刻胶和BARC















评论