摘要
提供了清洁覆盖半导体衬底的金属区域的方法。文章全部详情:壹叁叁伍捌零陆肆叁叁叁从金属区域去除材料的方法包括加热金属区域,由包含氢气和二氧化碳的气体形成等离子体,以及将金属区域暴露于等离子体。


发明领域
本发明一般涉及半导体制造,更具体地涉及剥离光致抗蚀剂和/或清洁半导体结构的金属或金属硅化物区域的方法。
发明背景
电互连技术通常需要金属或其他导电层或区域之间的电连接,这些导电层或区域位于半导体衬底内或覆盖在半导体衬底上的不同高度处。这种互连通常部分地通过蚀刻穿过绝缘材料到较低高度金属层或金属化区域的沟槽和/或接触开口来进行。例如,通常制造接触开口以与金属氧化物半导体场效应晶体管(MOSFET)的金属硅化物区域形成导电接触。沟槽和接触开口也常规地制造到各种金属层以最终将一个高度上的一个半导体器件元件连接到另一个高度上的另一个半导体器件元件。
审核编辑:符乾江
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
半导体
+关注
关注
339文章
31279浏览量
266692 -
光刻胶
+关注
关注
10文章
357浏览量
31864
发布评论请先 登录
相关推荐
热点推荐
国产光刻胶开启“钳形攻势”
电子发烧友网报道(文/黄山明)如果对半导体产业有兴趣的话,一定对光刻胶(Photoresist)略有耳闻,这是一种对光敏感的高分子材料,广泛应用于微电子制造、半导体工艺、PCB制作以及
从光固化到半导体材料:久日新材的光刻胶国产替代之路
当您寻找可靠的国产半导体材料供应商时,一家在光刻胶领域实现全产业链突破的企业正脱颖而出——久日新材(688199.SH)。这家光引发剂巨头,正以令人瞩目的速度在半导体核心材料国产化浪潮中崭露头角
国产光刻胶突围,日企垄断终松动
厚胶量产到ArF浸没式胶验证,从树脂国产化到EUV原料突破,一场静默却浩荡的技术突围战已进入深水区。 例如在248nm波长的KrF光刻胶武汉太紫微的T150A胶以120nm分辨率和
针对晶圆上芯片工艺的光刻胶剥离方法及白光干涉仪在光刻图形的测量
引言 在晶圆上芯片制造工艺中,光刻胶剥离是承上启下的关键环节,其效果直接影响芯片性能与良率。同时,光刻图形的精确测量是保障工艺精度的重要手段

用于 ARRAY 制程工艺的低铜腐蚀光刻胶剥离液及白光干涉仪在光刻图形的测量
引言 在显示面板制造的 ARRAY 制程工艺中,光刻胶剥离是关键环节。铜布线在制程中广泛应用,但传统光刻胶剥离液易对铜产生腐蚀,影响器件性能

低含量 NMF 光刻胶剥离液和制备方法及白光干涉仪在光刻图形的测量
引言 在半导体制造过程中,光刻胶剥离液是不可或缺的材料。N - 甲基 - 2 - 吡咯烷酮(NMF)虽在光刻胶剥离方面表现出色,但因其高含量




 《华林科纳-半导体工艺》光刻胶剥离清洗
《华林科纳-半导体工艺》光刻胶剥离清洗





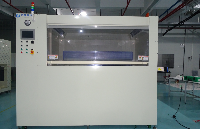




评论