1 晶圆切割
晶圆切割的方法有许多种,常见的有砂轮切割,比如disco的设备;激光切割、划刀劈裂法,也有金刚线切割等等。

这个就是砂轮切割,一般就是切穿晶圆,刀片根据产品选择,有钢刀、树脂刀等等。
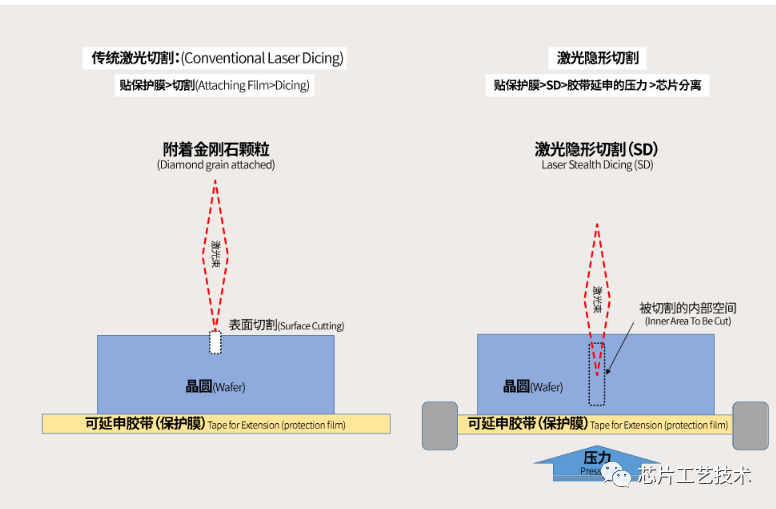
但是对于激光器芯片来说不能进行激光或者刀片这些直接物理作用的方法进行切割。
比如GaAs或者Inp体系的晶圆,做侧发光激光时,需要用到芯片的前后腔面,因此端面必须保持光滑,不能有缺陷。切GaAs、InP材质具有解离晶面,沿此晶面,自动解离出光滑的晶向面,对发光效率等影响很大。
责任编辑:haq
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
激光器
+关注
关注
19文章
3044浏览量
64873 -
晶圆
+关注
关注
53文章
5478浏览量
132908
原文标题:激光器晶圆的切割工艺
文章出处:【微信号:dingg6602,微信公众号:芯片工艺技术】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
热点推荐
什么是晶圆切割与框架内贴片
在半导体制造的精密工艺链条中,芯片切割作为晶圆级封装的关键环节,其技术演进与设备精度直接关系到芯片良率与性能表现;框架内贴片作为连接芯片与封装体的核心环节,其技术实施直接影响器件的电性

晶圆减薄工艺分为哪几步
“减薄”,也叫 Back Grinding(BG),是将晶圆(Wafer)背面研磨至目标厚度的工艺步骤。这个过程通常发生在芯片完成前端电路制造、被切割前(即



 关于晶圆切割的一些工艺
关于晶圆切割的一些工艺


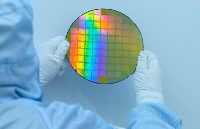





评论